Что такое статические и динамические характеристики биполярных транзисторов. Как они влияют на работу схем. Какие режимы работы транзисторов существуют. На что обратить внимание при анализе характеристик.
Что такое статические характеристики биполярных транзисторов
Статические характеристики биполярных транзисторов — это графики зависимостей между токами и напряжениями на входе и выходе транзистора при отсутствии нагрузки. Основные виды статических характеристик:
- Входные характеристики — зависимость входного тока от входного напряжения
- Выходные характеристики — зависимость выходного тока от выходного напряжения
- Характеристики прямой передачи по току — связь между входным и выходным токами
Статические характеристики снимаются для разных схем включения транзистора — с общей базой (ОБ), общим эмиттером (ОЭ) и общим коллектором (ОК). Наиболее часто используются схемы ОБ и ОЭ.
Особенности входных характеристик транзисторов
Входные характеристики биполярных транзисторов имеют следующие особенности:
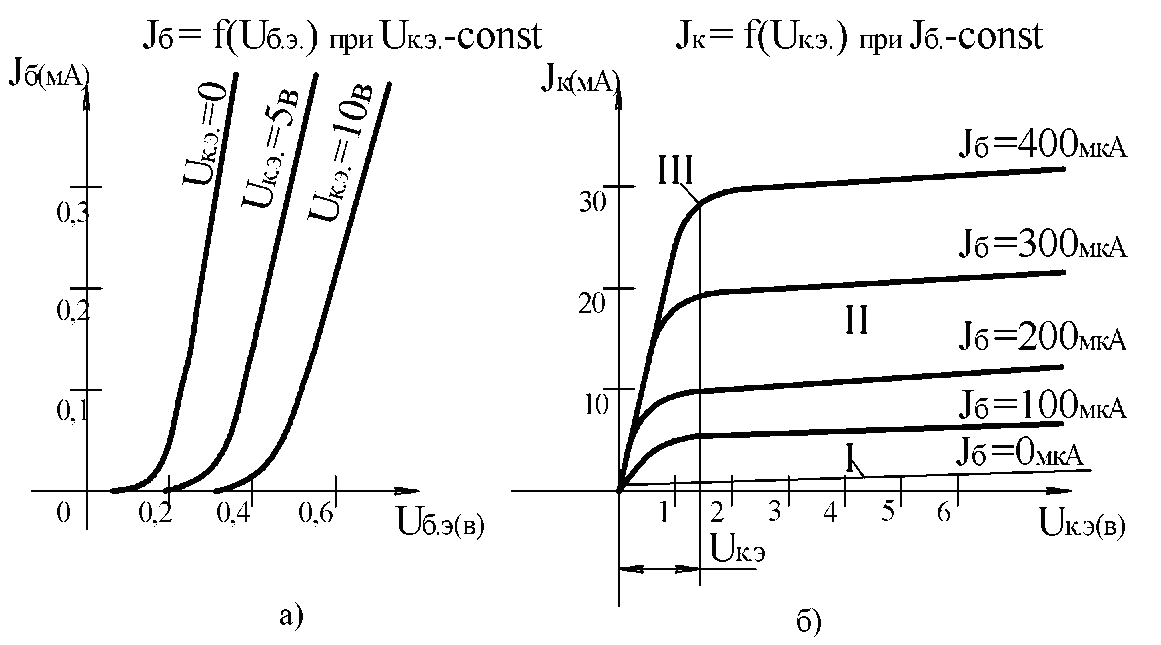
- Нелинейный характер, похожи на ВАХ диода
- Для германиевых транзисторов напряжение база-эмиттер не превышает 0.4 В
- Для кремниевых транзисторов напряжение база-эмиттер не превышает 0.8 В
- При увеличении напряжения коллектор-эмиттер характеристики незначительно смещаются
По входным характеристикам можно определить входное сопротивление транзистора по постоянному и переменному току.
Выходные характеристики биполярных транзисторов
Выходные характеристики транзисторов отражают зависимость коллекторного тока от напряжения коллектор-эмиттер при фиксированных значениях базового тока. Их особенности:
- Нелинейный характер
- При малых напряжениях коллектор-эмиттер (до 0.4-0.8 В) ток коллектора быстро растет
- При больших напряжениях ток коллектора слабо зависит от напряжения
- Ток коллектора в основном определяется током базы
По выходным характеристикам определяют выходное сопротивление транзистора по постоянному и переменному току.
Характеристики прямой передачи по току
Характеристики прямой передачи по току показывают связь между входным и выходным токами транзистора. По ним определяют коэффициенты усиления по току:

- β = ΔIк / ΔIб — для схемы с ОЭ (обычно 20-200)
- α = ΔIк / ΔIэ — для схемы с ОБ (обычно 0.95-0.99)
В схеме с ОБ усиление по току практически отсутствует, в отличие от схемы с ОЭ.
Динамические характеристики биполярных транзисторов
Динамические характеристики отражают работу транзистора при наличии нагрузки в выходной цепи. Основные виды:
- Входная динамическая характеристика
- Выходная динамическая (нагрузочная) характеристика
Динамический режим позволяет оценить работу транзистора в реальных схемах с нагрузкой. По динамическим характеристикам определяют рабочую точку транзистора.
Режимы работы биполярных транзисторов
В зависимости от состояния p-n переходов выделяют следующие режимы работы транзисторов:
- Режим отсечки — оба перехода закрыты
- Режим насыщения — оба перехода открыты
- Активный (линейный) режим — эмиттерный переход открыт, коллекторный закрыт
- Инверсный режим — коллекторный переход открыт, эмиттерный закрыт
Для усиления сигналов используется активный режим работы транзистора.

Методы повышения быстродействия транзисторных ключей
Для повышения быстродействия транзисторных ключей применяются следующие методы:
- Использование форсирующих конденсаторов в цепи управления
- Предотвращение глубокого насыщения транзистора
- Применение диодов Шоттки для ограничения насыщения
- Использование ненасыщенных режимов работы
Эти методы позволяют уменьшить время переключения транзисторных ключей.
Практическое применение характеристик транзисторов
Знание статических и динамических характеристик транзисторов необходимо для:
- Выбора рабочей точки транзистора
- Расчета параметров транзисторных схем
- Определения коэффициентов усиления
- Анализа температурной стабильности
- Оценки быстродействия схем
Характеристики позволяют оптимизировать работу транзисторных устройств и прогнозировать их поведение в различных условиях.
10. Статические и динамические характеристики биполярного транзистора
Статическим режимом работы транзистора называется режим при отсутствии нагрузки в выходной цепи.Статическими характеристиками транзисторов называют графически выраженные зависимости напряжения и тока входной цепи (входные ВАХ) и выходной цепи (выходные ВАХ). Вид характеристик зависит от способа включения транзистора. Эти характеристики показывают графическую зависимость между токами и напряжениями транзистора и могут применяться для определения некоторых его параметров, необходимых для расчета транзисторных схем. Наибольшее применение получили статические входные и выходные характеристики. Входные статические характеристики представляют собой вольт-амперные характеристики эмиттерного электронно-дырочного перехода. Если транзистор включен по схеме с общей базой, то это будет зависимость тока эмиттера Iэ от напряжения на эмиттерном переходе UэБ . При отсутствии коллекторного напряжения (UКБ = 0) входная характеристика представляет собой прямую ветвь вольт-амперной характеристики эмиттерного ЭДП, такой же, как ВАХ диода. Если на коллектор подать некоторое напряжение, смещающее его в обратном направлении, то коллекторный ЭДП расширится и толщина базы вследствие этого уменьшится. В результате уменьшится и сопротивление базы эмиттерному току, что приведет к увеличению эмиттерного тока, то есть характеристика пройдет выше.
При включении транзистора по схеме с общим эмиттером входной характеристикой будет графическая зависимость тока базы IБ ОТ напряжения на эмиттерном переходе UБЭ. Так как эмиттерный переход и при таком включении остается смещенным в прямом направлении, то входная характеристика будет также подобна прямой ветви вольт-амперной характеристики эмиттерного ЭДП .
Выходные статические характеристики биполярного транзистора — это вольт-амперные характеристики коллекторного электронно-дырочного перехода, смещенного в обратном направлении. Их вид также зависит от способа включения транзистора и очень сильно
от состояния, а точнее — режима работы, в котором находится эмиттерный ЭДП.Если транзистор включен по схеме с общей базой (ОБ) и Iэ = 0, то есть цепь эмиттера оборвана, то эмиттерный ЭДП не оказывает влияния на коллекторный переход. Так как на коллекторный ЭДП подано обратное напряжение, то выходная характеристика, представляющая собой зависимость тока коллектора Iк от напряжения между коллектором и базой UКБ, будет подобна обратной ветви ВАХ диода (нижняя кривая ). Если же на эмиттерный ЭДП подать прямое напряжение
, то появится ток эмиттера Iэ, который создаст почти такой же коллекторный ток Iк. Чем больше прямое напряжение на эмиттерном ЭДП, тем больше значения эмиттерного и коллекторного токов и тем выше располагается выходная характеристика.
Сказанное справедливо и при включении биполярного транзистора по схеме с общим эмиттером (ОЭ). Разница состоит лишь в том, что в этом случае выходные характеристики снимают не при постоянных значениях тока эмиттера, а при постоянных значениях тока базы IБ , и идут они более круто, чем выходные характеристики в схеме с ОБ.
При чрезмерном увеличении коллекторного напряжения происходит пробой коллекторного ЭДП, сопровождающийся резким увеличением коллекторного тока, разогревом транзистора и выходом его из строя. Для большинства транзисторов напряжение пробоя коллекторного перехода лежит в пределах от 20 до 30 В. Это важно знать при выборе транзистора для заданного напряжения источника питания или при определении необходимого напряжения источника питания для имеющихся транзисторов.
Увеличение температуры вызывает возрастание токов транзистора и смещение его характеристик. Особенно сильно влияет температура на выходные характеристики в схеме ОЭ .
Динамические характеристики ключей на биполярных транзисторах и повышение их быстродействия
Для неискажающей передачи информации транзисторными ключами необходимо, чтобы все гармоники спектра прямоугольных импульсов или импульсной последовательности усиливались с одинаковым коэффициентом усиления и начальные фазовые сдвиги между гармониками не изменялись.
Это обеспечивается равномерной амплитудно-частотной характеристикой (АЧХ) в рабочем диапазоне частот и линейно-возрастающей фазово-частотной характеристикой ФЧХ.
Искажения частотных характеристик обусловлено реактивными элементами схемы В области низких частот оказывает влияние емкость разделительных конденсаторов
Различают несколько временных интервалов, характеризующих работу транзистора в импульсном режиме (рис. 15.7):
Рис. 15.7. Импульсный режим работы ключа
— время рассасывания неосновных носителей,
— время нарастания выходного напряжения,
— время задержки,
— время спада выходного напряжения.
Можно заметить, что время рассасывания существенно превышает остальные временные интервалы. В течение этого времени происходит запирание предварительно насыщенного транзистора ( UКЭ = UКЭнас). Если у открытого транзистора обеспечить UКЭ большее, чем UКЭнас, то время рассасывания существенно уменьшается. Поэтому, если требуется получить быстродействующую схему ключа, используют различные способы предотвращения глубокого насыщения транзистора. Цифровые схемы, работающие по этому принципу, называют ненасыщенной логикой. Как это достигается схемотехническими средствами, будет показано при рассмотрении конкретных схем.
Обычно частотные свойства цифровых схем характеризуют усредненным параметром, так называемой задержкой распространения сигнала: tзд = (tздL + tздH)/2,где tздL – интервал времени между точками 50%-ного значения на фронте нарастания импульса входного напряжения и 50%-ного значения на фронте спада выходного напряжения, a
Повышение быстродействия ключей. Биполярный транзистор является инерционным элементом, причем его инерционность определяется как собственно частотными свойствами транзистора, так и параметрами управляющего сигнала. Последнее обстоятельство имеет большое практическое значение, так как, формируя определенным образом сигнал управления, можно существенно влиять на инерционность электронного ключа на биполярном транзисторе.
Ключ с форсирующим конденсатором широко применят на практике для повышения быстродействия. Суть данного метода заключается в том, что на интервале включения и выключения формируют такие значения управляющего сигнала, которые существенно превосходят аналогичные, необходимые с точки зрения обеспечения стационарно включенного и выключенного состояний биполярного транзистора.
Рис. 15.8. Определение времени прохождения импульса
Наиболее просто эта идея реализуется в схеме с форсирующим конденсатором в управляющей цепи (рис.15.9).
В момент включения управляющего сигнала t1 в соответствии со вторым законом коммутации входной базовый ток скачкообразно увеличивается от нуля до величины начального импульса базового тока, тем самым ускоряя включение транзистора. По мере заряда конденсатора ток базы постепенно уменьшается до величины тока базы насыщения (момент t2). По приходу заднего фронта входного импульса t3 происходит перезаряд конденсатора, вызывающий скачкообразное уменьшение тока базы транзистора и, соответственно, ускорение запирания ключа.
Рис.15.9. Схема управления биполярным транзистором с форсирующим конденсатором (а) и временные диаграммы, поясняющие его работу
Ненасыщенные ключи на биполярных транзисторах. Одним из способов повышения быстродействия является предотвращение насыщения транзистора. Это, как отмечалось ранее, уменьшает время рассасывания. Обеспечить этот режим можно ограничением базового тока на уровне IБнас. Непосредственно путем соответствующего выбора элементов управляющей цепи это сделать нежелательно, так как этот способ имеет существенные недостатки, в частности из-за большого разброса параметров реальных транзисторов и их температурной нестабильности работа ключа может быть нестабильна. На практике для ограничения базового тока используют фиксацию минимального напряжения коллекторного перехода транзистора. Так как на границе насыщенного режима напряжение на переходе коллектор – база близко к нулю, то ограничивая это напряжение на низком уровне, можно, ограничить ток базы, т.е. исключить накопление избыточных зарядов в области базы, тем самым исключить интервал рассасывания неосновных носителей при выключении транзистора. Это режим реализуется в схеме, приведенной на рис.15.10.
Рис.15.10. Ненасыщенный ключ на биполярном транзисторе
Схема работает следующим образом. До тех пор, пока режим работы транзистора не приближается к режиму насыщения, диод VDостается закрытым и весь ток источника входного сигнала поступает в базу транзистора, вызывая его быстрое отпирание. На границе активного режима и режима насыщения напряжение перехода коллектор-база уменьшается и диод начинает открываться. После этого часть тока источника входного сигнала ответвляется в цепь диода, ток базы не увеличивается и транзистор не входит в режим насыщения. Таким образом, в схеме имеет место нелинейная отрицательная обратная связь по напряжению. Для высокого быстродействия в схеме должны использоваться высокочастотные диоды, имеющие малую величину прямого напряжения.
Наиболее хорошие результаты дает использование диодов Шоттки для реализации ненасыщенных ключей (рис.15.11).
Рис.15.11. Ненасыщенный ключ с диодом Шоттки
Диоды Шоттки отличаются большим быстродействием и малым падением напряжения (время восстановления может быть порядка 0,1 нс и меньше, прямое напряжение около 0,25 В).
Кроме повышенного быстродействия, ненасыщенные ключи имеют недостатки: повышенное напряжение на открытом ключе, пониженная помехоустойчивость и пониженная температурная стабильность. Несмотря на указанные недостатки, ненасыщенные ключи широко используются на практике.
Выходные статические характеристики биполярного транзистора
Статическим режимом работы транзистора называется такой режим, при котором отсутствует нагрузка в выходной цепи, а изменение входного тока или напряжения не вызывает изменение выходного напряжения Рис.7.
| Рис.7. Схема включения транзистора с ОЭ. |
Статические характеристики транзисторов бывают двух видов: входные и выходные. На Рис.8. изображена схема установки для измерения статических характеристик транзистора, включённого по схеме с общим эмиттером.
параметров транзистора с ОЭ.
Входная статическая характеристика – это зависимость входного тока IБ от входного напряжения UБЭ при постоянном выходном напряжении UКЭ. Для схемы с общим эмиттером:
Поскольку ветви входной статической характеристики для UКЭ> 0 расположены очень близко друг к другу и практически сливаются в одну, то на практике с достаточной точностью можно пользоваться одной усреднённой характеристикой (Рис.9а). Особенность входной статической характеристики является наличие в нижней части нелинейного участка в районе изгиба U1 (приблизительно 0,2…0,3 В для германиевых транзисторов и 0,3…0,4 В – для кремниевых).
Выходная статическая характеристика – это зависимость выходного тока IК от выходного напряжения UКЭ при постоянном входном токе IБ. Для схемы включения с общим эмиттером:
Из Рис.9б видно, что выходные характеристики представляют собой прямые линии, почти параллельные оси напряжения. Это объясняется тем, что коллекторный переход закрыт независимо от величины напряжения база-коллектор, и ток коллектора определяется только количеством носителей заряда, проходящих из эмиттера через базу в коллектор, т. е. током эмиттера IЭ.
Динамическим режимом работы транзистора называется такой режим, при котором в выходной цепи стоит нагрузочный резистор RК, за счёт которого изменение входного тока или напряжения UВХ будет вызывать изменение выходного напряжения UВЫХ = UКЭ (Рис.10).
Рис.9. Статические характеристики транзистора с ОЭ: а – входные; б – выходные.
Входная динамическая характеристика – это зависимость входного тока IБ от входного напряжения UБЭ при наличии нагрузки. Для схемы с общим эмиттером:
Поскольку в статическом режиме для UКЭ> 0 мы пользуемся одной усреднённой характеристикой, то входная динамическая характеристика совпадает со входной статической (Рис.11а).
Рис.10. Схема включения транзистора в динамическом режиме с ОЭ.
Выходная динамическая (нагрузочная) характеристика представляет собой зависимость выходного напряжения UКЭ от выходного тока IК при фиксированных значениях входного тока IБ (Рис.11б):
Так как это уравнение линейное, то выходная динамическая характеристика представляет собой прямую линию и строится на выходных статических характеристиках по двум точкам, например: А, В на Рис.11б.
Координаты точки В [IK = 0; UКЭ = ЕК] – на оси UКЭ.
Координаты точки Р [U0К; IK] – соответствуют положению рабочей точки РТ в режиме покоя (при отсутствии сигнала).
Рис.11. Динамические характеристики транзистора с ОЭ: а) – входная; б) – выходная.
Нагрузочная пряма проводится через любые две точки А, В, или Р, координаты которых известны.
В зависимости от состояния p-n переходов транзисторов различают несколько видов его работы – режим отсечки, режим насыщения, предельный и линейный режимы (Рис.11).
Режим отсечки. Это режим, при котором оба его перехода закрыты – транзистор заперт. Ток базы в этом случае равен нулю. Ток коллектора будет равен обратному току IК0, а напряжение UКЭ = EК.
Режим насыщения – это режим, когда оба перехода – и эмиттерный и коллекторный открыты, а в транзисторе происходит свободный переход носителей зарядов. При этом ток базы будет максимальный, ток коллектора будет равен току коллектора насыщения, а напряжение между коллектором и эмиттером стремиться к нулю.
Предельные режимы – это режимы, работа в которых ограничена максимально-допустимыми параметрами: IК доп, UКЭдоп, PК доп (Рис.11б) и IБ нас, UБЭдоп(Рис.11а) и связана с перегревом транзистора или выхода его из строя.
Линейный режим – это режим, в котором обеспечивается достаточная линейность характеристик и он может использоваться для активного усиления.
Дата добавления: 2016-07-05 ; просмотров: 21539 ; ЗАКАЗАТЬ НАПИСАНИЕ РАБОТЫ
Характеристики биполярного транзистора в основном нелинейные и выражаются сложными формулами, неудобными на практике. Поэтому проще и нагляднее использовать графики зависимости параметров транзистора между собой . Так же удобнее изображать измеренные показания параметров конкретного транзистора графическим способом.
Статические характеристики биполярного транзистора c ОЭ
Статические характеристики биполярного транзистора отражают зависимость между напряжениями и токами на его входе и выходе при отсутствии нагрузки.
Эти характеристики будут разные в зависимости от выбранного способа включения транзистора. В основном применяются характеристики со схемами включения с общей базой (ОБ) и общим эмиттером (ОЭ).
Для снятия входных и выходных характеристик биполярного транзистора с ОЭ можно использовать схему как на рис.1 . В ней при помощи потенциометров R1 и R2 подаются нужные напряжения в базовую и коллекторную цепи с определенным током.
Входные характеристики биполярного транзистора
На рис.2 , для сравнения, показаны входные характеристики биполярного транзистора с ОЭ германиевого и кремневого транзисторов. Они выражают (при определенном напряжении между коллектором и эмиттером Uкэ ) зависимость базового тока Iб от приложенного между базой и эмиттером напряжением Uбэ . По форме они нелинейны и похожи на характеристики диодов, т.к. эмиттерный переход транзистора можно представить в виде диода включенным в прямом направлении.
Для каждого типа транзисторов при увеличении коллекторного напряжения характеристики немного смещаются в сторону увеличения базового напряжения, но на практике это увеличение не учитывается.
Из графиков еще видно , что в схеме с ОЭ базо-эмиттерное напряжение в германиевых транзисторах не превышает 0,4В, а в кремниевых — 0,8В. При превышении этих входных напряжений токи, проходящие через транзистор, могут стать недопустимо большими, которые приведут к пробою транзистора.
Так как входная характеристика биполярного транзистора нелинейна, значит и входное сопротивление, зависящее от входного напряжения и тока, тоже нелинейно.
Для примера определим базовый и коллекторный токи транзистора МП42Б с коэффициентом усиления β=50 ( рис.3 ) в разных точках характеристики.
В точке А базовый ток Iб=0,02mA и тогда коллекторный ток равен
Iк=β•Iб=50•0.02=1mA.
Можно наоборот определить на графике по известному коллекторному току Iк=13mA базовое напряжение Uэб . Базовый ток при таком Iк равен:
Iб=Iк/β=13/50=0,26mA.
Значит Uэб=0,25В ( точка В ).
На этой же характеристике так же можно найти входное сопротивление транзистора для постоянного и переменного (дифференциально динамического) токов.
Сопротивление по постоянному току относится к постоянной составляющей сигнала, а по переменному току — к переменной составляющей сигнала. Входное сопротивление по переменному току имеет существенное значение для согласования между собой транзисторных каскадов.
Сопротивление по постоянному току определяется по закону Ома:
R_=U/I .
В точке А на графике оно будет равно:
Rвх_= Uбэ/Iб = 0,1/ 0,02•10ˉ³ = 5 кОм.
Таким же образом находим сопротивление в точке Б — Rвх_= 1,6 кОм, и в точке В — Rвх_= 1 кОм.
Сопротивление по переменному току находим тоже по закону Ома, но в только в дифференциальной форме:
Rвх
= ∆U/∆I ,
где ∆U ) и ∆I ) — приращения напряжения и тока возле выбранной точки.
Для примера определим сопротивление по переменному току в точке Б ) ( рис.4 ). Задаем приращения (желтый треугольник на рисунке):
∆Uбэ = 0,225-0,175 = 0,05 В,
∆Iэ = 0,16-0,06 = 0,1 mA.
Тогда сопротивление по переменному току равно:
Rвх
=0,05/0,1•10ˉ³ = 500 Ом
Аналогично вычислим сопротивление по переменному току в точке А — Rвх
= 4кОм, а в точке В — 400 Ом. Обычно в схеме с ОЭ это сопротивление бывает в пределах от 500 Ом до 5 кОм.
Выходные характеристики биполярного транзистора
Выходные характеристики биполярного транзистора показывают зависимость коллекторного тока Iк ) от выходного напряжения Uэк ) при определенном базовом токе Iб .
На рис.5 приведено семейство выходных характеристик транзистора.
На графике видно, что выходные характеристики нелинейны, и что при увеличении напряжения Uэк от нуля до 0,4÷0,8 вольт коллекторный ток увеличивается быстро, а затем приращение уже мало и почти не зависит от величины Uэк , а зависит от базового тока. Отсюда можно сделать вывод: в основном базовый ток управляет коллекторным током.
По выходной характеристике транзистора МП42Б ( рис.6 ) определим в точке Б коллекторный ток при Uкэ = 5,7 В и Iб = 40 μA. Он будет равен Iк = 4,5 mA.
А для точки А ток базы при коллекторном напряжении Uкэ = 5,7 В и Iк = 8 mA будет Iб = 80 μA.
Так же по выходной характеристике этого транзистора можно найти выходные сопротивления для постоянного и переменного токов.
Сопротивление по постоянному току в точке Б будет равно:
Rвых_= Uкэ/Iк = 5,7/4,5•10ˉ³ = 1,3 кОм.
Сопротивление по переменному току при приращении:
∆U = 8-3 = 5 В; ∆I = 4,5-4 = 0,5 mA
равно:
Rвых
= ∆U/∆I = 5/0,5•10ˉ³ = 10 кОм.
Это cопротивление может достигать 50 кОм.
Статистические характеристики биполярного транзистора с ОБ.
Для снятия входных и выходных характеристик биполярного транзистора с ОБ используют схему как на рис7 . В ней при помощи потенциометров R1 и R2 подаются нужные напряжения в базовую и коллекторную цепи с определенным током.
Входные характеристики биполярного транзистора
Входные характеристики биполярного транзисторат с ОБ показывают, как зависит эмиттерный ток Iэ от напряжения между эмиттером и базой Uэб при выбранном напряжении Uкб ( рис.8 ) для транзисторов разной проводимости.
Сравнив с входной характеристикой биполярного транзистора с ОЭ видим, что они похожи, но и имеют различия.
Это, во-первых, при увеличении коллекторного напряжения ветви характеристик германиевых и кремниевых транзисторов смещаются влево, Во-вторых, ток эмиттера в этом случае намного больше чем базовый ток при включении с ОЭ и масштаб измерения по оси ординат уже не в микроамперах, а в милиамперах.
По входным характеристикам биполярного транзистора с ОБ можно определить такие же параметры как и с ОЭ: зависимость Iэ от Uэб , входные сопротивления Rвх_ и Rвх
.
По параметрам входной характеристики ( рис.9 ) найдем входные сопротивления в точке А :
∆Uэб= 0,225-0,175 = 0,05 В,
∆Iэ = 16- 6 = 10 mA.
Rвх_= Uбэ/Iэ = 0,2/10•10ˉ³ =20 Ом,
Rвх
= ∆Uэб/∆Iэ =0,05/10•10ˉ³ = 5 Ом.
Вывод: входные сопротивления в схеме с ОБ на много меньше чем с ОЭ и обычно не превышают 100 Ом.
Выходные характеристики биполярного транзистора
На рис.10 показано семейство выходных характеристик биполярного транзистора МП42Б которые выражают зависимость коллекторного тока Iк от выходного напряжения Uбк при определенном эмиттерном токе Iэ . Они чем то похожи на выходные характеристики с ОЭ, но имеют и большие различия.
Одним из отличий является то, что коллекторный ток протекает даже тогда, когда коллекторное напряжение равно нулю. Причина в наличии источника тока в цепи эмиттера.
Второе отличие — выходные характеристики в схеме с ОБ почти горизонтальны, а это значит, что выходное сопротивление больше чем при ОЭ и может достигать по переменному току до 2 МОм.
Статические характеристики прямой передачи по току биполярного транзистора
По характеристике прямой передачи транзистора по току, которая представляет собой связь между входным и выходным токами, можно определить коэффициенты усиления по току в схеме с ОЭ и ОБ как на рис.11
.Коэффициент усиления по току с ОЭ равен:
β=∆Iк/∆Iб
где ∆Iк=2,8-2=0,8 mA;
∆Iб=30-20=10 μА.
β=0,8/10•10ˉ³= 80.
Коэффициент усиления по току с ОБ равен:
α=∆Iк/∆Iэ
где ∆Iк=2,8-2=0,8 mA;
∆Iэ=3-2=1 mA;
α=0,8/1=0,8.
Можно сделать вывод, что при включении транзистора с ОБ усиление по току почти не происходит.
Как уже отмечалось в п. 3.1, транзистор в электрических схемах используется в качестве четырехполюсника, характеризующегося четырьмя величинами: входным и выходным напряжениями и входным и выходным токами ( uВХ, uВЫХ, iВХ, iВЫХ). Функциональные зависимости между этими величинами называются статическими характеристиками транзистора, Чтобы установить функциональные связи между указанными величинами, необходимо две из них взять в качестве независимых переменных, а две оставшиеся выразить в виде функций этих независимых переменных. Как правило, применительно к биполярному транзистору в качестве независимых переменных выбирают входной ток и выходное напряжение. В этом случае входное напряжение и выходной ток выражаются следующим образом:
На практике удобнее использовать функции одной переменой. Для перехода к таким функциям необходимо вторую переменную, называемую в этом случае параметром характеристики, поддерживать постоянной. В результате получаются четыре типа характеристик транзистора:
; (3.31)
характеристика обратной передачи ( связи) по напряжению:
; (3.32)
характеристика (прямой) передачи тока, называемая также управляющей или передаточной характеристикой:
; (3.33)
. (3.34)
Статические характеристики транзистора могут задаваться соответствующими аналитическим выражениями, а могут быть представлены графически. Несколько характеристик одного типа, полученные при различных значениях параметра, образуют семейство характеристик. Семейства входных и выходных характеристик транзистора считаются основными и приводятся в справочниках, с их помощью легко могут быть получены два других семейства характеристик. В различных схемах включения транзистора в качестве входных и выходных токов и напряжений выступают токи, протекающие в цепях различных электродов, и напряжения, приложенные между различными электродами. Поэтому конкретный вид статических характеристик зависит от схемы включения транзистора. Рассмотрим статические характеристики транзистора в наиболее распространенных схемах ОБ и ОЭ.
Статические характеристики в схеме об
В схеме с ОБ (см. рис. 3.3,а) входным током является ток эмиттера iЭ, а выходным — ток коллектора iК, соответственно, входным напряжением является напряжение uЭБ, а выходным — напряжение uКБ.
Входная характеристика в схеме ОБпредставляет собой зависимость
.
Однако, реально в справочниках приводится обратная зависимость
.
Семейство входных характеристик кремниевого n-p-n-транзистора приведено на рис. 3.20. Выражение для идеализированной входной характеристики транзистора в активном режиме имеет вид:
Следует отметить, что в выражении (3.35) отсутствует зависимость токаiЭ от напряжения на коллекторном переходе uКБ. Реально такая зависимость существует и связана она с эффектом Эрли. Как показано в п. 3.3, при увеличении обратного напряжения uКБ. сужается база транзистора , в результате чего несколько увеличивается ток эмиттера iЭ. Увеличение тока iЭ с ростом uКБ. отражается небольшим смещением входной характеристики в сторону меньших напряжений uЭБ. — см. рис. 3.20. Режиму отсечки формально соответствует обратное напряжение uЭБ.>0 , хотя реально эмиттерный переход остается закрытым ( iЭ 0) и при прямых напряжениях uЭБ меньших порогового напряжения.
Выходная характеристика транзистора в схеме ОБ представляет собой зависимость
.
Семейство выходных характеристик n-p-n-транзистора приведена на рис. 3.21. Выражение дляидеализированной выходной характеристики в активном режиме имеет вид: iК= · iЭ+ IКБ0. (3.36)
Всоответствие с этим выражением ток коллектора определяется только током эмиттера и не зависит от напряженияuКЭ. Реально (см. рис. 3.21) имеет место очень небольшой рост iК при увеличении обратного напряжения uКБ, связанный с эффектом Эрли. В активном режиме характеристики практически эквидистантны (расположены на одинаковом расстоянии друг от друга), лишь при очень больших токах эмиттера из-за уменьшения коэффициента передачи тока эмиттера эта эквидистантность нарушается, и характеристики несколько приближаются друг к другу. При iЭ= 0 в цепи коллектора протекает тепловой ток ( iК= IКБ0). В режиме насыщения на коллекторный переход подается прямое напряжение uКБ, большее порогового значения, открывающее коллекторный переход. В структуре транзистора появляется инверсный сквозной поток электронов, движущийся из коллектора в эмиттер навстречу нормальному сквозному потоку, движущемуся из эмиттера в коллектор. Инверсный поток очень резко увеличивается с ростом uКБ. , в результате чего коллекторный ток уменьшается и очень быстро спадает до нуля — см. рис. 3.21.
Динамические свойства биполярных транзисторов
Динамические свойства электронных ключей проявляются при переходе транзистора из отсечки в насыщение и обратно. Этот процесс происходит при нахождении транзистора в линейном режиме и изменении его коллекторного тока от состояния отсечки ( ) до насыщения ( ). Длительность переходного процесса определяется инерционными элементами транзистора и схемы ключа. В эквивалентной схеме транзистора, используемой при анализе линейных схем [ ], в качестве моделей инерционности используют диффузионную ёмкость и ёмкость коллекторно-базового перехода . Свойства схемы ключа, определяемые уровнем используемой технологии, обычно моделируются паразитной ёмкостью монтажа (ёмкостью нагрузки) . Для выяснения роли каждой ёмкости рассмотрим их действие порознь. Возможность и способ объединения результатов раздельного анализа будут рассмотрены позже.
2.2.1 Переходный процесс, определяемый током диффузии
В биполярных транзисторах протекание тока от эмиттера к коллектору происходит как процесс диффузии неосновных носителей за счёт неравномерной плотности их распределения вдоль базы [ ]. Ток диффузии пропорционален градиенту плотности зарядов и скорости диффузии (свойству материала базы):
.
Интегрируя распределение зарядов вдоль базы, определим, что величины диффузионного тока (постоянного вдоль базы) и суммарного заряда в базе связаны пропорциональной зависимостью:
. (2.12)
Здесь Б = К-Э – толщина базы, — скорость диффузии, а — время диффузии носителей от эмиттера до коллектора, основной показатель быстродействия дифузионного процесса. . Оба показателя, влияющие на величину , определяются технологией изготовления транзистора: минимально реализуемой толщиной базы и скоростью диффузии, зависящей от материала базы и использования его легирования.
В режиме отсечки и . При ступенчатом напряжении управляющий ток схемы ключа на рис.2.2 согласно (2.7) изменяется скачком: . Тогда заряд в базе при начинает накапливаться по линейному закону:
(2.13)
и согласно с (2.12) коллекторный ток увеличивается со скоростью:
. (2.14)
При этом рекомбинация неосновных носителей в базе определяет появление базового тока, пропорционального накопленному заряду:
. (2.15)
Возрастание базового тока уменьшает скорость накопления заряда. Поэтому адекватной моделью для (2.13) является эквивалентная схема базо-эмиттерной цепи на рис.2.7.а. В этой схеме ёмкость , называемая диффузионной, моделирует накопление заряда, а ток через резистор — базовый ток . При включении генератора тока (2.7) базовый ток нарастает по мере заряда по экспоненте
, (2.16)
где .
Линейный режим. Если асимптотическая величина тока недостаточна по (2.10) для перехода транзистора в режим насыщения: , то при переходном процессе сохраняется линейный режим и коллекторный ток возрастает пропорционально базовому . Можно определить длительность фронта переходной характеристики линейной импульсной схемы по рис.2.7б и (1.13) как .
Для заданной величины заряда , сравнивая (2.14) и (2.15), находим:
. (2.17)
Схема рис.2.7а демонстрирует характерную особенность схемы ключа в нестационарном режиме (рис.2.2), состоящую в том, что ток после включения разветвляется в базо-эмитерной цепи рис.2.7а между резистором (ток ) и диффузионной ёмкостью: . Поэтому на стадии переходного процесса (рис.2.7б), пока заряжается дифузионная ёмкость , обычное для транзисторов условие не выполняется.
Рис. 2.7
Также напомним, что в частотной области граничную частоту линейной схемы с общим эмиттером определяют постояной времени базовой цепи эквивалентной схемы [ ]: . Полагая , получают удобную и широко используемую формулу оценки связи временных и частотных показателей линейных схем:
. (2.18)
Режим переключения. При достаточной величине входного тока транзистор при достижении базовым током величины переходит в режим насыщения (рис.2.8). Интервал включения можно определить с помощью (1.13) :
. (2.19)
Величина сокращается при увеличении открывающего тока. Для достаточно большой величины , апроксимируя экспоненту в (2.16) двумя слагаемыми, получим :
. (2.20)
Рис. 2.8
В качестве максимальной величины открывающего тока можно предположить . Это соответствует практическому случаю, когда источником управляющего напряжения , в схеме ключа рис.2.2 служит коллекторная цепь , предыдущего аналогичного ключевого каскада. Используя такое допущение в (2.20), получим:
. (2.21)
Величину (2.21) можно считать оценкой минимально возможной величины .
Отметим, что время включения определяется током открывающего генератора , а не схемой включения транзистора. Так, для схемы включения с общей базой, если ток генератора, как в рассмотренном примере, равен току коллектора насыщения, ток коллектора нарастает в линейном режиме с постоянной времени , стремясь к величине . Длительность фронта экспоненциального переходного процеса при этом оказывается даже хуже оценки (2.21) для схемы с общим эмиттером.
После момента коллекторный ток фиксируется на уровне , но ток базы продолжает увеличиваться (рис.2.8), стремясь к величине , т.е. продолжается накопление заряда в базе. Поскольку пропорциональная связь заряда и коллекторного тока (2.12) в режиме насыщения прекращается, заряд, доставленный током , называют избыточным.
На диаграммах (рис.2.8) процесс накопления избыточного заряда изображен штриховой линией, продолжающей экспоненту нарастания коллекторного тока до . Этот ток называют кажущимся [ ], предполагая, что транзистор якобы остался в активном режиме. Фактически кажущийся ток показывает наличие в базе транзистора избыточного заряда. Процесс переключения в насыщение завершается установлением статического уровня заряда, т.е. достижением кажущимся током асимптотического уровня за время .
2.2.2. Этапы процесса переключения биполярного транзистора
(влияние диффузионной ёмкости)
После достижения статического состояния насыщения ключа возможно рассмотрение этапа обратного переключения в отсечку.
Для выявления общих принципов управления длительностью различных этапов переключения рассмотрим схему транзисторного ключа (рис.2.9а), в базовой цепи которого имеется дополнительная цепочка с источником отрицательной полярности . На диаграммах рис.2.10 представлены изменения во времени токов , и напряжения на коллекторе на различных этапах переключения.
Этап перехода в насыщение
Для стадии перехода в насыщение используем, как и ранее, приближение и составим эквивалентную схему базовой цепи рис.2.9б. Применяя принцип суперпозиции, определим ток , управляющий режимом транзистора:
. (2.22)
Рис. 2.9
При включении открывающего напряжения в базу транзистора поступает скачёк тока (рис.2.10а) и аналогично с рис.2.8 коллекторный ток растёт по экспоненте до тока коллектора насыщения: . Время перехода транзистора в насыщение
. (2.23)
Заметим, что это больше, чем длительность на рис.2.8 вследствие уменьшения открывающего тока (2.22), вызванного действием источника в базовой цепи.
Напряжение на коллекторе также уменьшается по экспоненте , причём асимптотическая величина в условиях насыщения оказывается отрицательной.
Рис. 2.10
Прекращение процессов нарастания и уменьшения (на уровне ) в точке на рис.2.10б,в выглядит как изломы на диаграммах, свидетельствующие о нелинейном событии перехода транзистора в насыщение. Отметим, что такие изломы обычно хорошо видны на экспериментальных осциллограммах.
В точке завершается этап переключения коллекторного напряжения в схеме рис.2.9. Однако ток продолжает нарастать, доставляя в базу избыточный заряд (пунктирная линия на рис.2.10б).
Этап перехода в отсечку
Для переключения схемы рис.2.9 в режим отсечки следует выключить открывающий ток . Предположим предварительное достижение статического состояния насыщения и выключим при , (рис.2.10а). При этом наличие в базе (диффузионной ёмкости) избыточного заряда позволяет по-прежнему использовать линейную эквивалентную схему рис.2.9б. Полагая в (2.22) , определим, что ток в цепи базы становится отрицательным (рис.2.10а):
. (2.24)
Ток в соответствии с рис.2.7а разряжает диффузионную ёмкость с постоянной времени , уменьшая величину избыточного заряда. Этот процесс представлен на рис.2.10б экспонентой с начальным значением и асимптотическим (штриховая линия).
Начальный этап выключения состоит в уменьшении величины кажущегося тока от до (точка на рис.2.10б), при этом сохраняется режим насыщения, коллекторный ток и напряжение не изменяются (рис.2.10б,в). Длительность этого этапа называют временем задержки:
. (2.25)
Из (2.25) и диаграммы рис.2.10б можно видеть, что интервал задержки определяется степенью насыщения (2.11) транзистора и сокращается при увеличении закрывающего тока , создаваемого источником .
Вторая часть этапа выключения начинается в момент времени , когда кажущийся коллекторный ток достигает уровня и транзистор выходит из насыщения. Линейная эквивалентная схема рис.2.7а остаётся справедливой и базовый ток убывает по той же экспоненте. Однако, в активном режиме коллекторный ток убывает с уменьшением базового тока (сплошная линия на рис.2.10б). Асимптотическое значение коллекторного тока по-прежнему определяется отрицательным током . Коллекторное напряжение при этом увеличивается , стремясь к асимптоте , превышающей уровень . Этап выключения, заканчивается в точке обращением коллекторного тока в ноль и переходом транзистора в отсечку. Длительность выключения
(2.26)
также сокращается за счёт тока .
В режиме отсечки линейная схема рис.2.9б не применима, токи и обращаются в ноль (рис.2.10а,б), а коллекторное напряжение . Характерные изломы диаграмм рис.2.10 в точках и , как отмечалось, свидетельствуют о нелинейных событиях процесса переключения.
В режиме отсечки источник способствует улучшению помехоустойчивости. Применяя к базовой цепи рис.2.9а теорему об эквивалентном генераторе при получим
, (2.27)
что увеличивает допустимиую величину открывающей помехи по сравнению с (2.3).
2.2.3. Анализ возможностей управления длительностью этапов переключения диффузионного транзистора
Проведенный анализ позволяет сформулировать общие положения в отношении ускорения процессов переключения транзисторного ключа.
Для сокращения длительности этапа включения следует увеличивать открывающий ток . После перехода транзистора в режим насыщения ( ) этот ток может быть уменьшен до уровня , сохраняющего степень насыщения на уровне . Такое управление открывающим током обеспечивает исключение этапа задержки при выключении транзистора.
На этапе выключения использование выключающего тока обеспечивает сокращение этапа выключения. Необходимая длительность действия этого тока определяется переходом транзистора в отсечку.
Перечисленные требования удовлетворяются при обобщённой форме базового тока (рис.2.11). Здесь величина определяется током , который после перехода в насыщение уменьшается до .
Рис. 2.11
После возможно переключение транзистора в состояние отсечки. Однако, в практических условиях нахождение транзистора в насыщении должно быть достаточно длительным, чтобы этот факт был зафиксирован в схемах-нагрузках, присоединённых к выходу ключа рис.2.2, например, в простейшем случае, чтобы эти схемы успели перейти в отсечку. Для этого длительность открывающего импульса должна превышать несколько единиц от времени включения .
Длительность этапа выключения определяется величиной выключающего тока . В большинстве применений оптимальным условием считается близость длительности переходных процессов (на цифровом языке – переходов и ).
После перехода в отсечку также требуется интервал для переключения схем — нагрузок. Снова используя величину , оценим минимальный период (максимальную частоту) переключения (рис.2.11):
. (2.28)
Схема с ускоряющим конденсатором
Изложенные принципы переключения имитируются в транзисторном ключе рис.2.12. В схеме используется генератор прямоугольного импульса . Полагая для простоты , определим, что ток генератора (рис.2.13а) при включении импульса равен и убывает по мере заряда конденсатора к асимптоте , которую в соответствии с рис.2.11 следует выбрать близкой к току базы насыщения . Постоянная времени заряда по теореме об эквивалентном генераторе равна .
Коллекторный ток нарастает с постоянной времени , стремясь к асимптотичесому уровню . Однако, в отличие от рис.2.8, ток убывает на этапе включения . Избежим поиска решения дифференциального уравнения второго порядка, предположив достаточно большим соотношение постоянных времени и , как показано на рис.2.13б. Тогда коллекторный ток на этапе включения можно представить экспонентой с асимптотой и для использовать формулу (2.24).
(2.29)
Погрешность вычисления согласно рис.2.13 оценивается величиной отношения .
Рис. 2.12
В режиме насыщения кажущийся коллекторный ток (рис.2.13б) переходит от нарастания к спаду вследствие уменьшения токов генератора и базы.. Интервал достижения кажущимся током величины определяет необходимую длительность импульса генератора , при которой исключается этап задержки при переходе в отсечку. По диаграмме определим: .
Рис. 2.13
После выключения генератора в базовой цепи схемы рис.2.12 протекает отрицательный ток, вызванный накопленным зарядом конденсатора (рис.2.13а)
. (2.30)
Уменьшение коллекторного тока происходит по экспоненте с отрицательной асимптотой и время выключения, как в (2.27) равно
(2.31)
Таким образом, схема рис.2.12 реализует все высказанные идеи сокращения интервалов переключения транзисторного ключа и поэтому интересна в процессе обучения. Тем не менее, использование конденсатора, как элемента, занимающего значительный объём конструкции, в микроэлектронных цифровых схемах, содержащих большое количество ключевых элементов, обычно не желательно. Возможные более эффективные решения будут рассматриваться позже.
2.2.4. Переходный процесс, определяемый действием коллекторно-базовой ёмкости
Вторым фактором, влияющим на динамические показатели транзисторного ключа, является коллекторно-базовая ёмкость , входящая вместе с граничной частотой в паспортные данные транзистора. Характерное свойство действия состоит в том, что эта ёмкость связывает выходную и входную цепи ключа, осуществляя этим обратную связь. На рис.2.14 показана схема транзисторного ключа с учётом действия .
Рис. 2.14
При подаче на вход ступенчатого воздействия возникает ток
. (2.32)
В активном режиме транзистора по мере заряда диффузионной ёмкости (рис.2.7) с постоянной времени нарастают базовый и коллекторный токи , в результате чего уменьшается напряжение на коллекторе транзистора и возникает ток через коллекторно-базовую ёмкость:
. (2.33)
Этот ток согласно рис.2.14 ответвляется от тока генератора , чем уменьшает ток базо-эмиттерного перехода , что в свою очередь уменьшает скорость нарастания базового и коллекторного токов. Таким образом ёмкость осуществляет отрицательную обратную связь и является причиной замедления процесса переключения транзистора между отсечкой и насыщением (или обратно).
Обобщённое описание действия обратной связи
При всём многообразии использования обратных связей существует общее соотношение, связывающее свойства передаточных функций системы с обратной связью и при её отсутствии. На структурной схеме рис.2.15 обозначены: — входная и выходная переменные системы с обратной связью, — глубина обратной связи, — переменная обратной связи и — коэффициент усиления без обратной связи.
По умолчанию предполагается отрицательная обратная связь, поэтому переменная на входе усилителя при включении обратной связи образуется вычитанием . Тогда передаточная функция системы . (2.34)
Формула (2.34) обладает общностью , поскольку применима к переменным любой физической природы, в частности, к напряжениям или токам при соответствующем определении функции обратной связи .
Рис.2.15
Во многих практических применениях обратная связь используется при . Тогда в знаменателе (2.34)можно пренебречь единицей и определить, что свойства системы с обратной связью определяются только свойствами цепи обратной связи.
. (2.35)
Такая независимость от свойств усилителя оказывается весьма полезной во многих применениях, поскольку при микроэлектронной технологии изготовления параметры могут очень мало зависеть от дестабилизирующих факторов любого свойства: температуры, влажности, радиации и др.
Отметим также, что (2.34) применима и для положительной обратной связи ( ), если . Однако при этом превышает коэффициент усиления усилителя и благоприятное свойство стабильности (2.35) утрачивается. При коэффициент передачи обращается в бесконечность и система с положительной обратной связью становится неустойчивой к действию сколь угодно малых помех.
Переходная характеристика ключа с учётом действия . Переменные в (2.34) могут быть вещественными функциями, изображениями по Лапласу, преобразованиями Фурье и др.линейными преобразованиями переменных , . Для анализа схемы рис.2.14 применим к (2.34) преобразование Лапласа и получим:
В схеме рис.2.14 в отсутствие цепи обратной связи ступенчатый ток генератора (2.32) целиком попадает в базу транзистора и токи базы и коллектора нарастают по экспоненте с постоянной времени : . Изображение по Лапласу этого тока: . Тогда передаточная функция по току транзистора без обратной связи равна:
. (2.36)
Ток в цепи обратной связи (рис.2.14) протекает через ёмкость и согласно (2.33) пропорционален производной по времени от коллекторного тока. Преобразуя (2.33) по Лапласу, получим: . Тогда передаточная функция цепи обратной связи по току равна:
.
Обозначим и, подставляя и в (2.34), получим:
. (2.37)
Таким образом, схема ключа рис.2.14 при учёте действия коллекторно-базовой ёмкости по–прежнему описывается дифференциальным уравнением первого порядка с передаточной функцией (2.37) и экспоненциальной переходной характеристикой, а действие отрицательной обратной связи проявляется в увеличении постоянной времени от величины до . Соответственно ухудшаются показатели быстродействия при переходе ключа из отсечки в насыщение или наоборот. Влияние дополнительного слагаемого в может быть значительным даже при малой величине ёмкости вследствие множителя . Уменьшения действия обратной связи можно достичь уменьшением сопротивления резистора (уменьшением коэффициента усиления транзистора в активном режиме).
В то же время возможно и используется целенаправленное увеличение ёмкости между выходом и входом транзисторного усилителя. Тогда передаточная функция (2.37) приближённо равна , т.е. схема рис.2.14 выполняет функцию интегратора.
2.2.5. Переходный процесс, определяемый действием монтажной ёмкости
Дополнительным фактором, влияющим на вид переходного процесса транзисторного ключа, является присутствие в схеме монтажной («паразитной») ёмкости, неизбежное при любом уровне технологии. Для определения влияния такой ёмкости рассмотрим схему ключа на рис.2.16а, где переходная характеристика транзистора определяется временной зависимостью коллекторного тока
. (2.38)
Рис. 2.16
На эквивалентной схеме рис.2.16б показано, что этот ток протекает не только через резистор , но и через ёмкость , что изменяет вид зависимости . Определим суммарную переходную характеристику ключа рис.2.16, как временную зависимость тока через резистор при ступенчатом единичном воздействии на входе схемы. Решая задачу в частотной области, составим эквивалентную схему рис.2.16в для изображений по Лапласу переходной характеристики и токов через резистор и ёмкость, создаваемых коллекторным током транзистора. Заметим, что схема рис.2.16в представляет составляющую суперпозиции в схеме рис.2.16б при , т.е. составлена для переменной составляющей тока. Определим изображение переходной характеристики (2.38) транзистора по коллекторному току , тогда ток согласно рис.2.16в равен:
, (2.39)
где . Для нормированной переходной характеристики по теореме обращения (1.17) находим вычеты: , , и определяем переходную характеристику схемы рис.2.16 с учётом действия монтажной ёмкости:
. (2.40)
Предположим использование достаточно хорошей технологии, чтобы монтажные свойства мало ухудшали свойства транзисторов, например, .
Рис. 2.17
Переходная характеристика в этих условиях показана на рис.2.17. Согласно (2.40) она определяется суммой нарастающей ( ) и спадающей ( ) экспонент, в результате чего приобретает временное запаздывание (сплошная линия на рис.2.17) относительно переходной характеристики схемы без монтажной ёмкости (кружки на рис.2.17), близкое к величине . В то же время скорость нарастания, определяемая постоянной времени , на большей части экспоненты от действия монтажной ёмкости практически не зависит. Этот вывод в отношении действия относительно большой и малой инерционностей на характер переходного процесса имеет достаточно общий характер и будет обсуждаться применительно к цепочке последовательно соединённых ключей.
Поскольку схема ключа работает в нелинейном режиме, то нарастание переходной характеристики прекращается (как на рис.2.10б) при достижении нормированной величины тока насыщения (точка на рис.2.17). Запаздывание момента перехода транзистора в насыщение относительно схемы без монтажной ёмкости примерно равно постоянной времени монтажной ёмкости: .
2.2.6. Переходный процесс в цепочке ключевых каскадов
В достаточно общем виде можно говорить о том, что структура цифровых устройств состоит из многочисленных ключевых элементов, соединённых в последовательные и ветвящиеся цепочки, осуществляющие логические и арифметические операции над двоичными переменными. Поэтому имеет значение вопрос о преобразовании параметов переключения импульсных элементов при распространении операции переключения вдоль цепочки ключей (рис.2.18). Предполагая воздействие на первый ключ функции единичного перепада, определяем переходную характеристику (2.40) с учётом действия расмотренных факторов инерционности . В момент перехода первой схемы в насыщение напряжение на её выходе и присоединённая к выходу ключа последующая схема начинает переходить из предполагавшегося насыщения в отсечку с параметрами переключения, рассмотренными в 2.2.2. Этот процесс снова допускает анализ в линейном режиме и возможность применения
Рис. 2.18
схемы рис.2.16 в для случаев нарастания и убывания выходного напряжения.
Свойства каждого последующего элемента цепочки рис.2.18 описываются такой же переходной характеристикой, однако на вход поступает уже не единичный перепад, а функция . Для определения выходной переменной можно использовать метод Лапласа и определить передаточную характеристику двух звеньев как произведение передаточных характеристик и . Ясно, что число вычетов и число экспоненциальных слагаемых в результате удвоится. При дальнейшем увеличении числа ключей в цепочке усложнение задачи может создать проблемы даже при компьютерном анализе.
Используем анализ во временной области, основанный на вычислении свёртки входного воздействия с импульсной характеристикой:
, (2.41)
где — импульсная характеристика элементов на рис.2.18.
Вычисление свёртки
Не нашли то, что искали? Воспользуйтесь поиском гугл на сайте:
Гибридный силовой транзистор IGBT — статистические и динамические характеристики
Однако актуальными задачами все еще остаются снижение остаточного падения напряжения на IGBT в проводящем состоянии и улучшение стойкости прибора к токовым и температурным перегрузкам. Биполярный p-n-p-транзистор, входящий в состав ячейки IGBT, невозможно перевести в режим насыщения: он принципиально остается в активном режиме. Это приводит к тому, что падение напряжения на открытом IGBT составляет единицы вольт, уступая в несколько раз силовым биполярным транзисторам (БТ) и тиристорам. Кроме того, коллектор БТ, входящий в базовую ячейку IGBT, и область истока полевого транзистора МОПТ необходимо шунтировать общей металлизацией для подавления активной работы паразитной p-n-p-n-структуры, самопроизвольно включающейся в режимах перегрузки (эффект «защелкивания» в IGBT, приводящий к потере управляемости ключом).
Все эти проблемы требуют постоянного усовершенствования технологий IGBT, главным направлением развития которых является изменение картины распределения профиля носителей в базовой области прибора (технология Trench-Gate с эффектами усиленной инжекции и накопления носителей). Однако подобные решения весьма дорогостоящи, технологически сложны и доступны только для мировых лидеров в области создания силовых приборов.
Остановимся на некоторых физических явлениях в структуре IGBT, позволяющих предложить техническое решение указанных выше проблем. Во-первых, это фундаментальный эффект смыкания p-областей объемного заряда в канале IGBT, разрешающий использовать низковольтный полевой транзистор МОПТ в монолитной структуре прибора. За счет данного эффекта обеспечивается статическая и динамическая отсечка высокого потенциала со стороны коллектора. Во-вторых, одним из возможных вариантов, подавляющих эффект «защелкивания», является разделение p-областей коллектора составного биполярного транзизстора БТ и истока низковольтного полевого транзистора МОПТ. В монолитной ячейке IGBT этого достичь практически невозможно. Вот почему и было предложено разделение структуры IGBT на два отдельных монокристалла: высоковольтный p-i-n-диод с полевым управлением (аналог силового тиристора с электростатическим управлением — ТЭУ) и низковольтный управляющий полевой транзистор. В структуре ключа оба монокристалла соединены по гибридной технологии (рис. 2), что и определило его название — гибридный IGBT (H-IGBT).
Рис. 1. Структура базовой ячейки IGBT силового транзистора
Рис. 2. Структура гибридного IGBT транзистора.
Аббревиатура IGBT в названии гибридного ключа оставлена по следующим соображениям:
- Эквивалентные схемы гибридного и монолитного IGBT практически совпадают [1].
- Функциональные аналоги обоих транзисторов размещаются в идентичных серийных корпусах и имеют одинаковые массо-габаритные показатели.
- Сравнительное исследование динамических параметров силовых модулей и дискретных ключей данных аналогов демонстрирует схожие, а в ряде случаев одинаковые показатели.
4. Управление обоими типами ключей осуществляется от одинаковых серийных драйверов.
В то же время гибридный IGBT имеет целый ряд преимуществ:
- Остаточное падение напряжения существенно меньше, чем у монолитных IGBT за счет насыщения внутреннего p—n—p-транзистора.
- Полностью подавлен эффект «защелкивания».
- Каскадная схема соединения приводит к значительному уменьшению эффекта Миллера в переходном процессе переключения гибридного IGBT.
- Существенно увеличена стойкость к эффекту dU/dt, что позволяет обходиться без источника отрицательного смещения в цепи затвора.
5. Доступ к целому ряду характерных точек конструкции ключа позволяет считывать важную информацию о его работе. Основные характеристики, параметры и конструктивные особенности гибридного IGBT достаточно подробно были рассмотрены в предыдущих статьях, опубликованных в журнале «Силовая электроника». В настоящей статье приводятся новые результаты исследования вольт-амперных характеристик (ВАХ) гибридных IGBT с различным временем жизни носителей, полученным посредством электронного облучения.
Результаты исследования ВАХ в полном диапазоне токов нагрузки представлены на рис. 3, а в области малых плотностей тока — на рис. 4.
Рис. 3. ВАХ гибридного IGBT
Рис. 4. ВАХ гибридного IGBT в области малых плотностей тока
В этих характеристиках номера соответствуют приборам с различными дозами облучения:
- Без облучения (tt = 12 мкс).
- Доза облучения — 1 (tt = 4 мкс).
- Доза облучения — 2 (tt = 2 мкс).
- Доза облучения — 3 (tt = 1 мкс).
- Доза облучения — 4 (tt = 0,6 мкс).
- Доза облучения — 5 (tt = 0,4 мкс).
- Доза облучения — 6 (tt = 0,1 мкс).
Как и в монолитных IGBT первого-второго поколения, на статических ВАХ (кривые 3-7) наблюдаются области отрицательного дифференциального сопротивления ОДС (S-об-разные ВАХ). Наличие ОДС на ВАХ транзисторов с изолированным затвором объясняется следующим образом [4]. При малых токах, то есть при малых уровнях инжекции время жизни носителей также невелико (τ/τpo< 10) и эффект модуляции проводимости n—-базы транзистора слабо выражен. При переходе
к области относительно высоких плотностей тока (j > 30 А/см2) сопротивление «–-базы сильно уменьшается. Это снижение сопротивления тем резче, чем больше отношение времени жизни носителей при высоком и низком уровне инжекции. Как правило, ОДС проявляется, если τ/τpo ≥50-100. Чем меньше время жизни, тем ОДС больше и по току, и по напряжению. С увеличением тока нагрузки ОДС исчезает. Такое соотношение времен характерно для IGBT-транзисторов с сильно легированным буферным слоем n’. В структурах без n’-слоя эффект не проявляется, так как переход к большому уровню инжекции в подобных приборах происходит уже при сравнительно малых токах нагрузки.
Следует упомянуть также влияние степени легирования буферного слоя n’ на эффект «защелкивания». Чем выше степень легирования этого слоя, тем выше плотность тока, при которой наступает упомянутый эффект. Следовательно, для гибридного IGBT, где эффект «защелкивания» устранен конструктивным решением, возможно более рациональное решение по выбору оптимальной величины степени легирования слоя n’.
На рис. 5, 6 показано влияние величины форсирующего заряда на фронт включения гибридного IGBT. Для осуществления диодного режима в высоковольтном кристалле прибора его затвор должен находиться в режиме «плавающего» потенциала. Однако в процессе выключения необходимо обеспечить качественную шунтировку затвора на общую шину. Данное переключение обеспечивается в структуре ключа дополнительным регулирующим элементом (РЭ). Динамика процесса включения-выключения РЭ определяет качество переходных процессов ключа в целом. Например, при включении важным моментом является обеспечение дополнительного форсирующего заряда в базовую цепь гибридного IGBT. Если динамика переключения регулирующего элемента относительно медленна, то может происходить шунтировка этим элементом форсирующего тока от драйвера, и фронт включения IGBT значительно ухудшается. При выключении прибора высокое сопротивление в цепи затвора р-г-п-диода при медленном переключении регулирующего элемента может приводить к динамической перегрузке управляющего полевого транзистора.
Рис. 5. Включение при форсирующем заряде 75 нК: 1 — Ugs(10 В/дел), 2 — Uds(100 В/дел), 3 — Id(5 А/дел)
Рис. 6. Включение при форсирующем заряде 150 нК: 1 — Ugs(10 В/дел), 2 — Uds(100 В/дел), 3 — Id(5 А/дел)
Структура и технология нового ключа были разработаны специалистами ВЭИ и МЭИ в рамках государственной программы «Национальная технологическая база» [2, 3]. К выпуску гибридного IGBT первого поколения в 2006 г. приступила компания ОАО НПО «Энергомодуль» (г. Троицк, Московская область).
Литература
- Воронин П. А. Силовые полупроводниковые ключи. Семейства, характеристики, применение. М.: Додека — XXI, 2001.
- Полупроводниковое ключевое устройство с полевым управлением. Патент РФ № 2199795. Опубл. 27.02.2003. Бюл. № 6.
- Полупроводниковое ключевое устройство. Патент РФ RU2268545С2. Опубл. 20.01.2006. Бюл. № 2.
- Кузьмин В. А., Юрков С. Н, Поморцева Л. И. Анализ и моделирование статических характеристик биполярных транзисторов с изолированным затвором // Радиотехника и электроника. 1996, том 41, № 7.
ЧАСТОТНЫЕ И ПЕРЕХОДНЫЕ ХАРАКТЕРИСТИКИ БИПОЛЯРНЫХ ТРАНЗИСТОРОВ
1 МОСКОВСКИЙ ГОСУДАРСТВЕННЫЙ УНИВЕРСИТЕТ имени М. В. ЛОМОНОСОВА Физический факультет Практикум кафедры физики колебаний Описание задачи ЧАСТОТНЫЕ И ПЕРЕХОДНЫЕ ХАРАКТЕРИСТИКИ БИПОЛЯРНЫХ ТРАНЗИСТОРОВ Составитель: Сенаторов К.Я. Новая редакция: Николаева Е.П. Москва, 2012
2 1 ЧАСТОТНЫЕ И ПЕРЕХОДНЫЕ ХАРАКТЕРИСТИКИ БИПОЛЯРНЫХ ТРАНЗИСТОРОВ 1. ВВЕДЕНИЕ Биполярный транзистор полупроводниковый усилительный прибор с двумя взаимодействующими p-n — переходами. Полупроводниковая структура биполярного транзистора содержит три слоя, составляющие единый монокристалл полупроводника. Полупроводниковые слои различаются типом проводимости (n-слой с электронной проводимостью, p-слой с дырочной проводимостью). В структуре транзистора области p- и n-типов проводимости чередуются. Эти области образуют два p- n-перехода. Одна из крайних областей называется эмиттером, другая — коллектором, а средняя область называется базой. В зависимости от чередования типа проводимости областей (n- или p- типов) транзисторы бывают n-p-n — типа и p-n-p — типа. Схематическая структура биполярного транзистора p-n-p — типа и распределение токов в нем представлены на рис I Э I Б I К Э p n p К Б E Б E К Рис.1.1
3 2 Передача и усиление электрических сигналов транзисторами определяется процессами инжекции в базу со стороны эмиттера дырок и электронов, их диффузией и дрейфом в области базы и процессом их собирания коллектором. Эмиттерный p-n — переход смещен в прямом направлении, через него в область базы инжектируются неосновные для базы носители. Носители диффундируют через базу и за вычетом рекомбинировавших в ней доходят до коллекторного p-n — перехода, смещенного в обратном направлении. Эти носители, являющиеся для области коллектора уже основными носителями, целиком втягиваются в него. В биполярных транзисторах базовая область очень тонкая (~1 мкм) и время жизни неосновных носителей в базе достаточно велико. Поэтому бóльшая часть неосновных носителей, диффундирующих в базе, достигает коллектора. Вследствие этого, ток рекомбинации мал по сравнению с током эмиттера и током коллектора. Транзистор является активным четырехполюсником. Из трѐх выводов транзистора на один подаѐтся входной сигнал, со второго снимается выходной сигнал, а третий вывод является общим для входной и выходной цепи. Схемы включения транзисторов получили своѐ название в зависимости от того, какой из выводов транзисторов будет являться общим с общей базой (ОБ), с общим эмиттером (ОЭ), с общим коллектором (ОК). Отношение коллекторного тока I К к эмиттерному току I Э, (точнее отношение их приращений) называется коэффициентом передачи эмиттерного тока в схеме с общей базой (ОБ) и является одним из основных параметров транзистора (1) Для современных транзисторов.
4 3 Поскольку для узла токов (см. рис. 1.1) выполняются соотношения (I Б ток в цепи базы транзистора) и, постольку отсюда следует (2) Величину называют коэффициентом усиления по току в схеме с общим эмиттером (ОЭ). В этом случае входным током является ток базы I Б, а выходным током — ток коллектора I К. Современные транзисторы имеют значение величины порядка и более. Чем ближе к 1 (то есть, чем менее интенсивен процесс рекомбинации в базовой области), тем больше значение. Полученные соотношения для приращений токов хорошо соблюдаются только для медленно изменяющихся токов. Коэффициенты усиления зависят от скорости изменения входного тока. Если входной ток меняется по гармоническому закону, то коэффициенты функции частоты. Инерционные свойства электронных приборов обуславливаются конечностью пролетного времени частиц, образующих ток в приборе, и наличием резервуаров энергии в виде емкостей обедненных слоев p-n — переходов. При прохождении тока через транзистор в его базовой области происходят два физических процесса: диффузия носителей заряда и их рекомбинация. В зависимости от способа управления входным током инерционные свойства транзистора определяются либо процессом диффузии, либо процессом рекомбинации. Рассмотрим схему включения транзистора с ОБ, в которой входной ток ток эмиттера, а выходной ток ток коллектора. Будем считать, что соотношение между концентрациями основных носителей в соответствующих областях таково, что электронным током через эмиттерный переход можно пренебречь, а ток базы образуется только за счет рекомбинации.
5 4 Предположим, что задаваемый извне ток эмиттера I Э получил мгновенное приращение на величину. До этого момента ток I Э был постоянным, и ему соответствовало определенное распределение концентрации неосновных носителей в базовой области (рис. 1.2, кривая 1). 0 и W — координаты границ базовой области. Задание ступеньки тока соответствует тому, что на эмиттерном переходе концентрация и градиент концентрации изменятся скачком (рис. 1.2, кривая 2). При этом градиент концентрации неосновных носителей у коллекторного перехода в начальный момент времени остается прежним, и коллекторный ток поэтому не претерпевает изменений. Поскольку после скачка входного тока он продолжает поддерживаться постоянным, то и во все последующие после скачка моменты времени градиент концентрации неосновных носителей у эмиттерного перехода не меняется. Изменившийся градиент приводит к тому, что в базовую область начинает втекать большее количество дырок, которые, заполняя базовую область, с течением времени постепенно увеличивают градиент N концентрации неосновных носителей у коллекторной границы базы, в результате чего происходит установление нового значения тока коллектора (рис. 1.2, кривая 3). Таким образом, инерционность нарастания тока коллектора (при мгновенном скачке тока эмиттера) обусловлена диффузионным 0 W характером движения неосновных носителей в Рис.1.2 области базы. Если ток эмиттера изменяется по гармоническому закону с амплитудой, обеспечивающей линейную зависимость между токами транзистора, то при повышении частоты переменная составляющая коллекторного тока уменьшается, так как градиент концентрации неосновных носителей у коллекторного перехода не успевает следовать за градиентом концентрации неосновных
6 5 носителей у эмиттерного перехода. Частоту, при которой переменная составляющая коллекторного тока становится в раз меньше своего максимального значения на низких частотах, называют критической частотой транзистора в схеме с общей базой. Качественно рассмотрение частотных свойств транзистора в схеме с общим эмиттером (ОЭ) проводится при тех же предположениях о концентрации основных носителей, хорошо отражающих особенности реальных процессов. При этих условиях использование тока базового контакта в качестве входного тока имеет характерную черту: для поступающих в базу электронов нет «стока» в соседние области, и они расходуются только на рекомбинацию с дырками, «втекающими» из эмиттерной области (обратным током коллекторного перехода пренебрегаем). Предположим, что в какой-то момент времени под действием внешнего источника ток базы I Б скачком изменился на малую величину, то есть, в базу вводят электроны. Тогда для компенсации их объемного заряда из эмиттерной области в базу поступят дырки. Увеличение концентрации дырок и электронов в базе вызовет увеличение скорости их рекомбинации, что обусловит увеличение притока дырок из эмиттерной области. Увеличение притока дырок будет происходить до тех пор, пока эмиттерный ток не достигнет такого значения, при котором убыль дырок за счет рекомбинации и ухода в коллекторную область не будет компенсирована извне. Частотные свойства транзисторов в схеме с общей базой определяются диффузионным характером движения носителей в базовой области, а в схеме с общим эмиттером — процессом рекомбинаций носителей. Целью задачи является экспериментальное измерение и изучение переходных характеристик биполярных транзисторов.
7 6 2. ТЕОРИЯ Наиболее важными характеристиками линейных электрических цепей и различных электронных приборов, работающих в линейном режиме, являются переходные и частотные характеристики. Переходная характеристика представляет собой отклик линейной системы на ступенчатое изменение сигнала на входе системы. Она описывают процесс установления сигнала h(t) на выходе линейной система с течением времени после подачи на вход единичного импульса. Частотные характеристики (амплитудно-частотная и фазочастотная) являются характеристиками работы линейных систем в стационарных режимах при различных частотах гармонических сигналов на их входе. Оба подхода к исследованию свойств линейных систем с учетом инерционности процессов передачи сигналов от входа системы на ее выход (процессов диффузии заряда через базу и накопления и исчезновения зарядов в емкостях p-n — переходов) являются эквивалентными. А именно, выражения для частотных и переходных h(t) характеристик связаны между собой преобразованием Лапласа [1]. Биполярные транзисторы могут быть отнесены к линейным системам при следующих условиях: 1. Концентрация избыточных неосновных носителей, вводимых в базу через эмиттерный переход, должна быть много меньше концентрации основных носителей в базе. Это условие позволяет пренебречь влиянием электрического поля на движение неосновных носителей заряда в базе по сравнению с процессом диффузии. 2. На входе биполярного транзистора должен быть задан ток. Это устраняет влияние нелинейности вольт-амперной характеристики эмиттерного перехода на задаваемый ток
8 7 инжекции носителей в базу. 3. На выходе транзистора должно быть в хорошем приближении выполнено условие короткого замыкания (КЗ):. Это условие позволяет в чистом виде выделить зависимость между выходным и входным токами. Если же условие КЗ не выполнено, то выходной ток при определенных условиях может сильно зависеть от характера и величины нагрузки. Коэффициент передачи но току плоскостного транзистора при коротком замыкании на выходе и при включении транзистора по схеме с общей базой дается выражением [1]: (3) где W 0 толщина базового слоя, L p диффузионная длина дырок в n — материале базы, время жизни дырок в области базы, частота сигнала, комплексная амплитуда плотности тока выходного сигнала при коротком замыкании на выходе, комплексная амплитуда плотности входного тока,. Соотношение (3) получено при рассмотрении диффузионного движения дырок в базовой области при учете эффекта рекомбинации [1]. Считается, что полный ток через переходы является током дырок, а электронный базовый ток идет только на рекомбинацию. Упростим (3) используя связь между переходной характеристикой линейного четырехполюсника h(t) и его коэффициентом передачи (по Лапласу) [1] (4) Для переходной характеристики приближенно получим [1] (5)
9 8 Из (4) видно, что является условной граничной частотой, на которой (т.е. ). С другой стороны, значение граничной частоты можно найти также и из переходной характеристики, определив интервал времени, при котором (при этом ) Аналогичным путем, используя (3), можно получить приближенное выражение для переходной характеристики и соответствующего ей коэффициента передачи по току для того же плоскостного транзистора, включенного по схеме с общим эмиттером (6) (7) Из (4) — (7) следует, что условная граничная частота может быть экспериментально определена как по амплитудночастотной, так и по переходной характеристикам. Существование зависимости коэффициента усиления по току или от частоты связано с двумя принципиально различными физическими причинами: а) процессами диффузии и рекомбинации движущихся от эмиттера к коллектору неосновных носителей в базе; б) совокупным влиянием емкостей p-n переходов транзистора Рассмотрим более подробно механизмы, ограничивающие высокочастотный предел работы транзистора для подключения с ОБ. У биполярных транзисторов с малыми площадями коллекторных переходов и относительно большим расстоянием между эмиттером и коллектором (широкой базой) критическая
10 9 частота определяется, в основном, скоростью диффузионного процесса. Это характерно для «сплавных» транзисторов. Биполярные транзисторы, изготовляемые с помощью планарно-эпитаксиальных технологий, имеют очень тонкие базовые слои. У таких приборов решающее влияние на ход амплитудно-частотных (АЧХ) и фазо-частотных (ФЧХ) характеристик оказывают величины емкостей коллекторных переходов и сопротивлений базовых слоев. Как известно, в области p-n — переходов образуются двойные обедненные слои, в которых нет подвижных носителей заряда. Эти слои образуют конденсаторы. В Т-образной эквивалентной схеме транзистора это отражается введением емкостей С э и С к (см. рис. 2.1). В Вход Выход схеме с ОБ символ характеризует частотную Рис. 2.1 зависимость эффектов переноса заряда через базу. С э емкость обедненного слоя эмиттерного перехода. С к емкость обедненного слоя коллекторного перехода. Из этих двух емкостей наибольшее влияние оказывает емкость С К, так как она включена параллельно большому сопротивлению r к Емкость С э шунтирована малым сопротивлением, включенным в прямом направлении эмиттерного перехода. При условии короткого замыкания на выходе постоянная времени коллекторной цепи С к r б определяет наивысшую критическую частоту прибора (если частотная зависимость не ограничит ее раньше): (8)
11 10 Влияние емкости С к на частотную характеристику биполярного транзистора, работающего в усилителе тем заметнее, чем больше сопротивление нагрузки в цепи коллектора., град. На рис. 2.2 представлены расчетные ФЧХ: кривая 1 1 соответствует выражению (3), полученному при рассмотрении диффузионного движения дырок в базовой области; кривая соответствует зависимости фазы коэффициента передачи от частоты для итегрирующего RC-звена Рис МЕТОДИКА ЭКСПЕРИМЕНТАЛЬНОГО ИССЛЕДОВАНИЯ ЧАСТОТНЫХ И ПЕРЕХОДНЫХ ХАРАКТЕРИСТИК. УСТАНОВКА ДЛЯ ИЗМЕРЕНИЙ В биполярных транзисторах входной и выходной токи связаны линейными зависимостями (1) и (2). Поэтому в качестве генератора исходного сигнала, вводимого в транзистор через эмиттерный или базовый контакты, следует применить «генератор тока». Генератор тока строго определяется как идеальный генератор, обеспечивающий требуемый ток в исследуемом приборе независимо от значения комплексного сопротивления r цепи, в которой задан этот ток. Ясно, что на практике это условие строго не выполняется; однако его легко выполнить в хорошем для практики приближении, подключая сигнал генератора напряжения к входу транзистора через сопротивление R г
12 11 достаточно большое по сравнению с входным r вх, то есть R г >> r вх. В нашем случае сопротивлением нагрузки будет входное сопротивление транзистора, которое в схеме с общим эмиттером достигает десятков ком. Поэтому стандартные источники сигналов, имеющие небольшое внутреннее сопротивление, должны подключаться к входу транзистора через омические сопротивления, величина которых, по крайней мере, на порядок превышает соответствующее входное сопротивление транзистора. Принципиальные схемы для измерений частотных свойств биполярных транзисторов показаны на рис. 3.1 а, б. В задаче используются транзисторы p-n-p — типа. R 1 Вход Э Б К Выход R 1 Э Б К Выход E(t) Вход R 2 + Е Э — R Е К E(t) R 2 R Е — Б + Е К Рис. 3.1а. Схема с общей базой. Рис. 3.1б. Схема с общим эмиттером. Необходимо создать режим питания биполярного транзистора, обеспечивающий линейную зависимость между входным и выходным переменными токами. Для этого необходимо соблюдать условия достаточной малости переменного сигнала на входе и выходе транзистора. Это накладывает дополнительные ограничения на величины и. Выбор рабочей точки (постоянный ток эмиттера I Э0 и постоянное напряжение на коллекторе), осуществляют следующим образом. Выходной переменный ток транзистора необходимо наблюдать при условии короткого замыкания на его выходе. Выходное сопротивление биполярных транзисторов r вых велико (порядка
13 12 сотен ком), поэтому подключение к его выходу омической нагрузки, величина которой много меньше выходного сопротивления транзистора r вых, обеспечивает с хорошей точностью условия короткого замыкания на выходе, и напряжение на этой нагрузке будет линейно связано со значением входного тока. Ток I Э0 должен быть прямым током (т.е. эмиттерный переход смещен в прямом направлении), а источник коллекторного напряжения Е К должен подключаться так, чтобы коллекторный контакт имел отрицательный потенциал относительно контакта базы (т.е. коллекторный переход смещен в обратном направлении). Для задания тока I Э0 источник э.д.с следует подключить к эмиттерному контакту через сопротивление, величина которого должна быть много больше, чем входное сопротивление транзистора на постоянном токе в схеме с общей базой. При выполнении этого условия ток I Э0 с хорошей степенью точности определяется из соотношения Источник коллекторного смещения подключается к контакту коллектора через сопротивление. Значение E К выбирается из следующих соображений. Выходные характеристики транзистора представляют собой семейство зависимостей тока коллектора I К от напряжения U К для различных значений тока эмиттера I Э0. Нагрузочная прямая где определяется параметрами и E К. Для работы транзистора в режиме линейного усиления рабочая точка выбирается примерно на середине нагрузочной прямой. Поскольку, то. Определив (из условия ), получим
14 13 причем в правой части все величины известны. Итак, расчет параметров схемы для создания режима работы транзистора. соответствующего определенной рабочей точке, производится с использованием соотношений: причем (r вх ~ 10 Ом), (r вых ~ 100 ком). Значение сопротивления (рис. 3.1), обеспечивающего задание переменной составляющей тока эмиттера, определяется из следующих соображений. Амплитуду переменной составляющей следует брать такой величины, чтобы она была примерно на порядок меньше постоянной составляющей тока эмиттера и одновременно обеспечивала сохранение отрицательного потенциала на коллекторном контакте в любой момент времени. Расчет параметров схемы с общим эмиттером использует те же соображения. Поскольку в данном случае входным током является ток базы, а в паспорте транзистора рабочая точка определяется заданием тока эмиттера и напряжением коллектора, то для установления рабочей точки в такой схеме следовало бы рассчитать ток покоя базового контакта с помощью статических характеристик транзистора. Однако при небольших токах эмиттера можно считать, что, где статический коэффициент передачи по току. Схема установки для экспериментального изучения частотных свойств транзистора позволяет снимать как частотные, так и переходные h(t) характеристики транзисторов при включении их по схеме c общей базой или общим эмиттером. На рис приведена блок-схема установки. Для получения частотных характеристик используется генератор гармонических сигналов (ГГС) на входе и осциллограф на выходе схем. Для наблюдений переходных
15 14 характеристик используется генератор прямоугольных импульсов (ГПИ) на входе и осциллограф на выходе схем. Прямоугольный импульс положительной полярности подается в эмиттерную цепь исследуемого транзистора для получения переходных характеристик при включении транзистора по схеме с общей базой. ГГС ОБ Отрицательный прямоугольный импульс используется для создания ГПИ ОЭ отрицательного перепада тока в цепи базы Рис. 3.2 исследуемого транзистора для получения переходных характеристик при включении транзистора по схеме с общим эмиттером. 4. УПРАЖНЕНИЯ Упражнение 1. Снятие частотных характеристик биполярных транзисторов при включении их по схеме с общей базой и общим эмиттером. Снимается зависимость амплитуды выходного сигнала от частоты при постоянной амплитуде сигнала на входе Включить транзистор в исследуемую схему (с общей базой, общим эмиттером) Установить необходимый режим работы (I Э0, U К0 ) или (I Б0, U К0 ). В задаче такой режим обеспечивается при E К ~ 10 В и E Э (E Б ) ~ 10 В Подать на вход исследуемой цепи сигнал от генератора синусоидальных сигналов Выход цепи подключить к осциллографу.
16 Проверить выполнение неравенств и. При выбранных параметрах схем это условие выполняется при амплитуде гармонического сигнала, подаваемого на вход системы 1 В При выполнении измерений следует следить за постоянством амплитуды входного сигнала при изменении его частоты Снять частотные характеристики для трех транзисторов в двух схемах включения, построить графические зависимости и определить критические частоты f кр Подключить параллельно нагрузке конденсатор С, величина которого сравнима с величиной С к в схеме с общей базой для используемого транзистора Снять несколько точек АЧХ в окрестности f кр и нанести их на график, полученный в п Упражнение 2. Снятие переходных характеристик транзисторов при включении их по схеме с общей базой и общим эмиттером. Переходные характеристики транзисторов наблюдаются на осциллографе Установить рабочую точку исследуемого транзистора (см.п. 1.2) Подать на вход исследуемой цепи сигнал необходимой полярности от генератора прямоугольных импульсов Выход цепи подключить к осциллографу Проверить выполнение неравенств, указанных в п. 1.5, учитывая значение амплитуды импульсов напряжения, подаваемых на вход цепи от генератора импульсов.
17 Измерить длительность переходного процесса, наблюдаемого в цепи коллектора исследуемых транзисторов в двух схемах включения. Рассчитать критические частоты транзисторов для этих двух схем Сравнить значения критической частоты транзистора, полученные двумя способами Сравнить переходную характеристику транзистора в схеме с ОБ, с переходной характеристикой, полученной. при подсоединении конденсатора С к нагрузке. Упражнение 3. Снятие фазо-частотных характеристик биполярного транзистора в схеме с общей базой. Для этих измерений нужно использовать оба луча осциллографа Для исследовании ФЧХ выбрать самый «низкочастотный» (по АЧХ) транзистор Включить транзистор в схему с общей базой Установить необходимый режим работы прибора Подать на вход исследуемой схемы синусоидальный сигнал. Этот же сигнал подвести к входу одного из каналов осциллографа Выходной сигнал с нагрузки подать на вход другого канала осциллографа Меняя частоту сигнала, наблюдать сдвиг фаз между синусоидами в первом и втором каналах осциллографа Построить график ФЧХ, сняв ее в диапазоне до 4f кр Сравнить полученную ФЧХ с теоретической кривой 1 на рис. 2.2.
18 17 ЛИТЕРАТУРА 1. Миддлбрук Р. Д. Введение в теорию транзисторов. М.. Атомиздат, 1960 г. 2. Степаненко М. П. Основы теории транзисторов и транзисторных схем. М..»Энергия» г. 3. Ржевкин К. С. Физические принципы действия полупроводниковых приборов. Изд-во МГУ, 1977 г. 4. Кузнецов Ю.И., Логгинов А.С. Митрофанов В.П. Усилители и RC-генераторы низкой частоты на транзисторах и интегральных схемах. Изд-во МГУ. 2009г.
3. Биполярные транзисторы. Физические основы электроники. Курс лекций
3.1. Принцип действия биполярного транзистора. Режимы работы
3.1.1. Общие сведения
3.1.2. Физические процессы в бездрейфовом биполярном транзисторе
3.2. Статические характеристики биполярных транзисторов
3.2.1. Схема с общей базой
3.2.2. Схема с общим эмиттером
3.2.3. Влияние температуры на статические характеристики БТ
3.3. Дифференциальные параметры биполярного транзистора в статическом режиме
3.4. Линейная (малосигнальная) модель биполярного транзистора
3.5. Частотные свойства биполярного транзистора
3.6. Способы улучшения частотных свойств биполярных транзисторов
3.7. Работа транзистора в усилительном режиме
3.8. Особенности работы транзистора в импульсном режиме
3.8.1. Работа транзистора в режиме усиления импульсов малой амплитуды
3.8.2. Работа транзистора в режиме переключения
3.8.3. Переходные процессы при переключении транзистора
3.1. Принцип действия биполярного транзистора. Режимы работы
3.1.1. Общие сведения
Биполярным транзистором (БТ) называется трехэлектродный полупроводниковый прибор с двумя взаимодействующими p-n переходами, предназначенный для усиления электрических колебаний по току, напряжению или мощности. Слово “биполярный” означает, что физические процессы в БТ определяются движением носителей заряда обоих знаков (электронов и дырок). Взаимодействие переходов обеспечивается тем, что они располагаются достаточно близко — на расстоянии, меньшем диффузионной длины. Два p-n-перехода образуются в результате чередования областей с разным типом электропроводности. В зависимости от порядка чередования различают БТ типа n-p-n (или со структурой n-p-n) и типа p-n-p (или со структурой p-n-p), условные изображения которых показаны на рисунке 3.1.
|
а) |
б) |
|
Рисунок 3.1. |
|
Структура реального транзистора типа n-p-n изображена на рисунке 3.2. В этой структуре существуют два перехода с неодинаковой площадью: площадь левого перехода n1+-p меньше, чем у перехода n2-p. Кроме того, у большинства БТ одна из крайних областей (n1 с меньшей площадью) сечения легирована гораздо сильнее, чем другая крайняя область (n2).
Рисунок 3.2
Сильнолегированная область обозначена верхним индексом “+” (n+). Поэтому БТ является асимметричным прибором. Асимметрия отражается и в названиях крайних областей: сильнолегированная область с меньшей площадью (n1+) называется эмиттером, а область n2 — коллектором. Соответственно переход n1+-р называют эмиттерным, а n2-pколлекторным.Средняя область (p) называется базовой (или базой). Правая область n+ служит для снижения сопротивления коллектора. Контакты с областями БТ обозначены на рисунках 3.1 и 3.2 буквами: Э — эмиттер; Б — база; К- коллектор.
Основные свойства БТ определяются процессами в базовой области, которая обеспечивает взаимодействие эмиттерного и коллекторного переходов. Поэтому ширина базовой области должна быть малой (обычно меньше 1 мкм). Если распределение примеси в базе от эмиттера к коллектору однородное (равномерное), то в ней отсутствует электрическое поле и носители совершают в базе только диффузионное движение. В случае неравномерного распределения примеси (неоднородная база) в базе существует “внутреннее” электрическое поле, вызывающее появление дрейфового движения носителей: результирующее движение определяется как диффузией, так и дрейфом. БТ с однородной базой называют бездрейфовыми, а с неоднородной базой — дрейфовыми.
Биполярный транзистор, являющийся трехполюсным прибором, можно использовать в трех схемах включения: с общей базой (ОБ) (рисунок 3.3,а), общим эмиттером (ОЭ) (рисунок 3.3,б), и общим коллектором (ОК) (рисунок 3.3,в). Стрелки на условных изображениях БТ указывают (как и на рисунке 3.1) направление прямого тока эмиттерного перехода. В обозначениях напряжений вторая буква индекса обозначает общий электрод для двух источников питания.
В общем случае возможно четыре варианта полярностей напряжения переходов, определяющих четыре режима работы транзистора. Они получили названия: нормальный активный режим, инверсный активный режим, режим насыщения (или режим двухсторонней инжекции) и режим отсечки.
|
а) |
б) |
в) |
|
Рисунок 3.3. |
||
В нормальном активном режиме (НАР) на эмиттерном переходе действует прямое напряжение (напряжение эмиттер — база UЭБ), а на коллекторном переходе — обратное (напряжение коллектор — база UКБ). Этому режиму соответствуют полярности источников питания на рисунке 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные.
Рисунок 3.4.
Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую базовую область, которая обеспечивает практически без потерь перемещение инжектированных носителей до коллекторного перехода. Коллекторный переход не создает потенциального барьера для подошедших носителей, ставших неосновными носителями заряда в базовой области, а, наоборот, ускоряет их и поэтому переводит эти носители в коллекторную область. “Собирательная” способность этого перехода и обусловила название “коллектор”. Коллектор и эмиттер могут поменяться ролями, если на коллекторный переход подать прямое напряжение UКБ, а на эмиттерный — обратное UЭБ. Такой режим работы называется инверсным активным режимом (ИАР). В этом случае транзистор “работает” в обратном направлении: из коллектора идет инжекция дырок, которые проходят через базу и собираются эмиттерным переходом, но при этом его параметры отличаются от первоначальных.
Режим работы, когда напряжения на эмиттерном и коллекторном переходах являются прямыми одновременно, называют режимом двухсторонней инжекции (РДИ) или менее удачно режимом насыщения (РН). В этом случае и эмиттер, и коллектор инжектируют носители заряда в базу навстречу друг другу и одновременно каждый из переходов собирает носители, приходящие к нему от другого перехода.
Наконец, режим, когда на обоих переходах одновременно действуют обратные напряжения, называют режимом отсечки (РО), так как в этом случае через переходы протекают малые обратные токи.
Следует подчеркнуть, что классификация режимов производится по комбинации напряжений переходов, В схеме включения с общей базой (ОБ) они равны напряжениям источников питания UЭБ и UКБ. В схеме включения с общим эмиттером (ОЭ) напряжение на эмиттерном переходе определяется напряжением первого источника (UЭБ = -UБЭ), а напряжение коллекторного перехода зависит от напряжений обоих источников и по общему правилу определения разности потенциалов UКБ = UКЭ + UЭБ. Так как UЭБ = -UБЭ, тo UКБ = UКЭ — UБЭ; при этом напряжение источников питания надо брать со своим знаком: положительным, если к электроду присоединен положительный полюс источника, и отрицательным — в другом случае. В схеме включения с общим коллектором (ОК) напряжение на коллекторном переходе определяется одним источником: UКБ = -UБК. Напряжение на эмиттерном переходе зависит от обоих источников: UЭБ = UЭК + UКБ = UЭК — UБК, при этом правило знаков прежнее.
3.1.2. Физические процессы в бездрейфовом биполярном транзисторе
Основные физические процессы в идеализированном БТ удобно рассматривать на примере схемы с общей базой (рисунок 3.4), так как напряжения на переходах совпадают с напряжениями источников питания. Выбор p-n-p транзистора связан с тем, что направление движения инжектируемых из эмиттера носителей (дырок) совпадает с направлением тока.
В нормальном активном режиме (НАР) на эмиттерном переходе действует прямое напряжение UЭБ. Поэтому прямой ток перехода
, (3.1)
где Iэ р, Iэ n — инжекционные токи дырок (из эмиттера в базу) и электронов (из базы в эмиттер), а Iэрек — составляющая тока, вызванная рекомбинацией в переходе тех дырок и электронов, энергия которых недостаточна для преодоления потенциального барьера. Относительный вклад этой составляющей в ток перехода Iэ в (3.1) тем заметнее, чем меньше инжекционные составляющие Iэр и Iэn, определяющие прямой ток в случае идеализированного р-n перехода. Если вклад Iэ рек незначителен, то вместо (3.1) можно записать
. (3.2)
Полезным в сумме токов выражения (3.1) является только ток Iэ р, так как он будет участвовать в создании тока коллекторного перехода. “Вредные” составляющие тока эмиттера Iэ n и Iэ рек протекают через вывод базы и являются составляющими тока базы, а не коллектора. Поэтому вредные компоненты Iэ n, Iэ рек должны быть уменьшены.
Эффективность работы эмиттерного перехода учитывается коэффициентом инжекции эмиттера
, (3.3)
который показывает, какую долю в полном токе эмиттера составляет полезный компонент. В случае пренебрежения током Iэ рек
. (3.4)
Коэффициент инжекции g Э «тем выше (ближе к единице), чем меньше отношение Iэ n/ Iэ р. Величина Iэ n/ Iэ р << 1, если концентрация акцепторов в эмиттерной области p-n-p транзистора NАЭ на несколько порядков выше концентрации доноров NДБ в базе (NАЭ >> NДБ). Это условие обычно и выполняется в транзисторах.
Какова же судьба дырок, инжектированных в базу из эмиттера, определяющих полезный ток IЭр? Очевидно, что инжектированные дырки повышают концентрацию дырок в базе около границы с эмиттерным переходом, т.е. вызывают появление градиента концентрации дырок — неосновных носителей базы. Этот градиент обусловливает диффузионное движение дырок через базу к коллекторному переходу. Очевидно, что это движение должно сопровождаться рекомбинацией части потока дырок. Потерю дырок в базе можно учесть введением тока рекомбинации дырок IБ рек, так что ток подходящих к коллекторному переходу дырок
. (3.5)
Относительные потери на рекомбинацию в базе учитывают коэффициентом переноса:
. (3.6)
Коэффициент переноса показывает, какая часть потока дырок, инжектированных из эмиттера в базу, подходит к коллекторному переходу. Значение c Б тем ближе к единице, чем меньшее число инжектированных дырок рекомбинирует с электронами — основными носителями базовой области. Ток IБрек одновременно характеризует одинаковую потерю количества дырок и электронов. Так как убыль электронов в базе вследствие рекомбинации в конце концов покрывается за счет прихода электронов через вывод базы из внешней цепи, то ток IБрек следует рассматривать как составляющую тока базы наряду с инжекционной составляющей IЭ n.
Чтобы уменьшить потери на рекомбинацию, т.е. увеличить c Б, необходимо уменьшить концентрацию электронов в базе и ширину базовой области. Первое достигается снижением концентрации доноров Nд Б. Это совпадает с требованием NАЭ/NДБ, необходимым для увеличения коэффициента инжекции. Потери на рекомбинацию будут тем меньше, чем меньше отношение ширины базы WБ и диффузионной длины дырок в базовой области Lp Б. Доказано, что имеется приближенное соотношение
. (3.7)
Например, при WБ/Lp Б = 0,1 c Б = 0,995, что очень мало отличается от предельного значения, равного единице.
Если при обратном напряжении в коллекторном переходе нет лавинного размножения проходящих через него носителей, то ток за коллекторным переходом с учетом (3.5)
(3.8)
С учетом (3.6) и (3.3) получим
, (3.9)
где
. (3.10)
Это отношение дырочной составляющей коллекторного тока к полному току эмиттера называет статическим коэффициентом передачи тока эмиттера.
Ток коллектора имеет еще составляющую IКБО, которая протекает в цепи коллектор — база при IЭ = 0 (холостой ход, “обрыв” цепи эмиттера), и не зависит от тока эмиттера. Это обратный ток перехода, создаваемый неосновными носителями областей базы и коллектора, как в обычном p-n переходе (диоде).
Таким образом, полный ток коллектора с учетом (3.8) и (3.10)
. (3.11)
Из (3.11) получим обычно используемое выражение для статического коэффициента передачи тока:
, (3.12)
числитель которого (IК — IКБО) представляет собой управляемую (зависимую от тока эмиттера) часть тока коллектора, IКр. Обычно рабочие токи коллектора IК значительно IКБО, поэтому
. (3.13)
С помощью рисунка 3.4 можно представить ток базы через компоненты:
. (3.14)
По первому закону Кирхгофа для общей точки
. (3.15)
Как следует из предыдущего рассмотрения, IК и IБ принципиально меньше тока IЭ; при этом наименьшим является ток базы
. (3.16)
Используя (3.16) и (3.11), получаем связь тока базы с током эмиттера
. (3.17)
Если в цепи эмиттера нет тока (IЭ = 0, холостой ход), то IБ = -IКБО, т. е. ток базы отрицателен и по величине равен обратному току коллекторного перехода. При значении I*Э = IКБО /(1-a ) ток IБ = 0, а при дальнейшем увеличении IЭ (IЭ>I*Э) ток базы оказывается положительным.
Подобно (3.11) можно установить связь IК с IБ. Используя (3.11) и (3.15), получаем
, (3.18)
где
(3.19)
— статический коэффициент передачи тока базы. Так как значение a обычно близко к единице, то b может быть очень большим (b >>1). Например, при a = 0,99 b = 99. Из (3.18) можно получить соотношение
. (3.20)
Очевидно, что коэффициент b есть отношение управляемой (изменяемой) части коллекторного тока (IК — IКБО) к управляемой части базового тока (IБ + IКБО). Действительно, используя (3.14), получаем
.
Все составляющие последнего выражения зависят от IЭ и обращаются в нуль при IЭ = 0. Введя обозначение
, (3.21)
можно вместо (3.18) записать
. (3.22)
Отсюда очевиден смысл введенного обозначения IКЭО это значение тока коллектора при нулевом токе базы (IБ = 0) или при “обрыве” базы. При IБ = 0
IК = IЭ, поэтому ток IКЭО проходит через все области транзистора и является “сквозным” током, что и отражается индексами “К” и “Э” (индекс “О” указывает на условие IБ = 0).
3.2. Статические характеристики биполярных транзисторов
Обычно анализируют входные и выходные характеристики БТ в схемах с общей базой и общим эмиттером. Для определенности и преемственности изложения будем рассматривать p-n-p-транзистор.
3.2.1. Схема с общей базой
Семейство входных характеристик схемы с ОБ представляет собой зависимость IЭ = f(UЭБ) при фиксированных значениях параметра UКБ — напряжения на коллекторном переходе (рисунок 3.5,а).
|
а) |
б) |
|
Рисунок 3.5 |
|
При UКБ = 0 характеристика подобна ВАХ p-n-перехода. С ростом обратного напряжения UКБ (UКБ < 0 для p-n-p-транзистора) вследствие уменьшения ширины базовой области (эффект Эрли) происходит смещение характеристики вверх: IЭ растет при выбранном значении UЭБ. Если поддерживается постоянным ток эмиттера (IЭ = const), т.е. градиент концентрации дырок в базовой области остается прежним, то необходимо понизить напряжение UЭБ, (характеристика сдвигается влево). Следует заметить, что при UКБ < 0 и UЭБ = 0 существует небольшой ток эмиттера IЭ0, который становится равным нулю только при некотором обратном напряжении UЭБ0.
Семейство выходных характеристик схемы с ОБ представляет собой зависимости IК = f(UКБ) при заданных значениях параметра IЭ (рисунок 3.5,б).
Выходная характеристика p-n-p-транзистора при IЭ = 0 и обратном напряжении |UКБ < 0| подобна обратной ветви p-n-перехода (диода). При этом в соответствии с (3.11) IК = IКБО, т. е. характеристика представляет собой обратный ток коллекторного перехода, протекающий в цепи коллектор — база.
При IЭ > 0 основная часть инжектированных в базу носителей (дырок в p-n-p транзисторе) доходит до границы коллекторного перехода и создает коллекторный ток при UКБ = 0 в результате ускоряющего действия контактной разности потенциалов. Ток можно уменьшить до нуля путем подачи на коллекторный переход прямого напряжения определенной величины. Этот случай соответствует режиму насыщения, когда существуют встречные потоки инжектированных дырок из эмиттера в базу и из коллектора в базу. Результирующий ток станет равен нулю, когда оба тока одинаковы по величине (например, точка А’ на рисунок 3.5,б). Чем больше заданный ток IЭ, тем большее прямое напряжение UКБ требуется для получения IК = 0.
Область в первом квадранте на рис. 3.5,б, где UКБ < 0 (обратное) и параметр IЭ > 0 (что означает прямое напряжение UЭБ) соответствует нормальному активному режиму (НАР). Значение коллекторного тока в НАР определяется формулой (3.11) IК = a IЭ + IКБО. Выходные характеристики смещаются вверх при увеличении параметра IЭ. В идеализированном транзисторе не учитывается эффект Эрли, поэтому интегральный коэффициент передачи тока a можно считать постоянным, не зависящим от значения |UКБ|. Следовательно, в идеализированном БТ выходные характеристики оказываются горизонтальными (IК = const). Реально же эффект Эрли при росте |UКБ| приводит к уменьшению потерь на рекомбинацию и росту a . Так как значение a близко к единице, то относительное увеличение а очень мало и может быть обнаружено только измерениями. Поэтому отклонение выходных характеристик от горизонтальных линий вверх “на глаз” не заметно (на рисунке 3.5,б не соблюден масштаб).
3.2.2. Схема с общим эмиттером
Семейство входных характеристик схемы с ОЭ представляет собой зависимости IБ = f(UБЭ), причем параметром является напряжение UКЭ (рисунок 3.6,а). Для p-n-p транзистора отрицательное напряжение UБЭ (UБЭ < 0) означает прямое включение эмиттерного перехода, так как UЭБ = -UБЭ > 0. Если при этом UКЭ = 0 (потенциалы коллектора и эмиттера одинаковы), то и коллекторный переход будет включен в прямом направлении: UКБ = UКЭ + UЭБ = UЭБ > 0. Поэтому входная характеристика при UКЭ = 0 будет соответствовать режиму насыщения (РН), а ток базы равным сумме базовых токов из-за одновременной инжекции дырок из эмиттера и коллектора. Этот ток, естественно, увеличивается с ростом прямого напряжения UЭБ, так как оно приводит к усилению инжекции в обоих переходах (UКБ = UЭБ) и соответствующему возрастанию потерь на рекомбинацию, определяющих базовый ток.
|
а) |
б) |
|
Рисунок 3.6 |
|
Вторая характеристика на рисунке 3.6,а (UКЭ á 0) относится к нормальному активному режиму, для получения которого напряжение UКЭ должно быть в p-n-p транзисторе отрицательным и по модулю превышать напряжение UЭБ. В этом случае (UКБ = UКЭ + UЭБ = UКЭ — UБЭ < 0. Формально ход входной характеристики в НАР можно объяснить с помощью выражения (3.14) или (3.17): IБ =(1 — a )IЭ — IКБО. При малом напряжении UБЭ инжекция носителей практически отсутствует (IЭ = 0) и ток
IБ = -IКБО, т.е. отрицателен. Увеличение прямого напряжения на эмиттерном переходе UЭБ = -UБЭ вызывает рост IЭ и величины (1 — a ) IЭ. Когда (1 — a ) IЭ = IКБО, ток IБ = 0. При дальнейшем роете UБЭ (1 — a ) IЭ > IКБО и IБ меняет направление и становится положительным (IБ > 0) и сильно зависящим от напряжения перехода.
Влияние UКЭ на IБ в НАР можно объяснить тем, что рост |UКЭ| означает рост |UКБ| и, следовательно, уменьшение ширины базовой области (эффект Эрли). Последнее будет сопровождаться снижением потерь на рекомбинацию, т.е. уменьшением тока базы (смещение характеристики незначительно вниз).
Семейство выходных характеристик схемы с ОЭ представляет собой зависимости IК = f(UКЭ) при заданном параметре IБ (рисунок 3.6,б).
Крутые начальные участки характеристик относятся к режиму насыщения, а участки с малым наклоном — к нормальному активному режиму. Переход от первого режима ко второму, как уже отмечалось, происходит при значениях |UКЭ|, превышающих |UБЭ|. На характеристиках в качестве параметра берется не напряжение UБЭ, а входной ток IБ. Поэтому о включении эмиттерного перехода приходится судить по значению тока IБ, который связан с входной характеристикой на рисунке 3.6,а. Для увеличения IБ необходимо увеличивать |UБЭ|, следовательно, и граница между режимом насыщения и нормальным активным режимом должна сдвигаться в сторону больших значений.
Если параметр IБ = 0 (“обрыв” базы), то в соответствии с (3.22) IК = IКЭО = (b + 1 ) IКБО. В схеме с ОЭ можно получить (как и в схеме с ОБ) I = IКБО, если задать отрицательный ток IБ = -IКБО. Выходная характеристика с параметром IБ = -IКБО может быть принята за границу между НАР и режимом отсечки (РО). Однако часто за эту границу условно принимают характеристику с параметром IБ = 0.
Наклон выходных характеристик в нормальном активном режиме в схеме с общим эмиттером во много раз больше, чем в схеме с общей базой (h22Э » b h22Б) Объясняется это различным проявлением эффекта Эрли. В схеме с общим эмиттером увеличение UКЭ, а следовательно и UКБ сопровождается уменьшением тока базы, а он по определению выходной характеристики должен быть неизменным. Для восстановления тока базы приходится регулировкой напряжения UБЭ увеличивать ток эмиттера, а это вызывает прирост тока коллектора D IК, т.е. увеличение выходной проводимости (в схеме с ОБ ток IЭ при снятии выходной характеристики поддерживается неизменным).
3.2.3. Влияние температуры на статические характеристики БТ
Влияние температуры на положение входной характеристики схемы с ОБ при поддержании неизменным ее параметра аналогично ее влиянию на ВАХ полупроводникового диода. В нормальном активном режиме ток эмиттерного перехода можно представить формулой
.
С ростом температуры тепловой ток IЭО растет быстрее, чем убывает экспонента из-за увеличения j Т = kT/q. В результате противоположного влияния двух факторов входные характеристики схемы с ОБ смещаются влево при выбранном токе IЭ на величину D U » (1…2) мВ/°С (рисунок 3.7,а).
Начало входной характеристики в схеме с ОЭ определяется тепловым током коллекторного перехода IКБО который сильно зависит от температуры, так что начало характеристики при увеличении температуры опускается (рисунок 3.7, б).
|
а) |
б) |
|
Рисунок 3.7 |
|
Влияние температуры на выходные характеристики схем с ОБ и ОЭ в НАР удобно анализировать по формулам (3.11) и (3.22):
и .
Снятие выходных характеристик при различных температурах должно проводиться при поддержании постоянства параметров (IЭ = const в схеме с ОБ и IБ = const в схеме с ОЭ). Поэтому в схеме с ОБ при IЭ = const рост IК будет определяться только увеличением IКБО (рисунок 3.8, а).
|
а) |
б) |
|
Рисунок 3.8 |
|
Однако обычно IКБО значительно меньше a IЭ, изменение IК составляет доли процента и его можно не учитывать.
В схеме с ОЭ положение иное. Здесь параметром является IБ и его надо поддерживать неизменным при изменении температуры. Будем считать в первом приближении, что коэффициент передачи b не зависит от температуры. Постоянство b IБ означает, что температурная зависимость IК будет определяться слагаемым (b + 1)IКБО. Ток IКБО (как тепловой ток перехода) примерно удваивается при увеличении температуры на 10°С, и при b >> 1 прирост тока (b + 1)IКБО может оказаться сравнимым с исходным значением коллекторного тока и даже превысить его.
На рисунке 3.8,б показано большое смещение выходных характеристик вверх. Сильное влияние температуры на выходные характеристики в схеме с ОЭ может привести к потере работоспособности конкретных устройств, если не принять схемотехнические меры для стабилизации тока или термостатирование.
3.3. Дифференциальные параметры биполярного транзистора в статическом режиме
Статические характеристики и их семейства наглядно связывают постоянные токи электродов с постоянными напряжениями на них. Однако часто возникает задача установить количественные связи между небольшими изменениями (дифференциалами) этих величин от их исходных значений. Эти связи характеризуют коэффициентами пропорциональности -дифференциальными параметрами.
Рассмотрим процедуру введения дифференциальных параметров БТ на примере наиболее распространенных h-параметров, приводимых в справочниках по транзисторам. Для введения этой системы параметров в качестве независимых переменных при описании статического режима берут входной ток IВХ (IЭ или IБ) и выходное напряжение UВЫХ (UKБ или (UКЭ):
U1= f (I1,U2) (3.23)
I2= f (I1,U2)
В этом случае полные дифференциалы
(3.24)
Частные производные в выражениях (3.24) и являются дифференциальными h-napaметрами, т.е.
dU1=h11 d I1 +h12 dU2 (3.25)
dI2=h21 dI1 + h22 dU2
(h11 -входное сопротивление, h12 -коэффициент обратной передачи, h21 -коэффициент передачи входного тока и h22 -выходная проводимость). Названия и обозначения этих параметров взяты из теории четырехполюсников для переменного тока.
Приращения статических величин в нашем случае имитируют переменные токи и напряжения.
Для схемы с общей базой
dUЭБ=h11Б d IЭ +h12Б dUКБ (3.26)
dIК=h21Б dIЭ + h22Б dUКБ
Эти уравнения устанавливают и способ нахождения по статическим характеристикам, и метод измерения h-параметров. Полагая dUКБ = 0, т.е. UКБ = const, можно найти h11Б и h21Б, а считая dIЭ = 0, т. е. IЭ = const. определить h12Б и h22Б.
Аналогично для схемы с общим эмиттером можно переписать (3.26) в виде
dUБЭ=h11Э d IБ +h12Э dUКЭ (3.27)
dIК=h21Э dIБ + h22Э dUКЭ
Связь h-параметров со статическими характеристиками схем с ОБ и ОЭ и их определение по ним рассмотрены в.
3.4. Линейная (малосигнальная) модель биполярного транзистора
В качестве малосигнальных моделей могут быть использованы эквивалентные схемы с дифференциальными h-, у- и z-параметрами, которые имеют формальный характер и в которых отсутствуют непосредственная связь с физической структурой транзистора. Например, эквивалентная схема для системы Н-параметров приведена на рисунке.
Рисунок 3.9
Широкое распространение нашли эквивалентные схемы с так называемыми физическими параметрами, которые опираются на нелинейную динамическую модель Эберса — Молла, т.е. тесно связаны с физической структурой биполярного транзистора.
Малосигнальную схему БТ легко получить из нелинейной динамической модели заменой эмиттерного и коллекторного диодов их дифференциальными сопротивлениями, устанавливающими связь между малыми приращениями напряжения и тока. Кроме того, в усилительных схемах используется либо нормальный активный, либо инверсный активный режим, а режим насыщения недопустим. Поэтому при переходе к малосигнальной схеме можно ограничиться рассмотрением наиболее распространенного нормального активного режима, так как результаты легко перенести и на инверсный активный режим. В этом случае можно исключить генератор тока и малосигнальную модель БТ для схемы включения с ОБ изобразить, как на рисунке 3.10.
Рисунок 3.10
Поясним смысл элементов модели. Резистор RЭ представляет дифференциальное сопротивление эмиттерного перехода. В первом приближении его можно определить по формуле для идеализированного р-n перехода:
RЭ=dU/dI» j T/IЭ, (3.28)
где IЭ— постоянная составляющая тока эмиттера. Так как при комнатной температуре j т = 0,026 В, то при IЭ = 1 мА RЭ = 26 Ом.
Величина RК называется дифференциальным сопротивлением коллекторного перехода. Оно обусловлено эффектом Эрли и может быть определено по наклону выходной характеристики:
. (3.29)
Величина RК обратно пропорциональна значению параметра h22Б. Дифференциальное сопротивление коллектора может составлять сотни килоом и мегаомы, тем не менее его следует учитывать.
Реактивные элементы модели (Сэ, Ск) оказались теперь присоединенными параллельно резисторам RЭ и RК. Сопротивление базы r½ ББ, которое может превышать сотни ом, всегда остается в модели.
r½ ББ=h12/h22 . (3.30)
Приведенная эквивалентная малосигнальная модель БТ формально относится к схеме включения с ОБ. Однако она применима и для схемы с ОЭ. Для этого достаточно поменять местами плечи этой схемы, называемой Т-образной схемой с физическими параметрами. Электрод “Б” следует изобразить входным, а “Э” — общим, как показано на рисунке 3.11.
Рисунок 3.11
Значения всех элементов остаются прежними. Однако при таком изображении появляется некоторое неудобство, связанное с тем, что зависимый генератор тока в коллекторной цепи выражается не через входной ток (ток базы). Этот недостаток легко устранить преобразованием схемы к виду, изображенному на рисунке 3.11. Чтобы обе схемы были равноценными четырехполюсниками, они должны иметь одинаковые параметры в режимах холостого хода и короткого замыкания. Это требует перехода от тока H21БIЭ к току Н21ЭIБ и замены RК и CК на RК* и CК* соответственно. Связи этих величин определяются формулами
RК*=Н21БRК/ Н21Э=RК /( Н21Э+1) , ( 3.31 )
СК*= СК( Н21Э+1) . ( 3.32 )
Легко убедиться, что RК* характеризует наклон выходной характеристики (эффект Эрли) в схеме с ОЭ и связан с выходной проводимостью в этой схеме соотношением (5.43). Во сколько раз уменьшается RК* по сравнению с RК, во столько же раз возрастает емкость СK* по сравнению с СK, т.е. RKCK =RK*CK*.
3.5. Частотные свойства биполярного транзистора
Частотные свойства определяют диапазон частот синусоидального сигнала, в пределах которого прибор может выполнять характерную для него функцию преобразования сигнала. Принято частотные свойства приборов характеризовать зависимостью величин его параметров от частоты. Для биполярных транзисторов используется зависимость от частоты коэффициента передачи входного тока в схемах ОБ и ОЭ Н21Б и Н21Э. Обычно рассматривается нормальный активный режим при малых амплитудах сигнала в схемах включения с ОБ и ОЭ.
В динамическом режиме вместо приращения токов необходимо брать комплексные амплитуды, поэтому и коэффициенты передачи заменяются комплексными (частотно зависимыми) величинами: Н21Б и Н21Э.
Величины Н21Б и Н21Э могут быть найдены двумя способами:
• решением дифференциальных уравнений физических процессов и определением из них токов;
• анализом Т-образной эквивалентной схемы по законам теории электрических цепей.
Во втором случае Н21Б и Н21Э будут выражены через величины электрических элементов схемы. Мы проведем анализ частотных свойств коэффициентов передачи, используя Т-образную линейную модель (эквивалентную схему) n-р-n транзистора (рисунки 3.10 и 3.11).
На частотные свойства БТ влияют СЭ, СК и r½ ББ, а также время пролета носителей через базу t Б.
Нет надобности рассматривать влияние на частотные свойства транзистора каждого элемента в отдельности. Совместно все эти факторы влияют на коэффициент передачи тока эмиттера Н21Б, который становится комплексным, следующим образом:
, (3.33 )
где Н21Б0— коэффициент передачи тока эмиттера на низкой частоте, f — текущая частота, fН21Б— предельная частота. Модуль коэффициента передачи тока эмиттера равен
( 3.34 ).
Не трудно заметить, что модуль коэффициента передачи ½ Н21Б½ на предельной частоте fН21Б снижается в раз. Сдвиг по фазе между входным и выходным токами определяется формулой
. ( 3.35 )
Для схемы с ОЭ известно соотношение
( 3.36 ).
Подставляя (3.33) в (3.36) получим
(3.37),
где . Модуль коэффициента передачи тока базы будет равен
(3.38).
Как видно, частотные свойства БТ в схеме ОЭ значительно уступают транзистору, включенному по схеме с ОБ.
Граничная частота fГР — это такая частота, на которой модуль коэффициента передачи ½ Н21Э½ =1. В итоге получим, что fГР» fН21Э× Н21Э0.
Транзистор можно использовать в качестве генератора или усилителя только в том случае, если его коэффициент усиления по мощности КP> 1. Поэтому обобщающим частотным параметром является максимальная частота генерирования или максимальная частота усиления по мощности, на которой коэффициент усиления по мощности равен единице. Связь этой частоты с высокочастотными параметрами определяется выражением
, ( 3.39 ).
где fН21Б — предельная частота в мегагерцах; r1ББ — объемное сопротивление в омах; CК — емкость коллекторного перехода в пикофарадах; fМАКС — в мегагерцах.
3.6. Способы улучшения частотных свойств биполярных транзисторов
Рассмотренное выше позволяет сделать следующие выводы. Для улучшения частотных свойств (повышение предельной частоты) рекомендуется следующее.
1. Уменьшать время пролета инжектированных носителей в базовой области, т.е.
а) уменьшать ширину базовой области WБ; б) создавать n-р-n транзисторы, так как подвижность электронов выше, чем у дырок, примерно в 2 раза; в) использовать германиевые БТ, так как в германии подвижность носителей выше. Еще большие возможности открывает использование арсенида галлия.
2. Создавать ускоряющее поле в базовой области для инжектированных из эмиттера носителей. Последнее возникает при неравномерном распределении примесей в базе по направлению от эмиттера к коллектору (рис. 5.31,б). Концентрацию около эмиттера делают примерно в 100 раз больше, чем около коллектора.
Рисунок 3.12
Появление поля объясняется просто. Так как концентрация основных носителей в любой точке базы (дырок n-р-n транзистора) приблизительно равна концентрации примесей в этой точке, то распределение примесей Na(х) одновременно будет и распределением дырок p(х). Под влиянием градиента концентрации дырок будет происходить их диффузионное движение к коллектору, приводящее к нарушению условия электрической нейтральности: около эмиттера будет избыток отрицательного заряда ионов акцепторов, а около коллектора — избыток положительного заряда дырок, которые приходят к коллекторному переходу, но не проходят через него.
Нарушение электрической нейтральности приводит к появлению внутреннего электрического поля в базовой области (минус у эмиттера, плюс у коллектора). Появляющееся поле, в свою очередь, вызовет встречное дрейфовое движение дырок. Нарастание поля и дрейфового потока будет происходить до того момента, когда дрейфовый и диффузионный токи дырок уравняются. Легко видеть, что установившееся (равновесное) значение поля будет ускоряющим для электронов, которые входят в рабочем режиме из эмиттера в базу и будут уменьшать их время пролета, т.е. повышать предельную частоту БТ.
Биполярные транзисторы с неравномерным распределением примесей в базе, приводящим к появлению ускоряющего поля, называются дрейфовыми, а обычные — бездрейфовыми. Практически все современные высокочастотные и сверхвысокочастотные БТ являются дрейфовыми.
Уменьшение времени пролета в базовой области n-р-n транзистора при экспоненциальном законе убывания концентрации акцепторов от Nа(0) до Nа(WБ) учитывается коэффициентом неоднородности базы:
h =0,5ln[ NА(0)/NА(WБ)]
Поэтому можно написать
Для бездрейфовых транзисторовh =0 , а типичные значения для дрейфовых транзисторов .
3. Уменьшать барьерные емкости эмиттерного и коллекторного переходов путем уменьшения сечения областей транзистора и увеличения ширины переходов (выбором концентрации примесей и рабочего напряжения).
4. Уменьшать омическое сопротивление областей базы r½ ББ.
5. Уменьшать время пролета носителей в области коллекторного перехода.
Следует отметить, что ряд требований несовместимы и необходимо при создании транзисторов применять компромиссные решения.
3.7. Работа транзистора в усилительном режиме
При работе транзистора в различных радиотехнических устройствах в его входную цепь поступают сигналы, например переменные напряжения. Под действием входного переменного напряжения изменяются входной и выходной токи транзистора.
Для выделения полезного сигнала в выходную цепь транзистора включают элементы нагрузки. В простейшем случае нагрузкой может служить резистор Rк. На резисторе нагрузки за счет прохождения выходного тока выделяется, кроме постоянного, переменное напряжение. Амплитуда этого напряжения зависит от амплитуды переменной составляющей выходного тока и сопротивления резистора Rк и может быть больше входного напряжения. Процесс усиления сигнала удобно рассмотреть на примере простейших усилителей.
Простейшая схема усилителя на транзисторе, включенном по схеме с ОЭ, показана на рисунке 3.13.
Рисунок 3.13
Коллекторная цепь состоит из резистора Rк и источника Ек, а цепь базы — из источников тока IБ0 и IБm Источник IБ0 обеспечивает положение исходной рабочей точке на участке характеристик с наименьшей нелинейностью. Источник IБm— источник сигнала. В качестве выходного используется переменное напряжение, выделяемое на резисторе нагрузки Rк (на коллекторе транзистора).
Работа такого усилителя поясняется временными диаграммами токов и напряжений, изображенными на рис. 3..
При IБm =0 токи базы и коллектора будут определяться токами в рабочей точке (IБ 0, IК 0)и напряжением на коллекторе UК0= ЕК-IК0 × Rк
Рисунок 3.14
Во время положительного полупериода входного тока (рис. 3.14.,а) прямое напряжение эмиттерного перехода увеличивается, что вызывает рост тока коллектора (рис. 3.14,б) и уменьшение напряжения UКЭ за счет увеличения падения напряжения на сопротивлении коллектора (рисунок 3.14,в). Если работа происходит на линейных участках характеристик транзистора, то формы переменных составляющих токов базы и коллектора совпадают с формой входного напряжения, а переменное напряжение на коллекторе, обусловленной переменной составляющей коллекторного тока, оказывается сдвинутым относительно входного напряжения на 1800. При соответствующем выборе сопротивления нагрузки Rк амплитуда переменного напряжения на выходе такого усилителя Umвых=IКmRк может значительно превышать амплитуду входного напряжения.
3.8. Особенности работы транзистора в импульсном режиме
3.8.1. Работа транзистора в режиме усиления импульсов малой амплитуды
Если транзистор работает в режиме усиления импульсных сигналов малой амплитуды, то такой режим работы в принципе не отличается от линейного усиления малых синусоидальных сигналов. Импульс в этом случае может быть представлен в виде суммы ряда гармонических составляющих. Зная частотные свойства транзистора, можно определить искажения формы импульсов, возникающие при усилении.
Схема импульсного усилителя не отличается от схемы усилителя гармонических сигналов (рисунок 3.13).
3.8.2. Работа транзистора в режиме переключения
Биполярный транзистор широко используется в электронных устройствах в качестве ключа — функцией которого является замыкание и размыкание электрической цепи. Имея малое сопротивление во включенном состоянии и большое — в выключенном, биполярный транзистор достаточно полно удовлетворяет требованиям, предъявляемым к ключевым элементам.
Схема транзисторного ключа показана на рисунке 3.15. Во входной цепи действуют источник смещения ЕБЭ, создающий обратное напряжение на эмиттерном переходе, источник управляющих импульсов прямого напряжения UВХ и ограничительный резистор RБ. Обычно RБ> > Н11Э. В выходной цепи включены сопротивление нагрузки RК и источник питания ЕКЭ.
Рисунок 3.15
Когда нет импульса на входе, транзистор находится в режиме отсечки и ток коллектора практически отсутствует IК» IКБ0 (точка А на выходных характеристиках (рисунок 3.16,б). Напряжение на выходе транзистора uКЭ= ЕКЭ-IК× RК » ЕКЭ.
При подаче на вход транзистора импульсов прямого тока iБ=(UВХ— EБЭ)/RБ=IБ НАС, транзистор открывается, рабочая точка перемещается в точку Б (режим насыщения) и напряжение на коллекторе падает до значения uКЭ= ЕКЭ-IК НАС, RК=UКЭ ОСТ. При дальнейшем увеличении тока базы ток коллектора не увеличивается (рисунок 3.16,а) и напряжение на коллекторе не изменяется (рисунок 3.16,б).
|
а) |
б) |
|
Рисунок 3.16 |
|
3.8.3. Переходные процессы при переключении транзистора
При практическом использовании транзистора большое значение имеет скорость переключения, обуславливающая быстродействие аппаратуры. Скорость переключения определяется процессами накопления и рассасывания неравновесного заряда в базе и коллекторе транзистора, эмиттерном и коллекторном переходах.
В эмиттерном и коллекторном переходах находятся нескомпенсированные заряды неподвижных ионизированных атомов примеси — доноров и акцепторов; неравновесный заряд отсечки в базе можно считать равным нулю.
При переходе к режиму насыщения эмиттерный переход открывается, толщина перехода и его нескомпенсированный заряд уменьшаются, происходит как бы разряд ёмкости эмиттерного перехода. В следствии понижения напряжения на коллекторе, уменьшается его толщина и заряд в нем, т.е. происходит разряд ёмкости коллекторного перехода, открывается коллекторный переход и в области базы за счет инжекции электронов из эмиттерного и коллекторного переходах накапливается большой неравновесный заряд насыщения. В транзисторах, имеющих высокоомный коллектор носители заряда инжектируют и в область коллектора, где так же накапливается неравновесный заряд.
Графики напряжений и токов транзистора при переключении даны на рисунке 3.17. На базу транзистора подается прямоугольный импульс напряжения UВХ-EБЭ (рисунок 3.17,а).
График входного тока показан на рисунке 3.17,б. Величина импульса прямого тока базы IБ ПР определяется в основном сопротивлением ограничительного резистора RБ.
После переключения эмиттерного перехода на обратное направление ток перехода, как и в диоде, имеет первоначально большую величину, ограниченную лишь сопротивлением RБ: IБ ОБР= EБ/ RБ, так как сопротивление эмиттерного перехода в первый момент после переключения очень мало вследствие насыщения базы неравновесными носителями заряда (рисунок 3.17,г).
При прямоугольной форме импульса входного тока импульс выходного тока iК (рисунок 3.17,в) появляется с задержкой tЗ, которая определяется главным образом скоростью нарастания напряжения эмиттерного перехода, зависящей от величин ёмкости перехода и прямого тока базы, т.е. скоростью разряда эмиттерного перехода.
После того как транзистор перейдет из режима отсечки в активный режим, коллекторный ток начинает постепенно нарастать, достигая установившегося значения а время tн. Это время определяется скоростью накопления неравновесного заряда в базе и скоростью разряда емкости коллектора. Таким образом, полное время включения транзистора состоит из времени задержки и времени нарастания:
.
Практически оно может иметь величину от нескольких наносекунд до нескольких микросекунд в зависимости от параметров транзистора.
После подачи в цепь базы запирающего тока IБ ОБР=EБЭ/RБ выходной коллекторный ток прекращается не сразу. На протяжении некоторого времени рассасывания tp он практически сохраняет свою величину, так как концентрация носителей заряда в базе у коллекторного перехода еще остается выше равновесной и коллекторный переход благодаря этому оказывается открытым.
Лишь после того как неравновесный заряд у коллекторного перехода рассосется за счет ухода электронов из базы и рекомбинации, ток коллектора начинает постепенно спадать, достигая время спада tС установившегося значения IKЭ0. В течении этого времени продолжается рассасывание неравновесного заряда базы и происходит перезаряд емкости коллекторного перехода. Заметим, что эмиттерный переход при этом может закрыться раньше или позже коллекторного в зависимости от скорости рассасывания неравновесного заряда, сосредоточенного поблизости от него.
Процесс накопления и рассасывания неравновесного заряда qБ при переключении транзистора поясняется на рисунке 3.17,г. Накопление неравновесного заряда в базе начинается спустя время задержки tз, и заряд за время нарастания tн достигает установившегося значения qБ=Qакт. Далее вследствие падения коллекторного напряжения до величины UКЭ ОСТ< UБЭ коллекторный переход открывается и начинает инжектировать неравновесные носители заряда в базу. Заряд базы снова возрастает, достигая к концу входного импульса значения qБ=Qнас. После переключения напряжения эмиттерного перехода на обратное происходит рассасывание неравновесного заряда базы, за время tР+tС он достигает нулевого значения.
BJT (bipolar junction transistor) транзистор в качестве усилителя
BJT-транзистор — это трехконтактный полупроводниковый прибор, основанный на трех слоях p- и n-слоев с различной концентрацией легирования. БЮТ-транзистор может быть двух типов — pnp и npn BJT-транзистор.
Биполярный транзистор (BJT) имеет три области — базу (B), коллектор (C) и эмиттер (E). Базовый и коллекторный слои слабо легированы, эмиттерный слой — сильно легирован.
Расходы на БЮТ показаны на рисунке ниже.
Рассмотрим транзистор pnp. Он состоит из двух pn-переходов. Один переход смещен в прямом направлении, а другой — в обратном. Большинство профессий перемещаются от E через pn-переход с прямым смещением. Слой B обычно тонкий, но характеризуется высоким удельным сопротивлением, поэтому большая часть карьера будет проходить через слой C (из-за различных уровней легирования этих материалов).
Токи в транзисторе BJT можно найти с помощью закона Кирхгофа: IE = IC + IB.
Обратите внимание, что ток коллектора будет состоять из тока утечки и основного тока карьерного выхода IC = ICMJ + ICMN.
В режиме постоянного тока эмиттерный и коллекторный токи будут связаны соотношением IC = αIE. Для переменного режима отношение более сложное и другое для различных значений токов ∆IC = αAC∆IE.
Для цепи постоянного тока существует коэффициент s, который показывает соотношение между токами базы и коллектора в цепи IC = βIB, β — коэффициент усиления общего эмиттера.В случае цепи переменного тока этот параметр будет изменяться по формуле ∆IC = βAC∆IB.
Эти два коэффициента усиления связаны формулой α = ββ + 1. Еще одно соотношение для токов БЮТ, которое мы можем вывести, это IE = (β + 1) IB.
Основная особенность BJT — малый ток база-коллектор, управляющий большим током коллектора.
Конфигурация с общим эмиттером
Эта конфигурация называется общим эмиттером, поскольку эмиттер является общим для входного и выходного напряжений. Конфигурация обычного эмиттера PNP BJT изображена на рисунке ниже.
Токи в цепи связаны соотношениями: IE = IC + IB, IC = αIB.
Здесь соединение коллектор-база смещено в обратном направлении, а переход база-эмиттер смещено в прямом направлении. Входными данными здесь будет база-эмиттер, а на выходе — коллектор-эмиттер.
В активной области здесь pn-переход база-коллектор смещен в обратном направлении, а pn-переход база-эмиттер смещен в прямом направлении.
Common — базовая конфигурация
Эта конфигурация называется таковой, потому что база подключена как к эмиттеру, так и к коллектору.Выходные характеристики BJT можно разделить на три области — отсечка, насыщенность и активная область.
В области отсечки pn-переходы коллектор-база и эмиттер-база имеют обратное смещение — транзистор выключен.
В активной области pn-переход база-коллектор имеет обратное смещение, а база-эмиттер — прямое смещение.
Представим себе идеальный источник напряжения, пропускающий ток iB через базовую область, переход база-эмиттер становится смещенным в прямом направлении. Изменяя ток от идеального источника напряжения, вы можете управлять током iBE.Если этот идеальный источник напряжения подключен к коллекторной цепи, iCurrent также можно контролировать. Схема для определения ВАХ БЮТ изображена на рисунке ниже.
Наиболее важными динамическими характеристиками BJT являются его характеристики переключения. В стандартной работе транзистор BJT работает как усилитель.
Давайте применим к базовому сигналу переменного тока и постоянного тока, и мы увидим усиление на результирующей кривой IC – VEC, так что все колебания базового тока приводят к усилению тока коллектора.
Важным моментом, который следует учитывать, является схема BJT с самосмещением, которая изображена ниже. Его можно преобразовать в схемы, которые намного проще рассмотреть с точки зрения точки работы БЮТ.
Используя теорему Теневина, мы можем преобразовать схему в следующую схему с эквивалентным сопротивлением и источником напряжения.
Здесь эквивалентное напряжение источника равно V1 = R2R1 + R2V, а Rb — эквивалентное сопротивление базы.Здесь V1 = IbRb + IeRe + Vbe.
Т.е. = (β + 1) Ib, тогда V1 = IbRb + Vbe + Ib (1 + β) Re. V = IeRe + Vce + IcRc, Ie = (1 + 1β) Ic. V = ReIc (1β + 1) + RcIc + Vce.Тогда Ib = V1 – VbeRb + Re (1β + 1) и Vce = V – RcIc – ReIc (1β + 1).
BJT становится переключателем, как только база получает сигнал переменного тока, поэтому он будет работать от режима проводимости до режима блокировки. Характеристики динамического переключения здесь также очень важны, потому что высокочастотная скорость оказывает огромное влияние на потери устройства.
На рисунке ниже показаны вольт-амперные характеристики npn BJT.Чтобы использовать его как усилитель, транзистор должен находиться в линейной области. Для использования транзистора в качестве переключателя он должен работать от области отсечки до области насыщения — включаться и выключаться.
Область включения характеризуется увеличением тока коллектора, когда напряжение коллектор-эмиттер остается небольшим. Область обеднения в транзисторе становится очень маленькой, и по мере увеличения проводимости она соответствует области насыщения на Рисунке 1.
Область выключения характеризуется высоким напряжением коллектор-эмиттер и низким уровнем тока коллектора, что соответствует области отключения.Таким образом, коммутационные потери возникают, когда устройство переключается на высокой частоте. Время нарастания и спада сигнала играет очень важную роль.
Для расчета потерь мощности транзистора полезно использовать формулу PSlosses = VMIM2fstS, здесь VM и IM — максимальные значения напряжения и тока, ts и fs — время и частота переключения.
ВАХ BJT-переключателя 2SC5198 от Toshiba. Биполярный транзистор— обзор
8.4.3 Силовые транзисторы
Транзистор представляет собой трехслойное трехполюсное устройство. Это может быть биполярный переходной транзистор (BJT) или металлооксидный полупроводниковый полевой транзистор (MOSFET). Обычно производители классифицируют транзисторы в соответствии с их областью применения:
- •
-
Малосигнальные транзисторы общего назначения предназначены для работы с малой и средней мощностью (менее 1 Вт) или для коммутации.
- •
-
Силовые транзисторы предназначены для работы с большими токами и / или большими напряжениями.
- •
-
RF (радиочастотные) транзисторы предназначены для высокочастотной работы, например, в системах связи.
BJT представляет собой транзистор NPN или PNP, показанный на рис. 8.40, с тремя выводами: базой, коллектором и эмиттером. BJT иногда считают двумя диодами, соединенными последовательно, чтобы получить структуру n-p-n или p-n-p.
Рисунок 8.40. BJT: структура (вверху) и обозначение схемы (внизу), транзистор NPN (слева) и транзистор PNP (справа)
Протекание тока базы (I B ) позволяет увеличить ток коллектора (I C ) для поток.Ток эмиттера — это сумма токов базы и коллектора. BJT действует как усилитель тока, хотя во многих случаях этот ток пропускается через резистор для создания напряжения. Соединяя BJT с резисторами (и конденсаторами), результирующие схемы могут обеспечивать усиление как тока, так и напряжения.
MOSFET представляет собой транзистор nMOS или pMOS, показанный на рис. 8.41, с тремя выводами: затвор, сток и исток. Некоторые полевые МОП-транзисторы также имеют четвертое соединение, основную часть или подложку, но с трехконтактным устройством основная часть внутренне соединена с истоком транзистора.
Рисунок 8.41. MOSFET: структура (вверху) и обозначение схемы (внизу), nMOS-транзистор (слева) и pMOS-транзистор (справа)
Приложение напряжения между затвором и истоком (V GS ) MOS-транзистора (напряжение больше чем пороговое напряжение для транзистора) позволяет протекать току стока (I D ). Вход затвора в транзистор является емкостным, и в устройстве протекает только небольшой ток затвора (ток утечки в неидеальном конденсаторе). (В простом анализе предполагается, что этот ток затвора равен нулю для идеального конденсатора.) МОП-транзистор использует входное напряжение для управления выходным током. Во многих случаях этот ток пропускается через резистор для создания напряжения. Соединяя полевой МОП-транзистор с резисторами (и конденсаторами), полученные схемы могут обеспечивать выход напряжения и тока.
И BJT, и MOSFET могут использоваться для создания схем усилителя или аналоговых фильтров (линейные приложения) или коммутационных приложений (нелинейные приложения). Примеры применения силовых транзисторов:
- •
-
Управление двигателем постоянного тока
- •
-
Управление двигателем переменного тока
- •
-
Управление шаговым двигателем
- •
-
усилители звука (выходной каскад усилителя, управляющего громкоговорителями)
- •
-
импульсных источников питания
Для силового транзистора безопасная рабочая область (SOAR) определяет безопасные пределы работы транзистора с точки зрения рабочих напряжений и токи для непрерывной работы (уровни постоянного тока и напряжения), а также для уровней, которые превышают область непрерывной работы в течение ограниченного периода времени.При использовании в качестве переключателя (особенно применимо для управления двигателем) время включения и выключения также необходимо учитывать для обеспечения правильной работы схемы, в которой используется транзистор. Если схема пытается слишком быстро включать и выключать транзистор, транзистор не может реагировать достаточно быстро, и результатом будет неправильная работа схемы.
Выбор силового транзистора для использования зависит от ряда факторов:
- •
-
наличие транзистора, способного работать до требуемых уровней напряжения, тока и температуры
- •
-
максимальный транзистор рассеиваемая мощность
- •
-
подходящий корпус — корпус транзистора (два примера показаны на рисунке 8.42) требуется для крепления транзистора к печатной плате или корпусу и для отвода тепла, выделяемого внутри корпуса.
Рис. 8.42. Примеры корпусов силовых транзисторов
- •
-
размер транзистора
- •
-
материал корпуса (пластик, керамика или металл) — когда в корпусе корпуса используется металл, один из выводов устройства должен быть электрически подключен к корпусу
- •
-
Сопротивление включения и выключения — когда полевой МОП-транзистор используется в качестве переключателя
- •
-
стоимость
Когда транзистор используется в качестве усилителя, создается схема усилителя один из пяти классов усилителя (Таблица 8.13). Каждый класс имеет рейтинг эффективности, который описывает количество мощности, подаваемой на нагрузку схемы (например, электродвигателя), в процентах от мощности, подаваемой на усилитель. 100-процентный КПД означает, что усилитель не рассеивает мощность (в виде тепла), но 100-процентный КПД недостижим.
Таблица 8.13. Классы усилителя
| Класс усилителя | Описание |
|---|---|
| Класс A | Транзистор проводит в течение всего периода входного сигнала.КПД низкий, максимум 25%. |
| Класс B | Транзистор проводит в течение одной половины периода входного сигнала. КПД выше, максимум около 78%. |
| Класс AB | Усилитель работает где-то между классом A и классом B. |
| Класс C | Транзистор проводит менее половины периода входного сигнала. КПД приближается к 100%, но дает большие искажения входного сигнала. |
| Класс D | Транзистор используется в качестве переключателя (ВКЛ или ВЫКЛ) и производит усилитель с хорошим КПД. Их часто называют переключающими усилителями или переключаемыми усилителями. |
Силовые транзисторы могут использоваться в управлении двигателем, чтобы обеспечить управление скоростью, положением или крутящим моментом двигателя. Пример схемы транзисторного усилителя для управления скоростью электродвигателя постоянного тока показан на рисунке 8.43:
Рисунок 8.43. Управление скоростью двигателя без обратной связи
- •
-
Схема работает от двухканального источника питания, где + V S — положительное напряжение источника питания, а –V S — отрицательное напряжение источника питания.
- •
-
Пользователь устанавливает положение потенциометра для получения напряжения, которое представляет требуемую скорость двигателя.
- •
-
Выход потенциометра буферизируется с помощью операционного усилителя.
- •
-
Выход операционного усилителя управляет усилителем класса B.
- •
-
Усилитель класса B приводит в действие двигатель постоянного тока.
В усилителе класса B используются один транзистор NPN и один транзистор PNP.Когда входное напряжение (выходное напряжение операционного усилителя) положительно (по отношению к общему узлу), NPN-транзистор проводит. Ток течет от положительного источника питания к общему узлу через двигатель, и двигатель вращается в одном направлении. Когда входное напряжение (выходное напряжение операционного усилителя) отрицательное (по отношению к общему узлу), транзистор PNP проводит. Ток течет от общего узла к отрицательному источнику питания через двигатель, и двигатель вращается в другом направлении.Два диода с обратным смещением подключены к узлам коллектор-эмиттер транзистора и используются для защиты транзисторов от высоких напряжений, которые могут возникнуть из-за быстро меняющихся токов в индуктивных катушках двигателя.
Это пример системы без обратной связи, в которой напряжение, приложенное к двигателю от схемы контроллера, заставляет двигатель вращаться. Изменение напряжения двигателя приведет к тому, что двигатель будет вращаться с другой скоростью. Одна потенциальная проблема с этой компоновкой заключается в том, что скорость двигателя изменяется в зависимости от различных нагрузок, подключенных к выходному валу двигателя, даже когда приложенное напряжение является постоянным.
Если скорость вала двигателя измеряется с помощью тахогенератора, напряжение генерируется в соответствии с фактической скоростью двигателя. Если это напряжение затем подается обратно в схему контроллера, как показано на рисунке 8.44, создается замкнутая система, и этот сигнал обратной связи может использоваться для автоматического увеличения или уменьшения скорости двигателя. Здесь усилитель мощности (символ треугольника) представляет собой схему транзисторного усилителя. Пользовательский ввод устанавливает требуемую скорость, а схема контроллера автоматически регулирует скорость двигателя до правильного значения.Динамика полученной системы управления зависит от динамики двигателя и используемого алгоритма управления.
Рисунок 8.44. Управление скоростью двигателя с обратной связью
Система управления, показанная на рисунке 8.44, может быть реализована путем разработки цифровой схемы управления с аналоговым входом и выходом. Базовая компоновка показана на Рисунке 8.45. Здесь CPLD реализует алгоритм цифрового управления, такой как пропорционально-интегральное (PI) управление. Скорость двигателя устанавливается пользователем с помощью аналогового напряжения.Полярность вводимой команды определяет направление вращения вала двигателя, а величина определяет скорость вращения вала двигателя.
Рисунок 8.45. Пример управления двигателем постоянного тока через CPLD
Цифровой выход контроллера обеспечивает ввод данных в n-разрядный ЦАП. Выходное напряжение ЦАП подается через схему преобразования сигнала на базе операционного усилителя, которая обеспечивает вход для усилителя класса B. Схема преобразования сигнала на базе операционного усилителя создает выходное напряжение в диапазоне, требуемом для каскада усилителя мощности.Выход усилителя обеспечивает напряжение и ток, необходимые для вращения двигателя в любом направлении.
Тахогенератор вырабатывает напряжение постоянного тока с полярностью, определяемой направлением вращения вала двигателя, и величиной, определяемой скоростью вращения вала двигателя. Это напряжение является входом для схемы преобразования сигнала на базе операционного усилителя, которая изменяет уровни напряжения тахогенератора до уровней, требуемых n-разрядным АЦП. АЦП преобразует напряжение обратно в цифровое значение, которое обеспечивает цифровое представление напряжения аналогового тахогенератора.
Схема в CPLD обеспечивает функции цифрового алгоритма управления, который управляет напряжением, подаваемым на двигатель.
Каждый АЦП и ЦАП в конструкции требует своего собственного опорного сигнала (обычно напряжения).
Последней частью схемы является источник питания, который получает доступное напряжение источника питания и выдает уровни напряжения источника питания, необходимые для каждой части конструкции.
Примером коммерческого биполярного силового транзистора является транзистор 2N3772 NPN от ST Microelectronics.Это мощный кремниевый транзистор, помещенный в металлический корпус TO-3, и находит применение в таких областях, как линейные усилители и устройства индуктивной коммутации. В Таблице 8.14 приведены типичные абсолютные максимальные характеристики силового транзистора в различных условиях эксплуатации.
Таблица 8.14. Типовой лист технических данных Абсолютные максимальные значения
| Символ | Параметр | Единицы | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| В CE0 | Напряжение коллектора-эмиттера (I E = 0) | 902 CEVНапряжение коллектор-эмиттер (для установленного ненулевого значения В BE ) | В | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| В CB0 | Напряжение коллектор-база (I B = 0) | В | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| В EB0 | Напряжение эмиттер-база (I C = 0) | В | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| I c | Ток коллектора | 1 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| A | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| I b | Базовый ток | A | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| I bm | Базовый пиковый ток | A | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| P tot | Общая рассеиваемая мощность при заданных температурных условиях (T C ) | W | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| T stg | Температура хранения | ° C | An Примером коммерческого силового МОП-транзистора является N-канальный транзистор STF2NK60Z от ST Microelectronics.Это мощный кремниевый транзистор, доступный в следующих корпусах: TO-92, TO-220, IPAK и TO-220FP. Внутри транзистора находятся защитные стабилитроны. Приложения включают маломощные зарядные устройства, импульсные источники питания и управление люминесцентными лампами.||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Физические параметры, включенные в Таблицу 1, были вычислены с помощью следующих этапов: (a) Используя,,, и из Рисунка 2 (b) встроенных потенциалов и каждого соединения, указанного на рисунке 3.(b) Посредством (2) и (3) и в качестве кремниевого транзистора используется,, а затем получаются значения ширины и пространственного заряда при прямом смещении и в условиях обратного смещения. (c) После этого емкости переходного перехода и получаются по формулам (4) и (5), где для расчета использовались только значения, тогда как при прямом смещении пропорционально, а при обратном смещении пропорционально. (d) Наконец, зная и, а также оценивая эмпирические выражения и, получается из (1) для максимальной частоты для кремниевого NPN-транзистора МПШ20.
3.1. Графический отклик SJT в переходном режиме
Чтобы узнать графический отклик предложенной схемы на Рисунке 1 (b), решение для (6) — (9), управляющих режимами работы на Рисунке 3, получено в приложении. Кроме того, действие индуктора, показанное на рисунке 4, должно быть временно проанализировано вместе с эквивалентной схемой гибридного π на рисунке 2 (a), где уравнение, описывающее этот режим, состоит в том, чтобы понять ключевую роль индуктора на рисунке 1 (b ) были выбраны три катушки индуктивности (см. Таблицу 2) в зависимости от резонансного поведения в LC-цепи, работающей на высоких частотах, между включенными в Таблицу 1 и [13].Используя решение для (см. Приложение) в режимах 1 и 2, физическое поведение катушки индуктивности вычисляется с помощью (10). Практические индукторы были построены с одной обмоткой из AWG №20 на цилиндрической трубе длиной 1,5 см и диаметром 1 см.
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
3.2. Физическое поведение SJT в переходном режиме
Чтобы подтвердить, что SJT может работать в необычных условиях, была построена предложенная схема.На рисунках 8 (a) –8 (c) показаны результирующие формы колебаний переменного напряжения на выходе. Для обеспечения условий смещения использовался резистор R = 100 Ом. Цифровой запоминающий осциллограф Tektronix TDS1002B использовался для регистрации форм сигналов. Рабочие физические параметры при нескольких условиях испытаний приведены в таблице 2. Эти параметры включают выходное напряжение, рабочую частоту, время переходного процесса дырок, а также подвижность и коэффициент диффузии дырочных носителей, вводимых во время режимов 1 и 2 от базовой области до области коллектора. (см. рисунок 9 (а)).
Предположим, что инжекция дырок на низком уровне через переход база-коллектор происходит с толщиной, идентичной смещению переносчиков электронов, когда предел изменений в ответ на резкое изменение профиля соответствует длине Дебая, тогда он Следует учитывать это, учитывая номинальную ширину базы для модели переходного транзистора на Рисунке 2 (b) [20]. Следовательно, коэффициент диффузии, который зависит как от межатомного расстояния, так и от атомной частоты вибрации, может быть оценен с использованием, но, поскольку проводимость носителей в SJT чувствительна к изменениям напряжения смещения и температуры, подвижность при переходном режиме в течение режимов 1 и 2 следует из зависимости Аррениуса [21], где — коэффициент диффузии дырочных переносов, связанный с энергией активации из-за термически генерируемых электронно-дырочных пар, когда температура в SJT увеличивается из-за больших токов, используемых внутри базы-коллектора. переход в режимах 1 и 2 (см. Таблицу 1) [22].Следовательно, было измерено вдоль каждого наклона и указано на рисунках 8 (b) и 8 (c), а затем остальные физические параметры, ответственные за работу транзистора, такие как и были рассчитаны при комнатной температуре (см. Таблицу 2).
Развитие эквивалента в течение режимов 1 и 2 сравнивается с генерируемым для каждой катушки индуктивности, выбранной в таблице 2, где точки пересечения на рисунках 5 (а), 6 (а) и 7 (а) указывают соответствующие количество ионизированных примесей при переходном режиме.Было показано, что на рисунке 5 (а) линейно для каждой кривой с на низком уровне ~ 10 15 см -3 , ~ 10 11 см -3 и ~ 10 13 см −3 соответственно. На рисунке 6 (а), продолжает оставаться квазилинейным, и может происходить небольшое увеличение ионизированных примесей.
Вместо этого наблюдается небольшая нелинейность с большей величиной ~ 10 17 см −3 , ~ 10 13 см −3 и ~ 10 15 см −3 , что означает это смещение заряда переносится через переходы и может быть нарушено ионизационными процессами в основной области [14, 16].Однако, когда и увеличиваются как параметры смещения, нелинейность на Рисунке 7 (a) увеличивается, что означает, что плотности ионизированных примесей (,, и) могут быть неравномерно распределены в основной области.
Таким образом, диаграмма энергетического диапазона на Рисунке 9 (c) для действия транзистора на Рисунке 9 (a) показывает, что распределение потенциала на переходе эмиттер-база смещено в прямом направлении с напряжением, понижающим встроенный потенциал и сужающим его пространство. -ширина заряда, в то время как в переходе база-коллектор с прямым смещением при температуре, инжекция дырочных носителей возрастает, когда положение уровня Ферми, эквивалентного уровню Ферми, находится примерно в пределах запрещенной зоны в зависимости от температуры в базовой области, что позволяет двум Уровни Ферми, соответствующие донорам и акцепторам, должны быть близки.Однако в этом линейном режиме (омическое поведение) величина базового тока имеет тенденцию незначительно увеличиваться (небольшая проводимость дырочных переносов) из-за незначительного электрического поля через базовую область. Следовательно, плотность неосновных носителей будет намного меньше, чем плотность основных носителей, и уменьшается с увеличением электрического поля.
Решение (8) и (9), соответствующее режимам 3 и 4, дает эволюцию, эквивалентную на рисунках 5 (b), 6 (b) и 7 (b), когда соединение база-коллектор с обратным смещением как функция временной задержки, пропорциональной, где такие параметры, как,, и отвечают за более медленное смещение носителей заряда в зависимости от теоретических параметров и перечислены в таблице 1.Кроме того, рекомбинация в базовую область ограничивает диффузию электронных носителей, что может быть результатом нелинейности полярности индуктора на рисунке 7 (b). Следовательно, диаграмма энергетических зон на Рисунке 9 (c) при обычном обратном смещении, обозначенная пунктирными линиями, показывает, что электроны и дырки через переход база-коллектор возникают при напряжении, при котором слой обеднения расширяется (см. Рисунок 9 (b)). )).
В переходных рабочих условиях, показанных на Рисунке 1 (b), на величину увеличения до достижения их насыщения и уменьшение как минимум.Следовательно, электрическое поле максимизируется, и ток на переходе база-коллектор может вызвать ускорение ионизации при низком напряжении коллектор-эмиттер, создавая нелинейности в формах сигналов на рисунках 8 (b) и 8 (c), где сосуществуют как линейный режим, так и Реализуется режим ограничения ионизованных примесей [22, 23]. Эта нелинейность может быть результатом нерегулярного распределения ионизированных примесей вблизи металлургического перехода база-коллектор, когда инжекция дырок ограничена и ответственна за сужение и наличие двух коэффициентов диффузии, соответствующих каждому режиму проводимости.
Аналогичным образом, когда выбран индуктор с прямым смещением, регулирующий механизм проводимости в переходе база-коллектор будет зависеть от накопления энергии в индукторе и тока, ограниченного пространственным зарядом (SCLC) [24], который медленно увеличивается при постоянное электрическое поле, увеличивающийся режим с ограничением ионизированных примесей и истощающий линейный режим. С другой стороны, из-за более низкой диффузии электронных переносчиков при обратном смещении, когда полярность индуктора изменяется при (см. Рисунок 9 (b)), оба режима проводимости незначительны, и возникает истощение большинства переносчиков.
Для стабильного поведения предлагаемой схемы необходимо учитывать следующее: (a) Ионизированные примеси будут линейно увеличиваться в зависимости от времени, когда и на переходе база-эмиттер, а также на переходе база-коллектор. . (b) Стабильная концентрация ионизированных примесей будет иметь место с диффузионной емкостью, когда ≤ 200 нГн и ниже 450 см 2 В -1 с -1 , когда имеет место полярность индуктора. (c) и должны быть удовлетворены для работы SJT в их линейном режиме, как показано на рисунках 8 (a), 8 (b) и 8 (c) для и.
4. Выводы
В этой работе электрический отклик катушки индуктивности в условиях переключения, зависящий от работы транзистора, и их способность обмениваться энергией, были приняты во внимание вместе с физическими параметрами, задействованными для достижения необычной работы, основанной на динамическом поведении транзисторов. примеси. Эмпирическая модель для исследования физики SJT, зная только физические параметры материалов, была изучена с использованием приближения эквивалентной схемы.В качестве примера был выбран кремниевый транзистор МПШ20 NPN для проверки теоретической модели, обеспечивающей функциональную стабильность в зависимости от их электрических свойств, контролируемых примесями. Обнаружено хорошее согласие между теорией и измерениями. Моделирование физических параметров для существующих полупроводниковых технологий, по крайней мере, необходимо для предложения и разработки новых электронных схем с адаптивными рабочими характеристиками и улучшенными характеристиками. Интерес к открытию необычных свойств является ключевым моментом в продолжении тенденций оптимизации обработки сигналов в электронике следующего поколения.
Приложение
Решение основных уравнений для модели действия транзистора
Используя известный аналитический метод решения линейных дифференциальных уравнений второго порядка, решение (6) можно записать следующим образом. константы и определяются при начальных условиях, и где допустимое решение для (A.1) с максимальным встроенным потенциалом может быть выражено, как показано ниже. Для (7) встроенный потенциал должен быть решен как функция от следующее уравнение.Подставляя (A.2) в (A.3), подходящее решение для (A.3) определяется, как показано ниже. Чтобы найти в соответствии с операцией Mode 2 , необходимо учитывать, что емкость база-коллектор будет быть эквивалентным смещенной в прямом направлении емкости в переходе база-коллектор (см. Таблицу 1). Затем поведение схемы на рис. 1 (b) может быть подтверждено как функция потенциала, действительного для режимов 1 и 2 при значениях потенциала.
В переходном состоянии в Mode 3 , то есть приблизительно при, можно предположить, что потенциал эквивалентен; поэтому теперь (8) можно решить, как показано ниже.Опять же, константа определяется при начальных условиях, и где допустимое решение для (A.5) с максимальным встроенным потенциалом может быть подтверждено, как показано ниже. Уравнение (9) должно быть решено как функция от. Подставляя (A.6) в (9), полезное решение для, принимая во внимание временную задержку с, и для каждого условия смещения, установленного в таблице 1, чтобы отрегулировать временную характеристику во время динамического обмена энергией в LC-цепи, можно записать, как показано ниже. Опять же, чтобы найти в соответствии с операцией Mode 4 , необходимо учитывать, что емкость база-коллектор будет эквивалентна емкости с обратным смещением на переходе база-коллектор (см. Таблицу 1). .Затем поведение схемы на рис. 1 (b) может быть подтверждено как функция потенциала, действительного для режимов , 3 и 4 со значениями потенциала.
Наконец, используя (A.2) и (A.4), (10) можно проверить, чтобы продемонстрировать высокочастотный отклик предложенной схемы на Рисунке 1 (b) как функцию значения индуктивности.
Доступность данных
Вся рукопись удобна для чтения, поскольку она демонстрирует посредством воспроизводимых экспериментальных результатов необычные принципы работы переходного транзистора.Кроме того, в рукописи указано следующее: графический отклик уравнений, управляющих характеристиками схемы, от режимов работы, предлагаемых на каждом этапе, с подробностями о решениях уравнений, с приложением условий для решения этих уравнений, подтверждающих выводы учиться. Наконец, намерение автора состоит в том, чтобы мотивировать других исследователей исследовать новые исследовательские маршруты с использованием методологии, аналогичной предложенной здесь. Данные также доступны у соответствующего автора по запросу.
Конфликт интересов
Автор заявляет об отсутствии конфликта интересов в отношении публикации этой статьи.

