Что такое биполярные транзисторные сборки. Какие преимущества они имеют перед отдельными транзисторами. Где применяются транзисторные сборки. Какие популярные модели транзисторных сборок существуют. Как выбрать подходящую транзисторную сборку для своего устройства.
Что представляют собой биполярные транзисторные сборки
Биполярные транзисторные сборки — это интегральные микросхемы, содержащие несколько биполярных транзисторов в одном корпусе. Обычно в одной сборке объединяют от 2 до 8 транзисторов. Транзисторы в сборке могут быть как одинаковыми, так и разными по типу и характеристикам.
Основные преимущества транзисторных сборок перед отдельными транзисторами:
- Компактность — несколько транзисторов в одном корпусе занимают меньше места на печатной плате
- Лучшее согласование параметров транзисторов
- Снижение стоимости при массовом производстве
- Упрощение монтажа
Области применения биполярных транзисторных сборок
Транзисторные сборки широко применяются в различных областях электроники:

- Аналоговые схемы — дифференциальные усилители, токовые зеркала
- Цифровые схемы — логические элементы, триггеры
- Источники питания — стабилизаторы напряжения
- Драйверы светодиодов
- Интерфейсные схемы
- Схемы управления электродвигателями
Особенно эффективно применение транзисторных сборок в схемах, где требуется высокая степень согласования параметров транзисторов, например, в дифференциальных усилителях.
Популярные модели биполярных транзисторных сборок
Рассмотрим некоторые распространенные модели транзисторных сборок и их основные характеристики:
BC847BS
BC847BS — сборка из двух маломощных NPN-транзисторов в корпусе SOT-363. Основные параметры:
- Максимальное напряжение коллектор-эмиттер: 45 В
- Максимальный ток коллектора: 100 мА
- Коэффициент усиления по току: 200-450
- Граничная частота: 100 МГц
Применяется в маломощных аналоговых и цифровых схемах, например, в аудиоусилителях.
ULN2003A
ULN2003A — сборка из 7 составных транзисторов Дарлингтона с общим эмиттером. Характеристики:
- Максимальное напряжение коллектор-эмиттер: 50 В
- Максимальный ток коллектора: 500 мА на канал
- Встроенные защитные диоды
Часто используется как драйвер для управления реле, светодиодами, шаговыми двигателями.

Как выбрать подходящую транзисторную сборку
При выборе транзисторной сборки следует учитывать следующие факторы:
- Тип транзисторов (NPN, PNP)
- Количество транзисторов в сборке
- Максимальное напряжение коллектор-эмиттер
- Максимальный ток коллектора
- Коэффициент усиления по току
- Граничная частота
- Тип корпуса
- Рассеиваемая мощность
Важно также учитывать особенности конкретного применения — требуемую мощность, быстродействие, температурный диапазон и другие параметры.
Преимущества использования транзисторных сборок в электронных устройствах
Применение транзисторных сборок в электронных устройствах дает ряд существенных преимуществ:
- Экономия места на печатной плате за счет высокой плотности компонентов
- Снижение стоимости при массовом производстве
- Уменьшение паразитных емкостей и индуктивностей
- Лучшее согласование параметров транзисторов, что важно для дифференциальных схем
- Упрощение монтажа и повышение надежности за счет меньшего количества внешних соединений
Все это делает транзисторные сборки привлекательным выбором для разработчиков электронной аппаратуры.
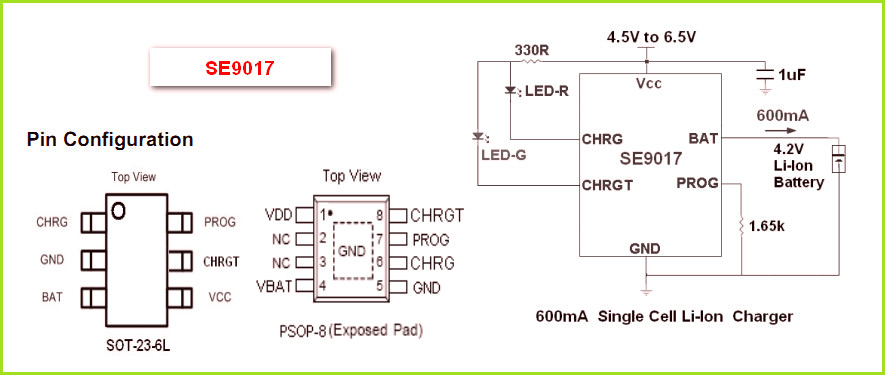
Особенности применения биполярных транзисторных сборок
При работе с транзисторными сборками следует учитывать некоторые особенности:
- Тепловая связь между транзисторами в сборке может влиять на их характеристики
- Необходимо обеспечивать адекватный теплоотвод, особенно для мощных сборок
- Важно учитывать паразитные связи между транзисторами при разработке высокочастотных схем
- Следует обращать внимание на максимально допустимое напряжение между выводами разных транзисторов в сборке
Правильный учет этих факторов позволяет максимально эффективно использовать преимущества транзисторных сборок.
Тенденции развития технологии биполярных транзисторных сборок
В области транзисторных сборок наблюдаются следующие тенденции развития:
- Увеличение степени интеграции — появление сборок с большим количеством транзисторов
- Улучшение частотных характеристик для применения в высокочастотных схемах
- Снижение энергопотребления для применения в мобильных устройствах
- Совершенствование корпусов для улучшения теплоотвода
- Интеграция дополнительных элементов (резисторов, диодов) для создания функционально законченных узлов
Эти тенденции открывают новые возможности для применения транзисторных сборок в современной электронике.

|
BC847BS Производитель: NXP 2xNPN 45V 100mA 300mW 100MHz Trans. BC847BS TSSOP6=SOT363 TBC847bs количество в упаковке: 100 шт |
под заказ 1000 шт срок поставки 14-28 дня (дней) |
||||||||||
|
BC847BS Производитель: NXP/Nexperia/We-En Подвоєний транзистор NPN; Uceo, В = 45; Ic = 100 мА; hFE = 200 @ 2 мA, 5 В; Icutoff-max = 15 нА; Uceo(sat), В @ Ic, Ib = 0,65 @ 5 мA, 100 мА; Р, Вт = 0,21; Тексп, °C = -55…+150; Тип монт. = smd; SOT-363 |
под заказ 170 шт срок поставки 2-3 дня (дней) |
|
|||||||||
|
BC847BS Производитель: DIODES |
под заказ 2379 шт срок поставки 16-23 дня (дней) |
|
|||||||||
|
BC847BS Производитель: NXP |
под заказ 1028 шт срок поставки 16-23 дня (дней) |
|
|||||||||
|
BC847BS Производитель: ONS |
под заказ 124 шт срок поставки 16-23 дня (дней) |
|
|||||||||
|
BC847BS Производитель: ON Semiconductor Trans GP BJT NPN 45V 0.1A 210mW 6-Pin SC-70 T/R |
под заказ 35 шт срок поставки 9-28 дня (дней) |
|
|||||||||
|
BC847BS Производитель: ON Semiconductor Description: TRANS 2NPN 45V 0.1A SC70-6 Base Part Number: BC847 Supplier Device Package: SC-88 (SC-70-6) Package / Case: 6-TSSOP, SC-88, SOT-363 Mounting Type: Surface Mount Operating Temperature: -55°C ~ 150°C (TJ) Power — Max: 210mW DC Current Gain (hFE) (Min) @ Ic, Vce: 200 @ 2mA, 5V Current — Collector Cutoff (Max): 15nA (ICBO) Vce Saturation (Max) @ Ib, Ic: 650mV @ 5mA, 100mA Voltage — Collector Emitter Breakdown (Max): 45V Current — Collector (Ic) (Max): 100mA Transistor Type: 2 NPN (Dual) Part Status: Obsolete Packaging: Cut Tape (CT) Manufacturer: onsemi |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor Description: TRANS 2NPN 45V 0.1A SC70-6 Base Part Number: BC847 Supplier Device Package: SC-88 (SC-70-6) Package / Case: 6-TSSOP, SC-88, SOT-363 Mounting Type: Surface Mount Operating Temperature: -55°C ~ 150°C (TJ) Power — Max: 210mW DC Current Gain (hFE) (Min) @ Ic, Vce: 200 @ 2mA, 5V Current — Collector Cutoff (Max): 15nA (ICBO) Vce Saturation (Max) @ Ib, Ic: 650mV @ 5mA, 100mA Voltage — Collector Emitter Breakdown (Max): 45V Current — Collector (Ic) (Max): 100mA Transistor Type: 2 NPN (Dual) Part Status: Obsolete Packaging: Manufacturer: onsemi |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor Description: TRANS 2NPN 45V 0.1A SC70-6 Base Part Number: BC847 Supplier Device Package: SC-88 (SC-70-6) Package / Case: 6-TSSOP, SC-88, SOT-363 Mounting Type: Surface Mount Operating Temperature: -55°C ~ 150°C (TJ) Power — Max: 210mW DC Current Gain (hFE) (Min) @ Ic, Vce: 200 @ 2mA, 5V Current — Collector Cutoff (Max): 15nA (ICBO) Vce Saturation (Max) @ Ib, Ic: 650mV @ 5mA, 100mA Voltage — Collector Emitter Breakdown (Max): 45V Current — Collector (Ic) (Max): 100mA Transistor Type: 2 NPN (Dual) Part Status: Obsolete Packaging: Cut Tape (CT) Manufacturer: onsemi |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor Description: TRANS 2NPN 45V 0.1A SC70-6 Mounting Type: Surface Mount Operating Temperature: -55°C ~ 150°C (TJ) Base Part Number: BC847BS Power — Max: 210mW DC Current Gain (hFE) (Min) @ Ic, Vce: 200 @ 2mA, 5V Current — Collector Cutoff (Max): 15nA (ICBO) Vce Saturation (Max) @ Ib, Ic: 650mV @ 5mA, 100mA Voltage — Collector Emitter Breakdown (Max): 45V Current — Collector (Ic) (Max): 100mA Part Status: Obsolete Transistor Type: 2 NPN (Dual) Packaging: Digi-Reel® (Дополнительная плата за катушку в размере $7) Supplier Device Package: SC-88 (SC-70-6) Package / Case: 6-TSSOP, SC-88, SOT-363 |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor Trans GP BJT NPN 45V 0.1A 210mW 6-Pin SC-70 T/R |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor Trans GP BJT NPN 45V 0.1A 210mW 6-Pin SC-70 T/R |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: YANGJIE TECHNOLOGY Material: BC847BS-YAN NPN SMD transistors |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: onsemi / Fairchild Bipolar Transistors — BJT NPN Si Transistor Epitaxial |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ON Semiconductor / Fairchild Bipolar Transistors — BJT NPN Si Transistor Epitaxial |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ONSEMI Description: ONSEMI — BC847BS — Bipolar Transistor Array, Dual NPN, 45 V, 100 mA, 210 mW, 200 hFE, SC-70 Transistor Polarity: Dual NPN Product Range: — Power Dissipation Pd: 210 DC Current Gain hFE: 200 Operating Temperature Max: 150 Transistor Mounting: Surface Mount MSL: MSL 1 — Unlimited Automotive Qualification Standard: — DC Collector Current: 100 Transistor Case Style: SC-70 Transition Frequency ft: — No. of Pins: 6 Collector Emitter Voltage V(br)ceo: 45 SVHC: No SVHC (15-Jan-2018) |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: ONSEMI Description: ONSEMI — BC847BS — Bipolar Transistor Array, Dual NPN, 45 V, 100 mA, 210 mW, 200 hFE, SC-70 Transistor Polarity: Dual NPN Product Range: — Power Dissipation Pd: 210 DC Current Gain hFE: 200 Operating Temperature Max: 150 Transistor Mounting: Surface Mount MSL: MSL 1 — Unlimited Automotive Qualification Standard: — DC Collector Current: 100 Transistor Case Style: SC-70 Transition Frequency ft: — No. of Pins: 6 Collector Emitter Voltage V(br)ceo: 45 SVHC: No SVHC (15-Jan-2018) |
товар отсутствует, Вы можете сделать запрос добавив товар в корзину |
||||||||||
|
BC847BS Производитель: NXP 10+ROHS SOT-363 |
под заказ 18000 шт срок поставки 14-28 дня (дней) |
Куплю транзисторы маломощные, средней и больной мощности, НЧ, ВЧ, СВЧ
Куплю транзисторы биполярные, полевые, транзисторные сборки, в металлических корпусах, пластмассе, с желтыми выводами и позолотой
Транзисторы полевые
КП150 КП250 КП302 КП350 КП364 КП402 КП403 КП450 КП460 КП501 КП502 КП504 КП505 КП507 КП508 КП511 КП601
2П701 2П703 КП704 КП705 2П706 КП707 КП707 КП709 КП723 КП726 КП727 КП727 КП728 КП731 КП733 КП737 КП739 КП740
КП741 КП742 КП743 КП743 КП744 КП745 КП746 КП747 КП748 КП749 КП750 КП751 КП767 КП768 КП769 КП770 КП771
КП775 КП780 КП784 КП785 КП796 2П797 2П7102КП7128 КП7129 2П7140 2П7144 2П7145 2П7160 КП7173 КП7174 КП7176
КП7177 КП7178 КП7180 КП7181 КП7182 КП7183 КП7184 КП7275 КП801 2П802 2П803 КП804 КП805 КП809 КП810 КП812
КП813 КП901 КП902 КП904 КП905 КП907 2П912 2П914П 2П917 КП921 КП922 2マ926 КП931 КП932 КП934 2П942 КП953 КП954
КП959 КП960 КП961 КП965 КП971 КП973
Транзисторы биполярные, малой, средней мощности, низкочастоные и высокочастоные
КТ372А КТ372Б
КТ372В КТ382А(М)
КТ382Б(М) КТ391А-2
КТ391Б-2 КТ391В-2 КТ399А
КТ399АМ КТ501А
КТ501Б
КТ501В КТ501Г КТ501Д
КТ501Е КТ501Ж
КТ501И КТ501К КТ501Л
КТ501М КТ502А
КТ502Б КТ502В КТ502Г
КТ502Д
КТ502Е KT503A KT503B
КТ503В КТ503Г
КТ503Д КТ503Е КТ504А
КТ504Б КТ504В
КТ505А КТ505Б КТ506А
КТ506Б
КТ601А(М) КТ602А(М)
КТ602Б(М) КТ602В КТ602Г
КТ603А КТ603Б
Кт603в КТ603Г Кт603д
КТ603Е Кт603и
КТ604А(М)
КТ604Б(М) КТ605А(М)
КТ605Б(М) КГ608А
кТ608Б КТ611БМ КТ6127А
КТ6127Б КТ6127В
КТ6127Г КТ6127Д КТ6127Е
КТ6127Ж КТ6127И КТ6127К
КТ626А КТ626Б
КТ626В КТ626Г КТ626Д
КТ630А КТ630Б
КТ630В КТ630Г КТ630Д
КТ630Е
КТ639А КТ639Б КТ639В
КТ639Г КТ639Д
КТ639Е КТ639И КТ644А
КТ644Б КТ644В
КТ644Г КТ645А КТ645Б
КТ646А
КТ646Б КТ660А КТ660Б
КТ668А КТ668Б
КТ668В КТ680А КТ681А
КТ663А КТ6836
КТ683В КТ683Г КТ683Д
КТ683Е
КТ684А КТ684Б
КТ684В КТ685А
КТ685Б КТ685В КТ685Г
КТ685д КТ685Е
КТ685Ж КТ686А КТ686Б
КТ686В КТ686Г
КТ686Д KT686F КТ686Ж
КТ695А КТ698А КТ698Б
KT698B КТ698Г
КТ698Д КТ698Е
КТ698Ж КТ698И КТ698К
2Т709А2
2Т709Б2 2Т709В2 2Т716АГ
2Т716б1 2Т716В1
КТ710А 2Т713А КТ801А
КТ801Б КТ802А
КТ803А КТ805АМ 1СТ805БМ
КТ805ВМ КТ805ИМ КТ807А
КТ807Б КТ808А
КТ808АМ КТ808БМ КТ808ВМ
КТ808ГМ КТ809А
КТ8101А КТ8101Б КТ8102А
КТ8102Б КТ8104А
КТ8105А КТ8106А
КТ8106Б КТ8107А КТ8107Б
КТ8107В КТ8108А
КТ8108Б КТ8109А КТ8109Б
КТ8110А
КТ8110Б ICT8110B КТ8111А’
КТ8111Б КТ8111В
КТ8114А КТ8114Б
КТ8114В КТ8116А КТ8116Б
КТ8118Б КТ8117А
КТ8118А
КТ812А КТ812Б КТ812В
2Т812А 2Т812Б
KT8120A КТ8121А КТ8121Б
КТ8123А КТ8124А
КТ8124Б КТ8124В КТ8127А(1)
КТ8127Б(1) КТ8127В(1)
КТ8129А КТ8130А КТ8130Б
КТ8130В КТ8131А
КТ8131Б КТ8131В КТ8136А
КТ8140А КТ814А
КТ814Б ICT814B
КТ814Г КТ815А
КТ815Б КТ815В КТ815Г
КТ816А КТ816А2
КТ816Б КТ816В КТ816Г
КТ817А КТ817Б
КТ817Б2 КТ817В КТ817Г
КТ817Г2 КТ818А
КТ818Б КТ818В КТ818Г
КТ818АМ КТ818БМ
КТ818ВМ КТ818ГМ 2Т818Б
2Т818В КТ819А КТ819Б
КТ919В КТ819Г
КТ819АМ КТ819БМ КТ919ВМ
КТ819ГМ 2Т819А
2Т819Б 2Т819В 2Т825А
2Т825Б
2Т825В КТ825 КТ825Д
КТ825Е КТ826А
КТ826Б КТ826В КТ827А
КТ827Б КТ827В
КТ828А КТ828Б КТ829А
КТ829Б КТ829В
КТ829Г КТ834А
КТ834Б КТ834В
КТ835А КТ835Б КТ837А
КТ837Б КТ837В
КТ837Г КТ837Д КТМ7Е
КТ837Ж КТ837И
КТ837К
КТ837Л КТ837М 2Т838А
2Т839А 1Т840А 2Т841А
2Т841Б 2Т841В Т846А
Т848Б Т846В Т847А
Т848А Т850А Т850Б
Т850В Т851А
Т851Б Т851В Т852А
Т852Б Т852В Т852Г
Т853А Т853Б
Т853В Т853Г Т854А
Т854Б Т855А КТ855Б
КТ855В КТ857А
КТ858А
КТ859А КТ863А
КТ872А КТ872Б
КТ872В КТ878А КТ878Б
КТ878В КТ879А
КТ879Б КТ886А1 КТ886Б1
КТ890А КТ890Б
КТ890В КТ892А КТ892Б
КТ892В КТ896А
КТ896Б КТ896В КТ897А
КТ897Б КТ898А
КТ898Б КТ898АГ КТ898Б1
КТ899А
КТ903А КТ903Б КТ908А
КТ908Б КТ9115А
КТ940А КТ940Б КТ940В
КТ945А КТ961А
КТ961Б КТ961В КТ972А
КТ972Б
КТ973А КТ973Б КТ997А
КТ997Б КТ999А
Транзисторы позолоченные Au (Аурум, Aurum) с желтыми выводами, непаяные с недеформированными выводами, необлуженные
Полезные и интересные статьи
Читать про стабилизаторы серии к142, к1114, к1145, к1168, 286
На предыдущую страницу На главную страницу На следующую страницу
Транзисторы биполярные импортные
Вид каталога:
Сортировать по: Дате поступления (по возрастанию)Дате поступления (по убыванию)Названию (по убыванию)Названию (по возрастанию)Цене (по возрастанию)Цене (по убыванию)
-
транзистор SS9013
20 р.
Купить за 1 клик
- Арт. —
- 00000007849
-
транзистор MJE13003 TO-220
55 р.
Купить за 1 клик
- Арт. —
- 00000125219
-
Транзистор D2901 2SD2901=BU2525AF
290 р.
Купить за 1 клик
- Арт. —
- 00000129083
-
Транзистор BLF878
0 р.
- Арт. —
- 00000131298
-
ZTX851*
138 р.
Купить за 1 клик
- Арт. —
- 00000118701
-
UN9211 = DTC114EE = RN1102 sot23
25 р.
Купить за 1 клик
- Арт. —
- 00000131460
-
TYN1225RG, Тиристор, 1.2 кВ, 40 мА, 16 А, 25 А, TO-220AB, 3 вывод(-ов)
260 р.
Купить за 1 клик
- Арт. —
- 00000014938
-
TT3043 TO-220F5*
430 р.
Купить за 1 клик
- Арт. —
- 00000118770
-
TT3043
215 р.
Купить за 1 клик
- Арт. —
- 00000115616
-
TT3034 TO-220F5 5 ног
470 р.
Купить за 1 клик
- Арт. —
- 00000118771
-
TT3034 TO-220F3 (3 ноги)
450 р.
Купить за 1 клик
- Арт. —
- 00000117562
-
TT2222 TO-220IS
120 р.
Купить за 1 клик
- Арт. —
- 00000134364
-
TT2206
83 р.
Купить за 1 клик
- Арт. —
- 00000115662
-
TT2194
120 р.
Купить за 1 клик
- Арт. —
- 00000126520
-
TT2190 NPN, 800 В, 8 А, 35 Вт
100 р.
Купить за 1 клик
- Арт. —
- 00000009177
-
TT2170
87 р.
Купить за 1 клик
- Арт. —
- 00000009176
-
TT2142
101 р.
Купить за 1 клик
- Арт. —
- 00000019747
-
TT2140
75 р.
Купить за 1 клик
- Арт. —
- 00000009175
-
TT2138
70 р.
Купить за 1 клик
- Арт. —
- 00000115107
-
TT2076, Биполярный транзистор, NPN, 1500 В, 8 А, 65 Вт
190 р.
Купить за 1 клик
- Арт. —
- 00000115013
-
TIP47
45 р.
Купить за 1 клик
- Арт. —
- 00000116735
-
TIP42 (BD244)!
45 р.
Купить за 1 клик
- Арт. —
- 00000008991
-
TIP41 (BD243)
45 р.
Купить за 1 клик
- Арт. —
- 00000008990
-
TIP36C TO-218
90 р.
Купить за 1 клик
- Арт. —
- 00000008989
-
TIP35C TO-218/247
95 р.
Купить за 1 клик
- Арт. —
- 00000008988
-
TIP33C (BD245)
95 р.
Купить за 1 клик
- Арт. —
- 00000008987
-
TIP32C
45 р.
Купить за 1 клик
- Арт. —
- 00000116734
-
TIP31C транзистор
40 р.
Купить за 1 клик
- Арт. —
- 00000008986
-
TIP3055
75 р.
Купить за 1 клик
- Арт. —
- 00000009002
-
TIP29C
40 р.
Купить за 1 клик
- Арт. —
- 00000008985
-
TIP2955
80 р.
Купить за 1 клик
- Арт. —
- 00000019558
-
TIP152
100 р.
Купить за 1 клик
- Арт. —
- 00000009001
-
TIP151(TIP152)
85 р.
Купить за 1 клик
- Арт. —
- 00000009000
-
TIP147T
70 р.
Купить за 1 клик
- Арт. —
- 00000008999
-
TIP147 (to-247)
120 р.
Купить за 1 клик
- Арт. —
- 00000134699
-
TIP146
100 р.
Купить за 1 клик
- Арт. —
- 00000008998
-
TIP142T
110 р.
Купить за 1 клик
- Арт. —
- 00000008997
-
TIP142
110 р.
Купить за 1 клик
- Арт. —
- 00000008996
-
TIP141
45 р.
Купить за 1 клик
- Арт. —
- 00000132756
-
TIP140
44 р.
Купить за 1 клик
- Арт. —
- 00000008995
| CA3046 | CA3046, Универсальная биполярная сборка из пяти n-канальных транзисторов, [DIP-14] | Подробнее |
| LB1274 | LB1274, Транзисторная сборка [DIP-14] | Подробнее |
| MC1413DG | MC1413DG, Транзисторная сборка, Darlington, 7х NPN, 50 В, 500 мА, 1000 hFE [SO-16] | Подробнее |
| TBD62003AFG,EL | TBD62003AFG,EL, Матрица из семи транзисторов Дарлингтона, 500мА [SOP-16] | Подробнее |
| TD62064APG | TD62064AP, Транзисторная сборка Darlington NPN 50В 1.5А [DIP-16] | Подробнее |
| ULN2003A | ULN2003A, Матрица из семи транзисторов Дарлингтона, 500мА, [DIP-16] | Подробнее |
| ULN2003ADR | ULN2003ADR, Матрица из семи транзисторов Дарлингтона, 500мА, [SO-16] | Подробнее |
| ULN2003AFWG | ULN2003AFWG, Матрица из семи транзисторов Дарлингтона, 500мА [SO-16] | Подробнее |
| ULN2003AID | ULN2003AID | Подробнее |
| ULN2003AN | ULN2003AN, Матрица из семи транзисторов Дарлингтона, 500мА, [DIP-16] | Подробнее |
| ULN2003APG | ULN2003APG, Матрица из семи транзисторов Дарлингтона, 500мА, [DIP-16] | Подробнее |
| ULN2003D1013TR | ULN2003D1013TR, Матрица из семи транзисторов Дарлингтона, 500мА, [SO-16] | Подробнее |
| ULN2004A | ULN2004A, Транзистор Дарлингтона 7- NPN 50V 0.5A, [DIP-16] | Подробнее |
| ULN2004AD | ULN2004AD, Матрица из семи транзисторов Дарлингтона, 500мА, [SO-16] | Подробнее |
| ULN2004ADR | ULN2004ADR, Матрица из семи транзисторов Дарлингтона, 500мА [SO-16] | Подробнее |
| ULN2004AN | ULN2004AN, Матрица из семи транзисторов Дарлингтона, 500мА, [DIP-16] | Подробнее |
| ULN2064B | ULN2064B, Счетверенный переключатель на транзисторах Дарлингтона, 50В, 1.5А, [DIP-16] | Подробнее |
| ULN2065B | ULN2065B, Счетверенный переключатель на транзисторах Дарлингтона, 80В, 1.5А | Подробнее |
Транзисторные сборки — Большая Энциклопедия Нефти и Газа, статья, страница 3
Транзисторные сборки
Cтраница 3
Микросхемы 219НТ1 и 219НТ2 — транзисторные сборки, предназначенные для создания маломощных транзисторных каскадов. Микросхема 219НТ1 содержит пять транзисторов 2Т317, а микросхема 219НТ2 — четыре. [31]
Микросхемы DA3 и DA7 представляют собой транзисторные сборки с транзисторными МОП-ключами, причем микросборка DA3 содержит ключи отключения цепей тонкомпенсации, а микросборка DA7 — ключи отключения цепей громкоговорителей. С выхода предварительного УЗЧ ( / 47) сигнал 34 подается через разъемы Х6 и Х7 на активные акустические системы правого и левого каналов. [32]
Исключение составляют микросхемы, представляющие собой диодные или транзисторные сборки, для которых приводятся параметры входящих в их состав транзисторов и диодов. [33]
Для повышения мощности PKmax B последнее время начали выпускать мощные транзисторные сборки, в которых транзисторы соединены одноименными выводами. Транзисторные сборки могут насчитывать несколько десятков мощных транзисторов и работать при токах до 500 А. [35]
Для повышения мощности PKmax B последнее время начали выпускать мощные транзисторные сборки, в которых транзисторы соединены одноименными выводами. Транзисторные сборки могут насчитывать несколько десятков мощных транзисторов и работать при токах до 500 А. [36]
Кремниевые полевые малошумящие эпитаксиально-планарные сдвоенные транзисторы КПС104А — КПС104Д с n — p — n — переходом и каналом n — типа используются в транзисторных полевых сборках ( транзисторных матрицах), предназначенных для работы во входных каскадах дифференциальных усилителей низкой частоты с большим входным сопротивлением и в аппаратуре широкого применения. Транзисторные сборки заключены в металлический герметичный корпус, имеют гибкие проволочные выводы и сохраняют работоспособность при температуре окружающей среды от — 40 до 85 С и относительной влажности 98 % при температуре 40 С. [37]
Для этого применяют специальные схемы — расширители ( транзисторные сборки), которые своими выходными точками К. Кроме того, схема имеет два выхода: прямой у2 — и инверсный г / i г / 2, что расширяет логические возможности элемента. К недостаткам схемы следует отнести малый перепад сигнала на выходе схемы, который составляет 0 7 — 0 8 В, а также низкий уровень допустимых помех. [38]
Масса полупроводниковых приборов невелика, определяется в основном массой корпуса и выводов. Поэтому масса маломощных бескорпусных приборов составляет 0 01 — 0 1 г, масса приборов, заключенных в металлический корпус — 1 — 10 г. И только мощные диоды, транзисторные сборки и тиристоры имеют массу 0 1 — 0 5 кг. [39]
Промышленность выпускает германиевые и кремниевые биполярные транзисторы: маломощные — Ртах. Вт; средней мощности — 0 3 / max 1.5 Вт; мощные — Ятах до десятков ватт и силовые — max Д сотен ватт, предназначенные для работы на низких частотах ( frp 30 МГц), высоких ( 30 МГц / Vp 300 МГц) и сверхвысоких ( frp 300 МГц), а также переключательные. Кроме того, выпускают транзисторные сборки и матрицы, содержащие от двух до четырех транзисторов. [40]
Страницы: 1 2 3
Транзисторные сборки Дарлингтона
Массив из семи NPN транзисторов Дарлингтона, способных выдавать ток 500 мА и напряжение 50 В
Матрица n-p-n транзисторов.
Матрица n-p-n-транзисторов
Матрица p-n-p транзисторов.
Матрица из p-n-p транзисторов.
Матрица из двух n-p-n транзисторов (для построения дифференциальных усилителей).
Показать ещеМатрицы n-p-n транзисторов.
Микросхемы представляют собой матрицу p-n-p транзисторов.
Набор p-n-p транзисторов
Сильноточная согласованная пара полевых транзисторов с p-n переходом и р-каналом, предназначенных для применения во входных каскадах усилителей постоянного тока, в дифферренциальных и операционных усилителях и коммутаторах.
Сильноточную согласованную пару полевых транзисторов с p-n переходом и р-каналом, предназначенных для применения во входных каскадах усилителей постоянного тока, в дифферренциальных и операционных усилителях и коммутаторах.
Слаботочная согласованная пара полевых транзисторов, предназначенных для применения во входных каскадах усилителей постоянного тока, в дифферренциальных и операционных усилителях и коммутаторах.
| RF TRANS PNP 20V 600MHZ SOT23-3 | $ 0,36000 | 29400 — Немедленно 6 | onsemi 9000 M 9005 -ND MMBTH81CT-ND MMBTH81DKR-ND | — | Лента и катушка (TR) Cut Tape (CT) Digi-Reel® | P 600 МГц | — | — | 225 мВт | 60 при 5 мА, 10 В | 50 мА | -55 ° C ~ 150 ° C (TJ) | Поверхностный монтаж | TO-236-3, SC-59, SOT -23-3 | SOT-23-3 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 7GHZ SSM | $ 0.09150 | 24000 — Немедленно | Toshiba Semiconductor and Storage | Toshiba Semiconductor and Storage | 1 | 2SC5066-OLFTR-ND 9000FC8 2SC5066-OLFTR-ND 9000FC8 2TSC50000 | — | Tape & Reel (TR) Cut Tape (CT) Digi-Reel® | Not for New Designs | NPN | 12V | 7GHz | 1dB @ 500MHz | — | — | — | — | — | 100 мВт80 при 10 мА, 5 В | 30 мА | 125 ° C (TJ) | Поверхностный монтаж | SC-75, SOT-416 | SSM | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 9V 14GHZ TSFP-3 | 0 руб.50000 | 1 — Немедленное | Infineon Technologies | Infineon Technologies | 1 | BFR360FH6327XTSA1TR-ND BFR360FH6327XTSA1CT-ND BFR360FH6327XTSA1DKR-ND | — | Tape & Reel (TR ) Cut Tape (CT) Digi-Reel® | Активный | NPN | 9 В | 14 ГГц | 1 дБ при 1,8 ГГц | 15.5 дБ | 210 мВт | 90 при 15 мА, 3 В | 35 мА | 150 ° C (TJ) | Поверхностный монтаж | SOT-723 | PG-TSFP-3 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12 В SOT323-3 | $ 0,48000 | 12728 — Немедленное | Infineon Technologies | Infineon Technologies |
| 1 BFR93AWH6327XTSA1TR-ND BFR93AWH6327XTSA1CT-ND BFR93AWH6327XTSA1DKR-ND | — | Tape & Reel (TR) Cut Tape (CT) Digi-Reel® | Active | NPN | 12V | 6GHz | 1.5 дБ ~ 2,6 дБ при 900 МГц ~ 1,8 ГГц | 10,5 дБ ~ 15,5 дБ | 300 мВт | 70 при 30 мА, 8 В | 90 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-70, SOT-323 | SOT-323 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 15V 5GHZ SOT23-3 | $ 0,49000 | 107,884 — Немедленно | Infineon Technologies7 | 5 | Infineon Technologies7 | 5 Infineon Technologies | 5 | Infineon Technologies7 | 5 Infineon Technologies -ND BFR106E6327HTSA1CT-ND BFR106E6327HTSA1DKR-ND | — | Лента и катушка (TR) Cut Tape (CT) | 44 44 5 ГГц 1.8 дБ ~ 3 дБ при 900 МГц ~ 1,8 ГГц | 8,5 дБ ~ 13 дБ | 700 мВт | 70 при 70 мА, 8 В | 210 мА | 150 ° C (TJ) | Поверхностный монтаж | TO-236-3, SC-59 , SOT-23-3 | PG-SOT23 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 5,5 В 25 ГГц 4TSFP | $ 0,54000 | 14,213 — Немедленно | Infineon Technologies | Infineon Technologies | Infineon Technologies | BFP420FH6327XTSA1TR-ND BFP420FH6327XTSA1CT-ND BFP420FH6327XTSA1DKR-ND | – | TRape & TRape | TRape | 5.5 В | 25 ГГц | 1,1 дБ при 1,8 ГГц | 19,5 дБ | 160 мВт | 60 при 5 мА, 4 В | 35 мА | 150 ° C (TJ) | Крепление на поверхность | 4-SMD, плоские выводы | 4-TSFP | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 4,5 В 37 ГГц SOT343-4 | $ 0,61000 | 36,265 — Немедленно | Infineon Technologies | Infineon Technologies | 000 TRS ND BFP650H6327XTSA1CT-ND BFP650H6327XTSA1DKR-ND | — | Лента и катушка (TR) Cut Tape (CT)
| 37 ГГц | 0,8 дБ ~ 1,9 дБ при 1,8 ГГц ~ 6 ГГц | 10,5 дБ ~ 21,5 дБ | 500 мВт | 110 при 80 мА, 3 В | 150 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-82A, SOT-343 | PG-SOT343-4 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 5V 24GHZ SOT343-4 | $ 0,72000 | 28,199 — Immediate 08 | Infine Technologies 1 | BFP450H6327XTSA1TR-ND BFP450H6327XTSA1CT-ND BFP450H6327XTSA1DKR-ND | — 9000 Tape-ND | — CTAPT 9000 (9000) Активный | NPN | 5 В | 24 ГГц | 1.25 дБ при 1,8 ГГц | 15,5 дБ | 450 мВт | 60 при 50 мА, 4 В | 100 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-82A, SOT-343 | PG-SOT343-4 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 6.1V 900MHZ SOT343 | $ 2.09000 | 17657 — Немедленно | Infineon Technologies | Infineon Technologies | D BFP780H6327XTSA1DKR-ND | — | Лента и катушка (TR) Cut Tape (CT) Digi-Reel® | Активный | NPN | 6.1 В | 900 МГц | 1,2 дБ ~ 2,4 дБ при 900 МГц ~ 3,5 ГГц | 27 дБ | 600 мВт | 85 при 90 мА, 5 В | 120 мА | 150 ° C (TJ) | Крепление на поверхность | SC-82A, SOT-343 | SOT343-4-2 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 6.1V 1.85GHZ SOT89 | $ 2.66000 | 21992 — Немедленное | Infineon Technologies | 9205 Infineon Technologies | BFQ790H6327XTSA1TR-ND BFQ790H6327XTSA1CT-ND BFQ790H6327XTSA1DKR-ND | — | Reader TRape и TRape | 9008 6.1 В | 1,85 ГГц | 2,6 дБ при 1,8 ГГц | 17 дБ | 1,5 Вт | 60 при 250 мА, 5 В | 300 мА | — | Поверхностный монтаж | TO-243AA | PG-SOT89 | 0 118,32000 | 132 — Немедленно | MACOM Technology Solutions | MACOM Technology Solutions | 1 | 1465-1189-ND | 8 000 Tray 900 | NPN | 50V | — | — | 14dB | 250W | 10 @ 5A, 10V | 16A | — | Монтаж на шасси | 211-11, Style 2 | 211-11, Style 2 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 2GHZ SOT23-3 | $ 0.32000 | 6379 — Немедленно | onsemi | onsemi | 1 | MMBT5179TR-ND MMBT5179CT-ND MMBT5179CT-ND TRAPE MMBT50009 Cut Tape (CT) Digi-Reel® | Активный | NPN | 12 В | 2 ГГц | 5 дБ при 200 МГц | 15 дБ | 225 мВт | 25 при 3 мА, 1 В | ° C ~ 150 ° C (TJ) | Поверхностный монтаж | TO-236-3, SC-59, SOT-23-3 | SOT-23-3 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 25V 650MHZ TO92 -3 | 0 руб.35000 | 4,929 — Немедленно | onsemi | onsemi | 1 | KSP10TACT-ND KSP10TATB-ND | — 9000 Tape Tape 9000 ( TB Box 9000 Cutape | ) ) | Активный | NPN | 25 В | 650 МГц | — | — | 350 мВт | 60 при 4 мА, 10 В | — | 150 ° C (TJ) | Сквозное отверстие | TO-22 -3, TO-92-3 (TO-226AA) (сформированные выводы) | TO-92-3 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 8GHZ SOT323-3 | $ 0.41000 | 18270 — Немедленное | Infineon Technologies | Infineon Technologies | 1 | BFR181WH6327XTSA1TR-ND BFR181WH6327XTSA1CT-ND BFR181WH6327XTSA1DKR-ND | — | Tape & Reel (TR ) Cut Tape (CT) Digi-Reel® | Active | NPN | 12 В | 8 ГГц | 0,9 дБ ~ 1,2 дБ при 900 МГц ~ 1.8 ГГц | 19 дБ | 175 мВт | 70 при 5 мА, 8 В | 20 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-70, SOT-323 | SOT-323 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
| RF TRANS NPN 12V 8GHz SOT323-3 $ 0,41000 | 11908 — Немедленное | Infineon Technologies | Infineon Technologies |
| 1 BFR182WH6327XTSA1TR-ND BFR182WH6327XTSA1CT-ND BFR182WH6327XTSA1DKR-ND | — | Tape & Reel (TR) Cut Tape (CT) Digi-Reel® | Active | NPN | 12V | 8GHz | 0.9 дБ ~ 1,3 дБ при 900 МГц ~ 1,8 ГГц | 19 дБ | 250 мВт | 70 при 10 мА, 8 В | 35 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-70, SOT-323 | SOT- 323 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 30 В 550 МГц SMINI | $ 0,46000 | 4,445 — Немедленно | Toshiba Semiconductor and Storage | Toshiba Semiconductor and Storage | Toshiba Semiconductor 2 9007 (TE85LF) TR-ND 2SC2714-Y (TE85LF) CT-ND 2SC2714-Y (TE85LF) DKR-ND | — | Лента и катушка (TR) Cut Tape (CT) Digi-Reel® | Активный | NPN | 30 В | 550 МГц | 2.5 дБ при 100 МГц | 23 дБ | 100 мВт | 100 при 1 мА, 6 В | 20 мА | 125 ° C (TJ) | Поверхностный монтаж | TO-236-3, SC-59, SOT-23-3 | S-Mini | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 8GHZ SOT343-4 | $ 0,50000 | 20,900 — Немедленно | Infineon Technologies | A 1 | Infineon Technologies | 9198— | Лента и катушка (TR) Cut Tape (CT)
| 1 дБ ~ 1.6 дБ при 900 МГц ~ 1,8 ГГц | 13,5 дБ ~ 20,5 дБ | 580 мВт | 70 при 30 мА, 8 В | 80 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-82A, SOT-343 | PG -SOT343-4 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 8GHZ SOT23-3 | $ 0,46000 | 14,808 — Немедленно | Infineon Technologies | B 9000TRU | ND — | Лента и катушка (TR) Cut Tape (CT) | 1 дБ ~ 1.6 дБ при 900 МГц ~ 1,8 ГГц | 10 дБ ~ 15 дБ | 580 мВт | 70 при 30 мА, 8 В | 80 мА | 150 ° C (TJ) | Поверхностный монтаж | TO-236-3, SC-59, SOT- 23-3 | PG-SOT23 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12V 8GHZ SOT323-3 | $ 0.50000 | 17,090 — Немедленно | Infineon Technologies | 5 | Infineon Technologies | 5 Infineon Technologies | BFR193WH6327XTSA1TR-ND BFR193WH6327XTSA1CT-ND BFR193WH6327XTSA1DKR-ND | — | 9000 TRAPEL 9000 9000 9000 9000 9000 9000 9000 9000 9000 TRapeel 12 В | 8 ГГц | 1 дБ ~ 1.6 дБ при 900 МГц ~ 1,8 ГГц | 10,5 дБ ~ 16 дБ | 580 мВт | 70 при 30 мА, 8 В | 80 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-70, SOT-323 | SOT- 323 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12 В 7,5 ГГц SOT343-4 | $ 0,51000 | 4821 — Немедленно | Infineon Technologies | N0007 | Infineon Technologies | 9TS BFP196WNH6327XTSA1CT-ND BFP196WNH6327XTSA1DKR-ND | — | Лента и катушка (TR) Cut Tape (CT)
| 1,3 дБ при 900 МГц | 9,7 дБ | 700 мВт | 70 при 50 мА, 8 В | 150 мА | 150 ° C (TJ) | Поверхностный монтаж | SC-82A, SOT-343 | PG-SOT343 -4 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| RF TRANS NPN 12 В 7,5 ГГц SOT143-4 | $ 0,53000 | 42,661 — Немедленно | Infineon Technologies
| Infineon Technologies | 6E | 8— | Лента и катушка (TR) Cut Tape (CT)
Обзор биполярных транзисторовБиполярный транзистор, полное название биполярного переходного транзистора (BJT), представляет собой электронное устройство с тремя выводами, состоящее из трех частей полупроводников с разными уровнями легирования. Поток заряда в транзисторе в основном происходит из-за диффузионного и дрейфового движения носителей в PN-переходе. Каталог
I Биполярный и униполярный транзисторБиполярный транзистор — революционное изобретение в истории электроники. Его изобретатели Уильям Шокли, Джон Бардинг и Уолтер Брэтон были удостоены Нобелевской премии по физике в 1956 году. Работа этого типа транзистора включает поток как электронных, так и дырочных носителей, поэтому он является биполярным и называется биполярным носителем. транзистор. Этот режим работы отличается от униполярных транзисторов, таких как полевые транзисторы, которые включают дрейф только одного типа несущей.Граница между двумя различными областями накопления легирующей примеси образована PN-переходом.
Биполярные транзисторы состоят из трех частей полупроводников с различными уровнями легирования .Поток заряда в транзисторе в основном происходит из-за диффузионного и дрейфового движения носителей в PN-переходе. Если взять в качестве примера NPN-транзистор, согласно конструкции, электроны в высоколегированной области эмиттера перемещаются к базе посредством диффузии. В основной области дырки являются основными носителями, а электроны — неосновными носителями. Поскольку площадь основания очень тонкая, эти электроны достигают коллектора посредством дрейфующего движения, тем самым формируя ток коллектора, поэтому биполярные транзисторы классифицируются как устройства с неосновными носителями. Биполярные транзисторы могут усиливать сигналы и обладают хорошим регулированием мощности, возможностью высокоскоростной работы и долговечностью, поэтому они часто используются для формирования схем усилителя или управления динамиками, двигателями и другим оборудованием, а также широко используются в аэрокосмической технике. , медицинское оборудование и роботы. II Как работает биполярный транзистор?Здесь мы берем биполярный транзистор NPN в качестве цели для обсуждения принципа работы биполярных транзисторов. Биполярный транзистор типа NPN можно рассматривать как два диода с общим анодом, соединенных вместе.При нормальной работе биполярного транзистора переход база-эмиттер («коллекторный переход») находится в состоянии прямого смещения, в то время как база-коллектор («коллекторный переход») находится в состоянии обратного смещения.
Рисунок 1. Поперечное сечение биполярного транзистора PNP Когда нет приложенного напряжения, концентрация электронов в N-области эмиттерного перехода (большинство носителей в этой области) больше, чем электронная. концентрация в P-области, и часть электронов диффундирует в P-область.Таким же образом часть отверстий в области P также будет распространяться в область N. Таким образом, на эмиттерном переходе образуется область пространственного заряда (также известная как обедненный слой), генерирующая внутреннее электрическое поле, направление которого — от области N к области P. Это электрическое поле будет препятствовать дальнейшему протеканию вышеупомянутого процесса диффузии и достичь динамического баланса. В это время, если прямое напряжение приложено к эмиттерному переходу, динамический баланс между вышеупомянутой диффузией носителей и внутренним электрическим полем в обедненном слое будет нарушен, что вызовет инжекцию термически возбужденных электронов в базовый регион.В NPN-транзисторе базовая область легирована P-типом, где дырки являются основной примесью, поэтому электроны в этой области называются «неосновными носителями». С одной стороны, электроны, инжектированные из эмиттера в базовую область, здесь рекомбинируют с дырками основных носителей заряда, с другой стороны, потому что базовая область слабо легирована с тонким физическим размером, а коллекторный переход находится в обратном направлении. В состоянии смещения большая часть электронов достигнет области коллектора посредством дрейфующего движения, образуя ток коллектора. Чтобы минимизировать рекомбинацию электронов до того, как они достигнут коллекторного перехода, базовая область транзистора должна быть сделана достаточно тонкой, чтобы время, необходимое для диффузии носителей, было меньше, чем время жизни неосновных полупроводниковых носителей. При этом толщина базы должна быть много меньше диффузионной длины электронов (см. Закон Фика). В современных биполярных транзисторах толщина базовой области обычно составляет несколько десятых микрон. Следует отметить, что, хотя коллектор и эмиттер легированы N-типом, степень легирования и физические свойства этих двух элементов не одинаковы. Следовательно, биполярный транзистор следует отличать от двух диодов, соединенных последовательно в противоположных направлениях. III Типы биполярных транзисторовБиполярный транзистор состоит из трех различных легированных полупроводниковых областей: эмиттерной области , базовой области и области коллектора .Эти области представляют собой полупроводники N-типа, P-типа и N-типа в транзисторах типа NPN и полупроводники P-типа, N-типа и P-типа в транзисторах типа PNP. У каждой полупроводниковой области есть штыревой конец, обычно с буквами E, B и C, обозначающими эмиттер, базу и коллектор. База физически расположена между эмиттером и коллектором, и она сделана из легированных материалов с высоким сопротивлением. Коллектор окружает основание. Из-за обратного смещения коллекторного перехода электроны отсюда трудно инжектировать в область базы.Это приводит к тому, что коэффициент усиления по току общей базы становится примерно равным 1, в то время как коэффициент усиления по току общего эмиттера больше. Числовое значение. В биполярном транзисторе NPN площадь коллекторного перехода больше, чем эмиттерного перехода. Кроме того, эмиттер имеет относительно высокую концентрацию легирования. В нормальных условиях несколько областей биполярных транзисторов асимметричны по физическим свойствам и геометрическим размерам. Предполагая, что транзистор, включенный в схему, расположен в области прямого усилителя, если соединение коллектора транзистора и эмиттера в схеме поменять местами в это время, транзистор выйдет из области прямого усилителя и войдет в обратную рабочую область. Внутренняя структура транзистора определяет, что он подходит для работы в области прямого усилителя, поэтому коэффициент усиления по току общей базы и коэффициент усиления по току общего эмиттера в обратной рабочей области намного меньше, чем в области прямого усилителя. Эта функциональная асимметрия в основном связана с разными уровнями легирования эмиттера и коллектора. Следовательно, в NPN-транзисторе, хотя коллектор и эмиттер оба легированы N-типом, электрические свойства и функции обоих не могут быть взаимозаменяемы вообще. Эмиттерная область имеет наивысшую степень легирования , коллекторная область является второй, а базовая область имеет самую низкую степень легирования. Кроме того, физические размеры трех регионов также различаются. Базовая область очень тонкая, а площадь коллектора больше, чем площадь эмиттера. Поскольку биполярный транзистор имеет такую структуру материала, он может обеспечивать обратное смещение для коллекторного перехода, но при этом предполагается, что обратное смещение не может быть слишком большим, иначе транзистор будет поврежден.Целью сильного легирования эмиттера является повышение эффективности инжекции электронов из эмиттера в базовую область для достижения максимально возможного усиления по току. При соединении биполярных транзисторов с общим эмиттером небольшие изменения напряжения, приложенного к базе и эмиттеру, вызовут значительные изменения тока между эмиттером и коллектором. Используя это свойство, вы можете усилить входной ток или напряжение. Что касается базы биполярного транзистора в качестве входа и коллектора в качестве выхода, двухпортовая сеть может быть проанализирована с помощью теоремы Тевенина.Используя принцип эквивалентности, биполярный транзистор можно рассматривать как источник тока, управляемый напряжением, или источник напряжения, управляемый током. 1.Тип NPNТранзистор NPN является одним из двух типов биполярных транзисторов. Он состоит из двух слоев легированных областей N-типа и слоя легированного полупроводника P-типа (основы) между ними. Крошечный ток, подаваемый на базу, будет усилен, создавая больший ток коллектор-эмиттер. Когда базовое напряжение NPN-транзистора выше, чем напряжение эмиттера, а напряжение коллектора выше, чем базовое напряжение, транзистор находится в состоянии прямого усилителя.В этом состоянии между коллектором и эмиттером транзистора есть ток. Усиленный ток является результатом того, что электроны инжектируются эмиттером в базовую область (неосновные носители в базовой области) и перемещаются к коллектору под действием электрического поля. Поскольку подвижность электронов выше подвижности дырок , большинство используемых сегодня биполярных транзисторов относятся к типу NPN. Электрический символ биполярного транзистора NPN показан справа, а стрелка между базой и эмиттером указывает на эмиттер.
Рисунок 2. a) Символ биполярного транзистора NPN b) Символ биполярного транзистора PNP 2.Тип PNPБиполярный транзистор PNP другого типа состоит из двух слоев легированных областей P-типа и слоя легированных полупроводников N-типа между ними. Крошечный ток, протекающий через базу, может быть усилен на конце эмиттера. Другими словами, когда базовое напряжение PNP-транзистора ниже, чем у эмиттера, напряжение коллектора ниже, чем базовое напряжение, и транзистор находится в области прямого усилителя. В символе биполярного транзистора стрелка между базой и эмиттером указывает направление тока. В отличие от типа NPN, стрелка транзистора типа PNP указывает от эмиттера к базе. 3.ГетеропереходБиполярный транзистор с гетеропереходом — это улучшенный биполярный транзистор, способный работать на высокой скорости . Исследования показали, что этот транзистор может обрабатывать сверхвысокочастотные сигналы с частотами до нескольких сотен ГГц, поэтому он подходит для приложений, требующих жестких рабочих скоростей, таких как усилители мощности ВЧ и драйверы лазеров. Гетеропереход — это тип PN-перехода. Два конца этого перехода изготовлены из различных полупроводниковых материалов . В этом типе биполярного транзистора эмиттерный переход обычно имеет структуру гетероперехода, то есть материал с широкой запрещенной зоной используется в области эмиттера, а материал с узкой запрещенной зоной используется в области базы. Обычный гетеропереход использует GaAs для создания основной области и AlxGa1-xAs для создания области эмиттера. С такой структурой гетероперехода эффективность инжекции биполярного транзистора может быть улучшена, а коэффициент усиления по току также может быть увеличен на несколько порядков. Концентрация легирования базовой области биполярного транзистора с гетеропереходом может быть значительно увеличена, так что сопротивление базового электрода и ширина базовой области могут быть уменьшены. В традиционном биполярном транзисторе, то есть транзисторе с гомопереходом, эффективность инжекции носителей из эмиттера в базу в основном определяется соотношением легирования эмиттера и базы. В этом случае, чтобы получить более высокую эффективность инжекции, базовая область должна быть слегка легирована, что неизбежно увеличивает базовое сопротивление. В базовой области состав полупроводникового материала распределен неравномерно, что приводит к постепенному изменению запрещенной зоны базовой области. Эта медленно изменяющаяся ширина запрещенной полосы может создавать внутреннее электрическое поле для неосновных носителей, ускоряющее их через базовую область. Это дрейфовое движение будет иметь синергетический эффект с диффузионным движением, чтобы уменьшить время прохождения электронов через базовую область, тем самым улучшая высокочастотные характеристики биполярного транзистора.Параметры | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Прирост | Нормальный | Хороший | Хороший | Хороший | Хороший | Нормальный | Отличный | Хороший | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Эффективность | Нормальный | Хороший |
Отличный |
Отличный 9000 | Отлично | Хорошо | Отлично | Отлично | Хорошо | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Отлично 0005
Напряжение пробоя 000 | Хорошо | Хорошо | Хорошее | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Одиночный источник питания | √ |
| 8
|
Хотя для создания транзисторов с гетеропереходом можно использовать множество различных полупроводников, чаще используются транзисторы с гетеропереходом кремний-германий и транзисторы с гетеропереходом на основе арсенида алюминия и галлия.Процесс изготовления транзисторов с гетеропереходом представляет собой кристаллическую эпитаксию, такую как эпитаксия из паровой фазы металлоорганических соединений (MOCVD) и молекулярно-лучевая эпитаксия.
IV Параметры
1.
Рассеиваемая мощность коллектораМаксимальная рассеиваемая мощность коллектора биполярного транзистора — это максимальная мощность, при которой устройство может нормально работать при определенной температуре и условиях рассеивания тепла. В тех же условиях, если фактическая мощность превышает это значение, температура транзистора превысит максимально допустимое значение, что ухудшит производительность устройства и даже приведет к физическому повреждению.
2.
Ток и напряжениеКогда ток коллектора увеличивается до определенного значения, хотя биполярный транзистор не будет поврежден, коэффициент усиления по току будет значительно уменьшен. Чтобы транзистор нормально работал, как задумано, необходимо ограничить значение тока коллектора. Кроме того, поскольку биполярные транзисторы имеют два PN перехода, их обратное напряжение смещения не может быть слишком большим, чтобы предотвратить обратный пробой PN перехода.В техническом описании биполярного переходного транзистора эти параметры подробно перечислены.
Когда напряжение обратного смещения коллектора силового биполярного транзистора превышает определенное значение, а ток, протекающий через транзистор, превышает определенный допустимый диапазон, в результате чего мощность транзистора превышает критическую мощность вторичного пробоя, возникает своего рода опасная ситуация. Явление « секунд разбивки » будет произведено. В этом случае ток, выходящий за пределы расчетного диапазона, вызовет локальный температурный дисбаланс в различных областях внутри устройства, а температура в некоторых областях выше, чем в других областях.
Поскольку легированный кремний имеет отрицательный температурный коэффициент , его проводимость выше, когда он находится при более высокой температуре. Таким образом, более горячая часть может проводить больше тока, и эта часть тока будет генерировать дополнительное тепло, в результате чего локальная температура превысит нормальное значение, и устройство не сможет нормально работать.
Вторичный пробой — это разновидность теплового разгона. При повышении температуры проводимость будет еще больше увеличиваться, вызывая порочный круг и в конечном итоге серьезно разрушая структуру транзистора.Весь процесс вторичной поломки может быть завершен за миллисекунды или микросекунды.
Если эмиттерный переход биполярного транзистора обеспечивает обратное смещение, которое превышает допустимый диапазон и не ограничивает ток, протекающий через транзистор, в эмиттерном переходе произойдет лавинный пробой, который приведет к повреждению устройства.
3.
Температурный дрейфКак аналоговое устройство, все параметры биполярных транзисторов в той или иной степени зависят от температуры, особенно на коэффициент усиления по току.Согласно исследованиям, каждый раз при повышении температуры на 1 градус Цельсия коэффициент усиления тока увеличивается примерно на 0,5–1%.
4.
Радиационная стойкостьБиполярные транзисторы более чувствительны к ионизирующему излучению . Если транзистор находится в среде ионизирующего излучения, устройство будет повреждено излучением. Повреждение происходит из-за того, что излучение вызывает дефекты в области основания, которые образуют центры рекомбинации в энергетической зоне.Это приведет к более короткому сроку службы неосновных носителей, которые работают в устройстве, что, в свою очередь, постепенно снизит производительность транзистора.
Биполярные транзисторы типа NPN имеют большую эффективную площадь рекомбинации носителей в радиационной среде, и отрицательное влияние более значимо, чем у транзисторов типа PNP. В некоторых специальных приложениях, таких как электронные системы управления в ядерных реакторах или космических кораблях, должны использоваться специальные меры для смягчения негативного воздействия ионизирующего излучения.
В Рабочая область
В зависимости от состояния смещения трех выводов транзистора можно определить несколько различных рабочих областей биполярного транзистора. В полупроводниках NPN (примечание: профили напряжения транзисторов PNP и транзисторов NPN прямо противоположны), в соответствии с смещением эмиттерного перехода и коллекторного перехода, рабочую область можно разделить на:
1.
Биполярный транзисторный усилитель Область(1) Область прямого усилителя
Когда эмиттерный переход смещен в прямом направлении, а коллекторный переход смещен в обратном направлении, транзистор работает в области усилителя.Целью разработки большинства биполярных транзисторов является получение максимального коэффициента усиления по току с общим эмиттером баррелей в зоне прямого усилителя. Когда транзистор работает в этой области, ток коллектор-эмиттер и ток базы примерно линейны. Из-за усиления по току, когда ток базы немного нарушен, ток коллектор-эмиттер значительно изменится.
(2) Область обратного усилителя
Если вышеупомянутые напряжения смещения эмиттера и коллектора транзистора в области прямого усилителя поменять местами, биполярный транзистор будет работать в области обратного усилителя.В этом режиме работы области эмиттера и коллектора полностью противоположны функциям в области прямого усилителя. Однако, поскольку концентрация легирования коллектора транзистора ниже, чем у эмиттера, эффект, производимый областью обратного усилителя, не такой, как в области прямого усилителя.
Целью конструкции большинства биполярных транзисторов является получение максимального усиления по току прямого усилителя, насколько это возможно. Следовательно, коэффициент усиления по току в области обратного усилителя будет меньше, чем в области прямого усилителя.Фактически, этот режим работы вряд ли принят, но для предотвращения повреждения устройства или других опасностей, вызванных неправильным подключением, его необходимо учитывать при проектировании. Кроме того, некоторые типы биполярных логических устройств также учитывают область обратного усилителя.
Рис. 3. Отсечка в прямом и обратном направлениях BJT и насыщение
2. Область насыщения
Когда два PN-перехода в биполярном транзисторе смещены в прямом направлении, транзистор будет находиться в области насыщения.В это время ток от эмиттера до коллектора транзистора достигает максимального значения. Даже если базовый ток увеличится, выходной ток больше не будет увеличиваться. Область насыщения может использоваться для обозначения высокого уровня логических устройств.
3.
Область отсечкиЕсли смещение двух PN-переходов биполярного транзистора точно противоположно таковому в области насыщения, то транзистор будет в области отсечки.В этом режиме работы выходной ток очень мал (менее 1 мкА для маломощных кремниевых транзисторов и менее даже мкА для германиевых транзисторов), что можно использовать для представления низких уровней в цифровой логике.
4.
Лавинный пробойКогда обратное смещение, приложенное к коллекторному переходу, превышает диапазон, который может выдержать коллекторный переход, PN переход будет разрушен. Если сила тока достаточно велика, устройство выйдет из строя.
Кроме того, когда мы анализируем и проектируем схемы биполярных транзисторов, следует отметить, что максимальная рассеиваемая мощность коллектора Pcm биполярного транзистора не может быть превышена. Если рабочая мощность транзистора меньше этого значения, совокупность этих рабочих состояний называется безопасной рабочей зоной. Если рабочая мощность транзистора превышает этот предел, температура устройства выйдет за пределы нормального диапазона, и производительность устройства значительно изменится и даже вызовет повреждение.
Допустимая температура перехода кремниевых транзисторов составляет от 150 до 200 градусов Цельсия. Максимально допустимое рассеивание мощности может быть увеличено за счет уменьшения внутреннего теплового сопротивления, использования радиаторов и принятия таких мер, как воздушное охлаждение, водяное охлаждение и охлаждение масла.
На самом деле, абсолютных границ между вышеупомянутыми рабочими регионами нет. В пределах диапазона небольших изменений напряжения (менее нескольких сотен милливольт) между различными областями может быть определенное перекрытие.
Рекомендуемый артикул:
Введение в TFT-дисплеи
Структура и принцип работы полевых транзисторов
Какие методы тестирования и типы транзисторов?
Биполярный транзистор — обзор
12.3 Биполярный транзистор с гетеропереходом
Биполярный транзистор с гетеропереходом (HBT) — это тип BJT, в котором используется другой тип полупроводникового материала для областей эмиттера и базы, создавая гетеропереход .Основное преимущество HBT — более высокие частотные характеристики, которые зависят от типа используемого полупроводникового материала и геометрии устройства [22]. Например, HBT, изготовленные с использованием составного полупроводникового материала GaAs / арсенид галлия (GaAs / AlGaAs), могут иметь f T вплоть до сотен ГГц. Еще более высокие частоты могут быть получены с устройствами с двойным гетеропереходом InP / арсенид галлия индия (InGaAs) [9,23]. HBT находят применение либо в качестве генераторов, либо в качестве малошумящих усилителей [6,24].Еще одним преимуществом HBT является высокий КПД и высокая плотность мощности, что делает их очень подходящими для применения в усилителях мощности СВЧ [25].
Существует две версии HBT, биполярный транзистор с одинарным гетеропереходом (SHBT) и биполярный транзистор с двойным гетеропереходом (DHBT), как показано на рисунке 12.5 [26].
Рисунок 12.5. Упрощенное концептуальное сечение HBT с материалами.
В обоих случаях структура HBT обычно формируется путем создания эмиттера из материала с широкой запрещенной зоной, такого как AlInAs (1.45 эВ) или InP (1,35 эВ) и основание из соединения с более узкой запрещенной зоной, например, GaInAs (0,75 эВ). В случае SHBT один и тот же материал используется как для коллектора, так и для основания, тогда как третий материал используется в качестве коллектора в случае DHBT.
Эта смесь материалов имеет несколько преимуществ. Во-первых, ширина запрещенной зоны GaInAs, более узкая, чем у кремния и GaAs, дает InP HBT, которые имеют очень низкое напряжение включения и поэтому идеально подходят для низковольтных приложений. Во-вторых, смещение валентной зоны, которое блокирует поток дырок базового эмиттера, позволяет базовому легированию быть на один-два порядка выше в HBT, чем в устройстве с одним материалом (гомопереход).В результате снижается базовое сопротивление, увеличивается максимальная рабочая частота (fmax) и разрешаются устройства меньших размеров.
Справочник по биполярным транзисторам— Часть 1
Биполярный транзистор является наиболее важным «активным» схемным элементом, используемым в современной электронике, и он составляет основу большинства линейных и цифровых ИС, операционных усилителей и т. Д. В своей дискретной форме он может функционировать либо как цифровой переключатель, либо как как линейный усилитель и доступен во многих формах низкой, средней и высокой мощности.В этом вступительном эпизоде основное внимание уделяется базовой теории транзисторов, их характеристикам и конфигурациям схем. Остальные семь частей серии представят широкий спектр практических схем применения биполярных транзисторов.
ОСНОВА БИПОЛЯРНОГО ТРАНЗИСТОРА
Биполярный транзистор (впервые изобретен в 1948 году) представляет собой трехконтактное (база, эмиттер и коллектор) устройство усиления тока, в котором небольшой входной ток может управлять величиной гораздо большего выходного тока. Термин «биполярный» означает, что устройство изготовлено из полупроводниковых материалов, в которых проводимость зависит как от положительных, так и от отрицательных (основных и неосновных) носителей заряда.
Обычный транзистор сделан из трехслойного полупроводникового материала n-типа и p-типа, с базовым или «управляющим» выводом, подключенным к центральному слою, а выводы коллектора и эмиттера подключены к внешним слоям. Если он использует многослойную конструкцию n-p-n, как на Рис. 1 (a) , он известен как npn-транзистор и использует стандартный символ на Рис. 1 (b) .
РИСУНОК 1. Базовая конструкция (a) и обозначение (b) npn-транзистора.
Если он использует структуру p-n-p, как на рис. 2 (a) , он известен как pnp-транзистор и использует символ на рис. 2 (b) .
РИСУНОК 2. Базовая конструкция (a) и обозначение (b) pnp-транзистора.
При использовании транзисторам npn и pnp требуется источник питания соответствующей полярности, как показано на рис. 3 .
РИСУНОК 3. Подключения полярности к (a) npn-транзисторам и (b) pnp-транзисторам.
Устройству npn требуется источник питания, который делает коллектор положительным по отношению к эмиттеру — его выходной или выходной ток сигнала (I c ) течет от коллектора к эмиттеру, а его амплитуда регулируется входным «управляющим» током ( I b ), который течет от базы к эмиттеру через внешний токоограничивающий резистор (R b ) и положительное напряжение смещения. Транзистору pnp требуется отрицательное питание — ток его основного вывода течет от эмиттера к коллектору и управляется входным током эмиттер-база, который течет до отрицательного напряжения смещения.
В первые годы использования биполярных транзисторов большинство транзисторов были изготовлены из германиевых полупроводниковых материалов. У таких устройств было много практических недостатков: они были хрупкими, чрезмерно чувствительными к температуре, с электронным шумом и очень низкими показателями мощности. Германиевые транзисторы уже устарели. Практически все современные биполярные транзисторы изготовлены из кремниевых полупроводниковых материалов. Такие устройства надежны, обладают хорошей мощностью, не слишком чувствительны к температуре и генерируют незначительный электронный шум.
Сегодня доступно очень большое количество превосходных типов кремниевых биполярных транзисторов. На рис. 4 перечислены основные характеристики двух типичных маломощных типов общего назначения — 2N3904 (npn) и 2N3906 (pnp), каждый из которых размещен в пластиковом корпусе TO-92 и имеет штифт на нижней стороне. соединения показаны на схеме.
РИСУНОК 4. Общие характеристики и схема маломощных кремниевых транзисторов 2N3904 и 2N3906.
Обратите внимание, при чтении списка Рисунок 4 , что V CEO (max) — это максимальное напряжение, которое может быть приложено между коллектором и эмиттером, когда база разомкнута, а V CBO (max) — максимальное напряжение, которое может быть приложено между коллектором и базой при разомкнутой цепи эмиттера. I C (макс.) — это максимальный средний ток, который может протекать через клемму коллектора устройства, а P T (макс.) — максимальная средняя мощность, которую устройство может рассеять без использования внешний радиатор, при нормальной комнатной температуре.
Одним из наиболее важных параметров транзистора является его коэффициент передачи прямого тока, или h fe — это коэффициент усиления по току или отношение выходного / входного тока устройства (обычно от 100 до 300 в двух перечисленных устройствах). Наконец, цифра f T показывает доступное произведение коэффициента усиления / ширины полосы частот устройства, т. Е. Если транзистор используется в конфигурации обратной связи по напряжению, которая обеспечивает усиление по напряжению x100, ширина полосы составляет 1/100 от f T цифра, но если коэффициент усиления по напряжению уменьшается до x10, полоса пропускания увеличивается до f T /10 и т. Д.
ХАРАКТЕРИСТИКИ ТРАНЗИСТОРАЧтобы получить максимальное значение от транзистора, пользователь должен понимать как его статические (постоянный ток), так и динамические (переменный ток) характеристики. На рисунке 5 показаны статические эквивалентные схемы npn- и pnp-транзисторов.
РИСУНОК 5. Статические эквивалентные схемы npn- и pnp-транзисторов.
Стабилитрон неизбежно формируется каждым из np- или pn-переходов транзистора, и, таким образом, транзистор (в статических терминах) равен паре обратно соединенных стабилитронов, подключенных между выводами коллектора и эмиттера, с выводом базы. подключены к их «общей» точке.В большинстве маломощных транзисторов общего назначения переход база-эмиттер имеет типичное значение стабилитрона в диапазоне от 5 В до 10 В — типичное значение стабилитрона перехода база-коллектор находится в диапазоне от 20 В до 100 В.
Таким образом, переход база-эмиттер транзистора действует как обычный диод при прямом смещении и как стабилитрон при обратном смещении. В кремниевых транзисторах смещенный в прямом направлении переход пропускает небольшой ток, пока напряжение смещения не возрастет примерно до 600 мВ, но при превышении этого значения ток быстро увеличивается.При прямом смещении фиксированным током прямое напряжение перехода имеет тепловой коэффициент около -2 мВ / 0 C. Когда транзистор используется с разомкнутой цепью эмиттера, переход база-коллектор действует так же. описан, но имеет большее значение стабилитрона. Если транзистор используется с разомкнутой базой, путь коллектор-эмиттер действует как стабилитрон, включенный последовательно с обычным диодом.
Динамические характеристики транзистора можно понять с помощью Рисунок 6 , на котором показаны типичные характеристики прямого перехода маломощного кремниевого npn-транзистора с номинальным значением 100 h fe (коэффициент усиления по току).
РИСУНОК 6. Типичные передаточные характеристики маломощных npn-транзисторов со значением h fe , равным 100 номиналу.
Таким образом, когда ток базы (I b ) равен нулю, транзистор пропускает только небольшой ток утечки. Когда напряжение коллектора превышает несколько сотен милливольт, ток коллектора почти прямо пропорционален токам базы и мало зависит от значения напряжения коллектора. Таким образом, устройство можно использовать в качестве генератора постоянного тока, подавая фиксированный ток смещения в базу, или можно использовать как линейный усилитель, наложив входной сигнал на номинальный входной ток.
ПРАКТИЧЕСКИЕ ПРИМЕНЕНИЯ
Транзистор может использоваться во множестве различных конфигураций основных схем, и оставшаяся часть этого вступительного эпизода представляет собой краткое изложение наиболее важных из них. Обратите внимание, что хотя все схемы показаны с использованием транзисторов типа npn, их можно использовать с типами pnp, просто изменив полярность схемы и т. Д.
ДИОД И ЦЕПИ ПЕРЕКЛЮЧЕНИЯ
Переход база-эмиттер или база-коллектор кремниевого транзистора может использоваться как простой диод или выпрямитель, или как стабилитрон, используя его с соответствующей полярностью. Рисунок 7 показывает два альтернативных способа использования npn-транзистора в качестве простого диодного зажима, который преобразует прямоугольный входной сигнал, связанный по переменному току, в прямоугольный выходной сигнал, который колеблется между нулем и положительным значением напряжения, т. Е. Который «фиксирует» выходной сигнал. к нулевой контрольной точке либо через внутреннюю базу-эмиттер транзистора, либо через «диодный» переход база-коллектор.
РИСУНОК 7. Схема ограничивающего диода, использующая npn-транзистор в качестве диода.
На рисунке 8 показан транзистор npn, используемый в качестве стабилитрона, который преобразует нерегулируемое напряжение питания в стабилизированный выходной сигнал с фиксированным значением с типичным значением в диапазоне от 5 В до 10 В, в зависимости от конкретного транзистора. Для этого приложения подходит только переход база-эмиттер транзистора с обратным смещением. Если используется переход база-коллектор с обратным смещением, значение стабилитрона обычно возрастает до диапазона 30–100 В, и транзистор может самоуничтожиться (из-за перегрева) при довольно низких уровнях тока стабилитрона.
РИСУНОК 8. Транзистор, используемый в качестве стабилитрона.
На рисунке 9 показан транзистор, используемый в качестве простого электронного переключателя или цифрового инвертора. Его база приводится в действие (через R b ) цифровым входом, имеющим либо нулевое, либо положительное значение, а нагрузка R L подключается между коллектором и положительной шиной питания. Когда входное напряжение равно нулю, транзистор отключен и через нагрузку протекает нулевой ток, поэтому между коллектором и эмиттером появляется полное напряжение питания.Когда на входе высокий уровень, транзисторный ключ полностью включен (насыщен), и в нагрузке протекает максимальный ток, и между коллектором и эмиттером вырабатывается всего несколько сотен милливольт. Таким образом, выходное напряжение представляет собой инвертированную форму входного сигнала.
РИСУНОК 9. Транзисторный переключатель или цифровой инвертор.
Базовая схема Figure 9 предназначена для использования в качестве простого цифрового переключателя или инвертора, управляющего чисто резистивной нагрузкой.Его можно использовать в качестве электронного переключателя, который приводит в действие катушку реле или другую высокоиндуктивную нагрузку (например, двигатель постоянного тока), подключив его, как показано на рис. 10 , рис. 10 , в котором диоды D1 и D2 защищают транзистор от высокоточного переключателя. — индуцированные обратные ЭДС от индуктивной нагрузки в момент отключения питания.
РИСУНОК 10. Транзисторный переключатель (цифровой инвертор), управляющий катушкой реле (или другой индуктивной нагрузкой).
ЦЕПИ ЛИНЕЙНОГО УСИЛИТЕЛЯ
Транзистор можно использовать в качестве линейного усилителя тока или напряжения, подав соответствующий ток смещения в его базу, а затем подав входной сигнал между соответствующей парой клемм.В этом случае транзистор может использоваться в любом из трех основных режимов работы, каждый из которых обеспечивает уникальный набор характеристик. Эти три режима известны как «общий эмиттер» (, рисунок 11, ), «общая база» (, рисунок 12, ) и «общий коллектор» (, рисунки 13 и 14, ).
В схеме с общим эмиттером (которая показана в очень простой форме на рис. 11 ) резистивная нагрузка R L подключена между коллектором транзистора и положительной линией питания, а ток смещения подается в базу через резистор R b , значение которого выбирается для установки коллектора на значение половины напряжения покоя (для обеспечения максимальных неискаженных колебаний выходного сигнала).Входной сигнал подается между базой транзистора и эмиттером через конденсатор C, а выходной сигнал (который инвертирован по фазе относительно входа) принимается между коллектором и эмиттером. Эта схема дает среднее значение входного импеданса и довольно высокий общий коэффициент усиления по напряжению.
РИСУНОК 11. Линейный усилитель с общим эмиттером.
В схеме с общей базой в Рис. 12 база смещена через R b и развязана по переменному току (или заземлена по переменному току) через конденсатор C b .Входной сигнал эффективно применяется между эмиттером и базой через C1, а усиленный, но не инвертированный выходной сигнал эффективно берется между коллектором и базой. Эта схема отличается хорошим коэффициентом усиления по напряжению, почти единичным коэффициентом усиления по току и очень низким входным сопротивлением.
РИСУНОК 12. Линейный усилитель с общей базой.
В цепи общего коллектора постоянного тока на рис. 13 коллектор закорочен на низкоомную положительную шину питания и, таким образом, фактически находится на уровне импеданса «виртуальной земли».Входной сигнал подается между базой и землей (виртуальный коллектор), а неинвертированный выход берется между эмиттером и землей (виртуальный коллектор). Эта схема дает почти единичный общий коэффициент усиления по напряжению, а ее выход «следует» за входным сигналом. Таким образом, он известен как повторитель постоянного напряжения (или эмиттерный повторитель) и имеет очень высокий входной импеданс (равный произведению значений R L и h fe ).
РИСУНОК 13. Линейный усилитель постоянного тока с общим коллектором или повторитель напряжения.
Обратите внимание, что приведенная выше схема может быть модифицирована для использования переменного тока, просто смещая транзистор на половину напряжения питания и соединяя входной сигнал с базой по переменному току, как показано в базовой схеме на рис. 14 , в котором делитель потенциала R1-R2 обеспечивает смещение половинного напряжения питания.
РИСУНОК 14. Усилитель с общим коллектором переменного тока или повторитель напряжения.
На диаграмме , рис. 15, приведены характеристики трех основных конфигураций усилителя.Таким образом, усилитель с общим коллектором дает почти единичный общий коэффициент усиления по напряжению и высокий входной импеданс, в то время как усилители с общим эмиттером и общей базой дают высокие значения усиления по напряжению, но имеют значения входного импеданса от среднего до низкого.
РИСУНОК 15. Сравнительные характеристики трех основных схемных конфигураций.
ДИФФЕРЕНЦИАЛЬНЫЙ УСИЛИТЕЛЬ
Рисунок 16 показывает — в базовой форме — как пару усилителей типа базового Рисунок 11 можно соединить вместе, чтобы образовать «дифференциальный» усилитель или «длиннохвостую пару», которая выдает пропорциональный выходной сигнал. на разницу между двумя входными сигналами.В этом случае Q1 и Q2 имеют общий эмиттерный резистор («хвост»), а схема смещена (через R1-R2 и R3-R4), так что два транзистора пропускают идентичные токи коллектора (таким образом, давая нулевую разницу между токами коллектора). два напряжения коллектора) в условиях покоя с нулевым входом.
РИСУНОК 16. Дифференциальный усилитель или длиннохвостая пара.
Если в приведенной выше схеме возрастающее входное напряжение подается только на вход одного транзистора, это приводит к падению выходного напряжения этого транзистора и (в результате действия связи эмиттера) вызывает выходное напряжение другого транзистора. транзистор поднимается на аналогичную величину, что дает большое дифференциальное выходное напряжение между двумя коллекторами.С другой стороны, если на входы обоих транзисторов подаются идентичные сигналы, оба коллектора будут перемещаться на одинаковые величины, и, таким образом, схема будет производить нулевой дифференциальный выходной сигнал. Таким образом, схема выдает выходной сигнал, пропорциональный разнице между двумя входными сигналами.
ПОДКЛЮЧЕНИЕ ДАРЛИНГТОНА
Входное сопротивление схемы эмиттерного повторителя Рис. 13 равно произведению значений R L и значений h fe транзистора — если требуется сверхвысокий входной импеданс, его можно получить, заменив одиночный транзистор на пара транзисторов, подключенных по схеме «Дарлингтон» или «Супер-Альфа», как показано на Рис. 17 .Здесь эмиттерный ток входного транзистора подается непосредственно на базу выходного транзистора, и пара действует как один транзистор с общим значением h fe , равным произведению двух отдельных значений hfe, т. Е. Если каждое из них Транзистор имеет значение h fe , равное 100, пара действует как одиночный транзистор с h fe , равным 10 000, а полная схема имеет входное сопротивление 10 000 x R L .
РИСУНОК 17. Эмиттерный повторитель Дарлингтона или Супер-Альфа постоянного тока.
ЦЕПИ МУЛЬТИВИБРАТОРА
Мультивибратор, по сути, представляет собой цифровую схему с двумя состояниями, которую можно переключать из состояния с высоким выходом в состояние с низким уровнем выхода или наоборот, с помощью триггерного сигнала, который может быть получен от внешнего источника или с помощью автоматического или срабатывающий механизм синхронизации. Транзисторы могут использоваться в четырех основных типах схем мультивибратора, как показано на рисунках 18-21 .
Схема Рис. 18 Схема представляет собой простой бистабильный мультивибратор с перекрестной связью, запускаемый вручную, в котором смещение базы каждого транзистора происходит от коллектора другого, так что один транзистор автоматически отключается при включении другого. , наоборот.
РИСУНОК 18. Бистабильный мультивибратор с ручным запуском.
Таким образом, выход может быть понижен путем кратковременного отключения Q2 через S2, таким образом закорачивая путь Q2 база-эмиттер. Когда Q2 отключает привод базы питания R2-R4 на базу Q1, схема автоматически блокируется в этом состоянии до тех пор, пока Q1 не будет аналогичным образом отключен через S1, после чего выход снова блокируется в высоком состоянии, и так до бесконечности.
Рисунок 19 показывает — в базовой форме — моностабильный мультивибратор или схему генератора однократных импульсов.Его выход (от коллектора Q1) обычно низкий, так как Q1 обычно смещается через R5, но переключается на высокий уровень в течение заданного периода (определяемого значениями компонентов C1-R5), если Q1 на короткое время выключается посредством кратковременного закрытия кнопки « Пуск »переключатель S1.
РИСУНОК 19. Моностабильный мультивибратор с ручным запуском.
Фактический период времени моностабильности начинается при отпускании кнопочного переключателя «Пуск» и имеет период (P) приблизительно 0.7 x C1 x R5, где P выражено в мкСм, C в мкФ, а R в килом.
На рисунке 20 показан нестабильный мультивибратор или автономный генератор прямоугольной волны, в котором периоды включения и выключения прямоугольной волны определяются значениями компонентов C1-R4 и C2-R3. По сути, эта схема действует как пара перекрестно связанных моностабильных схем, которые последовательно автоматически запускают друг друга. Если периоды синхронизации C1-R4 и C2-R3 идентичны, схема генерирует свободный прямоугольный выходной сигнал.Если два периода синхронизации не идентичны, схема генерирует асимметричный выходной сигнал.
РИСУНОК 20. Нестабильный мультивибратор или автономный прямоугольный генератор.
Наконец, На рисунке 21 показан базовый триггер Шмитта или схема преобразователя синусоидальной формы сигнала в прямоугольную. Действие схемы здесь таково, что Q2 внезапно переключается из состояния «включено» в состояние «выключено» или наоборот, когда база Q1 поднимается выше или ниже заранее определенных уровней «триггерного» напряжения.
РИСУНОК 21. Триггер Шмитта или преобразователь синусоидального сигнала в прямоугольный.
Если на вход схемы подается синусоидальный сигнал разумной амплитуды, схема, таким образом, генерирует выходной сигнал симпатической прямоугольной формы. NV
ПОЛУПРОВОДНИК, ИМЕЮЩИЙ МНОЖЕСТВО БИПОЛЯРНЫХ ТРАНЗИСТОРОВ С РАЗЛИЧНОЙ ВЫСОТОЙ МЕЖДУ ИХ СЛОИ ЭМИТТЕРА И ЭЛЕКТРОДЫ ИЗЛУЧАТЕЛЯ
Это приложение является продолжением U.Заявка на патент S. Сер. № 16 / 440,700, поданной 13 июня 2019 г., в которой испрашивается приоритет по заявке на патент Японии № 2018-136042, поданной 19 июля 2018 г., все содержание которой включено в настоящий документ посредством ссылки.
Настоящее изобретение относится к полупроводниковому устройству.
Публикация нерассмотренной заявки на патент Японии № 2017-220584 описывает полупроводниковое устройство, которое имеет первый и второй биполярные транзисторы на одной полупроводниковой подложке. Множественные единичные транзисторы, образующие первый биполярный транзистор, не имеют слоя эмиттерного балластного резистора.Множественные единичные транзисторы, образующие второй биполярный транзистор, имеют слой эмиттерного балластного резистора.
Полупроводниковое устройство, описанное в публикации японской нерассмотренной патентной заявки № 2017-220584, имеет эмиттерную проводку (верхняя поверхность эмиттерного электрода) своего первого биполярного транзистора и второго биполярного транзистора на разной высоте от нижней поверхности полупроводниковая подложка. Таким образом, формирование выступа на каждом из первого и второго биполярных транзисторов и установка полупроводникового устройства на модульной подложке с выступами, вставленными между ними, может вызвать плохое соединение.
Соответственно, настоящее раскрытие предоставляет полупроводниковое устройство, которое может быть установлено на внешней подложке с уменьшенным возникновением плохого электрического соединения.
Согласно предпочтительным вариантам осуществления настоящего раскрытия полупроводниковое устройство имеет полупроводниковую подложку; и множество первых биполярных транзисторов на первой стороне первичной поверхности полупроводниковой подложки. Первые биполярные транзисторы имеют первую высоту между эмиттерным слоем и эмиттерным электродом в направлении, перпендикулярном первой первичной поверхности.Полупроводниковое устройство дополнительно имеет по меньшей мере один второй биполярный транзистор на первой стороне первичной поверхности полупроводниковой подложки. Второй биполярный транзистор имеет вторую высоту, большую, чем первая высота, между эмиттерным слоем и эмиттерным электродом в направлении, перпендикулярном первой первичной поверхности. Кроме того, полупроводниковое устройство имеет первый выступ, проходящий через множество первых биполярных транзисторов и по меньшей мере один второй биполярный транзистор.
Полупроводниковое устройство в соответствии с предпочтительными вариантами осуществления настоящего раскрытия может быть установлено на внешней подложке с уменьшенным возникновением плохого электрического соединения.
Другие особенности, элементы, характеристики и преимущества настоящего раскрытия станут более очевидными из следующего подробного описания предпочтительных вариантов осуществления настоящего раскрытия со ссылкой на прилагаемые чертежи.
РИС. 1 — вид сверху полупроводникового устройства согласно первому варианту осуществления;
РИС. 2 представляет собой поперечное сечение по линии II-II ‘на фиг. 1;
РИС. 3 — поперечный разрез первого биполярного транзистора;
РИС. 4 — поперечный разрез второго биполярного транзистора;
РИС.5 — эквивалентная принципиальная схема первого транзисторного узла;
РИС. 6 — эквивалентная принципиальная схема второго транзисторного узла;
РИС. 7 представляет схемы для описания способа изготовления полупроводникового устройства согласно варианту 1 осуществления;
РИС. 8 — вид сверху полупроводникового устройства согласно варианту 1 варианта осуществления 1;
РИС. 9 — поперечный разрез по линии IX-IX ‘на фиг. 8;
РИС. 10 — эквивалентная принципиальная схема первого транзисторного узла согласно варианту 1 варианта осуществления 1;
РИС.11 — вид сверху полупроводникового устройства согласно варианту 2 варианта 1 осуществления;
РИС. 12 — вид сверху полупроводникового устройства согласно варианту 3 варианта осуществления 1;
РИС. 13 — вид сверху полупроводникового устройства согласно варианту 4 варианта осуществления 1;
РИС. 14 — вид сверху полупроводникового устройства согласно варианту 5 варианта осуществления 1;
РИС. 15 — вид сверху полупроводникового устройства согласно варианту 6 варианта осуществления 1;
РИС.16 — вид сверху полупроводникового устройства согласно варианту 2 осуществления;
РИС. 17 представляет собой поперечное сечение по линии XVII-XVII ‘на фиг. 16;
РИС. 18 — эквивалентная принципиальная схема полупроводникового устройства согласно варианту 2 осуществления;
РИС. 19 — поперечное сечение полупроводникового устройства согласно варианту 3 осуществления;
РИС. 20 — поперечный разрез модуля усилителя мощности согласно варианту 4 осуществления; nd
РИС. 21 — блок-схема, иллюстрирующая структуру модуля усилителя мощности согласно варианту 4 осуществления.
Ниже приводится подробное описание полупроводниковых устройств согласно вариантам осуществления настоящего раскрытия со ссылкой на чертежи. Следует отметить, что ни один аспект настоящего раскрытия не ограничивается этими вариантами осуществления. Само собой разумеется, что варианты осуществления, представленные ниже, являются иллюстративными, и возможна частичная замена или комбинация конфигураций, описанных в различных вариантах осуществления. Второй и последующие варианты осуществления пропускают что-либо общее с вариантом осуществления 1 и описывают только различия.В частности, аналогичные преимущества, вытекающие из аналогичных конфигураций, не упоминаются по отдельности в каждом варианте осуществления.
РИС. 1 — вид сверху полупроводникового устройства согласно первому варианту осуществления. Фиг. 2 представляет собой поперечное сечение по линии II-II ‘на фиг. 1. Фиг. 3 — поперечный разрез первого биполярного транзистора. ИНЖИР. 4 — поперечный разрез второго биполярного транзистора. ИНЖИР. 5 — эквивалентная принципиальная схема первого транзисторного узла. ИНЖИР. 6 — эквивалентная принципиальная схема второго транзисторного узла.Следует понимать, что фиг. 1 представляет собой схематическое изображение конфигурации биполярных транзисторов и не иллюстрирует подробную структуру каждого биполярного транзистора.
Как показано на фиг. 1, полупроводниковое устройство , 100, имеет полупроводниковую подложку 1 , первый транзисторный узел Qa, второй транзисторный узел Qb, первый выступ 61 и второй выступ 62 .
В нижеследующем описании направление в плоскости, параллельной первой первичной поверхности S 1 полупроводниковой подложки 1 , определяется как направление X.Направление, перпендикулярное направлению X в плоскости, параллельной первой первичной поверхности S 1 , определяется как направление Y. Направление, перпендикулярное каждому из направлений X и Y, определяется как направление Z. Это не единственная возможная настройка, и направление Y может пересекать направление X под углом, отличным от 90 °. Направление Z может пересекать направления X и Y под углом, отличным от 90 °.
Как показано на фиг. 1 полупроводниковая подложка 1 является по существу прямоугольной на виде сверху или если смотреть в направлении Z.Как показано на фиг. 2, полупроводниковая подложка 1 имеет первую первичную поверхность S 1 и вторую первичную поверхность S 2 , противоположную первой первичной поверхности S 1 . Продольная ось полупроводниковой подложки 1 проходит вдоль направления X, поперечная ось проходит вдоль направления Y, а направление, перпендикулярное первой первичной поверхности S 1 , является направлением Z. Полупроводниковая подложка 1 изготовлена, например, из полуизолирующего арсенида галлия (GaAs).
Как показано на фиг. 1 и 2, первая и вторая транзисторные сборки Qa и Qb находятся на первой первичной поверхности S 1 стороне полупроводниковой подложки 1 . Первый и второй транзисторные сборки Qa и Qb расположены рядом друг с другом с промежутком между ними в направлении X. Первый транзисторный узел Qa имеет несколько первых биполярных транзисторов 20 и несколько вторых биполярных транзисторов 30 . Второй транзисторный узел Qb имеет несколько третьих биполярных транзисторов 40 .То есть имеется несколько первых биполярных транзисторов 20 , несколько вторых биполярных транзисторов 30 и несколько третьих биполярных транзисторов 40 на первой первичной поверхности S 1 стороне полупроводниковой подложки 1 .
Каждый из первого, второго и третьего биполярных транзисторов 20 , 30 и 40 является биполярным транзистором с гетеропереходом (HBT). На фиг. 1, второй и третий биполярные транзисторы 30 и 40 заштрихованы, чтобы их можно было отличить от первых биполярных транзисторов 20 .
Каждый из первого, второго и третьего биполярных транзисторов 20 , 30 и 40 также называется единичным транзистором. Первые биполярные транзисторы , 20, электрически соединены параллельно, чтобы сформировать первый транзисторный узел Qa. По меньшей мере, один из коллектора и базы вторых биполярных транзисторов 30 изолирован от первых биполярных транзисторов 20 , предотвращая функционирование вторых биполярных транзисторов 30 в качестве транзисторов.Множество третьих биполярных транзисторов , 40, электрически соединены параллельно с образованием второго транзисторного узла Qb. Единичный транзистор определяется как наименьший транзистор в первом или втором транзисторном узле Qa или Qb.
В этом варианте осуществления первый транзисторный узел Qa имеет шесть первых биполярных транзисторов 20 и три вторых биполярных транзистора 30 в качестве примера. В первом транзисторном узле Qa три вторых биполярных транзистора , 30, находятся в конечной и средней частях в направлении X, разнесенных друг от друга.Множество первых биполярных транзисторов 20 расположены между вторыми биполярными транзисторами 30 , смежными в направлении X. Это не единственная возможная конфигурация, и количество и конфигурация первого и второго биполярных транзисторов 20 и 30 могут быть изменены по мере необходимости. Например, первый транзисторный узел Qa может иметь один второй биполярный транзистор 30 .
В этом варианте осуществления второй транзисторный узел Qb имеет шесть третьих биполярных транзисторов 40 .Во втором узле Qb транзисторов несколько третьих биполярных транзисторов , 40, выстроены в линию в направлении X. Это не единственная возможная конфигурация, и количество и конфигурация третьих биполярных транзисторов 40 могут быть изменены по мере необходимости.
Первый выступ 61 проходит через несколько первых биполярных транзисторов 20 и несколько вторых биполярных транзисторов 30 . Второй выступ 62 проходит через несколько третьих биполярных транзисторов 40 .
Как показано на фиг. 2, имеется область 50 изоляции в полупроводниковой подложке 1 и субколлекторный слой 2 между первым и вторым узлами Qa и Qb транзисторов. Область 50 изоляции представляет собой область, созданную путем ионной имплантации электрически изолирующей частью полупроводниковой подложки 1 и субколлекторного слоя 2 . Область 50 изоляции электрически изолирует первый и второй транзисторные сборки Qa и Qb друг от друга.
Первые биполярные транзисторы 20 — это транзисторы, не имеющие эмиттерного балластного резистора 88 . Второй и третий биполярные транзисторы 30 и 40 представляют собой транзисторы, имеющие эмиттерный балластный резистор 88 .
В частности, первый биполярный транзистор 20 включает в себя, как показано на фиг. 3, субколлекторный слой 2 , коллекторный слой 3 , базовый слой 4 , эмиттерный слой 5 , первый контактный слой 6 , а также электроды и разводка.Подколлекторный слой 2 , коллекторный слой 3 , базовый слой 4 , эмиттерный слой 5 и первый контактный слой 6 уложены в этом порядке на полупроводниковой подложке 1 .
Подколлекторный слой 2 находится на первой первичной поверхности 51 полупроводниковой подложки 1 . Коллекторный слой 3 находится на субколлекторном слое 2 . Подколлекторный слой 2 функционирует как коллектор первого биполярного транзистора 20 вместе с коллекторным слоем 3 .Субколлекторный и коллекторный слои 2 и 3 представляют собой, например, полупроводники n-типа на основе GaAs. Слой субколлектора 2 может быть легирован Si с концентрацией около 5 × 10 18 см −3 и может иметь толщину около 600 нм. Слой коллектора 3 может быть легирован Si с концентрацией около 1 × 10 16 см −3 и может иметь толщину около 1000 нм.
Базовый слой 4 находится на слое коллектора 3 .Базовый слой 4 представляет собой, например, полупроводник p-типа на основе GaAs. Базовый слой 4 может быть легирован углеродом в концентрации примерно 5 × 10 19 см -3 и может иметь толщину примерно 96 нм.
Эмиттерный слой 5 находится на базовом слое 4 . Эмиттерный слой 5 представляет собой, например, полупроводник n-типа на основе InGaP. Эмиттерный слой 5 может иметь молярную долю InP около 0,48, может быть легирован Si с концентрацией около 4 × 10 17 см 3 и может иметь толщину около 35 нм.
Первый контактный слой 6 находится на эмиттерном слое 5 . Первый контактный слой 6 представляет собой, например, полупроводник n-типа на основе GaAs. Первый контактный слой 6 может быть легирован Si в концентрации примерно 5 × 10 18 см -3 и может иметь толщину примерно 50 нм.
Имеются два коллекторных электрода 15 на субколлекторном слое 2 , с коллекторным слоем 3 между ними в направлении X.Коллекторные электроды 15 состоят из AuGe (толщиной около 60 нм) / Ni (толщиной около 10 нм) / Au (толщиной около 200 нм). Символ «/» обозначает слоистую структуру. Например, AuGe / Ni / Au представляет собой структуру, в которой слой Ni находится на слое AuGe, а слой Au находится на слое Ni.
В этом варианте осуществления коллекторные электроды , 15, используются совместно с соседними первыми биполярными транзисторами 20 . То есть, как показано на фиг. 2, имеется один коллекторный электрод 15 между двумя соседними первыми биполярными транзисторами 20 .Один коллекторный электрод 15 электрически соединен с каждым из соседних первых биполярных транзисторов 20 . Это позволяет изготавливать первый транзисторный узел Qa с меньшим количеством электродов и меньшим количеством проводов, чем при использовании двух коллекторных электродов 15 на первый биполярный транзистор 20 .
Как показано на фиг. 3, на слое основы 4 расположены два основных электрода 16 . На виде сверху первый контактный слой 6 находится между двумя базовыми электродами 16 .Базовые электроды 16 представляют собой, например, Pt (толщиной около 20 нм) / Ti (толщиной около 50 нм) / Pt (толщиной около 50 нм) / Au (толщиной около 200 нм).
На первом контактном слое 6 находится эмиттерный электрод 17 . Эмиттерный электрод 17 представляет собой, например, Mo (толщиной около 10 нм) / Ti (толщиной около 5 нм) / Pt (толщиной около 30 нм) / Au (толщиной около 200 нм).
Защитный слой 57 покрывает субколлекторный слой 2 , коллекторный слой 3 , базовый слой 4 , эмиттерный слой 5 , первый контактный слой 6 и электроды.На защитном слое 57 находятся соединительная проводка коллектора 51 a и соединительная проводка эмиттера 52 a. Соединительная проводка коллектора 51 a соединена с электродами коллектора 15 через сквозные отверстия, созданные в защитном слое 57 . Соединительная проводка эмиттера 52 a соединена с эмиттерным электродом 17 через сквозное отверстие, созданное в защитном слое 57 .
На защитной пленке 57 находится межслойная изолирующая пленка 58 , покрывающая соединительную проводку коллектора и эмиттера 51 a и 52 a. На межслойной изолирующей пленке 58 находится проводка первого эмиттера 53 a. Первая проводка эмиттера 53 a подключается к соединительной проводке эмиттера 52 a через сквозное отверстие, созданное в межслойной изолирующей пленке 58 .В результате первая эмиттерная проводка 53 a электрически соединена с эмиттерным электродом 17 через соединительную проводку эмиттера 52 a.
Защитная пленка 57 и межслойная изолирующая пленка 58 представляют собой, например, SiN. Соединительная проводка коллектора 51 a, соединительная проводка эмиттера 52 a, и проводка первого эмиттера 53 a , например, являются Au.
Первый выступ 61 находится на проводке первого эмиттера 53 a с нижним металлическим слоем 56 a , расположенным между ними. Первый выступ 61 представляет собой выступ медной стойки и образован гальваническим покрытием. Первый выступ 61 может быть изготовлен из другого металлического материала, такого как Au. Нижний металлический слой , 56, , и представляет собой, например, Ti / Cu и при образовании первой выпуклости 61 служит затравочным металлом для нанесения покрытия.
РИС. 4 иллюстрирует слоистую структуру второго биполярного транзистора 30 . Третьи биполярные транзисторы 40 имеют такую же слоистую структуру, что и вторые биполярные транзисторы 30 . Таким образом, описание слоистой структуры второго биполярного транзистора 30 также применимо к третьим биполярным транзисторам 40 .
Как показано на фиг. 4, второй биполярный транзистор 30 имеет субколлекторный слой 2 , коллекторный слой 3 , базовый слой 4 , эмиттерный слой 5 , первый контактный слой 6 , коллекторные электроды 15 , базовые электроды 16 и соединительные провода коллектора 51 a на первой первичной поверхности S 1 полупроводниковой подложки 1 как первый биполярный транзистор 20 .Между первым контактным слоем 6 и эмиттерным электродом 17 находятся туннельный барьерный слой 7 , разделительный слой 8 , эмиттерный балластный резистор 88 , второй контактный слой 12 , третий контакт слой 13 и четвертый контактный слой 14 уложены стопкой в этом порядке.
Туннельный барьерный слой 7 находится на первом контактном слое 6 . Туннельный барьерный слой 7 представляет собой, например, полупроводник n-типа на основе InGaP.Туннельный барьерный слой 7 может иметь молярную долю InP около 0,48, может быть легирован Si с концентрацией около 5 × 10 18 см -3 и может иметь толщину около 3 нм.
Разделительный слой 8 находится на туннельном барьерном слое 7 . Разделительный слой 8 представляет собой, например, полупроводник n-типа на основе GaAs. Разделительный слой 8 может быть легирован Si в концентрации примерно 3 × 10 17 см -3 и может иметь толщину примерно 100 нм.
Эмиттерный балластный резистор 88 имеет первый слой эмиттерного балластного резистора 9 , второй эмиттерный слой балластного резистора 10 и третий слой эмиттерного балластного резистора 11 . Первый, второй и третий слои 9 , 10 и 11 эмиттерного балластного резистора уложены стопкой в этом порядке на промежуточном слое 8 . Каждый из первого, второго и третьего слоев эмиттерного балластного резистора 9 , 10 и 11 является полупроводником n-типа на основе AlGaAs.
Первый слой эмиттерного балластного резистора 9 может быть легирован Si в концентрации примерно 1 × 10 17 см -3 и может иметь толщину около 50 нм. Молярная доля AlAs в первом слое 9 балластного резистора эмиттера увеличивается по направлению ко второму слою 10 балластного резистора эмиттера. В частности, молярная доля AlAs составляет около 0 на границе раздела, где первый эмиттерный слой балластного резистора 9 касается разделительного слоя 8 , и составляет около 0.33 на границе раздела, где первый слой 9 балластного резистора эмиттера касается второго слоя 10 балластного резистора эмиттера. Первый слой 9 балластного резистора эмиттера сформирован так, что молярная доля AlAs в нем изменяется линейно.
Второй слой балластного резистора эмиттера 10 может иметь молярную долю AlAs около 0,33, может быть легирован Si в концентрации около 1 × 10 17 см 3 и может иметь толщину около 200 нм.
Третий слой 11 балластного резистора эмиттера может быть легирован Si в концентрации примерно 1 × 10 17 см −3 и может иметь толщину около 50 нм. Молярная доля AlAs в третьем эмиттерном слое 11 балластного резистора уменьшается по направлению ко второму контактному слою 12 . В частности, молярная доля AlAs составляет около 0,33 на границе раздела, где третий слой 11 балластного резистора эмиттера касается второго слоя 10 балластного резистора эмиттера, и около 0 на границе раздела, где третий слой балластного резистора эмиттера 11 касается второго контактного слоя 12 .Третий слой 11 балластного резистора эмиттера сформирован так, что молярная доля AlAs в нем изменяется линейно. Эмиттерный балластный резистор 88 имеет более высокое удельное сопротивление, чем первый контактный слой 6 . Необязательно, чтобы эмиттерный балластный резистор 88 состоял из трех слоев. Например, весь балластный резистор эмиттера , 88, может быть одним слоем второго слоя 10 эмиттерного балластного резистора.
Второй, третий и четвертый контактные слои 12 , 13 и 14 уложены в этом порядке на третьем эмиттерном слое балластного резистора 11 .Второй контактный слой , 12, представляет собой, например, полупроводник n-типа на основе GaAs. Второй контактный слой 12 может быть легирован Si в концентрации примерно 5 × 10 18 см -3 и может иметь толщину примерно 50 нм.
Третий контактный слой 13 представляет собой, например, полупроводник n-типа на основе InGaAs. Третий контактный слой 13 может быть легирован Si в концентрации примерно 5 × 10 18 см 3 и может иметь толщину примерно 50 нм.Молярная доля InAs в третьем контактном слое 13 увеличивается по направлению к четвертому контактному слою 14 . В частности, молярная доля InAs составляет около 0 на границе раздела, где третий контактный слой 13 касается второго контактного слоя 12 , и составляет около 0,5 на границе раздела, где третий контактный слой 13 касается четвертого контактного слоя. 14 . Третий контактный слой 13 сформирован так, что молярная доля InAs в нем изменяется линейно.
Четвертый контактный слой 14 представляет собой, например, полупроводник n-типа на основе InGaAs. Четвертый контактный слой 14 может иметь молярную долю InAs примерно 0,5, может быть легирован Si в концентрации примерно 1 × 10 19 см -3 и может иметь толщину примерно 50 нм.
Эмиттерный электрод 17 находится на четвертом контактном слое 14 . Защитный слой 57 покрывает слои от субколлекторного слоя 2 до четвертого контактного слоя 14 и коллекторных электродов 15 , базовых электродов 16 и эмиттерного электрода 17 .
Во втором биполярном транзисторе 30 также имеется проводка первого эмиттера 53 a на межслойной изолирующей пленке 58 , как и в первом биполярном транзисторе 20 . Первая проводка эмиттера 53 a соединена с соединительной проводкой эмиттера 52 a через сквозное отверстие, созданное в межслойной изолирующей пленке 58 . В результате первая эмиттерная проводка 53 a электрически соединена с эмиттерным электродом 17 второго биполярного транзистора 30 через соединительную проводку эмиттера 52 a.
Как показано на фиг. 3, в первом биполярном транзисторе 20 расстояние в направлении Z между верхней поверхностью эмиттерного слоя 5 и нижней поверхностью эмиттерного электрода 17 определяется как первая высота HEa. Как показано на фиг. 4, во втором биполярном транзисторе 30 расстояние в направлении Z между верхней поверхностью эмиттерного слоя 5 и нижней поверхностью эмиттерного электрода 17 определяется как вторая высота HEb.Вторая высота HEb больше первой высоты HEa. Третьи биполярные транзисторы 40 также имеют такую же вторую высоту HEb, что и вторые биполярные транзисторы 30 .
Как показано на фиг. 2, в первом транзисторном узле Qa несколько первых биполярных транзисторов 20 , имеющих первую высоту HEa, и несколько вторых биполярных транзисторов 30 , имеющих вторую высоту HEb, выстроены в линию в направлении X. Первая эмиттерная проводка 53, , и проходит через несколько первых и несколько вторых биполярных транзисторов 20, и 30 и электрически соединена с их соответствующими эмиттерными электродами 17 .
Первый выступ 61 простирается над несколькими первыми и несколькими вторыми биполярными транзисторами 20 и 30 над проводкой первого эмиттера 53 a. Первый выступ 61 проходит вдоль проводки первого эмиттера 53 a и имеет неровности, соответствующие разнице высот между множеством первых биполярных транзисторов 20 и множеством вторых биполярных транзисторов 30 .
Здесь расстояние в направлении Z между второй первичной поверхностью S 2 и самой высокой поверхностью первого выступа 61 определяется как первая максимальная высота Ha. В этом варианте осуществления пассивирующая пленка 59 покрывает первый транзисторный узел Qa, по меньшей мере, на его боковых поверхностях, а первый выступ 61 простирается до области, где он перекрывает часть пассивирующей пленки 59 . На фиг. 2 первая максимальная высота Ha представляет собой расстояние между верхней поверхностью части первой выпуклости 61 , которая перекрывает часть пассивирующей пленки 59 , и второй первичной поверхностью S 2 .Если пассивирующая пленка 59 не выше, чем проводка первого эмиттера 53 a, , первая максимальная высота Ha — это расстояние между верхней поверхностью части первого выступа 61 , которая перекрывает вторые биполярные транзисторы. 30 и вторая первичная поверхность S 2 .
Во втором транзисторном узле Qb несколько третьих биполярных транзисторов 40 , имеющих вторую высоту HEb, выстроены в линию в направлении X.Вторая эмиттерная проводка 53 b проходит через несколько третьих биполярных транзисторов 40 и электрически соединена с эмиттерным электродом 17 третьих биполярных транзисторов 40 через соединительную проводку эмиттера 52 b.
Второй выступ 62 находится над разводкой второго эмиттера 53 b с нижним металлическим слоем 56 b , вставленным между ними и простирающимся над множеством третьих биполярных транзисторов 40 .Второй выступ 62 проходит вдоль проводки второго эмиттера 53 b. Второй выступ 62 представляет собой выступ медной стойки, изготовленный из того же металлического материала, что и первый выступ 61 , и сформирован гальваническим способом. Второй выступ 62 может быть изготовлен из другого металлического материала, такого как Au.
Здесь расстояние в направлении Z между второй первичной поверхностью S 2 и самой высокой поверхностью второго выступа 62 определяется как вторая максимальная высота Hb.В этом варианте осуществления пассивирующая пленка 59 покрывает второй транзисторный узел Qb, по меньшей мере, на его боковых поверхностях, а второй выступ 62 простирается до области, где он перекрывает часть пассивирующей пленки 59 . На фиг. 2 вторая максимальная высота Hb — это расстояние между верхней поверхностью части второй выпуклости 62 , которая перекрывает часть пассивирующей пленки 59 , и второй первичной поверхностью S 2 . Если пассивирующая пленка 59 не выше второй эмиттерной проводки 53 b, , вторая максимальная высота Hb — это расстояние между верхней поверхностью части второго выступа 62 , перекрывающего третьи биполярные транзисторы. 40 и вторая первичная поверхность S 2 .
В этом варианте осуществления первая максимальная высота Ha первой транзисторной сборки Qa и вторая максимальная высота Hb второй транзисторной сборки Qb по существу равны, поскольку первая транзисторная сборка Qa имеет несколько первых биполярных транзисторов 20 и несколько вторых биполярных транзисторов 30 . Когда полупроводниковое устройство 100 установлено на внешней подложке с первым и вторым выступами 61 и 62 , обращенными к внешней подложке, следовательно, первый выступ 61 электрически соединен с внешней подложкой по крайней мере там, где он имеет первую максимальную высоту Ha.То есть первый выступ , 61, электрически соединен с внешней подложкой, по меньшей мере, там, где он перекрывает вторые биполярные транзисторы 30 . В результате первые биполярные транзисторы 20 , имеющие первую высоту HEa, электрически связаны с внешней подложкой через первый выступ 61 . Таким образом, полупроводниковое устройство , 100, может быть установлено на внешней подложке с менее частым возникновением плохого электрического соединения, чем с первым транзисторным узлом Qa, состоящим только из нескольких первых биполярных транзисторов 20 , имеющих первую высоту HEa.
Как показано на фиг. 5, в первом транзисторном узле Qa каждая база (базовые электроды 16 ) первых биполярных транзисторов 20 подключена к общей первой базовой проводке 54 a через емкость 86 . Первая базовая проводка 54 a подключена к базовой высокочастотной входной клемме 81 a. Емкости , 86, — это конденсаторы для блокировки составляющей постоянного тока.Каждая база (базовые электроды 16 ) первых биполярных транзисторов 20 также подключена к общей первой проводке смещения базы 55 a через базовый балластный резистор 87 . Первая проводка смещения базы 55 a подключена к клемме смещения базы 82 a. Каждая база вторых биполярных транзисторов 30 изолирована от первой базовой проводки 54 a и первой базы смещения 55 a.
Каждый эмиттер (эмиттерный электрод 17 ) первых биполярных транзисторов 20 и каждый эмиттер (эмиттерный электрод 17 ) вторых биполярных транзисторов 30 подключены к общей проводке первого эмиттера 53 и заземлен.
Каждый коллектор (коллекторные электроды 15 ) первых биполярных транзисторов 20 подключен к общей проводке первого коллектора 51 c. Первая проводка коллектора 51 c подключена к клемме высокочастотного выхода коллектора 83 a и клемме смещения коллектора 84 a. Каждый коллектор (коллекторные электроды 15 ) вторых биполярных транзисторов 30 изолирован от первой коллекторной проводки 51 c.
В такой конфигурации несколько первых биполярных транзисторов 20 усиливают высокочастотный сигнал, входящий с базовой высокочастотной входной клеммы 81 a , и выводят усиленный сигнал на высокочастотную выходную клемму коллектора. 83 а. Вторые биполярные транзисторы 30 , изолированные от базовой высокочастотной входной клеммы 81 a и коллекторной высокочастотной выходной клеммы 83 a, , не работают как транзисторы. Фактически, вторые биполярные транзисторы 30 должны иметь только по крайней мере одну из их базы и коллектора, изолированную от первой базовой проводки 54 a или первой коллекторной проводки 51 c. В силу того, что вторые биполярные транзисторы 30 не работают, они не нагреваются.Поскольку вторые биполярные транзисторы , 30, не выделяют тепла, они используются как промежутки, и поэтому ожидается, что они будут иметь эффект рассеивания локализованного тепла. Локализация тепла означает, что разница в тепле δ между транзисторами в середине и на концах мала. В качестве альтернативы ожидается, что вторые биполярные транзисторы , 30, будут иметь эффект уменьшения теплового сопротивления первого транзисторного узла Qa в силу того, что они не работают.
Как показано на фиг.6, во втором транзисторном узле Qb каждая база (базовые электроды 16 ) третьих биполярных транзисторов 40 подключена к общей второй базовой проводке 54 b. Вторая базовая проводка 54 b подключена к базовой высокочастотной входной клемме 81 b через емкость 85 . Емкость , 85, — это конденсатор для блокировки составляющей постоянного тока. Каждая база (базовые электроды 16 ) третьих биполярных транзисторов 40 также подключена к общей проводке смещения второй базы 55 b. Вторая базовая проводка 55 b подключена к клемме смещения базы 82 b.
Каждый эмиттер (эмиттерный электрод 17 ) третьих биполярных транзисторов 40 подключен к общей проводке второго эмиттера 53 b и заземлен. Каждый коллектор (коллекторные электроды 15 ) третьих биполярных транзисторов 40 подключен к общей проводке второго коллектора 51 d. Вторая проводка коллектора 51 d подключена к клемме высокочастотного выхода коллектора 83 b и клемме смещения коллектора 84 b.
В такой конфигурации несколько третьих биполярных транзисторов 40 усиливают высокочастотный сигнал, входящий с базовой высокочастотной входной клеммы 81 b , и выводят усиленный сигнал на высокочастотную выходную клемму коллектора. 83 б.
В силу общей структуры, изложенной выше, полупроводниковое устройство 100 имеет на одной полупроводниковой подложке 1 несколько первых биполярных транзисторов 20 , не имеющих балластного резистора эмиттера 88 на их эмиттерном слое 5 и несколько третьих биполярных транзисторов 40 , имеющих эмиттерный балластный резистор 88 на их эмиттерном слое 5 . Полупроводниковое устройство , 100, работает с уменьшенным пробоем транзисторов и поддерживает их характеристики усиления за счет переключения транзисторов на работу (между первой и второй сборками транзисторов Qa и Qb) в зависимости от напряжения коллектора.В частности, полупроводниковое устройство , 100, может работать с первыми биполярными транзисторами 20 , не имеющими эмиттерного балластного резистора 88 , когда напряжение коллектора относительно низкое (например, около 6 В или меньше), или работать с третьими биполярными транзисторами. 40 , имеющий эмиттерный балластный резистор 88 , когда напряжение коллектора относительно высокое (например, около 6 В или более). В результате полупроводниковое устройство , 100, достигает высокой эффективности добавленной мощности независимо от того, является ли выходная мощность низкой или высокой, а также более надежным, чем в предшествующем уровне техники.
Кроме того, размещение эмиттерных балластных резисторов 88 на той же полупроводниковой подложке 1 , что и третьи биполярные транзисторы 40 , снижает, по сравнению с размещением эмиттерных балластных резисторов вне полупроводникового устройства 100 , возникновение дефектов из-за к изменениям между несколькими третьими биполярными транзисторами 40 , таким как частичный тепловой разгон. В частности, во втором транзисторном узле Qb величина протекающего тока непостоянна через третьи биполярные транзисторы 40 и может концентрироваться на некоторых третьих биполярных транзисторах 40 .В таком случае размещение эмиттерных балластных резисторов вне полупроводникового устройства , 100, только уменьшает общий поток тока через вторую транзисторную сборку Qb и неэффективно для уменьшения величины тока, протекающего через определенные третьи биполярные транзисторы , 40, . В этом варианте осуществления, напротив, такие локальные высокие токи на некоторых третьих биполярных транзисторах 40 эффективно предотвращаются благодаря тому, что каждый третий биполярный транзистор 40 имеет эмиттерный балластный резистор 88 внутри полупроводникового устройства 100 .
Производство полупроводникового прибора
РИС. 7 представлены схемы для описания способа изготовления полупроводникового устройства согласно варианту осуществления 1. Как проиллюстрировано на фиг. 7, несколько первых биполярных транзисторов 20 , несколько вторых биполярных транзисторов 30 и несколько третьих биполярных транзисторов 40 сформированы на первой первичной поверхности 51 полупроводниковой подложки 1 (этап ST 1 ) .
Публикация нерассмотренной заявки на патент Японии №2017-220584 включает подробный метод производства, в котором первые биполярные транзисторы 20 , не имеющие балластного резистора эмиттера 88 , и второй и третий биполярные транзисторы 30 и 40 , имеющие балластный резистор эмиттера 88 , сформированы на том же самом полупроводниковая подложка 1 . Таким образом, этот вариант осуществления включает соответствующее описание в публикации нерассмотренной заявки на патент Японии № 2017-220584 вместо описания конкретного процесса формирования.
Пассивирующая пленка 59 формируется для растягивания по первому и второму узлам транзисторов Qa и Qb, а отверстия 59 a создаются фотолитографией и травлением. Проводка первого эмиттера 53 a и проводка второго эмиттера 53 b открыты через отверстия 59 a.
Затем формируют нижний металлический слой 56 и резист 71 (этап ST 2 ).Нижний металлический слой 56 формируется, например, напылением. Нижний металлический слой 56 формируется на поверхности разводки первого эмиттера 53 a и разводки второго эмиттера 53 b для покрытия пассивирующей пленки 59 и отверстий 59 a. Резист 71 получают путем формирования слоя резиста по всему нижнему металлическому слою 56 и последующего экспонирования и проявления с использованием фотошаблона.В результате резист 71 создается в области, где он перекрывает пассивирующую пленку 59 , а отверстия 71 a создаются в областях, где они перекрывают проводку первого эмиттера 53 a и проводка второго эмиттера 53 b.
Затем первый и второй выступы 61 и 62 формируются путем гальваники (этап ST 3 ). Первый выступ 61 сформирован над проводкой первого эмиттера 53 a для растягивания по множеству первых и множеству вторых биполярных транзисторов 20 и 30 .Второй выступ 62 сформирован над разводкой второго эмиттера 53 b для растягивания по множеству третьих биполярных транзисторов 40 . Поскольку первый и второй выступы 61 и 62 формируются на одном этапе, высота первого выступа 61 и второго выступа 62 по существу равны. Высота первого выступа 61 — это расстояние в направлении Z от поверхности разводки первого эмиттера 53 a до поверхности первого выступа 61 .Высота второго выступа 62 — это расстояние в направлении Z от поверхности разводки второго эмиттера 53 b до поверхности второго выступа 62 .
Участок первого выступа 61 , сформированный над первыми биполярными транзисторами 20 , по существу равен по высоте участку первого выступа 61 , сформированного над вторыми биполярными транзисторами 30 . Аналогично, часть первого выступа 61 , сформированного над вторыми биполярными транзисторами 30 , по существу равна по высоте части второго выступа 62 , сформированного над третьими биполярными транзисторами 40 .
Затем резист 71 удаляется травлением, а часть нижнего металлического слоя 56 , не покрытая первым или вторым выступом 61 или 62 , удаляется травлением (этап ST 4 ). Посредством такого процесса полупроводниковое устройство , 100, формируется с первой максимальной высотой Ha первой транзисторной сборки Qa, по существу равной второй максимальной высоте Hb второй транзисторной сборки Qb. Следует понимать, что способ производства, показанный на фиг.7 является просто примером и не единственным способом изготовления полупроводникового устройства 100 .
Вариант 1 варианта осуществления 1
Фиг. 8 — вид сверху полупроводникового устройства согласно варианту 1 варианта осуществления 1. Фиг. 9 — разрез по линии IX-IX ‘на фиг. 8. Фиг. 10 — эквивалентная принципиальная схема первого транзисторного узла Qa согласно варианту 1 варианта осуществления 1. В варианте 1 варианта осуществления 1 последовательность первого транзисторного узла Qa отличается от таковой в варианте осуществления 1.
Как показано на фиг. 8 и 9, первая транзисторная сборка Qa полупроводникового устройства 100 A имеет шесть первых биполярных транзисторов 20 и два вторых биполярных транзистора 30 . Шесть первых биполярных транзисторов 20 находятся между двумя вторыми биполярными транзисторами 30 в направлении X. Один из двух вторых биполярных транзисторов 30 находится дальше, чем первые биполярные транзисторы 20 от второго транзисторного узла Qb.Другой второй биполярный транзистор 30 расположен ближе, чем первые биполярные транзисторы 20 ко второму транзисторному узлу Qb.
Кроме того, как показано на фиг. 10, несколько первых биполярных транзисторов 20 функционируют как транзисторы, будучи подключенными к первой базовой разводке 54 a, первой базовой разводке смещения 55 a, первой эмиттерной разводке 53 a, и первой коллекторная проводка 51 c. Каждая из баз вторых биполярных транзисторов 30 изолирована от первой базовой проводки 54 a и первой базы смещения 55 a . Каждый коллектор вторых биполярных транзисторов 30 изолирован от первой коллекторной проводки 51 c. В результате вторые биполярные транзисторы 30 не работают как транзисторы.
В этом варианте полупроводниковое устройство 100 A может быть выполнено с первым транзисторным узлом Qa меньшего размера, чем в Варианте 1 осуществления, потому что оно использует меньше вторых биполярных транзисторов 30 .
Вариант 2 варианта осуществления 1
Фиг. 11 — вид сверху полупроводникового устройства согласно варианту 2 варианта осуществления 1. В варианте 2 варианта осуществления 1, в отличие от варианта осуществления 1, полупроводниковое устройство 100 B имеет один второй биполярный транзистор 30 .
Как показано на фиг. 11, второй биполярный транзистор 30 находится дальше, чем несколько первых биполярных транзисторов 20 от второго транзисторного узла Qb в направлении X.Другими словами, несколько первых биполярных транзисторов 20 находятся между вторым биполярным транзистором 30 и третьими биполярными транзисторами 40 . Как видно из этого, первый транзисторный узел Qa не ограничен структурами, имеющими несколько вторых биполярных транзисторов 30 , и должен иметь только по меньшей мере один второй биполярный транзистор 30 . В этом варианте, хотя и с одним вторым биполярным транзистором 30 , первая максимальная высота Ha полупроводникового устройства 100 B остается по существу равной второй максимальной высоте Hb.
Вариант 3 варианта осуществления 1
Фиг. 12 — вид сверху полупроводникового устройства согласно варианту 3 варианта осуществления 1. В варианте 3 варианта осуществления 1 положение одного второго биполярного транзистора 30 отличается от положения в варианте 2 варианта осуществления 1.
Как проиллюстрировано на фиг. 12, полупроводниковое устройство , 100, C имеет один второй биполярный транзистор 30 в средней части в направлении X первого транзисторного узла Qa.Второй биполярный транзистор 30 находится между несколькими первыми биполярными транзисторами 20 и несколькими первыми биполярными транзисторами 20 . Между вторым биполярным транзистором 30 и вторым транзисторным узлом Qb находятся три первых биполярных транзистора 20 . Есть три первых биполярных транзистора 20 , расположенных дальше, чем второй биполярный транзистор 30 от второго транзисторного узла Qb.
Количество первых биполярных транзисторов 20 может быть различным на одной стороне и другой стороне второго биполярного транзистора 30 .Предпочтительно, чтобы количество первых биполярных транзисторов 20 между вторым биполярным транзистором 30 и вторым транзисторным узлом Qb было больше, чем количество первых биполярных транзисторов 20 , расположенных дальше, чем второй биполярный транзистор 30 от второй транзисторный узел Qb. Это позволяет стабильно монтировать полупроводниковое устройство , 100, C на внешней подложке за счет увеличенного расстояния между вторым биполярным транзистором 30 , имеющим первую максимальную высоту Ha, в первом транзисторном узле Qa и втором транзисторном узле. Qb.
Вариант 4 варианта осуществления 1
Фиг. 13 — вид сверху полупроводникового устройства согласно варианту 4 варианта осуществления 1. В варианте 4 варианта осуществления 1, в отличие от варианта осуществления 1, первая и вторая сборки Qa и Qb транзисторов каждая имеет несколько рядов транзисторов.
Как показано на фиг. 13 первая транзисторная сборка Qa имеет первую строку Qas транзисторов и вторую строку Qat транзисторов. Первый и второй ряды транзисторов Qas и Qat расположены рядом друг с другом в направлении Y.Каждая из первых и вторых рядов транзисторов Qas и Qat имеет несколько первых и несколько вторых биполярных транзисторов 20 и 30 , выстроенных в линию в направлении X. Каждый из первого и второго рядов транзисторов Qas и Qat имеет три первых биполярных транзистора 20 между двумя вторыми биполярными транзисторами 30 .
Первые биполярные транзисторы 20 в первой и второй рядах транзисторов Qas и Qat объединены в первую транзисторную сборку Qa посредством электрического соединения с общей проводкой первого эмиттера 53 a, первой базовой проводкой Ma, первой базой проводка смещения 55 a, и проводка первого коллектора 51 c (см. РИС.5). Вторые биполярные транзисторы 30 в первой и второй рядах транзисторов Qas и Qat имеют по крайней мере одну из их базы и коллектора, изолированные от первой базовой проводки 54 a, первой базы смещения 55 a, и проводка первого коллектора 51 c.
Второй транзисторный узел Qb имеет первую строку транзисторов Qbs и вторую строку транзисторов Qbt. Ряды Qbs и Qbt первого и второго транзисторов расположены рядом друг с другом в направлении Y.Первая строка Qbs транзисторов второй сборки Qb транзисторов находится рядом с первой строкой Qas транзисторов первой сборки Qa транзисторов в направлении X. Вторая строка Qbt транзисторов второй сборки Qb транзисторов находится рядом со второй строкой Qat транзисторов первой сборки Qa транзисторов в направлении X. Каждая строка Qbs и Qbt первого и второго транзисторов имеет несколько третьих биполярных транзисторов 40 , выстроенных в линию в направлении X.
В этом варианте полупроводниковое устройство , 100, D может быть выполнено с первым и вторым транзисторными узлами Qa и Qb более короткими в направлении X, чем в Варианте 1 осуществления, даже если оно включает столько же или больше транзисторов, чем в Варианте 1 осуществления.В результате полупроводниковое устройство , 100, D может быть выполнено с полупроводниковой подложкой 1 , более короткой в направлении X, чем в Варианте 1 осуществления.
Вариант 5 Варианта осуществления 1
Фиг. 14 — вид сверху полупроводникового устройства согласно варианту 5 варианта осуществления 1. В варианте 5 варианта осуществления 1, в отличие от варианта 4 варианта осуществления 1, первый и второй ряды транзисторов Qas и Qat первого транзисторного узла Qa каждый имеют по одному второй биполярный транзистор 30 .
Как показано на фиг. 14, первая строка транзисторов Qas полупроводникового устройства , 100, E имеет несколько первых биполярных транзисторов 20 и один второй биполярный транзистор 30 . Второй биполярный транзистор 30 находится дальше, чем несколько первых биполярных транзисторов 20 , от первого ряда Qbs транзисторов второго узла Qb транзисторов в направлении X. Другими словами, несколько первых биполярных транзисторов , 20, находятся между одним вторым биполярным транзистором 30 и первой строкой Qbs транзисторов второго узла Qb транзисторов в направлении X.Вторая строка транзистора Qat имеет ту же последовательность, что и первая строка транзистора Qas. То есть в первой и второй рядах транзисторов Qas и Qat несколько первых биполярных транзисторов 20 расположены рядом друг с другом в направлении Y, а несколько вторых биполярных транзисторов 30 расположены рядом друг с другом в направлении Y.
Вариант 6 варианта осуществления 1
Фиг. 15 — вид сверху полупроводникового устройства согласно варианту 6 варианта осуществления 1. В варианте 6 варианта осуществления 1, в отличие от варианта 5 варианта осуществления 1, первые и вторые ряды Qas и Qat транзисторов первой сборки Qa транзисторов имеют разные последовательности.
Как показано на фиг. 15 первая строка транзисторов Qas полупроводникового устройства , 100, F имеет такую же структуру, что и на фиг. 14. Во второй строке Qat транзисторов один второй биполярный транзистор 30 находится ближе, чем несколько первых биполярных транзисторов 20 , ко второй строке Qbt транзисторов второго узла Qb транзисторов в направлении X. Другими словами, есть один второй биполярный транзистор 30 между второй строкой Qbt транзисторов второго транзисторного узла Qb и множеством первых биполярных транзисторов 20 в направлении X.Вторые биполярные транзисторы 30 в первой строке транзисторов Qas находятся рядом с первым биполярным транзистором 20 во второй строке Qat транзисторов в направлении Y. Второй биполярный транзистор 30 во второй строке Qat транзисторов находится рядом с первым биполярным транзистором 20 в первой строке Qas транзисторов в направлении Y.
Как указано выше, полупроводниковые устройства 100 и 100 A — 100 F согласно этому варианту осуществления имеют полупроводниковую подложку 1 , несколько первых биполярных транзисторов 20 , по крайней мере, один второй биполярный транзистор 30 и первый выступ 61 .Первые биполярные транзисторы 20 находятся на первой первичной поверхности S 1 стороне полупроводниковой подложки 1 и имеют первую высоту HEa между эмиттерным слоем 5 и эмиттерным электродом 17 в направлении, перпендикулярном к первая первичная поверхность S 1 . Второй биполярный транзистор 30 находится на стороне первой первичной поверхности S 1 полупроводниковой подложки 1 и имеет вторую высоту HEb, большую, чем первая высота HEa, между эмиттерным слоем 5 и эмиттерным электродом. 17 в направлении, перпендикулярном первой первичной поверхности S 1 .Первый выступ 61 проходит через несколько первых биполярных транзисторов 20 и по меньшей мере один второй биполярный транзистор 30 .
Когда полупроводниковое устройство 100 и 100 A — 100 F установлено на внешней подложке с первым выступом 61 , обращенным к внешней подложке, первый выступ 61 электрически соединен с внешней подложкой по крайней мере, там, где он перекрывает второй биполярный транзистор 30 .В результате первые биполярные транзисторы 20 , имеющие первую высоту HEa, электрически связаны с внешней подложкой через первый выступ 61 . Таким образом, полупроводниковые устройства с 100 и 100 A по 100 F могут быть установлены на внешней подложке с уменьшенным возникновением плохого электрического соединения.
Кроме того, полупроводниковые устройства с 100 и 100 A по 100 F согласно этому варианту осуществления имеют третьи биполярные транзисторы 40 и вторую выпуклость 62 .Третьи биполярные транзисторы 40 находятся на первой первичной поверхности S 1 стороне полупроводниковой подложки 1 и имеют вышеупомянутую вторую высоту HEb между эмиттерным слоем 5 и эмиттерным электродом 17 в направлении, перпендикулярном к первой первичной поверхности S 1 . Второй выступ 62 проходит через несколько третьих биполярных транзисторов 40 .
Третий биполярный транзистор 40 имеет практически такую же максимальную высоту, что и второй биполярный транзистор 30 .Полупроводниковое устройство с 100 и 100 A до 100 F может быть установлено на внешней подложке с менее частым возникновением плохого электрического соединения, чем с первым транзисторным блоком Qa, состоящим только из нескольких первых биполярных транзисторов 20 , имеющих первая высота HEa.
Для полупроводниковых устройств 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, первые биполярные транзисторы 20 находятся между вторым биполярным транзистором 30 и третьими биполярными транзисторами 40 в направлении, параллельном первой первичной поверхности S 1 полупроводниковой подложки 1 (направление X).Это позволяет стабильно устанавливать полупроводниковое устройство 100 и 100 A — 100 F на внешней подложке благодаря увеличенному расстоянию между вторым биполярным транзистором 30 , имеющим первую максимальную высоту Ha, в первый транзисторный узел Qa и третий биполярный транзистор 40 во втором транзисторном узле Qb.
Для полупроводниковых устройств с 100 и 100 A до 100 F в соответствии с этим вариантом осуществления, кроме того, первый, второй и третий биполярные транзисторы 20 , 30 и 40 являются биполярными с гетеропереходом. транзисторы.Это делает транзисторы в первой и второй транзисторных сборках Qa и Qb превосходными по эффективности добавленной мощности и линейности в качестве элементов усилителя.
Для полупроводниковых устройств с 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, первый и второй выступы 61 и 62 являются выступами опор. Когда полупроводниковое устройство , 100, монтируется на внешней подложке с помощью перевернутого кристалла, это обеспечивает хорошее соединение между контактными площадками на внешней подложке и выступами стойки.
Для полупроводниковых устройств 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, третьи биполярные транзисторы 40 имеют слой резистора (эмиттерный балластный резистор 88 ) между слоем эмиттера 5 и эмиттерный электрод 17 . Это означает, что первая транзисторная сборка Qa образована первыми биполярными транзисторами 20 , не имеющими слоя резистора, а вторая транзисторная сборка Qb образована третьими биполярными транзисторами 40 , имеющими резисторный слой.Благодаря своей способности переключать транзисторы для работы между первым и вторым транзисторными узлами Qa и Qb, в зависимости от напряжения коллектора, полупроводниковое устройство 100 и 100 A до 100 F поддерживает высокую мощность — повышенная эффективность вне зависимости от того, высокая или низкая выходная мощность.
Для полупроводниковых устройств 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, второй биполярный транзистор 30 имеет слой резистора (эмиттерный балластный резистор 88 ) между слоем эмиттера 5 и эмиттерный электрод 17 .Это позволяет первой максимальной высоте Ha первой транзисторной сборки Qa быть по существу равной второй максимальной высоте Hb второй транзисторной сборки Qb.
Для полупроводниковых приборов 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, слой резистора (эмиттерный балластный резистор 88 ) второго и третьего биполярных транзисторов 30 и 40 — это в первую очередь AlGaAs. Это позволяет сформировать резистивный слой третьих биполярных транзисторов 40 с желаемым значением сопротивления.Кроме того, второй и третий биполярные транзисторы 30 и 40 могут быть сформированы с по существу равной второй высотой HEb, поскольку резисторный слой второго биполярного транзистора 30 и третьего биполярного транзистора 40 может быть сформирован в тот же шаг.
Для полупроводниковых устройств с 100 и 100 A до 100 F в соответствии с этим вариантом осуществления, кроме того, базовые электроды 16 нескольких первых биполярных транзисторов 20 электрически соединены с общей первой базовой проводкой. 54 а. Коллекторные электроды 15 нескольких первых биполярных транзисторов 20 каждый электрически соединены с общей проводкой первого коллектора 51 c. Базовые электроды 16 и / или коллекторные электроды 15 второго биполярного транзистора 30 изолированы от первой базовой проводки 54 a и первой коллекторной проводки 51 c. Это приводит к тому, что в первом транзисторном узле Qa несколько первых биполярных транзисторов 20 функционируют как транзисторы, а второй биполярный транзистор 30 — нет.
Для полупроводниковых устройств 100 и 100 A до 100 F согласно этому варианту осуществления, кроме того, эмиттерный электрод 17 нескольких первых биполярных транзисторов 20 и второй биполярный транзистор 30 электрически соединены с общей проводкой первого эмиттера 53 a. Эмиттерный электрод 17 множества третьих биполярных транзисторов 40 электрически соединен с общей проводкой второго эмиттера 53 b. Первый выступ 61 проходит над проводкой первого эмиттера 53 a вдоль проводки первого эмиттера 53 a. Второй выступ 62 проходит над проводкой второго эмиттера 53 b вдоль проводки второго эмиттера 53 b.
Это дает первый выступ 61 неровностей, соответствующий первой высоте HEa первых биполярных транзисторов 20 и второй высоте HEb второго биполярного транзистора 30 .Часть первого выступа 61 , под которым находится второй биполярный транзистор 30 , определяет первую максимальную высоту Ha. В результате первая максимальная высота Ha первой транзисторной сборки Qa и вторая максимальная высота Hb второй транзисторной сборки Qb по существу равны.
РИС. 16 — вид сверху полупроводникового устройства согласно варианту 2 осуществления. Фиг. 17 представляет собой поперечное сечение по линии XVII-XVII ‘на фиг. 16. Фиг. 18 — эквивалентная принципиальная схема полупроводникового устройства согласно варианту 2 осуществления.В варианте осуществления 2, в отличие от варианта осуществления 1, имеется один выступ 63 над первым и вторым транзисторными узлами Qa и Qb.
Как показано на фиг. 16, несколько первых биполярных транзисторов 20 и несколько вторых биполярных транзисторов 30 чередуются в направлении X, направлении, параллельном первой первичной поверхности S 1 полупроводниковой подложки 1 . Первый транзисторный узел Qa имеет несколько первых биполярных транзисторов 20 .Второй транзисторный узел Qb имеет несколько вторых биполярных транзисторов 30 .
Как показано на фиг. 17, эмиттерная разводка 53 , нижний металлический слой 56 и выступ 63 проходят через несколько первых и несколько вторых биполярных транзисторов 20 и 30 . Эмиттерная проводка 53 электрически соединена с эмиттерным электродом 17 множества первых биполярных транзисторов 20 и множества вторых биполярных транзисторов 30 .Нижний металлический слой 56 находится на разводке эмиттера 53 . Выступ 63 находится на нижнем металлическом слое 56 . Выступ 63 проходит над проводкой эмиттера 53 вдоль проводки эмиттера 53 .
Между первым биполярным транзистором 20 и вторым биполярным транзистором 30 расположены области изоляции 50 . Каждый из первого и второго биполярных транзисторов 20 и 30 имеет свои собственные коллекторные электроды 15 .То есть коллекторные электроды 15 не используются совместно первым биполярным транзистором 20 и вторым биполярным транзистором 30 .
Как показано на фиг. 18, каждый эмиттер (эмиттерный электрод 17 ) первых биполярных транзисторов 20 и каждый эмиттер (эмиттерный электрод 17 ) вторых биполярных транзисторов 30 подключены к общей эмиттерной проводке 53 и заземлены.
В первом транзисторном узле Qa каждая база (базовые электроды 16 ) нескольких первых биполярных транзисторов 20 подключена к общей первой базовой проводке 54 a через емкость 86 .Кроме того, каждая база (базовые электроды 16 ) первых биполярных транзисторов 20 подключена к общей первой проводке смещения базы 55 a через базовый балластный резистор 87 . Каждый коллектор (коллекторные электроды 15 ) первых биполярных транзисторов 20 подключен к общей проводке первого коллектора 51 c.
Во втором транзисторном узле Qb каждая база (базовые электроды 16 ) множества вторых биполярных транзисторов 30 подключена к общей второй базовой проводке 54 b. Вторая базовая проводка 54 b подключена к базовой высокочастотной входной клемме 81 b через емкость 85 . Каждая база (базовые электроды 16 ) вторых биполярных транзисторов 30 также подключена к общей проводке смещения второй базы 55 b. Каждый коллектор (коллекторные электроды 15 ) вторых биполярных транзисторов 30 подключен к общей проводке второго коллектора 51 d.
В такой конфигурации несколько первых биполярных транзисторов 20 , образующих первую транзисторную сборку Qa, усиливают высокочастотный сигнал, входящий с базовой высокочастотной входной клеммы 81 a , и выводят усиленный сигнал на клемма высокочастотного выхода коллектора 83 a. Вторые биполярные транзисторы 30 , образующие вторую транзисторную сборку Qb, усиливают высокочастотный сигнал, входящий с базовой высокочастотной входной клеммы 81 b , и выводят усиленный сигнал на высокочастотную выходную клемму коллектора. 83 б.
Как изложено выше, полупроводниковое устройство 100 G согласно этому варианту осуществления имеет чередующиеся несколько первых биполярных транзисторов 20 , образующих первый транзисторный узел Qa, и несколько вторых биполярных транзисторов 30 , образующих второй транзисторный узел. Qb. Общий выступ 63 простирается на несколько первых и несколько вторых биполярных транзисторов 20 и 30 .
Полупроводниковое устройство 100 G согласно этому варианту осуществления имеет самую высокую поверхность выступа 63 над первым транзисторным узлом Qa и над вторым транзисторным узлом Qb на разных высотах от второй первичной поверхности S 2 .Даже в этом случае полупроводниковое устройство 100 G может быть установлено на внешней подложке с уменьшенным возникновением плохого электрического соединения, поскольку общий выступ 63 гарантирует электрическое соединение первого и второго транзисторных сборок Qa и Qb с внешней подложкой. через общий выступ 63 .
РИС. 19 — поперечное сечение полупроводникового устройства согласно варианту осуществления 3. В варианте осуществления 3, в отличие от вариантов осуществления 1 и 2, первый и второй выступы 61 и 62 покрыты слоями припоя 65 a и 65 b, соответственно.
Как показано на фиг. 19, имеется слой припоя 65 a на первом выступе 61 , растягивающийся на нескольких первых и нескольких вторых биполярных транзисторах 20 и 30 . На втором выступе 62 находится слой припоя 65 b , растягивающийся на нескольких третьих биполярных транзисторах 40 . Когда полупроводниковое устройство 100 H установлено на внешней подложке, слои припоя 65 a и 65 b входят в контакт с контактными площадками на внешней подложке.Затем первый и второй выступы 61 и 62 присоединяются к контактным площадкам с помощью слоев припоя 65 a и 65 b, , например, пайкой оплавлением.
Конфигурация в этом варианте осуществления также может применяться к полупроводниковым устройствам с 100 и 100 A до 100 G согласно вариантам осуществления 1 и 2.
Фиг. 20 — поперечный разрез модуля усилителя мощности согласно варианту 4 осуществления.ИНЖИР. 21 — блок-схема, иллюстрирующая структуру модуля усилителя мощности согласно варианту 4 осуществления. Модуль усилителя мощности 200 имеет подложку модуля 210 , полупроводниковое устройство 100 и слой смолы 240 .
Подложка модуля 210 имеет первую площадку 220 , сквозные переходные отверстия 211 , вторую площадку 212 , а также проводку и другие компоненты, сформированные между внутренними слоями подложки или через них.Первая площадка 220 представляет собой вывод для установки полупроводникового прибора 100 . Вторая площадка , 212, — это вывод, к которому приложен опорный потенциал. Первая и вторая контактные площадки 220 и 212 соединены между собой несколькими сквозными переходными отверстиями 211 .
Полупроводниковое устройство 100 монтируется на подложке модуля 210 путем монтажа на кристалле с откидной крышкой. Каждый первый и второй выступы 61 и 62 соединены с первой контактной площадкой 220 с припоем 230 между ними.В результате каждый биполярный транзистор в первом и втором узлах транзисторов Qa и Qb электрически соединен с подложкой модуля , 210, . Слой смолы 240 проходит на подложке модуля 210 , покрывая полупроводниковое устройство 100 .
Как показано на фиг. 21 модуль 200 усилителя мощности имеет первую сигнальную цепь Sc 1 и вторую сигнальную цепь Sc 2 .
Первая сигнальная цепочка Sc 1 представляет собой путь для прохождения первого высокочастотного сигнала и имеет первую входную клемму 91 a, a первую схему согласования входов 93 a, a первая схема усилителя начального каскада 96 a, первая схема межкаскадного согласования 94 a, схема усилителя первого выходного каскада 97 a, первая схема согласования выходного сигнала 95 a, и первый выходной терминал 92 a. Первая схема согласования входов 93 a представляет собой схему, которая обеспечивает согласование импеданса на входной стороне первой схемы усилителя начальной ступени 96 a. Первая схема межкаскадного согласования 94 a представляет собой схему, которая обеспечивает согласование импеданса между выходной стороной схемы усилителя первого каскада 96, a и входной стороной схемы усилителя первого выходного каскада 97 а. Первая схема согласования выходного каскада 95 a представляет собой схему, которая обеспечивает согласование импеданса на выходной стороне схемы усилителя первого выходного каскада 97 a. Первая входная, первая межкаскадная и первая выходные согласующие цепи 93 a, 94 a, и 95 a каждая образована, например, конденсатором и катушкой индуктивности. Каждая из схем 96 a и 97 a первого начального каскада и первого выходного каскада образована, например, первым транзисторным узлом Qa полупроводникового устройства 100 .Первый высокочастотный сигнал вводится с первой входной клеммы 91 a, усиливается через схемы согласования и усилителя и выводится с первой выходной клеммы 92 a.
Вторая сигнальная цепочка Sc 2 представляет собой путь для прохождения второго высокочастотного сигнала и имеет вторую входную клемму 91 b, вторую схему согласования входов 93 b, a вторая схема усилителя начального каскада 96 b, вторая схема межкаскадного согласования 94 b, схема усилителя второго выходного каскада 97 b, вторая схема согласования выходного сигнала 95 b, и второй выходной терминал 92 b. Согласующие схемы второго входа, второго межкаскадного и второго выходов 93 b, 94 b, и 95 b — это схемы, имеющие функцию, аналогичную функции первого входа, первого межкаскадного сигнала, и первые схемы согласования выходов 93 a, 94 a, и 95 a. Каждая из схем 96 b и 97 b второго начального каскада и второго выходного каскада схем усилителя образована, например, второй транзисторной сборкой Qb полупроводникового устройства 100 .Второй высокочастотный сигнал вводится из второго входного вывода 91 b, усиливается через схемы согласования и усилителя и выводится из второго выходного вывода 92 b.
Первая и вторая сигнальные цепи Sc 1 и Sc 2 не становятся электрически активными одновременно, а работают с разделением по времени. То есть, в то время как первая сигнальная цепочка Sc 1 электрически активна, вторая сигнальная цепочка Sc 2 электрически неактивна.В то время как вторая сигнальная цепочка Sc 2 электрически активна, первая сигнальная цепочка Sc 1 электрически неактивна. Это позволяет модулю 200 усилителя мощности поддерживать хороший КПД добавленной мощности за счет работы первой или второй сигнальной цепи Sc 1 или Sc 2 в зависимости от того, является ли выходная мощность низкой или высокой.
Хотя предпочтительные варианты осуществления раскрытия были описаны выше, следует понимать, что изменения и модификации будут очевидны специалистам в данной области без отклонения от объема и сущности раскрытия.Таким образом, объем раскрытия должен определяться исключительно следующей формулой изобретения.
Высокоскоростной биполярный NPN-транзистор с высоким коэффициентом усиления с защитой от насыщения и возможностью подавления переходных напряжений
% PDF-1.4 % 1 0 объект > эндобдж 5 0 obj > эндобдж 2 0 obj > эндобдж 3 0 obj > транслировать BroadVision, Inc.2020-10-29T16: 38: 34 + 08: 002013-08-08T11: 02: 56 + 02: 002020-10-29T16: 38: 34 + 08: 00application / pdf
Деталь продукта с неизолированными кристаллами: bc859 — Die Devices | Вафля | Игральные кости
Эти высоконадежные транзисторы подходят для сборки на толстых и тонкопленочных гибридных схемах с высоким механическим качеством и металлизацией золотого цвета.Выбирается из нескольких диапазонов усиления и предлагается в нескольких вариантах оценки наемника.
Характеристики:- Оптимизированный для низкого уровня шума
- Металлическая задняя крышка Hi-rel с золотым покрытием
- Непосредственно заменяет устаревшие транзисторы Zetex, Fairchild, Microsemi, Motorola и National Semiconductor.
- Подходит для использования в промышленной, медицинской, военной и аэрокосмической промышленности.
- Компактность для высокой интеграции и близкого размещения к источнику сигнала.
- Гарантированная долгосрочная поддержка без изменения маски штампа.
Семейства продуктов: , используемые для этого устройства, указаны в таблице ниже.
Спецификация: V (BR) CEO , V CES : -30V
I C (Макс) : -0.10A
ч FE1 (мин.) : 110
ч FE1 (макс.) : 800
ч FE1 @ I C : -2,0 мА
ч FE2 (мин.) : нет
ч FE2 @ I C : нет данных
V CE (насыщ.) 1 (макс.) : -0,300 В
V CE (насыщ.) 1 I C / I B : 0,01 / 0,5 А / мА
В CE (насыщ.) 2 (макс.) : -0,65 В
В CE (насыщ.) 2 I C / I B : 0,1 / 5A / мА
f T (тип. ) : 150 МГц
Другая деталь: Важная информация для этого устройства представлена в таблице ниже.
Настройка светофора для минимального количества заказа указывает на следующее:- Зеленый: доступно со склада или по низкой заводской MOQ.
- Янтарь: доступно по заводскому заказу с минимальным заказом.
- Красный: может применяться высокое заводское MOQ, пожалуйста, спрашивайте подробности.
- Зеленый: этот голый кристалл разработан и протестирован для использования в высоконадежных приложениях.
- Янтарный: этот голый кристалл может соответствовать более высоким требованиям надежности после дополнительных испытаний и квалификации, пожалуйста, спрашивайте подробности.
- Красный: этот голый кристалл не предназначен и специально не предназначен для использования в приложениях с высокой надежностью.
- Зеленый: этот голый кристалл подходит для космических приложений или имеет квалификационные данные на космическом уровне, пожалуйста, спрашивайте подробности.
- Янтарный: этот голый кристалл может быть использован для космических приложений с дополнительным тестированием и квалификацией, Пожалуйста спросите для подробностей.
- Красный: пригодность этого голого кристалла для космических приложений неизвестна и требует дополнительной квалификации. пожалуйста, спрашивайте подробности.

