Как создать полевой транзистор на основе алмаза с водородными связями и диэлектриком AlOx. Какие преимущества дает использование AlOx в качестве диэлектрика затвора. Каковы основные электрические характеристики такого транзистора. Как формируется слой AlOx методом самоокисления.
Особенности конструкции алмазного полевого транзистора с водородными связями
Алмазные полевые транзисторы с водородными связями (H-алмазные FET) представляют большой интерес для применения в высокочастотной и силовой электронике благодаря уникальным свойствам алмаза. Однако их разработка сопряжена с рядом технологических трудностей. Одна из ключевых проблем — выбор подходящего диэлектрика затвора.
В данном исследовании был успешно изготовлен H-алмазный полевой транзистор с диэлектрическим слоем AlOx, сформированным методом самоокисления алюминия на воздухе при комнатной температуре. Такой подход имеет ряд преимуществ:

- Простота формирования диэлектрика без использования сложных методов осаждения
- Низкая температура процесса, что позволяет сохранить водородные связи на поверхности алмаза
- Хорошие диэлектрические свойства оксида алюминия
Процесс изготовления транзистора с диэлектриком AlOx
Основные этапы изготовления H-алмазного FET с диэлектриком AlOx включали:
- Подготовку алмазной подложки и формирование водородных связей на поверхности
- Нанесение электродов истока и стока из золота
- Осаждение тонкого слоя алюминия (6 нм) методом электронно-лучевого испарения
- Окисление алюминия на воздухе при комнатной температуре в течение 48 часов
- Формирование алюминиевого затвора толщиной 100 нм
Для сравнения был также изготовлен транзистор без диэлектрического слоя AlOx. Это позволило оценить влияние диэлектрика на характеристики устройства.
Влияние диэлектрика AlOx на ток утечки затвора
Одной из важнейших характеристик полевого транзистора является ток утечки затвора. Проведенные измерения показали, что диэлектрический слой AlOx позволяет существенно снизить ток утечки:

- При напряжении затвор-исток -5 В плотность тока утечки в транзисторе с AlOx была в 40000 раз ниже, чем в транзисторе без диэлектрика
- Диэлектрик AlOx эффективно предотвращает обратный ток стока при малых напряжениях сток-исток
Таким образом, использование AlOx в качестве подзатворного диэлектрика позволяет значительно улучшить изолирующие свойства затвора H-алмазного полевого транзистора.
Выходные характеристики транзистора с диэлектриком AlOx
Анализ выходных характеристик показал, что транзистор с диэлектриком AlOx демонстрирует типичное поведение полевого транзистора с p-каналом:
- Четко выраженная область отсечки
- Уменьшение тока стока с уменьшением напряжения сток-исток
- Максимальный ток стока 300.9 мкА при напряжении затвор-исток -2.5 В и напряжении сток-исток -6.4 В
- Отношение токов во включенном и выключенном состояниях около 5.4 × 10^7
Важно отметить, что в транзисторе с AlOx не наблюдалось обратного тока стока при малых напряжениях, что указывает на эффективное подавление тока утечки затвора.
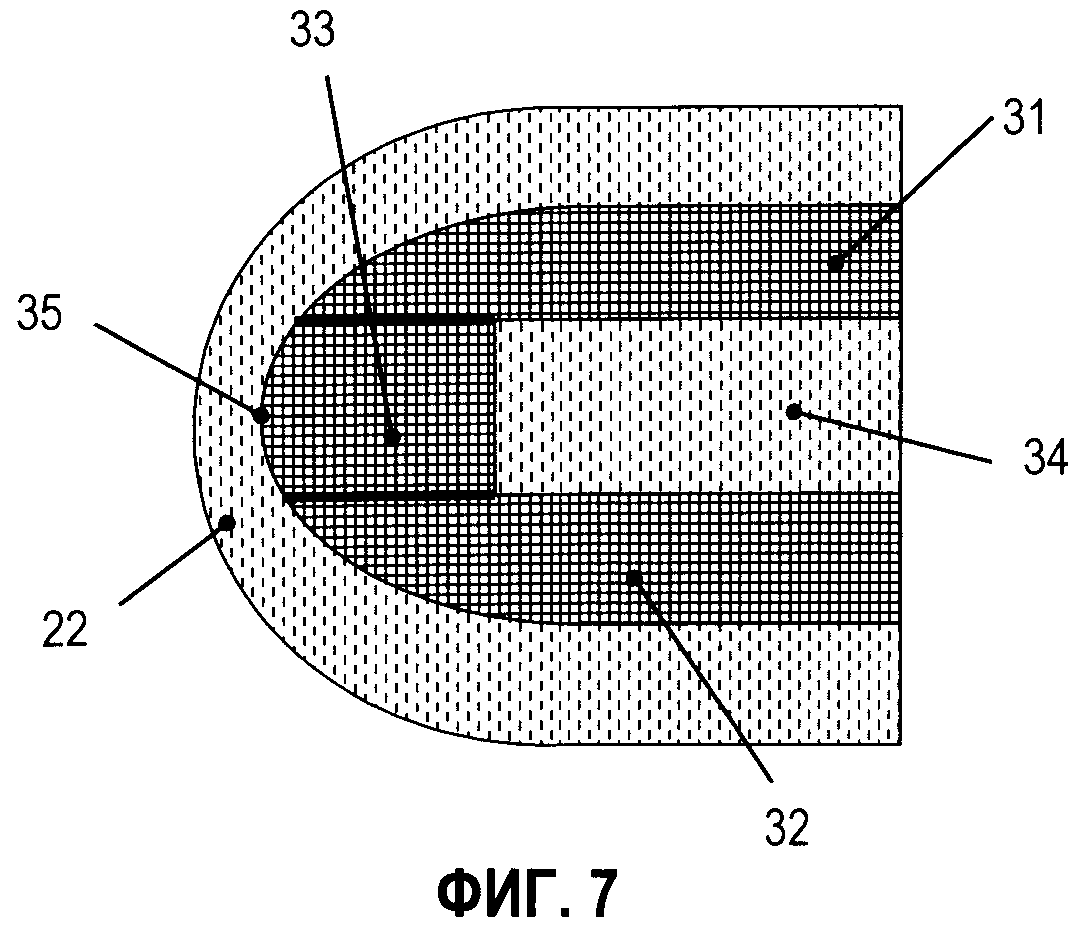
Пороговое напряжение и крутизна транзистора
Измерение передаточных характеристик позволило определить ключевые параметры транзистора:
- Пороговое напряжение составило -0.44 В при напряжении сток-исток -15 В
- Транзистор демонстрирует нормально-закрытый режим работы
Нормально-закрытый режим объясняется двумя факторами:
- Частичным удалением водородных связей с поверхности алмаза в процессе изготовления
- Обеднением носителями области канала под затвором из-за большой разницы работ выхода между алюминиевым затвором и H-алмазом
Преимущества самоокисленного AlOx по сравнению с термически окисленным Al2O3
В предыдущих работах для формирования диэлектрика использовалось термическое окисление тонкого слоя алюминия. Однако метод самоокисления при комнатной температуре имеет ряд преимуществ:
- Формирование сплошной пленки AlOx толщиной 6 нм вместо прерывистого слоя Al2O3 толщиной 3 нм
- Лучшая защита адсорбата и водородных связей на поверхности алмаза в процессе изготовления
- Отсутствие высокотемпературной обработки, способной повредить водородные связи
Это позволяет получить более качественный диэлектрический слой и сохранить свойства поверхности H-алмаза.
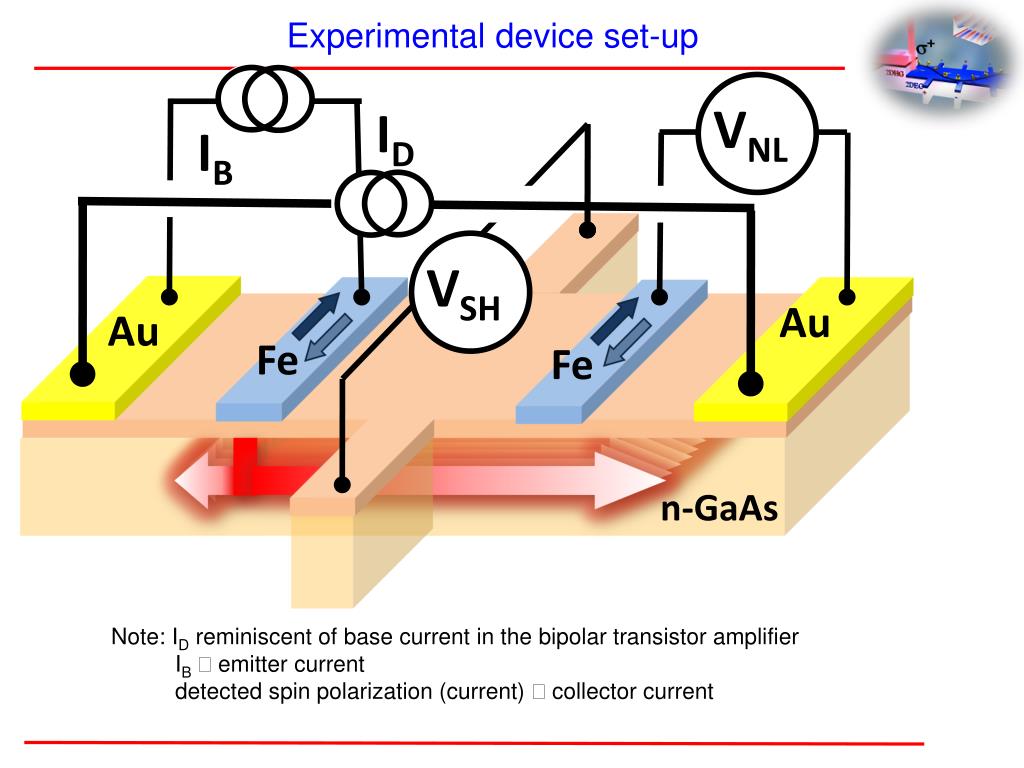
Основные результаты и перспективы применения
Проведенное исследование показало, что использование самоокисленного слоя AlOx в качестве подзатворного диэлектрика позволяет создать эффективный H-алмазный полевой транзистор с хорошими характеристиками:
- Низкий ток утечки затвора
- Высокое отношение токов во включенном и выключенном состояниях (5.4 × 10^7)
- Нормально-закрытый режим работы с пороговым напряжением -0.44 В
Такие транзисторы перспективны для применения в высокочастотной и силовой электронике, где требуются приборы с высокой термической и радиационной стойкостью. Дальнейшая оптимизация технологии позволит улучшить характеристики и расширить области применения H-алмазных полевых транзисторов.
Заключение и перспективы дальнейших исследований
Проведенное исследование продемонстрировало эффективность использования самоокисленного слоя AlOx в качестве подзатворного диэлектрика для H-алмазных полевых транзисторов. Этот подход позволяет получить приборы с хорошими электрическими характеристиками при относительно простой технологии изготовления.

Дальнейшие исследования в этом направлении могут включать:
- Оптимизацию толщины и условий формирования слоя AlOx
- Изучение долговременной стабильности характеристик транзисторов
- Исследование работы транзисторов при высоких температурах и в условиях радиации
- Создание интегральных схем на основе H-алмазных FET с диэлектриком AlOx
Развитие технологии H-алмазных полевых транзисторов открывает новые возможности для создания электронных устройств с уникальными характеристиками для экстремальных условий эксплуатации.
Один из электродов полевого транзистора, 5 букв, первая буква И — кроссворды и сканворды
исток
Слово «исток» состоит из 5 букв:
— первая буква И
— вторая буква С
— третья буква Т
— четвертая буква О
— пятая буква К
Посмотреть значние слова «исток» в словаре.
Альтернативные варианты определений к слову «исток», всего найдено — 48 вариантов:
- «Малая родина» реки
- «Точка отсчета» реки
- «Завязка» реки
- «Корень» реки
- Анаграмма к слову «кости»
- Анти-устье
- Верховье
- Верховье реки
- Верховье, место, где начинается водный источник
- Влад. лопаточка, для очистки при паханbи сошника
- Где начинает река свой путь?
- Где начинается река?
- Для дитя — роддом, а что для реки
- Другое названье родника, ключа
- Ключ от Волги
- Конец реки — устье, а начало
- Марка шампанского
- Место начала водного потока
- Место начала реки
- Мешанина из слова «стоик»
- Наивысшая точка речного потока
- Начало бурного потока
- Начало реки
- Начало, первоисточник чего-нибудь
- Начальн.
 пункт речной дистанц..
пункт речной дистанц.. - Начальная стадия реки
- Начальный пункт путешествия реки
- Предел плавания против течения
- Река в зародыше
- Река в своем начале
- Речная увертюра
- Речное начало
- Речной старт
- Родник по отношению к ручью
- Ручеек — реки …
- Ручей в начале дистанции
- Ручей на старте
- Ручей, начинающий реку
- Самое начало
- См. истекать
- Старт водотока
- Старт голубого потока
- Старт реки
- Старт ручья
- Там зарождается река
- Устье
- Устье наоборот
- Что можно сделать из слова «стоик» путем перестановки букв?
Другие вопросы:
- Японское боевое искусство
- Северный сосед штата Джорджия
- Этой монетой пытался расплатиться в трамвае Бегемот
- Принудительный крестьянский труд на Руси
- Цейлонский чай
- Скидка чистого веса товара которая прилипает к стенкам тары
- Народ Азии (множественное число)
- Представительница народа России
- Ученье по отношению к неученью
- Самый высокий в мире батолит
Только что искали: геофизика 1 секунда назад сьэямиул 1 секунда назад н а т п и л а 1 секунда назад г е р а н ь о 1 секунда назад пиооссь 1 секунда назад мясорубка 1 секунда назад д н о б е с т ь 1 секунда назад панибратство 1 секунда назад подкупр 1 секунда назад п е ч а л ь н 1 секунда назад д и а п а з о н 1 секунда назад кладкав 1 секунда назад л е й к а 1 секунда назад колпанаде 2 секунды назад повитуха 2 секунды назад
404 Cтраница не найдена
-
Сведения об образовательной организации
- Основные сведения
- Структура и органы управления образовательной организацией
- Документы
- Образование
- Образовательные стандарты
- Руководство. Педагогический (научно-педагогический состав)
- Материально-техническое обеспечение и оснащенность образовательного процесса
- Стипендии и иные виды материальной поддержки
- Платные образовательные услуги
- Финансово-хозяйственная деятельность
- Вакантные места для приёма (перевода)
- Энергосбережение и повышение энергетической эффективности
- Доступная среда
-
Наш техникум
- Теоретическое и производственное обучение
- Воспитательная работа
- Доступная среда
- Противодействие коррупции
- Приёмная комиссия
- Профессии
- Фото-экскурсия
- Видеогалерея
-
Студенту
- Полезные ссылки
- Расписание
- Библиотека
- ЕГЭ
- ГИА
- Центр содействия трудоустройству выпускников
- Учебно-методические материалы
- Контакты
-
WorldSkills Russia
- О нас
- Чемпионат
- Обращения граждан
- Новости
- Наши профессии
- Преподавателю
- Moodle
-
Организация питания в образовательной организации
- Меню (в том числе информация о наличии диетического меню в образовательной организации)
- Организация питания, документы и иная информация
- Обратная связь для родителей (законных представителей), обучающихся
- Международное сотрудничество
-
Наставничество
- Нормативные документы
- Формы наставничества
- Новости
- Наши наставники
Алмазный полевой транзистор с водородной клеммой и диэлектрическим слоем AlOx, сформированным автооксидированием
- Список журналов
- Научные отчеты
- PMC6435749
науч. респ. 2019; 9: 5192.
респ. 2019; 9: 5192.
Опубликовано онлайн 2019Mar 26. doi: 10.1038/s41598-019-41082-8
, 1 , 1 , 1 , 1 , 1 , 1 , 1 , 1 , 2 , 3 , 1 и 1
Информация об авторе Примечания к статье Информация об авторских правах и лицензии Отказ от ответственности х диэлектрический слой был успешно выполнен. AlO 9Слой размером 0045 x был сформирован путем автоокисления 6-нанометровой алюминиевой пленки на воздухе при комнатной температуре. Для сравнения также был изготовлен полевой транзистор без диэлектрического слоя AlO x . Для обоих полевых транзисторов в качестве электродов затвора были нанесены слои алюминия толщиной 100 нм соответственно. Плотность тока утечки в полевом транзисторе с диэлектрическим слоем AlO  и предотвратить реверс I D в I D − V DS вызван дефектами на поверхности алмаза. В измерении I D − V DS наблюдалась отчетливая отсечка с каналом p-типа. Пороговое напряжение составляло −0,4 В при V DS = −15 В.
и предотвратить реверс I D в I D − V DS вызван дефектами на поверхности алмаза. В измерении I D − V DS наблюдалась отчетливая отсечка с каналом p-типа. Пороговое напряжение составляло −0,4 В при V DS = −15 В.
Алмаз — привлекательный материал со многими превосходными свойствами, такими как хорошая биосовместимость, самая высокая теплопроводность (22 Вт/K·см), большая ширина запрещенной зоны ( 5,45 эВ), высокое теоретическое напряжение пробоя (>10 МВ·см −1 ), высокая подвижность носителей (электрон: 4500 см 2 V −1 S −1 , дырка: 3800 см 2 V −1 S) и т. д. потенциальное применение в области биологии, особенно в электронных устройствах, таких как полевые транзисторы на основе оксидов металлов (MOSFET) и полевые транзисторы на основе металлов и полупроводников (MESFET) 1 – 8 , которые могут работать на высокой частоте и высокой мощности , высокая температура. Однако из-за высоких энергий активации легирующих примесей (бора 380 мэВ и фосфора 570 мэВ) в алмазе на этой стадии плотности носителей при комнатной температуре (КТ) довольно низки, что приводит к плохой работе MOSFET и MESFET на основе алмаза 9.0015 8 . Чтобы решить эту проблему, некоторые группы пытаются использовать метод δ-легирования в алмазе. Однако эта техника была сложной и мобильности носителей не хватало 9 , 10 . К счастью, когда поверхность алмаза завершается С-Н связями с помощью обработки водородной плазмой, на его поверхности могут накапливаться двумерные дырочные газы (2DHG) с плотностью носителей слоя 10 13 см −2 11 , благодаря чему H-алмазный полевой транзистор может быть изготовлен.
Однако из-за высоких энергий активации легирующих примесей (бора 380 мэВ и фосфора 570 мэВ) в алмазе на этой стадии плотности носителей при комнатной температуре (КТ) довольно низки, что приводит к плохой работе MOSFET и MESFET на основе алмаза 9.0015 8 . Чтобы решить эту проблему, некоторые группы пытаются использовать метод δ-легирования в алмазе. Однако эта техника была сложной и мобильности носителей не хватало 9 , 10 . К счастью, когда поверхность алмаза завершается С-Н связями с помощью обработки водородной плазмой, на его поверхности могут накапливаться двумерные дырочные газы (2DHG) с плотностью носителей слоя 10 13 см −2 11 , благодаря чему H-алмазный полевой транзистор может быть изготовлен.
Up to now, many dielectric materials have been used in H-diamond FETs such as SiO 2 12 , ZrO 2 5 , Al 2 O 3 13 , AlN 14 , TiO x 4 , HfO 2 15 , LaAlO 3 16 and Ta 2 O 5 17 . Для изготовления диэлектрических слоев затвора в полевых МОП-транзисторах с водородным алмазом использовалось множество методов, таких как осаждение атомных слоев, химическое осаждение из паровой фазы металлоорганических соединений или методы магнетронного напыления. Однако эти методы дороги, сложны и могут повредить канальный слой 2DHG высокотемпературным или плазменным травлением, поскольку 2DHG H-алмаза термически и химически нестабильна 18 . Поэтому исследователи должны упростить нанесение оксида затвора и защитить слой канала 2DHG в процессе изготовления.
Для изготовления диэлектрических слоев затвора в полевых МОП-транзисторах с водородным алмазом использовалось множество методов, таких как осаждение атомных слоев, химическое осаждение из паровой фазы металлоорганических соединений или методы магнетронного напыления. Однако эти методы дороги, сложны и могут повредить канальный слой 2DHG высокотемпературным или плазменным травлением, поскольку 2DHG H-алмаза термически и химически нестабильна 18 . Поэтому исследователи должны упростить нанесение оксида затвора и защитить слой канала 2DHG в процессе изготовления.
В этой работе был успешно изготовлен H-алмазный полевой транзистор с диэлектрическим слоем AlO x , сформированным автоокислением на воздухе при КТ. Насколько известно авторам, сообщалось о нескольких исследованиях полевых транзисторов с H-алмазом с использованием самоокисленного диэлектрического слоя AlO x .
Два монокристаллических алмаза типа Ib (001) размером 3×3 × 0,5 мм 3 использовались в качестве подложек, определенных как образцы A и B. На рисунке показан процесс изготовления полевого транзистора H-алмаза с диэлектрическим слоем AlO x . (образец А) и полевой транзистор без AlO х диэлектрического слоя (образец Б) соответственно.
На рисунке показан процесс изготовления полевого транзистора H-алмаза с диэлектрическим слоем AlO x . (образец А) и полевой транзистор без AlO х диэлектрического слоя (образец Б) соответственно.
Открыть в отдельном окне
Процесс изготовления образца ( a ) A и ( b ) образца B соответственно.
Чтобы удалить неалмазную фазу с поверхности алмаза, образцы A и B были очищены смешанной кислотой, а затем обработаны смешанной щелочью, как в нашей предыдущей работе 6 , показанной на рис. После этого микроволновая плазменная CVD-система (AX5200 Seki Technotron Corp.) использовалась для выращивания монокристалла H-алмаза размером 200 нм на образцах A и B, показанных на рис. Условия роста были показаны в нашем предыдущем отчете 7 . Затем на образце А и В с помощью методов фотолитографии и электронно-лучевого испарения (ЭЛ) были изготовлены электроды истока и стока Au, как показано на рис. Толщина и расстояние между электродами (L SD ) составляли 100 нм и 20 мкм соответственно. После этого на каналы между электродами истока и стока методом фотолитографии нанесли негативный фоторезист. После этого на образцах А и В применяли УФ/озон для образования изоляции, показанной на рис. . Затем на образцах А и В методом фотолитографии были сформированы литниковые узоры. Для образца A пленка Al толщиной 6 нм была нанесена на поверхность алмаза с литниковым рисунком методом EB, а затем образец A был окислен на воздухе при КТ в течение 48 часов с образованием AlO 9Диэлектрический слой размером 0045 x , показанный на рис. . Для сравнения, образец B с литниковой структурой был помещен на воздух при комнатной температуре на 48 часов без осаждения Al толщиной 6 нм на поверхность алмаза. Через 48 часов на образцы A и B были нанесены алюминиевые электроды затвора толщиной 100 нм. Ширина затвора (W G ) и длина затвора (L G ) составляли 100 мкм и 8 мкм.
Толщина и расстояние между электродами (L SD ) составляли 100 нм и 20 мкм соответственно. После этого на каналы между электродами истока и стока методом фотолитографии нанесли негативный фоторезист. После этого на образцах А и В применяли УФ/озон для образования изоляции, показанной на рис. . Затем на образцах А и В методом фотолитографии были сформированы литниковые узоры. Для образца A пленка Al толщиной 6 нм была нанесена на поверхность алмаза с литниковым рисунком методом EB, а затем образец A был окислен на воздухе при КТ в течение 48 часов с образованием AlO 9Диэлектрический слой размером 0045 x , показанный на рис. . Для сравнения, образец B с литниковой структурой был помещен на воздух при комнатной температуре на 48 часов без осаждения Al толщиной 6 нм на поверхность алмаза. Через 48 часов на образцы A и B были нанесены алюминиевые электроды затвора толщиной 100 нм. Ширина затвора (W G ) и длина затвора (L G ) составляли 100 мкм и 8 мкм.
Микро-рамановская, рентгеновская дифракция (XRD) и атомно-силовой микроскоп (АСМ) использовались для характеристики образцов и электрических свойств полевых транзисторов с AlO и без него x были измерены с использованием зондовой системы RT в воздухе при комнатной температуре.
Качество алмаза с монокристаллическим H-алмазом размером 200 нм было охарактеризовано с помощью микро-рамановского анализа и рентгеновской дифракции. Объектив 20 × использовался в рамановских измерениях с лазером возбуждения 532 нм и разрешением 0,4 см -1 /пиксель. Три случайные точки комбинационного рассеяния были измерены на образце A и B соответственно. Средние результаты комбинационного рассеяния на полувысоте образцов A и B составили 4,2 см −1 и 4,0 см −1 соответственно. Кривые качания образцов A и B были измерены с использованием Ge (2 2 0)-монохромата Cu-K𝛼 с четырьмя отражениями с щелью 10 мм на плече детектора. XRD FWHM образцов A и B составляли 0,012 ° и 0,011 °, как показано на рис. Шероховатость образцов A и B составила 0,32 и 0,37 нм, измеренная с помощью АСМ, как показано на рисунке соответственно.
Шероховатость образцов A и B составила 0,32 и 0,37 нм, измеренная с помощью АСМ, как показано на рисунке соответственно.
Открыть в отдельном окне
( a , b ) показать результаты АСМ образца A и B соответственно; ( c ) показаны результаты XRD образцов A и B.
На рисунке показано абсолютное значение плотности тока утечки затвора (|J|) образцов A и B в логарифмической координате соответственно. На рисунке показана плотность тока утечки затвора (Дж) образцов A и B соответственно. На рис. напряжение затвор-исток (V GS ) составляло от −5 до 5 В. На рис.0045 GS было от 0 до 5 В. Когда V GS уменьшилось с 5 до 0 В, как показано на рис. -2 для образца А и от 2,3 × 10 -7 до -3 × 10 -8 А·см -2 для образца В, что указывает на то, что J образцов А и В были почти одинаковыми. При уменьшении V GS от 0 до −5 V на рис.0016 для образца А и от -3 × 10 -8 до -40 А·см -2 для образца В. А также, когда V GS составляло -5 В, отношение J между образцом В и А составляло 4 × 10 4 . Это показывает, что J образца A был намного меньше, чем J образца B при V GS в диапазоне от 0 до -5 В, что указывает на то, что диэлектрический слой AlO x в образце A может эффективно уменьшить ток утечки.
А также, когда V GS составляло -5 В, отношение J между образцом В и А составляло 4 × 10 4 . Это показывает, что J образца A был намного меньше, чем J образца B при V GS в диапазоне от 0 до -5 В, что указывает на то, что диэлектрический слой AlO x в образце A может эффективно уменьшить ток утечки.
Открыть в отдельном окне
( а , б ) показывают абсолютное значение плотности тока утечки затвора (|J|) образцов A и B в логарифмической координате от −5 до 5 В соответственно; ( c , d ) показывают J образца A и B от 0 до -5 В соответственно.
На рисунке показана зависимость тока сток-исток (I D ) от напряжения сток-исток (V DS ), выходные характеристики (I D − V DS ) кривые (а) образца А и (б) образца B. На рисунке V GS был изменен с 2 до -2,5 В с шагом -0,5 В. Когда V GS = 2, 1,5, 1, 0,5, 0 и −0,5 В, кривые I D различить не удалось из-за их малого значения на рис. Основываясь на результатах измерения образца A на рис., I D демонстрирует отчетливую характеристику отсечки. А также на рис. наблюдались характеристики канала p-типа, поскольку значение I D уменьшалось с уменьшением значения V DS от 2 до −2,5 V 3 . При V GS = −2,5 V и V DS = −6,4 В, I D составил 300,9 мкА, что было максимальным значением I D на рис. Когда V GS = 0 В и V DS = −6,4 В, I D составлял –5,6 × 10 −6 ×0 мкА (данные не показаны), что указывает на то, что отношение включения/выключения составляло около 5,4 . 7 . На рис. при V DS = 0 V наблюдался обратный (положительный) I D , на что указывает черная стрелка. И тогда значение I D уменьшилось с клапаном V DS уменьшение. Причиной реверса I D был ток утечки затвора по Ricardo S . Sussmann 19 .
Основываясь на результатах измерения образца A на рис., I D демонстрирует отчетливую характеристику отсечки. А также на рис. наблюдались характеристики канала p-типа, поскольку значение I D уменьшалось с уменьшением значения V DS от 2 до −2,5 V 3 . При V GS = −2,5 V и V DS = −6,4 В, I D составил 300,9 мкА, что было максимальным значением I D на рис. Когда V GS = 0 В и V DS = −6,4 В, I D составлял –5,6 × 10 −6 ×0 мкА (данные не показаны), что указывает на то, что отношение включения/выключения составляло около 5,4 . 7 . На рис. при V DS = 0 V наблюдался обратный (положительный) I D , на что указывает черная стрелка. И тогда значение I D уменьшилось с клапаном V DS уменьшение. Причиной реверса I D был ток утечки затвора по Ricardo S . Sussmann 19 . Этот ток утечки может быть вызван дефектами поверхности алмаза 19 . На рис. не наблюдалось реверса I D , что указывает на малый ток утечки затвора в образце А, что согласуется с результатами на рис. . Следовательно, диэлектрический слой AlO x в образце A может предотвратить обратное I D в I D − V DS измерение.
Этот ток утечки может быть вызван дефектами поверхности алмаза 19 . На рис. не наблюдалось реверса I D , что указывает на малый ток утечки затвора в образце А, что согласуется с результатами на рис. . Следовательно, диэлектрический слой AlO x в образце A может предотвратить обратное I D в I D − V DS измерение.
Открыть в отдельном окне
Результаты выходных характеристических кривых ( a ) образца A и ( b ) образца B.
Передаточные характеристики образца A были измерены для оценки порогового напряжения (V TH ) и максимальной внешней крутизны (g м ), как показано на рис. , соответственно. На рис. V TH составляет −0,44 В при V DS = −15 В, рассчитанном по методу 9.0333 Jiangwei Liu 15 , что указывает на то, что полевой транзистор с диэлектрическим слоем AlO x показал улучшенный режим (нормально выключен), который обсуждался в нашем предыдущем отчете 6 . Одной из причин нормально-отклоненных характеристик является уменьшение водородных обрывов на поверхности алмаза во время процесса изготовления образца А, такого как фотолитографический и электронно-лучевой процесс. Другой причиной может быть истощение дырочных носителей в полевом транзисторе под каналом, что связано с большой разницей работы выхода между 100-нм алюминиевым затвором и H-алмазом 9.0015 6 . На рис. ) Результат кривых передаточной характеристики образца А; ( b ) крутизна образца A.
Одной из причин нормально-отклоненных характеристик является уменьшение водородных обрывов на поверхности алмаза во время процесса изготовления образца А, такого как фотолитографический и электронно-лучевой процесс. Другой причиной может быть истощение дырочных носителей в полевом транзисторе под каналом, что связано с большой разницей работы выхода между 100-нм алюминиевым затвором и H-алмазом 9.0015 6 . На рис. ) Результат кривых передаточной характеристики образца А; ( b ) крутизна образца A.
В нашей предыдущей работе нормально выключенный H-алмазный полевой транзистор был выполнен с диэлектрическим слоем Al 2 O 3 3 нм 6 . Однако в этой работе H-алмазный полевой транзистор с 6 нм AlO 9Реализовано разрешение 0045 x . Для предыдущего образца прерывистая пленка Al 2 O 3 толщиной 3 нм была сформирована путем термического окисления алюминия толщиной 3 нм на воздухе. В течение длительного процесса термического окисления и осаждения затворного электрода части адсорбата и водородных концов между зазорами Al 2 O 3 на H-алмазе могут быть уменьшены 18 , 20 . В то время как для этой работы была сформирована непрерывная пленка AlO x толщиной 6 нм путем самоокисления пленки Al толщиной 6 нм при комнатной температуре, которая могла защитить адсорбат и водородные концевые соединения во время процесса осаждения затворного электрода 18 , 20 .
В течение длительного процесса термического окисления и осаждения затворного электрода части адсорбата и водородных концов между зазорами Al 2 O 3 на H-алмазе могут быть уменьшены 18 , 20 . В то время как для этой работы была сформирована непрерывная пленка AlO x толщиной 6 нм путем самоокисления пленки Al толщиной 6 нм при комнатной температуре, которая могла защитить адсорбат и водородные концевые соединения во время процесса осаждения затворного электрода 18 , 20 .
Таким образом, изготовление полевых транзисторов из H-алмаза с диэлектрическим слоем AlO x , образованным путем самоокисления слоя Al толщиной 6 нм в воздухе при комнатной температуре, было успешно выполнено. Плотность тока утечки в полевом транзисторе с диэлектрическим слоем AlO x была на 4 × 10 4 ниже, чем без диэлектрического слоя AlO x при V GS = −5 В. Диэлектрический слой AlO x может уменьшить утечку тока и предотвращения реверса I D в I D − V DS вызван дефектами на поверхности алмаза. Коэффициент включения/выключения полевого транзистора с диэлектрическим слоем AlO x составлял 5,4 × 10 7 . Полевой транзистор с диэлектрическим слоем AlO x показал нормально выключенные характеристики с пороговым напряжением −0,44 В при V DS = −15 В.
Диэлектрический слой AlO x может уменьшить утечку тока и предотвращения реверса I D в I D − V DS вызван дефектами на поверхности алмаза. Коэффициент включения/выключения полевого транзистора с диэлектрическим слоем AlO x составлял 5,4 × 10 7 . Полевой транзистор с диэлектрическим слоем AlO x показал нормально выключенные характеристики с пороговым напряжением −0,44 В при V DS = −15 В.
Эта работа поддерживается Национальным фондом естественных наук Китая (NSFC) (61627812), Координация технологий и инновационная инженерная программа Шэньси (2016KTZDGY02-03) и Китайского фонда постдокторских наук (PSFC) (2015M580850). Эта работа также поддерживается Китайским фондом постдокторской науки (2015M580850). Мы также благодарим мисс Ю Ван из Центра инструментального анализа Сианьского университета Цзяотун за их помощь в рамановском анализе. Эта работа также поддерживается Nan Zhu, Jiuhong Wang, которые оказали помощь в измерении АСМ с использованием INNOVA от BRUKER.
Yan-Feng Wang, Xiaohui Chang, Xiaofan Zhang, Jiao Fu разработали эксперимент. Yan-Feng Wang, Shuwei Fan, Renan Bu, Jingwen Zhang закончили эксперимент. Yan-Feng Wang, Dan Zhao, Guoqing Shao измерили образцы. Yan-Feng Wang, Zhangcheng Liu, Wei Wang, Hong-Xing Wang анализируют данные. Yan-Feng Wang пишет эту рукопись, и все авторы участвуют в обсуждениях.
Конкурирующие интересы
Авторы заявляют об отсутствии конкурирующих интересов.
Примечание издателя: Springer Nature остается нейтральной в отношении юрисдикционных претензий в опубликованных картах и институциональной принадлежности.
1. Х. Каварада и др. . Работа полевых МОП-транзисторов C-H Diamond для применения в силовой электронике в широком диапазоне температур (10–700 K) и высокого напряжения (~ 1000 В), Electron Devices Meeting 2015 , 11.2.1–11.2.4 (2015).
2. Jiangwei Liu, et al. Логические схемы на гидрированных алмазных полевых транзисторах. Письма IEEE об электронных устройствах. 2017;38:992–925. [Google Scholar]
Письма IEEE об электронных устройствах. 2017;38:992–925. [Google Scholar]
3. Wang W, et al. Полевые транзисторы на основе алмаза с двойными диэлектрическими слоями SiNx и ZrO2. Алмаз и сопутствующие материалы. 2016;69:237–240. doi: 10.1016/j.diamond.2016.04.014. [CrossRef] [Google Scholar]
4. Jing Zhao, et al. Сборка тонкого слоя TiOx с высокой диэлектрической проницаемостью непосредственно на полупроводниковом алмазе с H-терминалами. Письма по прикладной физике. 2016;108:012105. doi: 10.1063/1.4939650. [CrossRef] [Google Scholar]
5. Jiangwei Liu, et al. Алмазный полевой транзистор с низким сопротивлением во включенном состоянии с ZrO2 с высоким коэффициентом k в качестве диэлектрика. Научные отчеты. 2014;4:6395. [Бесплатная статья PMC] [PubMed] [Google Scholar]
6. Wang Y-F, et al. Нормально закрытый алмазный полевой транзистор с водородной клеммой и диэлектрическим слоем Al 2 O 3 , образованным термическим окислением Al. Алмаз и сопутствующие материалы. 2018; 81: 113–117. doi: 10.1016/j.diamond.2017.11.016. [CrossRef] [Google Scholar]
2018; 81: 113–117. doi: 10.1016/j.diamond.2017.11.016. [CrossRef] [Google Scholar]
7. Ян-Фэн, Ван и др. . Омический контакт между пленкой иридия и монокристаллическим алмазом с водородными концевыми группами. 7 , 12157 (2017). [Бесплатная статья PMC] [PubMed]
8. Chicot G, et al. Полупроводниковая структура оксида металла с использованием алмаза с кислородными концевыми группами. Письма по прикладной физике. 2013;102:242108. дои: 10.1063/1.4811668. [CrossRef] [Google Scholar]
9. Кунце М., Вескан А., Доллингер Г., Бергмайер А., Кон Э. Дельта-легирование алмаза. Углерод. 1999; 37: 787–791. doi: 10.1016/S0008-6223(98)00272-3. [CrossRef] [Google Scholar]
10. El-Hajj H, et al. Характеристики алмаза, легированного бором, для электронных приложений. Алмаз и сопутствующие материалы. 2008;17:409–414. doi: 10.1016/j.diamond.2007.12.030. [CrossRef] [Google Scholar]
11. Масатака Имура и др. Разработка полевых транзисторов с гетеропереходом AlN/алмаз. Алмаз и сопутствующие материалы. 2012; 124: 206–209. doi: 10.1016/j.diamond.2012.01.020. [CrossRef] [Google Scholar]
Алмаз и сопутствующие материалы. 2012; 124: 206–209. doi: 10.1016/j.diamond.2012.01.020. [CrossRef] [Google Scholar]
12. Saito T, et al. Изготовление полевых транзисторов металл-оксид-алмаз с субмикронной длиной затвора на легированных бором (111) H-концевых поверхностях с использованием электронно-лучевого напыления SiO2 и Al2O3. Журнал электронных материалов. 2011;40:247–252. doi: 10.1007/s11664-010-1500-1. [Перекрестная ссылка] [Академия Google]
13. Казуюки Хирама и др. Характеристика алмазных полевых транзисторов металл-изолятор-полупроводник с изолятором затвора из оксида алюминия. Письма по прикладной физике. 2006;88:112117. doi: 10.1063/1.2186072. [CrossRef] [Google Scholar]
14. Kueck D, et al. Пассивация алмаза с Н-терминалами с помощью MOCVD-нитрида алюминия — ключ к пониманию и стабилизации его поверхностной проводимости. Твердый физический статус. 2010;207:2035–2039. doi: 10.1002/pssa.201000072. [Перекрестная ссылка] [Академия Google]
15. Liu JW, Liao MY, Imura M, Koide Y. Нормально выключенные алмазные полевые транзисторы с HfO2-затвором. Письма по прикладной физике. 2013;103:092905. doi: 10.1063/1.4820143. [CrossRef] [Google Scholar]
Нормально выключенные алмазные полевые транзисторы с HfO2-затвором. Письма по прикладной физике. 2013;103:092905. doi: 10.1063/1.4820143. [CrossRef] [Google Scholar]
16. Liu JW, et al. Управление нормально включенными/выключенными характеристиками полевых транзисторов металл-изолятор-полупроводник на основе гидрогенизированного алмаза. Журнал прикладной физики. 2015;118:115704. doi: 10.1063/1.4930294. [CrossRef] [Google Scholar]
17. Liu JW, et al. Алмазные полевые транзисторы с высокой диэлектрической проницаемостью Ta 2 O 5 в качестве материала ворот. Журнал физики D Прикладная физика. 2014;47:245102. doi: 10.1088/0022-3727/47/24/245102. [CrossRef] [Google Scholar]
18. Ридель М., Ристайн Дж., Лей Л. Восстановление поверхностной проводимости Н-терминированного алмаза после термического отжига в вакууме. Physical Review B Конденсированные вещества. 2004;69:125338. doi: 10.1103/PhysRevB.69.125338. [CrossRef] [Google Scholar]
19. Рикардо, С. Суссманн о ссылках в CVD Diamond for Electronic Devices and Sensors (изд. Рикардо, С.) 296–298 (John Wiley & Sons Ltd, 2009).
Рикардо, С. Суссманн о ссылках в CVD Diamond for Electronic Devices and Sensors (изд. Рикардо, С.) 296–298 (John Wiley & Sons Ltd, 2009).
20. Майер Ф., Ридель М., Мантель Б., Ристайн Дж., Лей Л. Происхождение поверхностной проводимости в алмазе. Письма о физическом обзоре. 2000;85:16. [PubMed] [Google Scholar]
Статьи из Scientific Reports предоставлены здесь Nature Publishing Group
Высокопроизводительный комплементарный инвертор на основе дихалькогенидных полевых транзисторов на переходных металлах
Abstract
В течение нескольких лет графен был в центре внимания из-за его специфических характеристик, и в настоящее время он считается репрезентативным двумерным (2D) материалом. Несмотря на то, что многие исследовательские группы изучали графен, его внутренняя природа с нулевой запрещенной зоной ограничивает его использование в практических приложениях, особенно в логических схемах. В последнее время дихалькогениды переходных металлов (TMD), которые представляют собой другой тип 2D-материала, привлекли внимание из-за преимущества наличия значительной ширины запрещенной зоны и высокой подвижности. Здесь мы сообщаем о конструкции дополнительного инвертора, одного из самых основных логических элементов, основанного на MoS 9.0045 2 транзистор n-типа и WSe 2 транзистор p-типа. Преимущества, обеспечиваемые комплементарной конфигурацией металл-оксид-полупроводник (CMOS) и высокопроизводительными каналами TMD, позволяют нам изготовить комплементарный инвертор TMD с высоким коэффициентом усиления 13,7. Эта работа демонстрирует работу MoS 2 n-FET и WSe 2 p-FET на одной и той же подложке, а также измеряются электрические характеристики КМОП-инвертора, основанного на другом управляющем токе.
В последнее время дихалькогениды переходных металлов (TMD), которые представляют собой другой тип 2D-материала, привлекли внимание из-за преимущества наличия значительной ширины запрещенной зоны и высокой подвижности. Здесь мы сообщаем о конструкции дополнительного инвертора, одного из самых основных логических элементов, основанного на MoS 9.0045 2 транзистор n-типа и WSe 2 транзистор p-типа. Преимущества, обеспечиваемые комплементарной конфигурацией металл-оксид-полупроводник (CMOS) и высокопроизводительными каналами TMD, позволяют нам изготовить комплементарный инвертор TMD с высоким коэффициентом усиления 13,7. Эта работа демонстрирует работу MoS 2 n-FET и WSe 2 p-FET на одной и той же подложке, а также измеряются электрические характеристики КМОП-инвертора, основанного на другом управляющем токе.
История вопроса
С появлением графена, одного из наиболее изученных двумерных (2D) материалов, слоистые материалы привлекли большое внимание благодаря своим уникальным и выдающимся электрическим, механическим и оптическим характеристикам [1,2]. Несмотря на чрезвычайно высокую подвижность 15 000 см 2 /Вс и простоту масштабирования, отсутствие внутренней запрещенной зоны ограничивает возможности использования графена в логических схемах [3].
Несмотря на чрезвычайно высокую подвижность 15 000 см 2 /Вс и простоту масштабирования, отсутствие внутренней запрещенной зоны ограничивает возможности использования графена в логических схемах [3].
Дихалькогениды переходных металлов (TMD) представляют собой семейство двумерных материалов и считаются хорошими материалами-кандидатами, которые могут преодолеть ограничения графена. TMD следуют формуле МХ
2 , где M — переходный металл, а X — халькоген (S, Se, Te и т. д.). TMD состоит из атомных слоев, которые имеют очень слабые силы Ван-дер-Ваальса, связывающие их, и они обычно имеют ширину запрещенной зоны от 1,1 до 1,9 эВ [4]. Такие свойства позволяют использовать ДПМ в качестве материалов каналов в высокоэффективных полевых транзисторах (ПТ) [5]. Из различных доступных материалов TMD MoS 2 и WSe 2 по отдельности считаются подходящими материалами каналов для транзисторов n-типа и p-типа. МоС 2 n-FET продемонстрировал подвижность примерно 200 см 2 /Вс, а также сообщалось об эффективной подвижности дырок для WSe 2 p-FET примерно до 250 см 2 /Вс [6,7]. ].
МоС 2 n-FET продемонстрировал подвижность примерно 200 см 2 /Вс, а также сообщалось об эффективной подвижности дырок для WSe 2 p-FET примерно до 250 см 2 /Вс [6,7]. ].
Комплементарный инвертор металл-оксид-полупроводник (КМОП) является основным блоком для логических элементов схемы. Для изготовления КМОП-инвертора необходимы транзисторы как p-типа, так и n-типа [8]. По сравнению с инвертором с резистивной нагрузкой, дополнительный инвертор обладает выдающимися свойствами с точки зрения низкого энергопотребления и большого запаса по шуму [9].].
Было проведено несколько исследований по изготовлению дополнительных инверторов с использованием TMD. Хуан Дж. и др. . [9] сообщили о первом инверторе CMOS с использованием TMD, который был изготовлен из MoS 2 и углеродных нанотрубок в качестве материалов канала. После этого отчета исследователи попробовали несколько других материалов с p-каналом, таких как Bi 2 Sr 2 Co 2 O 8 [10] или фосфорен [11], и изготовили дополнительный инвертор с комбинацией MoS 2 . Такие отчеты имеют значение в том смысле, что и n-канал, и p-канал являются слоистыми материалами, но тем не менее электрические характеристики устройств были недостаточными. Первый инвертор CMOS, полностью основанный на TMD, был создан Tosun M et al . [12] с использованием одного материала WSe 2 . Для p-канала использовали чистый WSe 2 , а для n-канала использовали WSe 2 , легированный K. Полученное устройство продемонстрировало высокий пиковый коэффициент усиления, равный примерно 12, но из-за нестабильности легирования калием в воздухе его характеристики имеют тенденцию к ухудшению с течением времени работы. Недавно Das S и др. . [13] сообщили о комплементарном инверторе на основе WSe 2 , показывающем коэффициент усиления более 25. Поскольку они тщательно спроектировали пороговое напряжение как n-FET, так и p-FET, составляющих КМОП-инвертор, полученное свойство устройства было замечательным.
Такие отчеты имеют значение в том смысле, что и n-канал, и p-канал являются слоистыми материалами, но тем не менее электрические характеристики устройств были недостаточными. Первый инвертор CMOS, полностью основанный на TMD, был создан Tosun M et al . [12] с использованием одного материала WSe 2 . Для p-канала использовали чистый WSe 2 , а для n-канала использовали WSe 2 , легированный K. Полученное устройство продемонстрировало высокий пиковый коэффициент усиления, равный примерно 12, но из-за нестабильности легирования калием в воздухе его характеристики имеют тенденцию к ухудшению с течением времени работы. Недавно Das S и др. . [13] сообщили о комплементарном инверторе на основе WSe 2 , показывающем коэффициент усиления более 25. Поскольку они тщательно спроектировали пороговое напряжение как n-FET, так и p-FET, составляющих КМОП-инвертор, полученное свойство устройства было замечательным.
Здесь мы сообщаем о инверторе CMOS, полностью основанном на TMD, который состоит из MoS 2 n-FET и WSe 2 p-FET. Пиковое усиление для нашего дополнительного инвертора TMD достигает значения более 13 при управляющем напряжении 2 В. Мы использовали два различных собственных TMD n-типа и p-типа по отдельности и добились приемлемой производительности MoS 9.0045 2 -/WSe 2 инвертор на основе КМОП, который может быть большим потенциалом TMD в логических приложениях.
Пиковое усиление для нашего дополнительного инвертора TMD достигает значения более 13 при управляющем напряжении 2 В. Мы использовали два различных собственных TMD n-типа и p-типа по отдельности и добились приемлемой производительности MoS 9.0045 2 -/WSe 2 инвертор на основе КМОП, который может быть большим потенциалом TMD в логических приложениях.
Методы
Несколько слоев каждого TMD были получены из коммерчески доступного нерасфасованного MoS 2 (429ML-AB, SPI Supplies Inc., Западный Честер, Пенсильвания, США) и WSe 2 (NS00182, Nanoscience Instruments Inc., Феникс, Аризона, США) путем механического отшелушивания с помощью клейкой ленты. Высоколегированная кремниевая подложка с атомно-слоевым осаждением (ALD) толщиной 30 нм Al 2 O 3 был использован для изготовления дополнительного инвертора TMD. На половину площади одной подложки был нанесен многослойный MoS 2 , на другую половину – WSe 2 . Затем для материала каждого канала были изготовлены массивы квадратных электродов размером 200 мкм ×200 мкм с помощью обычного процесса отрыва. Чтобы сформировать омические контакты, 30 нм Ti и 30 нм Pt были индивидуально использованы в качестве металлов для электрических контактов n-FET и p-FET с учетом работы выхода MoS 9.0045 2 и WSE 2 . После изготовления n-FET и p-FET на одной подложке анализатор параметров Keithley 4200 использовался для измерения электрических характеристик MoS 2 и WSe 2 FET.
Затем для материала каждого канала были изготовлены массивы квадратных электродов размером 200 мкм ×200 мкм с помощью обычного процесса отрыва. Чтобы сформировать омические контакты, 30 нм Ti и 30 нм Pt были индивидуально использованы в качестве металлов для электрических контактов n-FET и p-FET с учетом работы выхода MoS 9.0045 2 и WSE 2 . После изготовления n-FET и p-FET на одной подложке анализатор параметров Keithley 4200 использовался для измерения электрических характеристик MoS 2 и WSe 2 FET.
По результатам измерений мы выбрали несколько наборов n- и p-полевых транзисторов, показавших приемлемую производительность. Наконец, была изготовлена соединительная линия Ti толщиной 50 нм между выбранными полевыми транзисторами MoS 2 и WSe 2 посредством процесса отрыва, после чего последовало электронно-лучевое осаждение. После изготовления КМОП-структуры инвертора приборы подвергались отжигу в течение 2 ч в трубчатой печи при 200°С с температурой N 2 атмосфера для уменьшения контактного сопротивления между каналом и металлическим электродом. Анализатор параметров Keithley 4200 использовался для измерения электрических характеристик инвертора MoS 2 /WSe 2 CMOS. Измерения проводились с использованием четырех щупов для построения графика входного и выходного напряжения инвертора. Управляющее напряжение ( В
DD ) был подключен к истоку p-FET, а земля была подключена к истоку n-FET. Входное напряжение подавалось на нижний затвор MoS 9.0045 2 FET и WSe 2 FET одновременно путем свипирования от -5 до 0 В, а выходное напряжение было зарегистрировано путем измерения на соединительной линии для обоих стоков.
Анализатор параметров Keithley 4200 использовался для измерения электрических характеристик инвертора MoS 2 /WSe 2 CMOS. Измерения проводились с использованием четырех щупов для построения графика входного и выходного напряжения инвертора. Управляющее напряжение ( В
DD ) был подключен к истоку p-FET, а земля была подключена к истоку n-FET. Входное напряжение подавалось на нижний затвор MoS 9.0045 2 FET и WSe 2 FET одновременно путем свипирования от -5 до 0 В, а выходное напряжение было зарегистрировано путем измерения на соединительной линии для обоих стоков.
Результаты и обсуждение
На рисунке 1 показана общая структура инвертора TMD CMOS, который содержит как n-FET, так и p-FET с TMD в качестве материала канала. Мы использовали многослойный MoS 2 для канала n-типа и многослойный WSe 2 для полупроводникового материала p-типа (рис. 2a,b). Ti был выбран в качестве металлического электрода для MoS 9. 0045 2 FET, так как известно, что этот металл имеет малую работу выхода, и поэтому проще сформировать омический контакт с MoS 2 [4]. С другой стороны, WSe 2 обладает уникальными характеристиками, поскольку легко может происходить одновременная инжекция как дырок, так и электронов, что приводит к амбиполярному транспорту [5,7]. Для достижения наших целей по изготовлению полевого транзистора р-типа для электрода лучше использовать металл с большой работой выхода. Поэтому мы выбрали Pt для WSe 9.0045 2 FET, поскольку Pt имеет работу выхода от 5,12 до 5,93 эВ.
0045 2 FET, так как известно, что этот металл имеет малую работу выхода, и поэтому проще сформировать омический контакт с MoS 2 [4]. С другой стороны, WSe 2 обладает уникальными характеристиками, поскольку легко может происходить одновременная инжекция как дырок, так и электронов, что приводит к амбиполярному транспорту [5,7]. Для достижения наших целей по изготовлению полевого транзистора р-типа для электрода лучше использовать металл с большой работой выхода. Поэтому мы выбрали Pt для WSe 9.0045 2 FET, поскольку Pt имеет работу выхода от 5,12 до 5,93 эВ.
Структура устройства с электрическими соединениями. Схематическое изображение и оптическая микроскопия дополнительного инвертора MoS 2 /WSe 2 с электрическими соединениями, которые использовались для измерения электрических характеристик.
Полноразмерное изображение
Рисунок 2
Оптические изображения и передаточные характеристики n-
FET и р-
полевой транзистор. Оптическое микроскопическое изображение (a) MoS 2 n-FET и (b) WSe 2 p-FET, которые использовались для изготовления инвертора TMD CMOS. Передаточные характеристики (c) MoS 2 n-FET и (d) WSe 2 p-FET при напряжении стока 0,2 В.
Оптическое микроскопическое изображение (a) MoS 2 n-FET и (b) WSe 2 p-FET, которые использовались для изготовления инвертора TMD CMOS. Передаточные характеристики (c) MoS 2 n-FET и (d) WSe 2 p-FET при напряжении стока 0,2 В.
Полноразмерное изображение
измеряется для проверки электрических характеристик полевых транзисторов. На рис. 2c,d представлены результирующие передаточные кривые для n-FET и p-FET. МоС 2 FET, показанный на рисунке 2c, имеет ширину канала 6 мкм и длину канала 10 мкм. Он показывает четкие характеристики n-типа с I
на / я
от соотношение примерно 10 5 . Когда напряжение на затворе становится выше порогового напряжения (-5,23 В), ток стока резко возрастает примерно до 10 -7 А. Полевая подвижность полевого транзистора MoS 2 , полученная из передаточной характеристики получается 0,86. ВСе 2 Полевой транзистор имеет характеристики р-типа, вызванные инжекцией дырок. Ток стока имеет тенденцию к резкому увеличению, примерно до 10 -7 А, при смещении затвора, меньшем его порогового напряжения, -8,79 В. Это устройство с шириной канала 2 мкм и длиной канала 10 мкм демонстрирует я
на / я
от соотношение примерно 10 4 и подвижность 8,87. Как n-FET, так и p-FET демонстрируют умеренный коэффициент включения-выключения при одинаковом уровне тока включения, что является одним из ключевых требований для работы в качестве дополняющего инвертора.
ВСе 2 Полевой транзистор имеет характеристики р-типа, вызванные инжекцией дырок. Ток стока имеет тенденцию к резкому увеличению, примерно до 10 -7 А, при смещении затвора, меньшем его порогового напряжения, -8,79 В. Это устройство с шириной канала 2 мкм и длиной канала 10 мкм демонстрирует я
на / я
от соотношение примерно 10 4 и подвижность 8,87. Как n-FET, так и p-FET демонстрируют умеренный коэффициент включения-выключения при одинаковом уровне тока включения, что является одним из ключевых требований для работы в качестве дополняющего инвертора.
После сортировки MoS 2 n-FET и WSe 2 p-FET, обладающих приемлемыми электрическими характеристиками, из них был изготовлен инвертор CMOS. Два полевых транзистора были соединены последовательно, сток n-FET за стоком p-FET, с металлической линией, чтобы они работали вместе как логический инвертор. Как показано на рисунке 1, электрическое соединение было сконфигурировано для измерения производительности завершенного комплементарного инвертора TMD. Для подачи напряжения и регистрации выходного напряжения использовались четыре датчика. Постоянное смещение В
DD = 2 В, и отношение между входным напряжением и выходным напряжением было измерено, как показано на рисунке 3. Передаточная характеристика напряжения на рисунке 3 была измерена для инвертора TMD CMOS, состоящего из n-FET и p- FET, указанные на рис. 2c,d соответственно. В то время как устройство получало низкое входное напряжение, полевой транзистор WSe 2 p-типа оставался во включенном состоянии, а полевой транзистор MoS 2 n-типа — в выключенном состоянии. Следовательно, выходное напряжение оставалось высоким, около В
ДД . С другой стороны, полевой транзистор MoS 2 n-типа находился во включенном состоянии, а полевой транзистор WSe 2 p-типа находился в выключенном состоянии при подаче высокого входного сигнала.
Как показано на рисунке 1, электрическое соединение было сконфигурировано для измерения производительности завершенного комплементарного инвертора TMD. Для подачи напряжения и регистрации выходного напряжения использовались четыре датчика. Постоянное смещение В
DD = 2 В, и отношение между входным напряжением и выходным напряжением было измерено, как показано на рисунке 3. Передаточная характеристика напряжения на рисунке 3 была измерена для инвертора TMD CMOS, состоящего из n-FET и p- FET, указанные на рис. 2c,d соответственно. В то время как устройство получало низкое входное напряжение, полевой транзистор WSe 2 p-типа оставался во включенном состоянии, а полевой транзистор MoS 2 n-типа — в выключенном состоянии. Следовательно, выходное напряжение оставалось высоким, около В
ДД . С другой стороны, полевой транзистор MoS 2 n-типа находился во включенном состоянии, а полевой транзистор WSe 2 p-типа находился в выключенном состоянии при подаче высокого входного сигнала. В результате было измерено выходное напряжение 0 В, что свидетельствует о выполнении логической операции от 1 до 0. Такая кривая передачи напряжения наглядно демонстрирует характеристики инвертора.
В результате было измерено выходное напряжение 0 В, что свидетельствует о выполнении логической операции от 1 до 0. Такая кривая передачи напряжения наглядно демонстрирует характеристики инвертора.
Характеристики передачи напряжения инвертора. Характеристики передачи напряжения и кривая усиления MoS 2 /WSe 2 дополнительный инвертор на В ДД от 2В.
Изображение полного размера
По графику входного и выходного напряжения можно рассчитать кривую усиления как Δ В
из /Δ В
в . Как показано на рисунке 3, пик на кривой усиления показывает точку перехода для инвертора. В нашей работе пиковое усиление MoS 2 /WSe 2 комплементарный инвертор достигает 13,7, что является значительно большим значением по сравнению с инверторами CMOS на основе других 2D полевых транзисторов. В таблице 1 представлены сводные данные о дополнительных инверторах, о которых сообщалось, а также их пиковое усиление. В нескольких отчетах обсуждалось изготовление КМОП-инвертора и псевдо-КМОП-инвертора (конфигурация инвертора с использованием двух амбиполярных транзисторов вместо одного n-FET и одного p-FET) на основе 2D-материалов. Однако инвертор, полностью основанный на TMD, обсуждался только Tosun 9.0565 и др. . [12] и S Das и др. . [13], которые использовали WSe 2 , легированные n-типом и p-типом, в качестве материала канала. Считается, что характеристики инвертора, предложенного в этой работе, замечательны, поскольку он был изготовлен с использованием TMD как для n-канала, так и для p-канала с различными материалами каналов. Кроме того, пиковое усиление более 13 является относительно высоким значением не только по сравнению с инверторами на основе 2D-материалов CMOS, но и с инверторами на основе оксидов или органических материалов (таблица 1). Считается, что изготовление такого высокопроизводительного инвертора в нашей работе было достигнуто за счет интеграции высокомобильных материалов TMD и конфигурации CMOS.
В таблице 1 представлены сводные данные о дополнительных инверторах, о которых сообщалось, а также их пиковое усиление. В нескольких отчетах обсуждалось изготовление КМОП-инвертора и псевдо-КМОП-инвертора (конфигурация инвертора с использованием двух амбиполярных транзисторов вместо одного n-FET и одного p-FET) на основе 2D-материалов. Однако инвертор, полностью основанный на TMD, обсуждался только Tosun 9.0565 и др. . [12] и S Das и др. . [13], которые использовали WSe 2 , легированные n-типом и p-типом, в качестве материала канала. Считается, что характеристики инвертора, предложенного в этой работе, замечательны, поскольку он был изготовлен с использованием TMD как для n-канала, так и для p-канала с различными материалами каналов. Кроме того, пиковое усиление более 13 является относительно высоким значением не только по сравнению с инверторами на основе 2D-материалов CMOS, но и с инверторами на основе оксидов или органических материалов (таблица 1). Считается, что изготовление такого высокопроизводительного инвертора в нашей работе было достигнуто за счет интеграции высокомобильных материалов TMD и конфигурации CMOS.
Полноразмерная таблица
Для дальнейшего изучения электрических характеристик мы изменили управляющее напряжение в три этапа: 1, 2 и 3 В, и выполнили измерения соответствующих характеристик передачи напряжения. На рис. 4а показаны электрические характеристики различных напряжений, используемых для подачи напряжения в цепь, а на рис. 4б представлен график коэффициента усиления, извлеченный из кривой передачи. Как показано на рисунке 4а, наше устройство работает при отрицательном входном напряжении. Пороговое напряжение переключения ( В
M ) инвертора, представляющее собой напряжение, при котором n-FET и p-FET включаются с одинаковой интенсивностью, также находится в отрицательной области. Все эти явления связаны с пороговым напряжением n-FET и p-FET. Обычно пороговое напряжение транзистора n-типа имеет положительное значение, а транзистора p-типа имеет отрицательное значение, поэтому пороговое напряжение переключения обычно находится в диапазоне от 0 В до 9 В. 0565 В
ДД . Однако в нашей работе как MoS 2 FET, так и WSe 2 FET имеют отрицательные пороговые напряжения. Соответственно уравнения
0565 В
ДД . Однако в нашей работе как MoS 2 FET, так и WSe 2 FET имеют отрицательные пороговые напряжения. Соответственно уравнения
Электрические свойства инвертора TMD. (a) Характеристики передачи напряжения и (b) кривая усиления для дополнительного инвертора MoS 2 /WSe 2 при различных управляющих напряжениях ( В ДД ).
Изображение в полный размер
$$ {V}_{\mathrm{M}}=\frac{V_{\mathrm{Tn}}+\sqrt{\frac{k_p}{k_n}}\;\left( {V} _ {\ mathrm {DD}} + {V} _ {\ mathrm {Tp}} \ right)} {1+ \ sqrt {\ frac {k_p} {k_n}}}, \; {k} _ {n, \; p} = {\ left (\ frac {W} {L} \ right)} _ {n, \; p} {\ mu} _ {n, \; p} {C} _ {\ mathrm{ox}} $$
(1)
может применяться там, где В
Тн и В
Tp — пороговое напряжение n-FET и p-FET соответственно, W — ширина канала, L — длина канала, μ — подвижность полевого транзистора, C
ox — емкость оксида на единицу площади.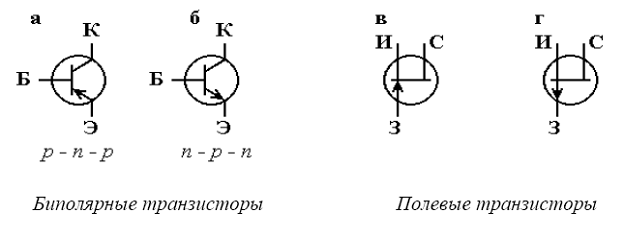 Таким образом, пороговое напряжение переключения рассчитывается как -7,10, -6,37 и -5,64 В при В
DD = 1, 2 и 3 В соответственно. Положительный сдвиг на кривой передачи напряжения обусловлен сдвигом порогового напряжения переключения, что также продемонстрировано на рисунке 4a.
Таким образом, пороговое напряжение переключения рассчитывается как -7,10, -6,37 и -5,64 В при В
DD = 1, 2 и 3 В соответственно. Положительный сдвиг на кривой передачи напряжения обусловлен сдвигом порогового напряжения переключения, что также продемонстрировано на рисунке 4a.
При изменении управляющего напряжения инвертора пиковое усиление также изменяется (рис. 4b). Устройство имело тенденцию показывать более высокое значение усиления по мере увеличения управляющего напряжения. Также пиковое усиление появилось при более высоком входном напряжении вместе с увеличением В DD от 1 до 3 В. Такие явления совпадают с хорошо известными рабочими характеристиками КМОП-инвертора.
Электрические свойства инвертора TMD CMOS, показанного на рисунке 4, хуже, чем на рисунке 3. Такое ухудшение в основном вызвано воздействием окружающей среды, которое часто наблюдается в транзисторах TMD [18]. Поскольку электрические характеристики при различном питающем напряжении измерялись после нескольких дней изготовления устройства, влага из окружающей среды могла поглощаться поверхностью канала. Равномерная герметизация конструкции инвертора сведет к минимуму воздействие окружающей среды и сохранит его свойства в условиях окружающей среды.
Равномерная герметизация конструкции инвертора сведет к минимуму воздействие окружающей среды и сохранит его свойства в условиях окружающей среды.
Выводы
Таким образом, мы изготовили КМОП-инвертор, используя полевой транзистор MoS 2 n-типа и полевой транзистор WSe 2 p-типа для достижения коэффициента усиления 13,7. Устройство явно работает как логический инвертор, преобразуя низкое входное напряжение в высокое выходное напряжение и наоборот . Рабочий диапазон, наблюдаемый в отрицательной области, обусловлен отрицательным пороговым напряжением n-FET. Считается, что этот результат имеет смысл, поскольку в дополнительном инверторе для каналов использовались два разных материала TMD, и он демонстрирует относительно высокие характеристики по сравнению с устройствами на основе других 2D-материалов, о которых сообщалось ранее. Этот результат обеспечит шаг вперед к изготовлению логических схем с использованием материалов TMD в качестве устройства генерации пост-Si.
Ссылки
-
Кастро Нето А.Х., Гвинея Ф., Перес ЯМР, Новоселов К.С., Гейм А.К. Электронные свойства графена. Ред. Мод. физ. 2009; 81: 109–62.
Артикул Google Scholar
-
Хсу П-Л. Выбор диэлектрика затвора для транзисторов на основе графена. Магистерская диссертация. Кембридж: Массачусетский технологический институт, факультет электротехники и информатики; 2008.
Google Scholar
-
Гейм А.К., Новоселов К.С. Расцвет графена. Нат Матер. 2007; 6: 183–91.
Артикул Google Scholar
-
Ван ЗМ. MoS 2 материалы, физика и устройства. Нью-Йорк: Спрингер; 2014.
Google Scholar
-
Радисавлевич Б.
 , Уитвик М.Б., Кис А. Интегральные схемы и логические операции на основе однослойного MoS 2 . АСУ НАНО. 2011;5:9934–8.
, Уитвик М.Б., Кис А. Интегральные схемы и логические операции на основе однослойного MoS 2 . АСУ НАНО. 2011;5:9934–8. Артикул Google Scholar
-
Радисавлевич Б., Раденович А., Бривио Дж., Джакометти В., Кис А. Однослойные транзисторы MoS 2 . Нац Нанотехнолог. 2011; 6: 147–50.
Артикул Google Scholar
-
Fang H, Chuang S, Chang TC, Takei K, Takahashi T, Javey A. Высокоэффективные однослойные полевые транзисторы WSe 2 p-FET с химически легированными контактами. Нано Летт. 2012;12:3788–92.
Артикул Google Scholar
-
Бейкер Р.Дж. Разработка схемы КМОП, компоновка и моделирование. Лондон: Wiley-Interscience; 2005.
Google Scholar
- «>
Huang J, Somu S, Busnaina A. Гетерогенный комплементарный инвертор дисульфид молибдена/углеродных нанотрубок. Нанотехнологии. 2012; 23:1–5.
Артикул Google Scholar
-
Yu WJ, Li Z, Zhou H, Chen Y, Wang Y, Huang Y и др. Вертикально расположенные мультигетероструктуры из слоистых материалов для логических транзисторов и комплементарных инверторов. Нат Мат. 2013;12:246–52.
Артикул Google Scholar
-
Liu H, Neal AT, Zhu Z, Luo Z, Xu X, Tomanek D, et al. Фосфорен: неисследованный двумерный полупроводник с высокой подвижностью дырок. АКС Нано. 2014;8:4033–41.
Артикул Google Scholar
-
Тосун М., Чуанг С., Фанг Х., Сашид А.Б., Хеттик М., Лин И и др. Инверторы с высоким коэффициентом усиления на комплементарных полевых транзисторах WSe 2 .
 АКС Нано. 2014; 8: 4948–53.
АКС Нано. 2014; 8: 4948–53. Артикул Google Scholar
-
Das S, Dubey M, Roelofs A. Полностью комплиментарный логический инвертор с высоким коэффициентом усиления и низким уровнем шума на основе двухслойных полевых транзисторов WSe 2 . Appl Phys Lett. 2014;105:083511.
Артикул Google Scholar
-
Линь И-Ф, Сюй И, Ван С-Т, Ли С-Л, Ямамото М, Апаресидо-Феррейра А и др. Амбиполярные транзисторы MoTe 2 и их применение в логических схемах. Adv мат. 2014;26:3263–9.
Артикул Google Scholar
-
Буддхараджу К.Д., Сингх Н., Фустаги С.К., Тео ШГ, Ло Г.К., Баласубраманиан Н. и др. Si-nanowire CMOS инверторная логика, изготовленная с использованием вентильных устройств и нисходящего подхода. Твердотельный электрон. 2008; 52:1312–7.

Артикул Google Scholar
-
Баркинья П., Мартинс Р., Перейра Л., Фортунато Э. Электроника на прозрачном оксиде: от материалов к устройствам. Лондон: Уайли; 2012.
Книга Google Scholar
-
Meijer EJ, De Leeuw DM, Setayesh S, Van Veenendaal E, Huisman B-H, Blom PWM и др. Обработанные раствором амбиполярные органические полевые транзисторы и инверторы. Нат Мат. 2003; 2: 678–82.
Артикул Google Scholar
-
Late DJ, Liu B, Ramakrishna Matte HSS, Dravid VP, Rao CNR. Гистерезис в однослойных полевых транзисторах MoS 2 . АСУ НАНО. 2012;6:5635–41.
Артикул Google Scholar
Ссылки для загрузки
Благодарности
Это исследование было поддержано MSIP (Министерство науки, ИКТ и планирования будущего) Кореи в рамках «Творческой программы IT Consilience» (NIPA-2014-H0201-14-1002). ) под контролем NIPA (Национальное агентство по продвижению ИТ-индустрии).
) под контролем NIPA (Национальное агентство по продвижению ИТ-индустрии).
Информация об авторе
Авторы и организации
-
Школа интегрированных технологий Университета Йонсей, 85 Сонгдогуахак-ро, Инчхон, 406-840, Корея of Convergence Technology, 85 Songdoguahak-ro, Incheon, 406-840, Korea
Ah-Jin Cho & Jang-Yeon Kwon
-
Факультет электронной инженерии, Konkuk University, 120 Neungdong-ro, Seoul, 143-701, Корея
Kee Chan Park
Авторы
- Ah-Jin Cho
Посмотреть публикации автора
Вы также можете искать этого автора в PubMed Google Scholar
- Kee Chan Park
Просмотр публикаций автора
Вы также можете искать этого автора в PubMed Google Scholar
- Jang-Yeon Kwon
Просмотр публикаций автора
Вы также можете искать этого автора в PubMed Google Академия
Автор, ответственный за переписку
Чан-Ён Квон.
Дополнительная информация
Конкурирующие интересы
Авторы заявляют об отсутствии конкурирующих интересов.
Участие авторов
Компания A-JC провела эксперименты по изготовлению инвертора TMD CMOS и электрические измерения устройства. A-CC также подготовил рукопись. KCP предоставил анализ результирующих электрических характеристик нашего устройства. J-YK руководил работой и рецензировал рукопись. Все авторы прочитали и одобрили окончательный вариант рукописи.
Права и разрешения
Открытый доступ Эта статья находится под лицензией Creative Commons Attribution 4.0 International License, которая разрешает использование, совместное использование, адаптацию, распространение и воспроизведение на любом носителе или в любом формате при условии, что вы укажете соответствующую ссылку на оригинальный автор(ы) и источник, предоставьте ссылку на лицензию Creative Commons и укажите, были ли внесены изменения.
Изображения или другие сторонние материалы в этой статье включены в лицензию Creative Commons на эту статью, если иное не указано в кредитной строке материала.

 пункт речной дистанц..
пункт речной дистанц..