Что такое крутизна характеристики полевого транзистора. Как измерить основные параметры полевых транзисторов. Какие схемы используются для измерения крутизны и других характеристик. Какие особенности нужно учитывать при работе с полевыми транзисторами.
Основные параметры полевых транзисторов
К основным параметрам полевых транзисторов относятся:
- Начальный ток стока IСнач
- Напряжение отсечки Uзиотс
- Крутизна характеристики S
Рассмотрим подробнее каждый из этих параметров:
Начальный ток стока
Начальный ток стока IСнач — это ток стока при нулевом напряжении на затворе. Данный параметр характерен для транзисторов с затвором на основе p-n перехода или с изолированным затвором и встроенным каналом.
Напряжение отсечки
Напряжение отсечки Uзиотс — это напряжение на затворе, при котором ток стока достигает близкого к нулю значения. Фактически это то напряжение, при котором канал транзистора полностью перекрывается.

Крутизна характеристики
Крутизна характеристики S определяется как отношение изменения тока стока ΔIС к вызвавшему его изменению напряжения между затвором и истоком ΔUзи:
S = ΔIС / ΔUзи
Единица измерения крутизны — мА/В (миллиампер на вольт).
Измерение параметров полевых транзисторов
Для измерения основных параметров полевых транзисторов можно использовать специальные приборы или собрать измерительную схему самостоятельно. Рассмотрим основные принципы измерения:
Схема для измерения параметров
Простейшая схема для измерения параметров полевого транзистора включает:
- Источник напряжения для подачи напряжения на затвор
- Амперметр для измерения тока стока
- Вольтметр для измерения напряжения затвор-исток
Изменяя напряжение на затворе и контролируя ток стока, можно определить все основные параметры транзистора.
Методика измерений
Измерение параметров полевого транзистора выполняется в следующей последовательности:
- Установить нулевое напряжение на затворе и измерить начальный ток стока IСнач
- Постепенно увеличивать напряжение на затворе до момента, когда ток стока станет близким к нулю. Это напряжение и будет напряжением отсечки Uзиотс
- Для определения крутизны измерить ток стока при двух близких значениях напряжения затвор-исток и рассчитать отношение приращения тока к приращению напряжения
Особенности измерения крутизны характеристики
При измерении крутизны характеристики полевого транзистора необходимо учитывать следующие особенности:
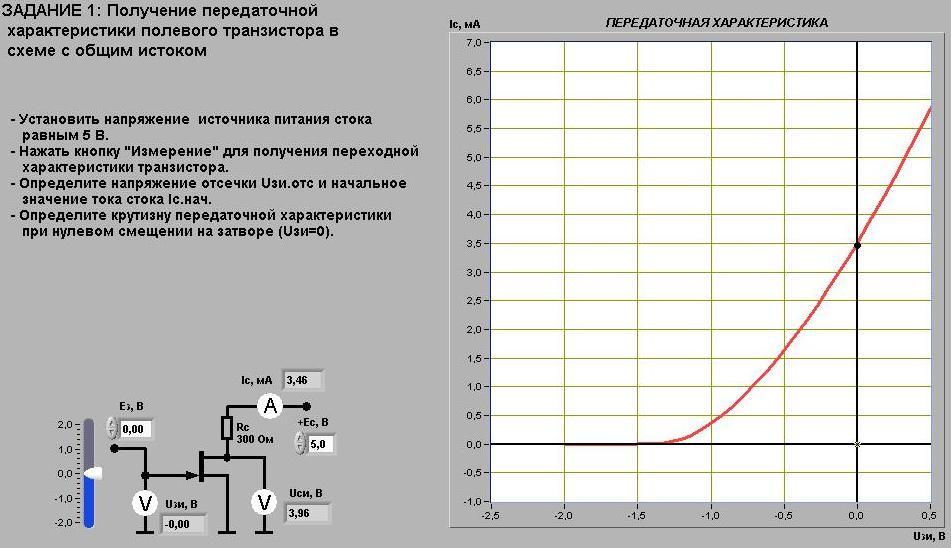
Зависимость от режима работы
Крутизна S полевого транзистора с управляющим p-n переходом зависит от напряжения затвор-исток Uзи. Максимальное значение Smax достигается при нулевом напряжении на затворе.
Расчет крутизны
Если измерены значения начального тока стока IСнач и напряжения отсечки Uзиотс, крутизну можно приблизительно оценить по формулам:
Smax = 2IСнач / Uзиотс
S = √(IСнач · Ic) / Uзиотс
Где напряжение — в вольтах, ток — в миллиамперах, крутизна — в мА/В.
Особенности для разных типов транзисторов
Для транзисторов с изолированным затвором крутизну при токе стока Ic и напряжении Uзи можно рассчитать по формуле:
S = 2Ic / |Uзи — Uзиотс|
Где Uзиотс — напряжение отсечки либо пороговое напряжение (для транзисторов с индуцированным затвором).
Прибор для измерения параметров полевых транзисторов
Для оперативного измерения основных параметров полевых транзисторов и контроля их работоспособности можно собрать специализированный прибор. Рассмотрим основные характеристики такого измерителя:

Технические характеристики
- Диапазон измеряемого напряжения на затворе: -12…+12 В
- Разрешающая способность вольтметра: 10 мВ
- Диапазон измеряемого тока стока: -20…+20 мА
- Разрешающая способность миллиамперметра: 10 мкА
- Погрешность измерения IСнач и Uзи: не более 1%
- Ток потребления прибора: не более 60 мА
Основные узлы прибора
Прибор для измерения параметров полевых транзисторов включает следующие основные узлы:
- Источник двухполярного питания ±12 В
- Переменный резистор для изменения напряжения на затворе
- Цифровой вольтметр для измерения напряжения затвор-исток
- Цифровой миллиамперметр для измерения тока стока
- Схему защиты измеряемого транзистора
- Переключатель полярности напряжения на стоке
Особенности конструкции измерителя параметров
При разработке и изготовлении прибора для измерения параметров полевых транзисторов следует учитывать ряд важных особенностей:
Выбор элементной базы
Для обеспечения высокой точности измерений рекомендуется использовать следующие компоненты:
- Резисторы с допуском не более ±0,5% для измерительных цепей
- Многооборотный переменный резистор для точной регулировки напряжения на затворе
- Прецизионные операционные усилители в измерительных схемах
- Стабилизаторы напряжения для питания измерительных узлов
Защита измеряемых транзисторов
Полевые транзисторы чувствительны к статическому электричеству, поэтому в приборе необходимо предусмотреть схему защиты:
- Реле для замыкания выводов транзистора на общий провод в режиме ожидания
- Ограничитель тока в измерительных цепях
- Защитные диоды на входах измерительных схем
Конструктивные особенности
При разработке конструкции прибора следует обратить внимание на следующие моменты:
- Экранирование измерительных цепей для уменьшения наводок
- Качественное заземление корпуса прибора
- Удобное расположение органов управления и индикации
- Возможность быстрой замены измеряемых транзисторов
Применение измерителя параметров полевых транзисторов
Прибор для измерения параметров полевых транзисторов может найти широкое применение в различных областях:
Ремонт электронной аппаратуры
При ремонте контрольно-измерительных приборов, усилителей, источников питания и другой аппаратуры часто возникает необходимость проверки полевых транзисторов. Измеритель параметров позволяет быстро определить исправность транзистора и его основные характеристики.
Входной контроль компонентов
На производстве электронной аппаратуры важно контролировать параметры используемых компонентов. Измеритель позволяет проводить входной контроль партий полевых транзисторов и отбраковывать элементы с отклонениями характеристик.
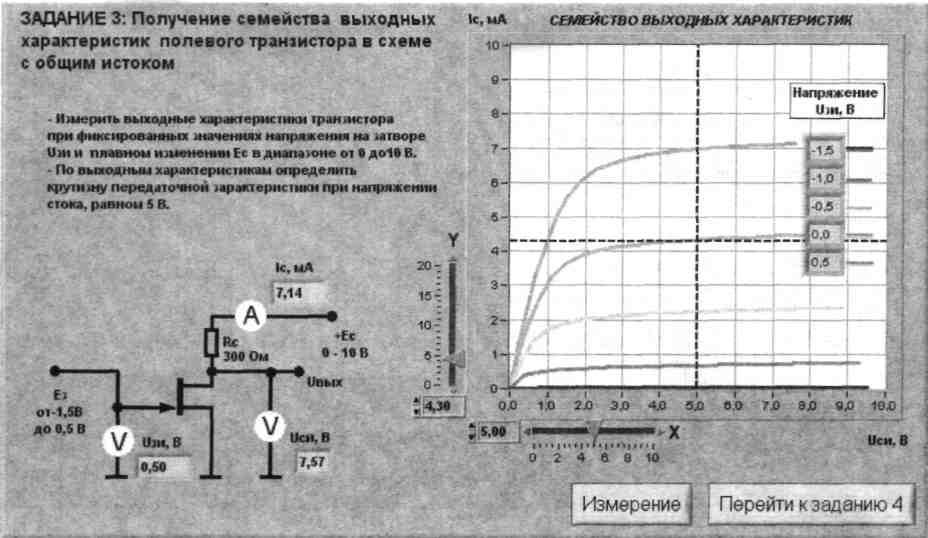
Подбор пар транзисторов
В дифференциальных каскадах и других схемах часто требуется использовать согласованные пары транзисторов с близкими параметрами. Измеритель позволяет быстро подобрать транзисторы с максимально близкими характеристиками.
Исследование характеристик транзисторов
При разработке новых электронных устройств часто возникает необходимость детального исследования характеристик используемых транзисторов. Измеритель параметров позволяет снять основные характеристики и построить графики зависимостей.
Заключение
Измерение параметров полевых транзисторов — важная задача при разработке, производстве и ремонте электронной аппаратуры. Знание основных характеристик транзисторов и методов их измерения позволяет грамотно подбирать компоненты и обеспечивать надежную работу электронных устройств.
Прибор для измерения параметров полевых транзисторов — полезный инструмент, который найдет применение в лабораториях, на производстве и в ремонтных мастерских. При его разработке важно обеспечить высокую точность измерений и удобство использования.

Развитие элементной базы и измерительных технологий позволяет создавать все более совершенные приборы для исследования полупроводниковых компонентов. Это открывает новые возможности для разработки инновационных электронных устройств с улучшенными характеристиками.
Крутизна характеристики транзистора
Как видим, максимальная величина крутизны проходной характеристики каскада S является условием получения усиления по току и напряжению. Полученные соотношения будут использованы при анализе конкретных схем усилительных каскадов. Усиление сигнала при преобразовании зависит от крутизны проходной характеристики транзистора лампы в режиме преобразования — крутизны преобразования Snp. При расчете преобразователей на электронных лампах, имеющих ярко выраженный максимум крутизны проходной характеристики , за 5 акс при расчетах принимают значение крутизны характеристики, указанное в справочных данных.
Поиск данных по Вашему запросу:
Крутизна характеристики транзистора
Схемы, справочники, даташиты:
Прайс-листы, цены:
Обсуждения, статьи, мануалы:
Дождитесь окончания поиска во всех базах.
По завершению появится ссылка для доступа к найденным материалам.

Содержание:
- 2.5. Параметры полевых транзисторов с управляющим p-n переходом
- ОСНОВНЫЕ ПАРАМЕТРЫ ПОЛЕВОГО ТРАНЗИСТОРА
- Вы точно человек?
- Основы устройства и применения силовых МОП-транзисторов (MOSFET)
- Транзистор КП901А
- Малосигнальные параметры
- Исследование статических характеристик полевых транзисторов с управляющим р-n переходом
- Характеристики и параметры полевого транзистора — схемы включения, ВАХ
- Транзистор КП302АМ
ПОСМОТРИТЕ ВИДЕО ПО ТЕМЕ: Лекция 82. Полевой транзистор.
Полевой транзистор.
2.5. Параметры полевых транзисторов с управляющим p-n переходом
О компании Реквизиты Сотрудники Вакансии. Информация Сертификаты Вопрос-ответ Справочники. Общие положения Оплата и доставка Гарантия на товар Заказать товар. КПАМ Купить: Задать вопрос. Предназначены для применения в широкополосных усилителях в диапазоне частот до МГц, а также в переключающих и коммутирующих устройствах. Выпускаются в металлостеклянном корпусе с гибкими выводами.
Тип прибора указывается на корпусе. Масса транзистора не более 1,5 г. Тип корпуса: КТ ТО Технические условия: ЖК3. Напряжение между затвором и истоком транзистора с p-n переходом или с изолированным затвором, работающего в режиме обеднения, при котором ток стока достигает заданного низкого значения. Ток затвора при заданном напряжении между затвором и остальными выводами, замкнутыми между собой.
Отношение изменения тока стока к изменению напряжения на затворе при коротком замыкании по переменному току на выходе транзистора в схеме с общим истоком. Ток стока при напряжении между затвором и истоком, равном нулю, и при напряжении на стоке, равном или превышающем напряжение насыщения.
Емкость между затвором и истоком при коротком замыкании по переменному току на выходе с общим истоком. Емкость между затвором и стоком при коротком замыкании по переменному току на входе в схеме с общим истоком.
Компания «Электроника и связь» eandc.
ОСНОВНЫЕ ПАРАМЕТРЫ ПОЛЕВОГО ТРАНЗИСТОРА
Параметры полевых транзисторов определяются из связи между выходным током — током стока и напряжениями затвор-исток, сток-исток:. Из функционального уравнения 9 получаем дифференциальное уравнение в частных производных вида. Э ффективность управляющего действия затвора в полевых транзисторах оценивается крутизной сток-затворной характеристики. Крутизна характеристики S показывает, на сколько миллиампер изменяется величина тока стока при изменении напряжения на затворе на один вольт. При определении крутизны S напряжение сток-исток должно оставаться постоянным. Графически величина S соответствует крутизне сток-затворной характеристики, то есть наклону касательной в заданной точке сток-затворной характеристики.
При определении крутизны S напряжение сток-исток должно оставаться постоянным. Графически величина S соответствует крутизне сток-затворной характеристики, то есть наклону касательной в заданной точке сток-затворной характеристики.
(ОЭ) (рис. ). Характеристики транзисторов измеряются как при стандартной крутизна (проводимость прямой передачи при коротком замыкании по.
Вы точно человек?
Рассматриваются различные типы и страктуры МОП-транзисторов, технологии их изготовления. Также приводятся основные способы и принципы применения МОП-транзисторов в силовых устройствах. На рис. На примере этой структуры можно уяснить основной принцип работы МОП-транзистора. На приведенной характеристике указан уровень напряжения V T , при котором формируется канал. Этот факт определяет существование такой важной характеристики МОП-транзистора, как крутизна. Четвертый электрод на условном обозначении транзистора рис. Для быстрого выключения транзистора требуется значительный импульс базового тока противоположной полярности. Биполярные транзисторы отличаются температурной нестабильностью.
Биполярные транзисторы отличаются температурной нестабильностью.
Основы устройства и применения силовых МОП-транзисторов (MOSFET)
Полевой транзистор с управляющим p-n-переходом ПТУП — это полевой транзистор, затвор которого отделен в электрическом отношении от канала p-n — переходом, смещенным в обратном направлении рис. При подключении к истоку отрицательного для n-канала , а к стоку положительного напряжения в канале возникает электрический ток, создаваемый движением электронов от истока к стоку, то есть основными носителями заряда. В этом заключается существенное отличие полевого транзистора от биполярного. Это напряжение называется напряжением затвор-исток отсечки U зи отс. Канал в этом случае будет иметь вид, показанный на рис.
Задача: Одной из наиболее важных характеристик определяющих быстродействаие МОП-транзистора является крутизна характеристики.
Транзистор КП901А
Скачать файл: referat. Схемы включения полевого транзистора. Эквивалентная схема полевого транзистора.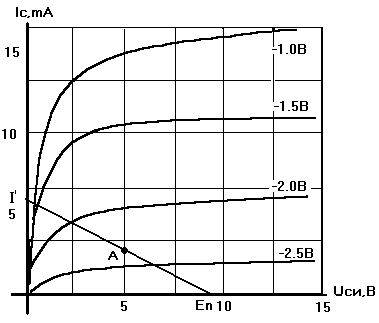 Параметры полевого транзистора. Действие транзистора можно сравнить с действием плотины.
Параметры полевого транзистора. Действие транзистора можно сравнить с действием плотины.
Малосигнальные параметры
Войдите , пожалуйста. Хабр Geektimes Тостер Мой круг Фрилансим. Войти Регистрация. Полевые транзисторы. For dummies Электроника для начинающих Введение А теперь давайте поговорим о полевых транзисторах. Что можно предположить уже по одному их названию?
Выходные характеристики полевого транзистора с управляющим . Удельная крутизна характеристики МОП-транзистора определяется выражением.
Исследование статических характеристик полевых транзисторов с управляющим р-n переходом
Крутизна характеристики транзистора
Прибор для проверки основных параметров маломощных полевых транзисторов выполнен на основе недорогих цифровых мультиметров, возможно, даже с неисправными переключателями пределов измерения. Это минимизировало затраты труда по монтажу и изготовлению конструкции. Цифровые показания несколько облегчают сравнение транзисторов и подбор пар для дифференциальных каскадов.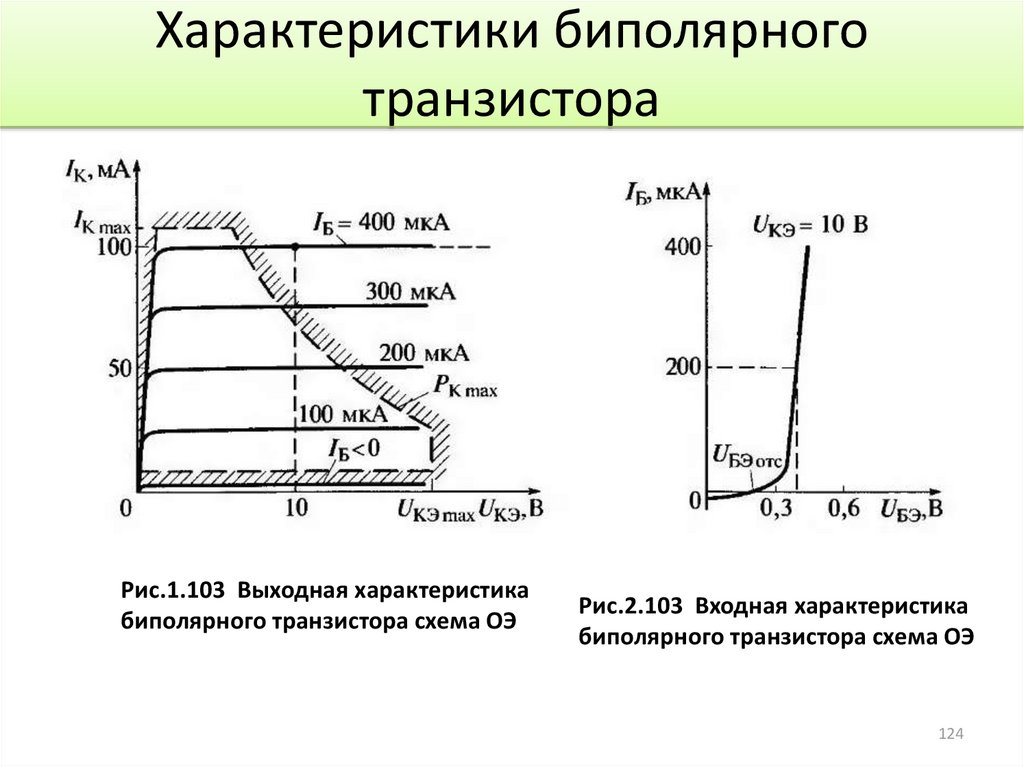
Характеристики и параметры полевого транзистора — схемы включения, ВАХ
ВИДЕО ПО ТЕМЕ: Характеристики транзистора (Транзистор- это просто 17)
Снятие статических характеристик полевого транзистора с р — n переходом. Изучение полевых транзисторов с n и p каналом, снятие статических выходных характеристик и сток-затворную характеристику. Исследовать влияние сопротивления нагрузки на сток-затворную характеристику и коэффициент усиления напряжения. Полевым транзистором называется полупроводниковый прибор, в котором ток через канал управляется электрическим полем, возникающим при подаче напряжения между затвором и истоком.
Примерный вид нескольких характеристик из серии I с U зи U си показан на рис. Напряжение U зи , при котором ток стока становится равным нулю, называют напряжением отсечки U зи.
Транзистор КП302АМ
В общем случае крутизна реальных приборов и устройств зависит от величины выходного тока и, соответственно, от управляющего напряжения. Входной и выходной импедансы ИТУН равны бесконечности, это означает, что при любом входном напряжении входной ток равен нулю и выходной ток не зависит от напряжения на выходе. Поэтому крутизна транзистора пропорциональна эффективному управляющему напряжению:. Фактическая крутизна маломощных дискретных транзисторов измеряется единицами или десятками мСм 2. Последняя, в свою очередь, убывает с ростом температуры кристалла. Относительный коэффициент крутизны p-канальных приборов примерно в 2…3 раза ниже из-за меньшей подвижности носителей заряда в канале [9].
Входной и выходной импедансы ИТУН равны бесконечности, это означает, что при любом входном напряжении входной ток равен нулю и выходной ток не зависит от напряжения на выходе. Поэтому крутизна транзистора пропорциональна эффективному управляющему напряжению:. Фактическая крутизна маломощных дискретных транзисторов измеряется единицами или десятками мСм 2. Последняя, в свою очередь, убывает с ростом температуры кристалла. Относительный коэффициент крутизны p-канальных приборов примерно в 2…3 раза ниже из-за меньшей подвижности носителей заряда в канале [9].
Полевые транзисторы в практике начинающих радиолюбителей. Думаю, начинающие радиолюбители оценят это. С другой стороны прибор В.
Крутизна характеристики полевого транзистора — определение термина
Термин и определение
отношение изменения тока стока к изменению напряжения на затворе при коротком замыкании по переменному току на выходе транзистора в схеме с общим истоком.
Еще термины по предмету «Электроника, электротехника, радиотехника»
Разрядник вентильный (Valve-typc arrester)
вентильный разрядник; устройство для замыкания электрических цепей, предназначенное для защиты электрооборудования сетей переменного тока от различных перенапряжений; представляет собой ряд искровых промежутков, последовательно с которыми включены резисторы, сопротивление которых зависит от напряжения.
Режим ведомой работы (Slave operation)
режим работы регулируемых источников питания, который достигается координацией параметров взаимосвязанных по управлению источников питания, один из которых настраивается на работу в качестве «ведущего» источника.
Рекуперирующее плечо (Regenerativc arm)
вспомогательное вентильное плeчo, предназначенное для передачи части энерrии от нагрузки в источник.
Похожие
- Полевой транзистор
- Крутизна характеристики по подложке
- Время включения полевого транзистора
- Время выключения полевого транзистора
- Время нарастания для полевого транзистора
- Время спада для полевого транзистора
- Входная емкость полевого транзистора
- Выходная емкость полевого транзистора
- Коэффициент шума полевого транзистора
- Напряжение отсечки полевого транзистора
- Полевой (униполярный, канальный) транзистор
- Полевой транзистор с изолированным затвором
- Пороговое напряжение полевого транзистора
- Проходная емкость полевого транзистора
- Шумовое напряжение полевого транзистора
- Шумовое сопротивление полевого транзистора
- Шумовой ток полевого транзистора
- Крутизна характеристики (Forward transcondunctance)
- Время задержки включения полевого транзистора
- Время задержки выключения полевого транзистора
Смотреть больше терминов
Научные статьи на тему «Крутизна характеристики полевого транзистора»
— это схема на полевом транзисторе, в которой стандартное напряжение снимается с резистора в цепи истока. ..
..
по напряжению рассчитывается по следующей формуле:
$К = (S*rds*Rl) / ((rds+Rl)*(1+S*rds))$
где: S — крутизна…
транзистора; rds — внутреннее сопротивление канала транзистора в активном режиме….
с максимальной крутизной (то есть быть близкой к нулю)….
Крутизна передаточной характеристики в рабочей точке рассматриваемого повторителя рассчитывается по формуле
Статья от экспертов
Представлена разработка прибора на базе микроконтроллера для измерения крутизны маломощных полевых транзисторов. Приведены структурная схема, принципиальная электрическая схема, а также алгоритм работы прибора. Дана принципиальная схема блока питания устройства и его нагрузочные характеристики. Результаты измерения крутизны полевых транзисторов различных типов представлены в виде таблицы.
Научный журнал
Creative Commons
Рассмотрены управляемые аттенюаторы поглощающего типа на полевых транзисторах с затвором Шоттки: Т-образная, Т-образная мостовая схемы и аттенюатор на транзисторе в режиме с управляемой крутизной вольтамперной характеристики. Проведено моделирование фазочастотных характеристик аттенюаторов. Главное отличие схем от ранее известных заключается в введении корректирующих цепей, что обуславливает широкополосность и больший диапазон вносимых ослаблений с минимумом фазового сдвига при регулировании….
Проведено моделирование фазочастотных характеристик аттенюаторов. Главное отличие схем от ранее известных заключается в введении корректирующих цепей, что обуславливает широкополосность и больший диапазон вносимых ослаблений с минимумом фазового сдвига при регулировании….
Научный журнал
Creative Commons
Повышай знания с онлайн-тренажером от Автор24!
- 📝 Напиши термин
- ✍️ Выбери определение из предложенных или загрузи свое
- 🤝 Тренажер от Автор24 поможет тебе выучить термины, с помощью удобных и приятных карточек
Возможность создать свои термины в разработке
Еще чуть-чуть и ты сможешь писать определения на платформе Автор24. Укажи почту и мы пришлем уведомление с обновлением ☺️
Измерение параметров полевых транзисторов — RadioRadar
Прибор для проверки основных параметров маломощных полевых транзисторов выполнен на основе недорогих цифровых мультиметров, возможно, даже с неисправными переключателями пределов измерения. Это минимизировало затраты труда по монтажу и изготовлению конструкции. Цифровые показания несколько облегчают сравнение транзисторов и подбор пар для дифференциальных каскадов. Крутизну транзисторов определяют простейшим расчетом.
Это минимизировало затраты труда по монтажу и изготовлению конструкции. Цифровые показания несколько облегчают сравнение транзисторов и подбор пар для дифференциальных каскадов. Крутизну транзисторов определяют простейшим расчетом.
По роду своей деятельности мне часто приходится ремонтировать контрольно-измерительную аппаратуру с полевыми транзисторами. Они применяются в модуляторах, входных каскадах усилителей в осциллографах и цифровых вольтметрах, коммутационных устройствах и пр. Например, в вольтметре В7-38 установлено около 30 транзисторов серии КП301. Эти транзисторы очень чувствительны к статическому электричеству, и малейшее несоблюдение технологии монтажа приводит к выходу их из строя. Большинство неисправностей приборов, которые связаны с выходом из строя полевых транзисторов, удается устранить простой заменой, но если транзисторы используют в дифференциальных или «симметричных» каскадах, их необходимо подобрать по основным параметрам.
Рис. 1
К основным параметрам полевых транзисторов относятся начальный ток стока, напряжение отсечки и крутизна характеристики.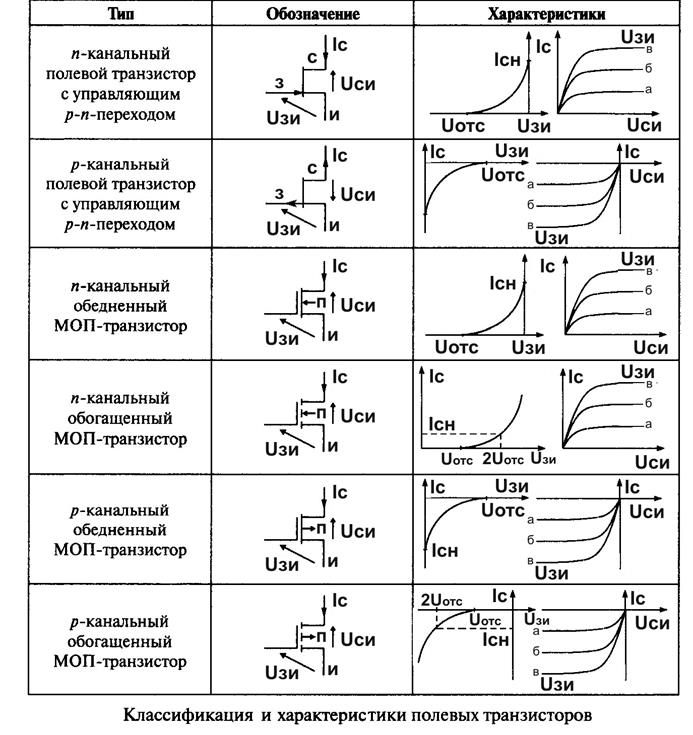 Определить их, а следовательно, и принять решение о пригодности полевого транзистора к использованию возможно с помощью устройства, схема которого изображена на рис. 1. Изменяя напряжение на затворе и контролируя ток стока, можно узнать все три основных параметра. Для транзисторов с затвором на основе р-n перехода или с изолированным затвором и встроенным каналом начальный ток стока IСнач — это ток стока при нулевом значении напряжения на затворе. Напряжение отсечки U3иотс — напряжение на затворе, при котором ток стока достигает близкого к нулю значения. Крутизна характеристики определяется как отношение изменения тока стока ΔIС (мА) к вызвавшему его изменению напряжения между затвором и истоком ΔUзи (В): S = ΔIС/Δ U3и- Применив в приборе цифровые измерители тока и напряжения, вычислить значение крутизны для транзисторов любой структуры будет несложно.
Определить их, а следовательно, и принять решение о пригодности полевого транзистора к использованию возможно с помощью устройства, схема которого изображена на рис. 1. Изменяя напряжение на затворе и контролируя ток стока, можно узнать все три основных параметра. Для транзисторов с затвором на основе р-n перехода или с изолированным затвором и встроенным каналом начальный ток стока IСнач — это ток стока при нулевом значении напряжения на затворе. Напряжение отсечки U3иотс — напряжение на затворе, при котором ток стока достигает близкого к нулю значения. Крутизна характеристики определяется как отношение изменения тока стока ΔIС (мА) к вызвавшему его изменению напряжения между затвором и истоком ΔUзи (В): S = ΔIС/Δ U3и- Применив в приборе цифровые измерители тока и напряжения, вычислить значение крутизны для транзисторов любой структуры будет несложно.
Крутизна S полевого транзистора с управляющим р-n переходом зависит от напряжения затвор- исток U3и и имеет максимальное значение Smax при напряжении на затворе, равном нулю. Если измерены значения начального тока стока IСнач и напряжения отсечки U3иотс. крутизну можно приблизительно оценить по формулам:
Если измерены значения начального тока стока IСнач и напряжения отсечки U3иотс. крутизну можно приблизительно оценить по формулам:
Smax = 2Iснач/Uзиотс
S = √Iснач·Ic/Uзиотс
где напряжение — в вольтах, ток — в миллиамперах, крутизна — в размерности мА/В [1].
Для транзисторов с изолированным затвором крутизну при токе стока Ic и напряжении Uзи можно рассчитать по формуле
S = 2Ic/|Uзи — Uзиотс|
где UЗИотс — напряжение отсечки либо пороговое напряжение (для транзисторов с индуцированным затвором).
На основе макета этого устройства изготовлен прибор для оперативного измерения основных параметров полевых транзисторов и контроля их работоспособности.
Технические характеристики
Измеряемое напряжение на затворе, В …………..-12…+12
Разрешающая способность вольтметра, мВ…………….10
Измеряемый ток стока, мА . .-20… +20
Разрешающая способность миллиамперметра, мкА………10
Погрешность измерения IСнач и Uзи, %, не более . ……….1
……….1
Ток потребления прибора, мА, не более ………………60
Рис. 2
В приборе есть защита проверяемого транзистора от повреждения.
Схема измерителя изображена на рис. 2. Для изменения напряжения на затворе транзистора используется переменный резистор R2, подключенный к двухполярному источнику питания 2×12 В, что позволяет получить характеристику крутизны любого полевого транзистора малой мощности как с n-каналом, так и с р-каналом. Резистор R3 необходим для ограничения тока затвора. Полярность напряжения на стоке изменяют переключателем SB1. Для исключения перегрузки миллиамперметра использован ограничитель тока на транзисторе VT1 и резисторе R1. Ограничение возникает при токе 25 мА, поскольку максимальный измеряемый ток выбран равным 20 мА. Диодный мост VD1 обеспечивает действие ограничителя при любом направлении тока стока. Реле К1 и К2 предотвращают выход из строя измеряемого полевого транзистора от статического электричества: пока не нажата кнопка «Измерение» SB2, обмотка реле отключена, а контакты для подключения транзистора замкнуты между собой и на общий провод. При измерении кнопка нажата и через контакты реле транзистор подключен к измерительным цепям. Светодиод HL1 сигнализирует о том, что происходит процесс измерения.
При измерении кнопка нажата и через контакты реле транзистор подключен к измерительным цепям. Светодиод HL1 сигнализирует о том, что происходит процесс измерения.
Главная часть устройства — миллиамперметр РА1 и вольтметр PV1 — собрана из готовых узлов мультиметров M890D. Основа этих мультиметров — широко известная микросхема ICL7106. Эти приборы выбраны из-за удобного большого корпуса, чтобы снизить трудозатраты при изготовлении измерителя параметров. Питание аналого-цифрового преобразователя (АЦП) мульти-метра — от двухполярного источника питания +5/-5 В, необходимого для микросхем АЦП и остальных частей устройства. Микросхема АЦП имеет такую возможность, если мультиметр доработать так, как показано на фрагменте схемы на рис. 3 (нумерация элементов условная).
Рис. 3
В основном включении, используемом при батарейном питании, выводы 30,32 и 35 соединены вместе. При двух-полярном питании вывод 30 (низкоуровневая цепь АЦП) отключают от этой точки. В этом случае микросхема измеряет разность потенциалов между выводами 30 и 31, при этом вход АЦП отвязан от цепей питания. Единственное условие — напряжение в любой из измерительных цепей не должно превышать напряжения питания АЦП относительно общего провода. Такая доработка описана в [2].
Единственное условие — напряжение в любой из измерительных цепей не должно превышать напряжения питания АЦП относительно общего провода. Такая доработка описана в [2].
При минимальных переделках микросхема обеспечивает измерение напряжения до 200 мВ без делителей. Для построения вольтметра с пределом 20 В, необходимого для измерения напряжения затвора, использован делитель 1:100, состоящий из резисторов R5 и R6. Для построения миллиамперметра с пределом измерения 20 мА служит резистор R7. При токе 20 мА на нем падает напряжение 200 мВ, которое и измеряет АЦП. Миллиамперметр установлен в цепь истока и измеряет ток транзистора. Такое решение продиктовано невозможностью измерять ток в цепи стока, потому что на измерительных выводах миллиамперметра может присутствовать напряжение, превышающее питающее для микросхемы АЦП. Вольтметр включен между затвором и истоком, поэтому через делитель R5R6 будет протекать ток с максимальным значением не более 12мкА, что будет вызывать ошибку в показаниях миллиамперметра в одну единицу младшего разряда, которая оказывается несущественной.
Схема блока питания прибора изображена на рис. 4.
Рис. 4
Для понижения сетевого напряжения до 12 В используется трансформатор Т1. Далее переменное напряжение выпрямляется диодным мостом VD1 и фильтруется конденсаторами С1, С2. Стабилизаторами двухполярного напряжения +12/-12В служат микросхемы DA1, DA2. Двухполярное напряжение +5/-5 В стабилизирует микросхемы DA3 и DA4. Стабилизаторы включены последовательно для уменьшения падения напряжения на стабилизаторах DA3 и DA4. Схема двухполярного источника питания может быть любой другой; возможно даже использовать автономное питание, например от батарей «Корунд». Для этого потребуется добавить преобразователь напряжения батареи в необходимое для питания остальных узлов измерителя.
Рис. 5
Детали и конструкция. В приборе можно применить следующие детали. Резисторы R5-R7 — С2-29 или другие с допуском не более ±0,5 %, хотя номиналы могут отличаться от указанных на схеме; главное — стабильность сопротивления. Остальные резисторы — любые, например МЛТ0.125. Переменный резистор R2 — многооборотный, например, РП1-53 или предназначенный для прецизионной регулировки (по гру-боточной схеме) — СП5-35, СП5-40.
Остальные резисторы — любые, например МЛТ0.125. Переменный резистор R2 — многооборотный, например, РП1-53 или предназначенный для прецизионной регулировки (по гру-боточной схеме) — СП5-35, СП5-40.
Если найти такой не удастся, резисторы R2 и R3 можно заменить аналогом — узлом из двух переменных и двух постоянных резисторов, как это сделано в моей конструкции. Схема такого узла изображена на рис. 5. Резистором R1 напряжение устанавливают грубо, a R2 — точно.
Светодиод можно заменить другими, например, из серий АЛ 102, АЛ307, КИПД, лучше красного цвета свечения. Диодные мосты — КЦ407 с любой буквой, вместо них можно применить отдельные кремниевые диоды с допустимым средним током не менее 200 мА в выпрямителе и 100 мА — в ограничителе тока. Для упрощения конструкции применены микросхемы интегральных стабилизаторов 7812, 7912, 7805 и 7905, отечественные аналоги которых — соответственно КР142ЕН8Б, КР1162ЕН12А, КР142ЕН5А и КР1162ЕН5А.
Реле — РЭС60 (исполнение РС4.569. 435-07) или аналогичные с двумя контактными группами на переключение.
435-07) или аналогичные с двумя контактными группами на переключение.
Сетевой трансформатор Т1 -любой, обеспечивающий выходные напряжения 2х 15 В и ток не менее 100 мА, его можно взять из сетевого адаптера мощностью не менее 6 Вт. Вторичную обмотку такого трансформатора перематывают для получения нужного двухполярного напряжения. Трансформатор и выпрямитель размещены в корпусе адаптера, а элементы стабилизатора расположены в корпусе прибора. Прибор соединяется с адаптером трехпроводным кабелем.
Весь измеритель сооран в корпусе одного из мультиметров. При изготовлении прибора мультиметры были вскрыты и после удаления ненужных частей плат объединены в одном корпусе, как показано на рис. 6.
Рис. 6
Лишние детали — резисторы делителя, переключатель и прочее — удаляют (поэтому поводом для изготовления такого прибора может быть неустранимый дефект переключателя подобного мультиметра). Оставляют только часть платы с микросхемой ICL7106, индикатором, элементами «обвязки» микросхемы и индикатора и кнопками включения, которые выполнят роль переключателей SB1, SB2.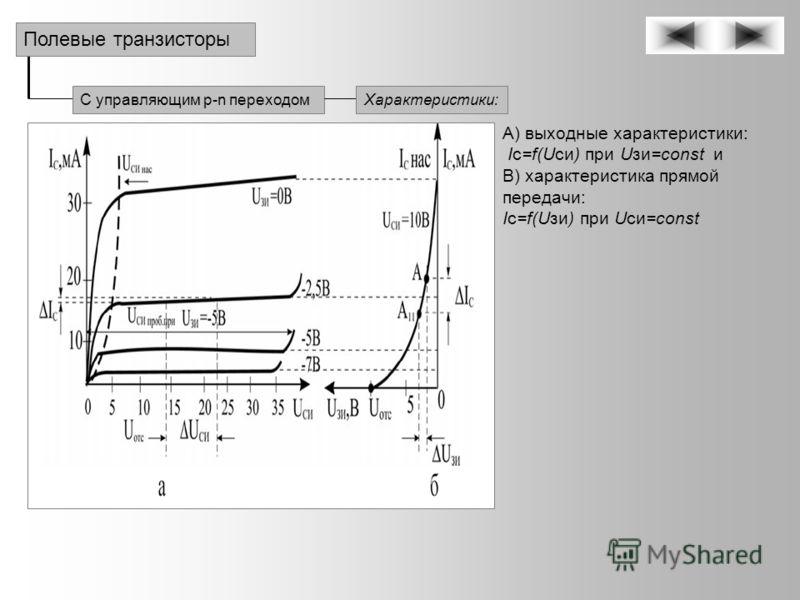 Печатные проводники, идущие к этим переключателям, должны быть обрезаны.
Печатные проводники, идущие к этим переключателям, должны быть обрезаны.
Нижнюю крышку мультиметра обработке не подвергают, а верхнюю придется доработать. У одного прибора крышку спиливают так, чтобы осталась только часть с индикатором и кнопкой. У второго вырезают середину там, где находится переключатель пределов, и на это место вклеивают вырезанную часть конструкции первого прибора. При вырезании частей от верхних крышек сохраняют стойки, в которые ввинчивают винты-саморезы, скрепляющие верхнюю и нижнюю крышки. Сверху, около кнопки, крепят резистор, регулирующий напряжение на затворе. Снизу устанавливают разъем для подключения полевых транзисторов. В качестве разъема использована цанговая панель для микросхем. Середину панели вырезают, и ряд контактов склеивают. Выбор цанговой панели обусловлен высокой износостойкостью.
В моей конструкции применена небольшая плата из фольгированного текстолита, на которой устанавливают панель, светодиод и реле. В свою очередь, плату двумя винтами крепят к лицевой панели. Лишние отверстия на лицевой панели заклеивают вырезанной по размеру пластиной из пластмассы или электрокартона, на которую приклеивают отпечатанную на принтере накладку, ее вид показан на рис. 7.
Лишние отверстия на лицевой панели заклеивают вырезанной по размеру пластиной из пластмассы или электрокартона, на которую приклеивают отпечатанную на принтере накладку, ее вид показан на рис. 7.
Рис. 7
Большинство транзисторов имеют цилиндрический корпус с меткой-ключом для определения выводов. Контакты разъема для подключения полевых транзисторов соединяются между собой согласно назначению таким образом, чтобы у каждого типа транзисторов было свое место без необходимости уточнять цоко-левку. В предлагаемом варианте транзисторы устанавливают ключом вверх. Соединения отдельного вывода корпуса транзисторов с истоком, а второго затвора транзисторов серий КП306, КП350 — со стоком обеспечивают через разъем перемычками между соответствующими гнездами. Внешний вид готового прибора показан на рис. 8.
Рис. 8
Перед первым включением прибора необходимо проверить значения выходных напряжений стабилизатора. Налаживание прибора заключается в настройке ограничителя тока и установке образцовых напряжений миллиамперметра и вольтметра. Для настройки ограничителя надо подключить образцовый миллиамперметр между контактами «С» и «И» разъема для подключения измеряемого транзистора, нажать на кнопку «Измерение» и подобрать резистор R1, добиваясь показаний 25…30 мА. Можно заранее подобрать транзистор по параметру ограничения тока, тогда резистор R1 заменяют перемычкой. Далее образцовый миллиамперметр последовательно с переменным резистором подсоединяют к этим же контактам, устанавливают ток 10 мА и резистором настройки образцового напряжения добиваются тех же показаний миллиамперметра прибора. Для настройки вольтметра образцовый вольтметр подключают к выводам «3» и «И», резистором прибора устанавливают напряжение затвора 10 В и резистором регулировки вольтметра прибора устанавливают те же показания.
Для настройки ограничителя надо подключить образцовый миллиамперметр между контактами «С» и «И» разъема для подключения измеряемого транзистора, нажать на кнопку «Измерение» и подобрать резистор R1, добиваясь показаний 25…30 мА. Можно заранее подобрать транзистор по параметру ограничения тока, тогда резистор R1 заменяют перемычкой. Далее образцовый миллиамперметр последовательно с переменным резистором подсоединяют к этим же контактам, устанавливают ток 10 мА и резистором настройки образцового напряжения добиваются тех же показаний миллиамперметра прибора. Для настройки вольтметра образцовый вольтметр подключают к выводам «3» и «И», резистором прибора устанавливают напряжение затвора 10 В и резистором регулировки вольтметра прибора устанавливают те же показания.
Ввиду того что полевые транзисторы могут выйти из строя из-за статического электричества, может быть рекомендована следующая методика работы с прибором. Перед подключением все выводы полевого транзистора следует замкнуть проволочной перемычкой между собой. На приборе устанавливают тип проводимости канала (п- или р-канал), кнопка «Измерение» отжата. Полевой транзистор подключают к своему гнезду, перемычку с выводов снимают, нажимают на кнопку «Измерение» и контролируют его параметры. После измерения отжать кнопку, замкнуть выводы транзистора между собой и вынуть транзистор из панельки.
На приборе устанавливают тип проводимости канала (п- или р-канал), кнопка «Измерение» отжата. Полевой транзистор подключают к своему гнезду, перемычку с выводов снимают, нажимают на кнопку «Измерение» и контролируют его параметры. После измерения отжать кнопку, замкнуть выводы транзистора между собой и вынуть транзистор из панельки.
С помощью прибора легко диагностировать любой вид неисправности полевых транзисторов. Как показала практика, большинство неисправностей транзисторов сводится к большому току утечки затвора, пробою или обрыву канала либо внутреннему разрыву одного из выводов. Если при нажатии на кнопку «Измерение» напряжение на затворе уменьшится по сравнению с установленным, то имеет место утечка тока с затвора. Показания миллиамперметра не будут нулевыми при любом напряжении на затворе. Во всех других случаях невозможность измерить начальный ток стока и напряжение отсечки говорит о неисправности измеряемого полупроводникового прибора.
ЛИТЕРАТУРА
- Титце У.
 , Шенк К. Полупроводниковая схемотехника. — М.: Мир, 1983.
, Шенк К. Полупроводниковая схемотехника. — М.: Мир, 1983. - Садченков Д. А. Современные цифровые мультиметры. — М.: СОЛОН-Р, 2001.
Автор: В. Андрюшкевич, г. Тула
Патент США на транзисторы с крутым наклоном и пороговыми переключающими устройствами Патент (патент № 11 189 717, выданный 30 ноября 2021 г.) НАКЛОННЫЕ ТРАНЗИСТОРЫ С УСТРОЙСТВАМИ ПОРОГОВОГО ПЕРЕКЛЮЧЕНИЯ», поданной 10 января 2019 г., которая полностью включена в настоящий документ посредством ссылки.
ЗАЯВЛЕНИЕ О ГОСУДАРСТВЕННЫХ ИНТЕРЕСАХ
Это изобретение было сделано при государственной поддержке в соответствии с DE-AR0000868, выданным Министерством энергетики, и в соответствии с 80NSSC 17K0768, выданным Национальным управлением по аэронавтике и исследованию космического пространства. Правительство имеет определенные права на изобретение.
ИСХОДНАЯ ИНФОРМАЦИЯ
Неизменность закона Мура стала довольно строгой для литейных производств полупроводников из-за ограничений физики и изготовления. Между тем, обычные полевые транзисторы металл-оксид-полупроводник на основе кремния (MOSFET) сталкиваются с фундаментальным ограничением подпорогового колебания (SS) теорией Больцмана. Чтобы продолжать предоставлять более быстрые вычислительные системы для клиентов в области электроники будущего поколения, были тщательно изучены инновационные материалы и технологии, включая соединения III-V, двумерные (2D) материалы, топологические изоляторы и нейронные сети. Тем не менее, улучшение средней SS, воспроизводимости и однородности этих устройств остается серьезной проблемой. Другие проблемы включают тепловую нестабильность в высокочастотных приложениях.
Между тем, обычные полевые транзисторы металл-оксид-полупроводник на основе кремния (MOSFET) сталкиваются с фундаментальным ограничением подпорогового колебания (SS) теорией Больцмана. Чтобы продолжать предоставлять более быстрые вычислительные системы для клиентов в области электроники будущего поколения, были тщательно изучены инновационные материалы и технологии, включая соединения III-V, двумерные (2D) материалы, топологические изоляторы и нейронные сети. Тем не менее, улучшение средней SS, воспроизводимости и однородности этих устройств остается серьезной проблемой. Другие проблемы включают тепловую нестабильность в высокочастотных приложениях.
РЕЗЮМЕ
Полевой транзистор с крутым наклоном на основе AlGaN/GaN металл-изолятор-полупроводник с высокой подвижностью электронов (MIS-HEMT), использующий SiO 2 устройств порогового переключения последовательно с источником раскрыто. Устройства порогового переключения на основе SiO 2 демонстрируют крутой наклон при изменении состояния сопротивления. Встроенный транзистор с крутым наклоном показывает низкое подпороговое колебание менее 5 мВ/дек с диапазоном перехода более 10 5 в передаточных характеристиках в обоих направлениях развертки при комнатной температуре, а также низкий ток утечки (10 −5 мкА/мкм) и высокое отношение I ON /I OFF (>10 7 ). Кроме того, было обнаружено, что с устройствами порогового переключения на основе SiO 2 пороговые напряжения (V th ) значительно улучшились. Результаты более чем 50 измерений передаточных характеристик также показывают, что средние крутые наклоны составляют менее 10 мВ/декаду. Этот транзистор с крутым наклоном и пороговыми переключающими устройствами на основе оксида может применяться на различных платформах транзисторов (например, Si и III-V) и подходит для силовых переключателей и высокочастотных устройств. По сравнению с изоляторами Мотта, SiO 2 Резистивная память с произвольным доступом (RRAM) на основе предпочтительнее, по крайней мере частично, из-за совместимости с внутренней обработкой (BEOL) в литейных цехах интегральных схем.
Встроенный транзистор с крутым наклоном показывает низкое подпороговое колебание менее 5 мВ/дек с диапазоном перехода более 10 5 в передаточных характеристиках в обоих направлениях развертки при комнатной температуре, а также низкий ток утечки (10 −5 мкА/мкм) и высокое отношение I ON /I OFF (>10 7 ). Кроме того, было обнаружено, что с устройствами порогового переключения на основе SiO 2 пороговые напряжения (V th ) значительно улучшились. Результаты более чем 50 измерений передаточных характеристик также показывают, что средние крутые наклоны составляют менее 10 мВ/декаду. Этот транзистор с крутым наклоном и пороговыми переключающими устройствами на основе оксида может применяться на различных платформах транзисторов (например, Si и III-V) и подходит для силовых переключателей и высокочастотных устройств. По сравнению с изоляторами Мотта, SiO 2 Резистивная память с произвольным доступом (RRAM) на основе предпочтительнее, по крайней мере частично, из-за совместимости с внутренней обработкой (BEOL) в литейных цехах интегральных схем.
В первом общем аспекте полевой транзистор (FET) с крутым наклоном (SS) включает в себя FET, содержащий область истока и область стока, и пороговое переключающее устройство, находящееся в непосредственном контакте с областью истока или областью стока ФЕТ.
Реализации первого общего аспекта могут включать одну или несколько следующих функций.
В некоторых случаях полевой транзистор включает транзистор металл-диэлектрик-полупроводник AlGaN/GaN с высокой подвижностью электронов (MIS-HEMT).
Устройство порогового переключения имеет структуру металл-изолятор-металл (MIM), включающую первый электрод, второй электрод и слой порогового переключения между первым электродом и вторым электродом. Первый электрод может включать титан. Первый электрод может находиться в непосредственном контакте с областью истока или областью стока полевого транзистора. Второй электрод может включать серебро. Слой порогового переключения включает SiO 2 .
В некоторых случаях резкий переход из состояния высокого сопротивления в состояние низкого сопротивления происходит, когда приложенное напряжение достигает порогового значения. Резкий переход обычно приводит к крутому наклону порога.
SS-FET обычно имеет подпороговый размах около 5 мВ/дек с диапазоном перехода более 10 5 в обоих направлениях развертки при комнатной температуре. SS-FET обычно имеет ток утечки 10 −5 мкА/мкм или менее, отношение тока включения к выключению (I ON /I OFF ) из более чем 10 7 или обоих.
Полевой транзистор включает Si, Ge, SiGe или бинарный или тройной составной полупроводник, включающий элементы из нитридов групп II-VI, III-V и IV-IV и группы III. В одном примере полевой транзистор включает кремниевую подложку, буферный слой GaN на подложке Si, канальный слой GaN на буферном слое GaN, промежуточный слой AlN, барьерный слой, содержащий Al, Ga и N, и покрывающий слой GaN. .
.
Во втором общем аспекте изготовление полевого транзистора (FET) с крутым наклоном (SS) включает изготовление AlGaN/GaN металл-изолятор-полупроводник транзистора с высокой подвижностью электронов (MIS-HEMT), имеющего область истока и область стока. , нанесение слоя первого электрода непосредственно на область истока или область стока, нанесение слоя порогового переключения непосредственно на слой первого электрода и нанесение слоя второго электрода непосредственно на слой переключения порога.
Реализации второго общего аспекта могут включать одну или несколько следующих функций.
Первый электродный слой может включать титан. Второй электродный слой может включать серебро. Слой порогового переключения обычно включает SiO 2 .
Подробности одного или нескольких вариантов осуществления предмета настоящего раскрытия изложены в прилагаемых чертежах и описании. Другие признаки, аспекты и преимущества предмета изобретения станут очевидными из описания, чертежей и формулы изобретения.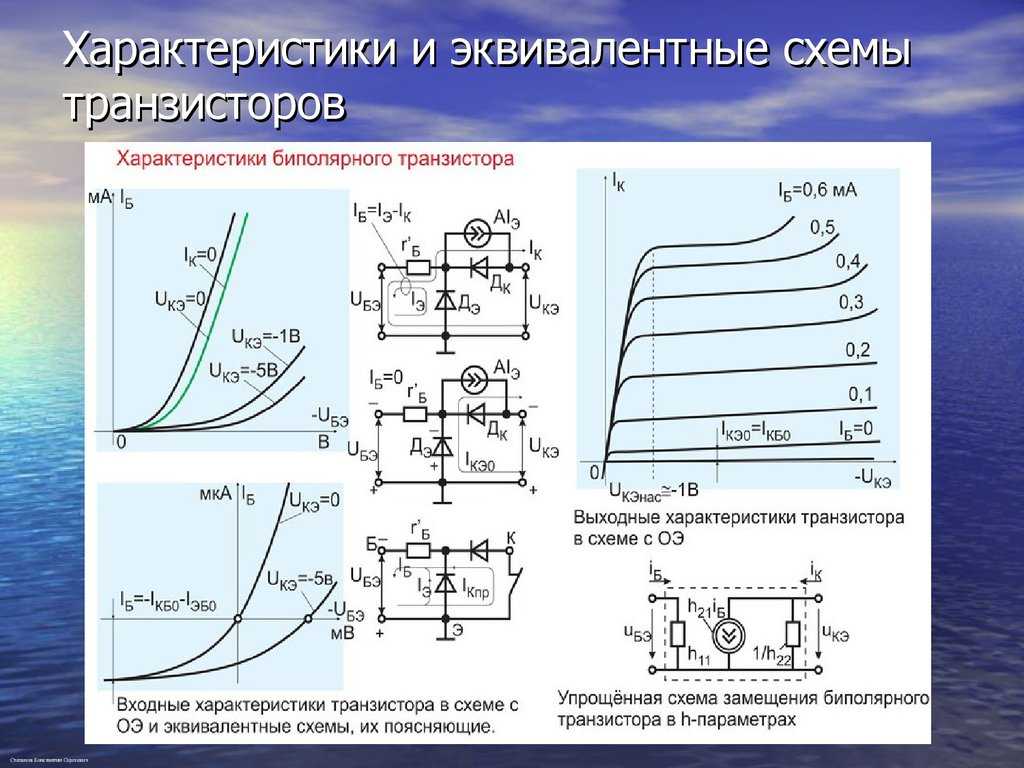
РИС. 1А представляет собой схематический вид поперечного сечения транзистора AlGaN металл-изолятор-полупроводник с высокой подвижностью электронов с переключением с крутым порогом (MIS-HEMT). ИНЖИР. 1B представляет собой схематический вид в разрезе металл-изолятор-металл (MIM). ИНЖИР. 1C показаны принципиальные схемы автономного (слева) и интегрированного устройства AlGaN MIS-HEMT с крутой коммутацией (справа).
РИС. 2A показана сводка значений V SS (определяемых как напряжение, при котором происходит переход с крутым наклоном) в зависимости от приложенных напряжений стока V ДС СС-HEMT. ИНЖИР. 2B показывает сводку значений SS в зависимости от приложенных напряжений стока V DS SS-HEMT. Значения SS автономного HEMT при V DS =6V также нанесены на график для справки.
ПОДРОБНОЕ ОПИСАНИЕ
Металл-изолятор-полупроводник AlGaN/GaN транзисторы с высокой подвижностью электронов (MIS-HEMT) с крутым наклоном (SS) на кремниевых подложках с использованием SiO 2 Пороговые переключающие устройства на основе последовательно с источником раскрыто. SiO 2 Устройства с пороговым переключением на основе имеют крутой наклон при изменении состояния сопротивления. Эти интегрированные устройства SS-HEMT обеспечивают низкий подпороговый размах ~5 мВ/дек с диапазоном перехода более 10 5 в передаточных характеристиках в обоих направлениях сканирования при комнатной температуре (КТ), а также низкий ток утечки (~ 10 -5 мкА/мкм) и высоким отношением I ON /I OFF (>10 7 ). Пороговое напряжение (V th ) также было значительно улучшено. Этот SS-HEMT также имеет низкий ток утечки (~10 -5 мкА/мкм) и высоким отношением I ON /I OFF (>10 7 ). По крайней мере, по этим причинам эта транзисторная архитектура подходит для других транзисторных систем, а также для коммутации с низким энергопотреблением и высокочастотных приложений.
SiO 2 Устройства с пороговым переключением на основе имеют крутой наклон при изменении состояния сопротивления. Эти интегрированные устройства SS-HEMT обеспечивают низкий подпороговый размах ~5 мВ/дек с диапазоном перехода более 10 5 в передаточных характеристиках в обоих направлениях сканирования при комнатной температуре (КТ), а также низкий ток утечки (~ 10 -5 мкА/мкм) и высоким отношением I ON /I OFF (>10 7 ). Пороговое напряжение (V th ) также было значительно улучшено. Этот SS-HEMT также имеет низкий ток утечки (~10 -5 мкА/мкм) и высоким отношением I ON /I OFF (>10 7 ). По крайней мере, по этим причинам эта транзисторная архитектура подходит для других транзисторных систем, а также для коммутации с низким энергопотреблением и высокочастотных приложений.
Приборные эпитаксиальные слои AlGaN/GaN для MIS-HEMT могут быть выращены методом химического осаждения из паровой фазы металлоорганических соединений (MOCVD) на кремниевых подложках. Подходящие предшественники для Ga и Al включают соответственно триметилгаллий (TMGa) и триметилалюминий (TMAl). Аммиак (NH 3 ) является подходящим источником N. Подходящие газы-носители включают, например, H 2 . Как показано на фиг. 1a, гетероструктура 100 включает в себя субстрат Si 102 , слой буфера Gan/канал Layer 104 , Aln Interlayer 106 , Algan Barrie 4 слой 112 и структура металл-изолятор-металл (MIM) 114 . Гетероструктура 100 также включает исток S, сток D и литник G, а также Si 3 N 4 слой 112 , выращенный методом химического осаждения из газовой фазы при низком давлении (LPCVD), может служить пассивирующим слоем и литником диэлектрики.
Подходящие предшественники для Ga и Al включают соответственно триметилгаллий (TMGa) и триметилалюминий (TMAl). Аммиак (NH 3 ) является подходящим источником N. Подходящие газы-носители включают, например, H 2 . Как показано на фиг. 1a, гетероструктура 100 включает в себя субстрат Si 102 , слой буфера Gan/канал Layer 104 , Aln Interlayer 106 , Algan Barrie 4 слой 112 и структура металл-изолятор-металл (MIM) 114 . Гетероструктура 100 также включает исток S, сток D и литник G, а также Si 3 N 4 слой 112 , выращенный методом химического осаждения из газовой фазы при низком давлении (LPCVD), может служить пассивирующим слоем и литником диэлектрики.
HEMT AlGaN/GaN могут быть изготовлены с использованием фотолитографии. Пластину обычно очищают перед осаждением металла. Изоляция планарного устройства может быть достигнута путем имплантации ионов фтора с несколькими энергиями. LPCVD-Si 3 N 4 в области контакта истока и стока можно удалить методом реактивного ионного травления (РИТ). Омические контакты для областей истока и стока могут быть сформированы электронно-лучевым напылением Ti/Al/Ni/Au и отожжены (например, в N 2 ). Катетерные металлы наносились методом электронно-лучевого испарения с Ni/Au и методом отрыва. В одном примере пространство от ворот к истоку, пространство от ворот к стоку, ширина ворот и длина ворот составляют 4, 15, 100 и 4 м соответственно.
Изоляция планарного устройства может быть достигнута путем имплантации ионов фтора с несколькими энергиями. LPCVD-Si 3 N 4 в области контакта истока и стока можно удалить методом реактивного ионного травления (РИТ). Омические контакты для областей истока и стока могут быть сформированы электронно-лучевым напылением Ti/Al/Ni/Au и отожжены (например, в N 2 ). Катетерные металлы наносились методом электронно-лучевого испарения с Ni/Au и методом отрыва. В одном примере пространство от ворот к истоку, пространство от ворот к стоку, ширина ворот и длина ворот составляют 4, 15, 100 и 4 м соответственно.
Пороговые коммутационные устройства со структурой MIM 114 изготавливаются на истоковом контакте МИС-HEMT, как показано на РИС. 1А. ИНЖИР. 1B показана структура MIM 114 , включающая нижний электрод из Ti 120 , SiO 2 переключающий слой 122 и верхний электрод из серебра 124 , последовательно нанесенные с помощью электронно-лучевого испарения без прерывания вакуума. Каждая ячейка MIM обычно имеет круглую форму диаметром 10-50 мкм. После этого термический отжиг обычно не проводят.
Каждая ячейка MIM обычно имеет круглую форму диаметром 10-50 мкм. После этого термический отжиг обычно не проводят.
Механизмы порогового переключения можно понять со ссылкой на фиг. 1С следующим образом: с устройством порогового переключения SiO 2 на истоке HEMT исходное напряжение затвора В ГС состоит из 2 частей: V GS’ и V SS . V SS (<0 В) соответствует условию, когда к Ag-электроду приложено положительное напряжение, а именно V SS’ >0, так как это HEMT в режиме обеднения, и резкое переключение происходит при отрицательном V ГС .
ПРИМЕР
Эпислойные слои устройства AlGaN/GaN для MIS-HEMT были выращены методом химического осаждения из паровой фазы металлоорганических соединений (MOCVD) на 2-дюймовых кремниевых подложках. Триметилгаллий (TMGa) и триметилалюминий (TMAl) использовались в качестве прекурсоров для Ga и Al соответственно, а аммиак (NH 3 ) был источником N. Газом-носителем был H 2 . Со ссылкой на фиг. 1А гетероструктура формировалась следующим образом: высокоомный буферный слой GaN, выращенный на подложке Si, канальный слой GaN толщиной 100 нм, прослойка AlN толщиной 1 нм, барьерный слой Al 0,26 Ga 0,26 N толщиной 28 нм, и защитный слой GaN толщиной 2 нм. Слой Si 3 N 4 толщиной 20 нм, выращенный методом химического осаждения из газовой фазы при низком давлении (LPCVD), служит диэлектриком затвора и пассивирующим слоем. Si 9, выращенный методом LPCVDСлой 0025 3 N 4 осаждали при 780°С аммиаком (NH 3 ), поток 280 куб. мин.
Газом-носителем был H 2 . Со ссылкой на фиг. 1А гетероструктура формировалась следующим образом: высокоомный буферный слой GaN, выращенный на подложке Si, канальный слой GaN толщиной 100 нм, прослойка AlN толщиной 1 нм, барьерный слой Al 0,26 Ga 0,26 N толщиной 28 нм, и защитный слой GaN толщиной 2 нм. Слой Si 3 N 4 толщиной 20 нм, выращенный методом химического осаждения из газовой фазы при низком давлении (LPCVD), служит диэлектриком затвора и пассивирующим слоем. Si 9, выращенный методом LPCVDСлой 0025 3 N 4 осаждали при 780°С аммиаком (NH 3 ), поток 280 куб. мин.
HEMT AlGaN/GaN были изготовлены с использованием фотолитографии. Пластину очищали в ацетоне и изопропиловом спирте под действием ультразвука, а затем ненадолго погружали в соляную кислоту перед осаждением металла. Изоляция планарного устройства была достигнута за счет имплантации ионов фтора с несколькими энергиями. LPCVD-Si 3 N 4 в зоне контакта исток/сток был вытравлен реактивным ионным травлением (РИТ). Омические контакты для областей истока и стока формировали электронно-лучевым напылением Ti/Al/Ni/Au (20/130/50/150 нм) и отжигали при 890°С в течение 30 с в N 2 (окружающая среда) . Затем металлы затвора осаждали электронно-лучевым испарением с Ni/Au (50/150 нм) и методом отрыва. Пространство затвор-исток, затвор-сток, ширина затвора и длина затвора составляли 4, 15, 100 и 4 м соответственно. После изготовления MIS-HEMT плотность двумерного электронного газа ˜1×10 13 см -2 и холловскую подвижность электронов ˜1800 см 2 /(В·с) измеряли при комнатной температуре.
LPCVD-Si 3 N 4 в зоне контакта исток/сток был вытравлен реактивным ионным травлением (РИТ). Омические контакты для областей истока и стока формировали электронно-лучевым напылением Ti/Al/Ni/Au (20/130/50/150 нм) и отжигали при 890°С в течение 30 с в N 2 (окружающая среда) . Затем металлы затвора осаждали электронно-лучевым испарением с Ni/Au (50/150 нм) и методом отрыва. Пространство затвор-исток, затвор-сток, ширина затвора и длина затвора составляли 4, 15, 100 и 4 м соответственно. После изготовления MIS-HEMT плотность двумерного электронного газа ˜1×10 13 см -2 и холловскую подвижность электронов ˜1800 см 2 /(В·с) измеряли при комнатной температуре.
Устройства порогового переключения со структурой MIM были затем изготовлены на истоковых контактах MIS-HEMT, как показано на РИС. 1А. Структура MIM, изображенная на фиг. 1B включал нижний электрод Ti толщиной 12 нм (BE), переключающий слой SiO 2 толщиной 12 нм и верхний электрод Ag (TE) толщиной 15 нм, последовательно осажденные с помощью электронно-лучевого испарения без прерывания вакуума. Каждая ячейка MIM имеет круглую форму диаметром 30 м. После этого термический отжиг не проводился. Окончательные устройства получили обозначение SS-HEMT. Характеристики постоянного тока устройств порогового переключения на основе оксида были выполнены с использованием измерителя источника Keithley 2400, а передаточные кривые MIS-HEMT и SS-HEMT были получены с использованием анализатора параметров Keithley 4200-SCS. Все измерения проводились при комнатной температуре.
Каждая ячейка MIM имеет круглую форму диаметром 30 м. После этого термический отжиг не проводился. Окончательные устройства получили обозначение SS-HEMT. Характеристики постоянного тока устройств порогового переключения на основе оксида были выполнены с использованием измерителя источника Keithley 2400, а передаточные кривые MIS-HEMT и SS-HEMT были получены с использованием анализатора параметров Keithley 4200-SCS. Все измерения проводились при комнатной температуре.
Репрезентативные кривые резистивного переключения устройств порогового переключения на основе Ag/SiO 2 /Ti на основе оксида были получены при соответствии тока (I CC ) 5 мкА и 7,5 мкА. Для каждого текущего соответствия было проведено ~30 циклов для обеспечения воспроизводимости и долговечности устройства. Устройства порогового переключения переходят из состояния высокого сопротивления (HRS) в состояние низкого сопротивления (LRS) или в состояние «ВКЛ» при пороговом напряжении (V th ). Для I CC =7,5 мкА, В -й составляет ~3,7 В для положительных сканирований и ~-1,8 В для негативных сканирований. В отличие от I CC = 5 мкА, V th составляет ˜3,2 В и ˜−2,8 В. Кроме того, состояние ON переключается обратно в состояние OFF, когда напряжение возвращается к низкому уровню (1,5 В для I CC = 7,5 мкА и 2,5 В для I CC = 5 мкА). Коэффициент выпрямления ˜10 2 может быть дополнительно повышен с меньшими устройствами MIM из-за обратно пропорциональной зависимости между HRS и размером устройства. Производительность устройства может быть улучшена за счет уменьшения шероховатости поверхности электродов источника и оптимизации процесса изготовления. Полагают, что механизм порогового переключения связан с образованием нестабильных или даже прерывистых проводящих нитей при малых токах податливости.
Для I CC =7,5 мкА, В -й составляет ~3,7 В для положительных сканирований и ~-1,8 В для негативных сканирований. В отличие от I CC = 5 мкА, V th составляет ˜3,2 В и ˜−2,8 В. Кроме того, состояние ON переключается обратно в состояние OFF, когда напряжение возвращается к низкому уровню (1,5 В для I CC = 7,5 мкА и 2,5 В для I CC = 5 мкА). Коэффициент выпрямления ˜10 2 может быть дополнительно повышен с меньшими устройствами MIM из-за обратно пропорциональной зависимости между HRS и размером устройства. Производительность устройства может быть улучшена за счет уменьшения шероховатости поверхности электродов источника и оптимизации процесса изготовления. Полагают, что механизм порогового переключения связан с образованием нестабильных или даже прерывистых проводящих нитей при малых токах податливости.
I D -V GS Передаточные характеристики автономных МДИС-HEMT AlGaN/GaN были получены при напряжениях стока (V DS ) от 3 В до 9 В и напряжениях затвора (V GS ) от – от 14 В до 4 В и наблюдается как в линейном, так и в логарифмическом масштабе. Пороговое напряжение для HEMT (V th ), определенное как напряжение при токе 10 -2 мкА/мкм, было определено как -12,28 В при V DS 6 В при прямом сканировании. Кроме того, гистерезис V 9Также было получено 0025-е значений между прямым и обратным сканированием. Гистерезис V th (ΔV th ) определяется следующим уравнением: ΔV th = V th (назад) − V th (вперед). ΔV th может возникать из акцепторных состояний ловушки на интерфейсе Si 3 N 4 /GaN. При V DS =6 В наблюдалось низкое значение ΔV th , равное 0,22 В, благодаря качественному интерфейсу между GaN и Si 3 N 4 выращены методом LPCVD. Отмечена тенденция гистерезиса ΔV th к уменьшению V DS к увеличению. Это можно объяснить, по крайней мере частично, тем фактом, что меньше электронов будет захвачено этими вышеупомянутыми состояниями ловушки, когда V DS увеличивается, а затем уменьшается электрическое напряжение между затвором и стоком (V GD ).
Пороговое напряжение для HEMT (V th ), определенное как напряжение при токе 10 -2 мкА/мкм, было определено как -12,28 В при V DS 6 В при прямом сканировании. Кроме того, гистерезис V 9Также было получено 0025-е значений между прямым и обратным сканированием. Гистерезис V th (ΔV th ) определяется следующим уравнением: ΔV th = V th (назад) − V th (вперед). ΔV th может возникать из акцепторных состояний ловушки на интерфейсе Si 3 N 4 /GaN. При V DS =6 В наблюдалось низкое значение ΔV th , равное 0,22 В, благодаря качественному интерфейсу между GaN и Si 3 N 4 выращены методом LPCVD. Отмечена тенденция гистерезиса ΔV th к уменьшению V DS к увеличению. Это можно объяснить, по крайней мере частично, тем фактом, что меньше электронов будет захвачено этими вышеупомянутыми состояниями ловушки, когда V DS увеличивается, а затем уменьшается электрическое напряжение между затвором и стоком (V GD ).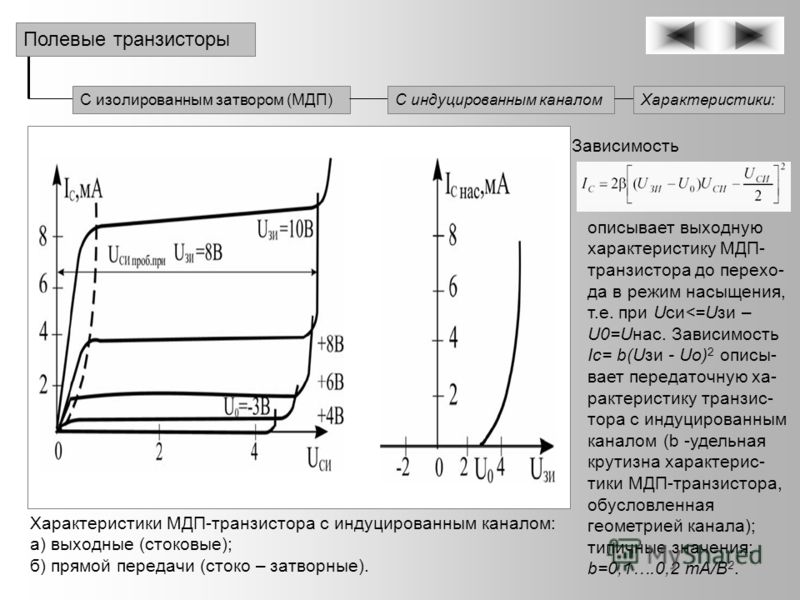 Ток стока насыщения (I D ) при V GS = 4 В и V DS = 9 В составлял 515 мкА/мкм. Соотношение ВКЛ/ВЫКЛ более 10 7 также был достигнут в этом автономном устройстве AlGaN MIS-HEMT.
Ток стока насыщения (I D ) при V GS = 4 В и V DS = 9 В составлял 515 мкА/мкм. Соотношение ВКЛ/ВЫКЛ более 10 7 также был достигнут в этом автономном устройстве AlGaN MIS-HEMT.
I D -V GS передаточные характеристики интегрированных SS-HEMT были получены при V DS от 5 В до 10 В как для прямого, так и для обратного сканирования в логарифмическом масштабе. Поведение крутого подпорогового переключения четко наблюдалось в обоих направлениях сканирования. Это переключение с крутым наклоном происходит в огромном диапазоне токов от ~10 -5 мкА/мкм до более чем 10 2 мкА/мкм, что указывает на высокое отношение ВКЛ/ВЫКЛ, превышающее 10 7 . Все значения подпорогового переключения ниже 5 мВ/дек. Кроме того, ток стока (I D ) был подавлен в SS-HEMT по сравнению с автономным MIS-HEMT. Это можно объяснить, по крайней мере частично, дополнительным сопротивлением истока от устройств порогового переключения на основе SiO 2 , что приводит к уменьшению фактического смещения, приложенного к стоку, и, таким образом, к уменьшению тока стока. Например, при V GS =3 В и V DS =9 В ток стока составлял 432 мкА/мкм для устройства SS-HEMT, а для автономного MIS-HEMT — 513 мкА/мкм.
Например, при V GS =3 В и V DS =9 В ток стока составлял 432 мкА/мкм для устройства SS-HEMT, а для автономного MIS-HEMT — 513 мкА/мкм.
Извлеченные подпороговые колебания (SS) наблюдались как функция тока стока для интегрированных SS-HEMT при V DS = 5 В, 6 В, 7 В, 8 В, 9 В и 10 В соответственно в обоих направлениях сканирования. . Выделенный подпороговый размах (ПС) наблюдался как функция тока стока для автономных МДИС-HEMT AlGaN/GaN при V DS =6В. Для устройства MIS-HEMT значения SS были выше предела Больцмана 60 мВ/дек при комнатной температуре, а минимальные значения составляли ~85 мВ/дек при прямом сканировании и ~80 мВ/дек при обратном сканировании соответственно. . При интеграции устройств порогового переключения на основе кремнезема крутое подпороговое переключение происходит в диапазоне резких переходов тока стока, который превышает 5 порядков при прямом сканировании. Кроме того, В -й сместился в менее отрицательный диапазон, наблюдаемый в обоих направлениях сканирования.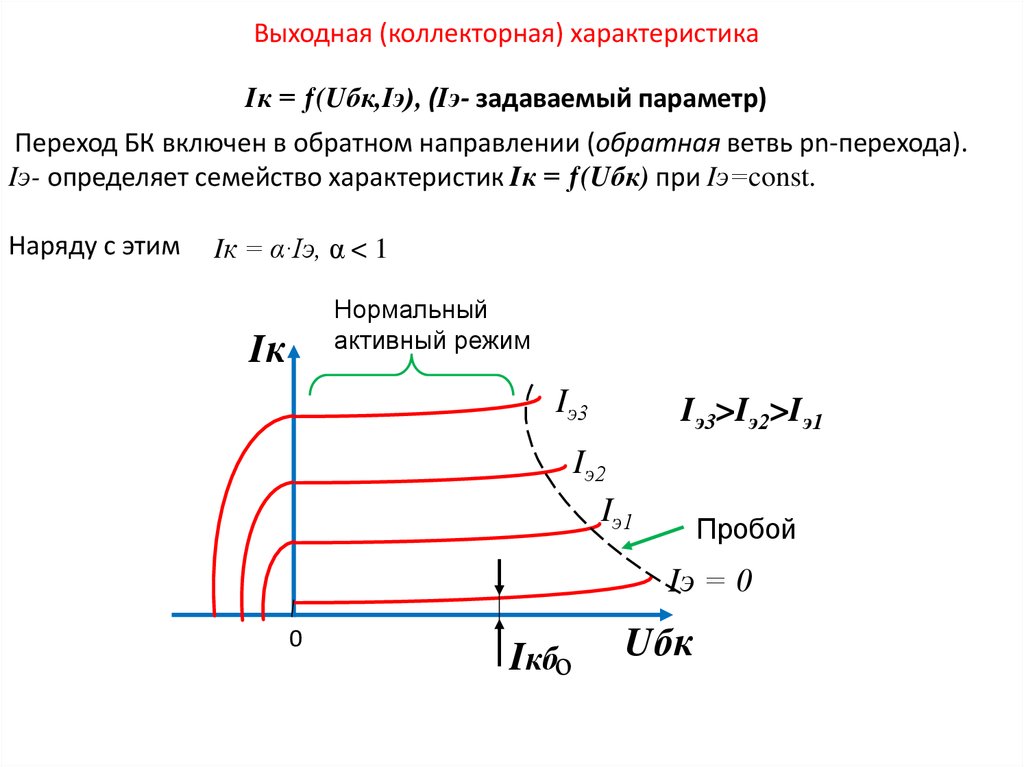 Начиная с V DS = 5 В, SS-HEMT продемонстрировал резкое подпороговое переключение и резко упал до 1,94 мВ/дек, 1,79 мВ/дек, 1,47 мВ/дек, 1,47 мВ/дек, 1,40 мВ/дек. и 4,07 мВ/дек при V DS =5 В, 6 В, 7 В, 8 В, 9 В и 10 В при прямом сканировании. При обратном сканировании значения SS были все еще меньше, чем предел Больцмана 60 мВ/дек при комнатной температуре, т.е.0 мВ/дек при V DS = 5 В, 6 В, 7 В, 8 В, 9 В и 10 В соответственно. В диапазонах с крутым наклоном значения SS сравнимы в обоих направлениях сканирования. Однако это не является общим случаем для результатов измерений более 50 раз. Значения SS при обратном сканировании обычно больше, чем при прямом сканировании. Это может быть объяснено, по крайней мере частично, тем фактом, что больше электронов накапливается в устройствах порогового переключения на основе SiO 2 во время развертки V GS от отрицательного до положительного диапазона.
Начиная с V DS = 5 В, SS-HEMT продемонстрировал резкое подпороговое переключение и резко упал до 1,94 мВ/дек, 1,79 мВ/дек, 1,47 мВ/дек, 1,47 мВ/дек, 1,40 мВ/дек. и 4,07 мВ/дек при V DS =5 В, 6 В, 7 В, 8 В, 9 В и 10 В при прямом сканировании. При обратном сканировании значения SS были все еще меньше, чем предел Больцмана 60 мВ/дек при комнатной температуре, т.е.0 мВ/дек при V DS = 5 В, 6 В, 7 В, 8 В, 9 В и 10 В соответственно. В диапазонах с крутым наклоном значения SS сравнимы в обоих направлениях сканирования. Однако это не является общим случаем для результатов измерений более 50 раз. Значения SS при обратном сканировании обычно больше, чем при прямом сканировании. Это может быть объяснено, по крайней мере частично, тем фактом, что больше электронов накапливается в устройствах порогового переключения на основе SiO 2 во время развертки V GS от отрицательного до положительного диапазона.
Чтобы подтвердить повторяемость устройства HEMT с крутым наклоном, измерения I DS -V GS были выполнены на нескольких устройствах более 50 раз. Сводка значений V SS (определяемых как напряжение затвора, при котором происходит переход с крутым наклоном) в зависимости от приложенных напряжений стока V DS в SS-HEMT и сводка значений SS в зависимости от приложенных напряжений стока V DS показаны на ФИГ. 2А и 2В соответственно. Для каждого направления развертки каждого напряжения стока V DS , более 10 кривых I DS -V GS были выбраны для расчета статистического распределения значений V SS и SS. Все подпороговые напряжения затвора, где происходит переход с крутым наклоном (V SS ), больше (меньше по величине), чем в обычном автономном устройстве HEMT (~-12,5 В). Кроме того, V SS при обратном сканировании обычно более негативны, чем при прямом сканировании. Это можно объяснить накоплением электронов в устройствах MIM и HEMT во время развертки. Что касается диапазонов SS, показанных на фиг. 2B, SS оказывается более стабильным при 2–5 мВ/дек, чем V9.
Сводка значений V SS (определяемых как напряжение затвора, при котором происходит переход с крутым наклоном) в зависимости от приложенных напряжений стока V DS в SS-HEMT и сводка значений SS в зависимости от приложенных напряжений стока V DS показаны на ФИГ. 2А и 2В соответственно. Для каждого направления развертки каждого напряжения стока V DS , более 10 кривых I DS -V GS были выбраны для расчета статистического распределения значений V SS и SS. Все подпороговые напряжения затвора, где происходит переход с крутым наклоном (V SS ), больше (меньше по величине), чем в обычном автономном устройстве HEMT (~-12,5 В). Кроме того, V SS при обратном сканировании обычно более негативны, чем при прямом сканировании. Это можно объяснить накоплением электронов в устройствах MIM и HEMT во время развертки. Что касается диапазонов SS, показанных на фиг. 2B, SS оказывается более стабильным при 2–5 мВ/дек, чем V9.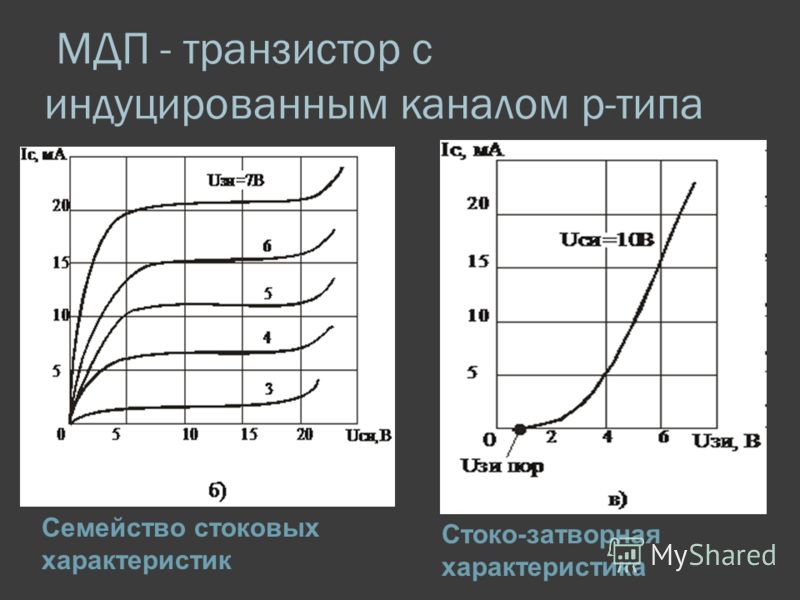 0025 DS увеличивается.
0025 DS увеличивается.
Механизмы порогового переключения можно понимать следующим образом: с устройством порогового переключения SiO 2 на истоке HEMT исходное напряжение затвора V GS состоит из 2 частей: V GS′ и V SS (см. фиг. 1C). V SS (<0 В) соответствует условию, когда к Ag-электроду было приложено положительное напряжение, а именно V SS’ >0, так как это HEMT в режиме обеднения и резкое переключение происходит при отрицательном V ГС .
Когда V GS меньше, чем V th HEMT [V th (HEMT)~−12 В], встроенный HEMT ведет себя как автономный HEMT, и устройство выключается.
As V th  Устройство MIM переключается на LRS, происходит резкое переключение и включается транзистор (в данном случае HEMT). Это возможно, потому что ток отключения находится в диапазоне от 10 -9 до 10 -7 А для структуры SiO 2 MIM, а ток выключения HEMT ниже 1×10 -8 А (предел обнаружения установки).
Устройство MIM переключается на LRS, происходит резкое переключение и включается транзистор (в данном случае HEMT). Это возможно, потому что ток отключения находится в диапазоне от 10 -9 до 10 -7 А для структуры SiO 2 MIM, а ток выключения HEMT ниже 1×10 -8 А (предел обнаружения установки).
Поскольку V GS отметает назад, V SS превысит V -й (MIM) на другом определенном уровне V GS . Затем токопроводящие нити обрываются, МИМ-устройство переходит в ГРП, происходит резкое переключение и транзистор выключается.
Таким образом, транзисторы с крутым наклоном (SS) с SiO 2 были раскрыты устройства порогового переключения на основе AlGaN/GaN металл-изолятор-полупроводник с высокой подвижностью электронов (MIS-HEMT) на кремниевых подложках. Это интегрированное устройство SS-HEMT достигло подпорогового колебания 5 мВ/дек с диапазоном изменения тока более 10 5 в передаточных характеристиках в обоих направлениях сканирования при комнатной температуре.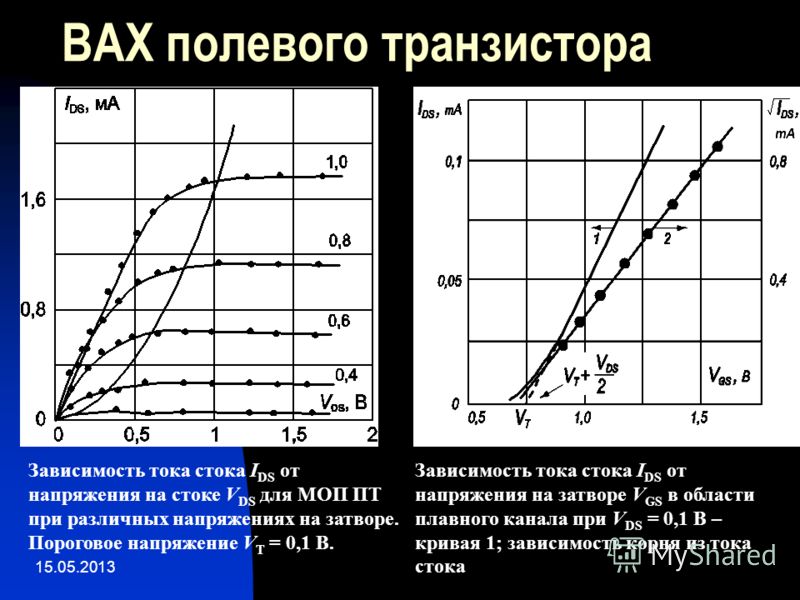 Он также продемонстрировал низкий ток утечки (~10 -5 мкА/мкм) и высокое отношение I ON /I OFF (>10 7 ). Более того, крутое подпороговое переключение не зависит от приложенного напряжения на стоке. Для изготовления транзистора с крутым наклоном с желаемой характеристикой переключения могут быть применены дополнительные инженерные подходы. Например, GaN HEMT, транзисторы III-V и даже Si FinFET в улучшенном режиме также могут быть интегрированы с такими устройствами порогового переключения на основе SiO 2 . Кроме того, уровень тока в выключенном состоянии может быть дополнительно снижен за счет уменьшения размера структуры MIM в поперечном направлении. Таким образом, эта конструкция транзистора использует уникальные свойства легкого и CMOS-совместимого SiO 9.0025 2 на основе устройств порогового переключения и обеспечивает преимущества в производительности по сравнению с обычными трехвыводными транзисторами.
Он также продемонстрировал низкий ток утечки (~10 -5 мкА/мкм) и высокое отношение I ON /I OFF (>10 7 ). Более того, крутое подпороговое переключение не зависит от приложенного напряжения на стоке. Для изготовления транзистора с крутым наклоном с желаемой характеристикой переключения могут быть применены дополнительные инженерные подходы. Например, GaN HEMT, транзисторы III-V и даже Si FinFET в улучшенном режиме также могут быть интегрированы с такими устройствами порогового переключения на основе SiO 2 . Кроме того, уровень тока в выключенном состоянии может быть дополнительно снижен за счет уменьшения размера структуры MIM в поперечном направлении. Таким образом, эта конструкция транзистора использует уникальные свойства легкого и CMOS-совместимого SiO 9.0025 2 на основе устройств порогового переключения и обеспечивает преимущества в производительности по сравнению с обычными трехвыводными транзисторами.
Хотя это раскрытие содержит много конкретных деталей вариантов осуществления, их не следует рассматривать как ограничения объема предмета или объема заявленных требований, а скорее как описание признаков, которые могут быть характерны для конкретных вариантов осуществления. Некоторые признаки, описанные в этом раскрытии в контексте отдельных вариантов осуществления, также могут быть реализованы в комбинации в одном варианте осуществления. И наоборот, различные признаки, описанные в контексте одного варианта осуществления, также могут быть реализованы в нескольких вариантах осуществления, по отдельности или в любой подходящей комбинации. Более того, хотя ранее описанные признаки могут быть описаны как действующие в определенных комбинациях и даже изначально заявлены как таковые, в некоторых случаях один или несколько признаков из заявленной комбинации могут быть исключены из комбинации, а заявленная комбинация может быть направлена на субкомбинация или вариант субкомбинации.
Некоторые признаки, описанные в этом раскрытии в контексте отдельных вариантов осуществления, также могут быть реализованы в комбинации в одном варианте осуществления. И наоборот, различные признаки, описанные в контексте одного варианта осуществления, также могут быть реализованы в нескольких вариантах осуществления, по отдельности или в любой подходящей комбинации. Более того, хотя ранее описанные признаки могут быть описаны как действующие в определенных комбинациях и даже изначально заявлены как таковые, в некоторых случаях один или несколько признаков из заявленной комбинации могут быть исключены из комбинации, а заявленная комбинация может быть направлена на субкомбинация или вариант субкомбинации.
Были описаны конкретные варианты осуществления предмета изобретения. Другие варианты осуществления, изменения и перестановки описанных вариантов осуществления входят в объем следующей формулы изобретения, как будет очевидно специалистам в данной области техники. Хотя операции изображены на чертежах или в формуле изобретения в определенном порядке, это не следует понимать как требующее, чтобы такие операции выполнялись в указанном конкретном порядке или в последовательном порядке, или чтобы выполнялись все проиллюстрированные операции (некоторые операции могут считаться необязательными). (или крутизной), где подвижность определяется как скорость заряда на единицу поля. В транзисторе, работающем при достаточно низком напряжении, скорость будет увеличиваться пропорционально поперечному полю (Vsd/Lch), где Vsd — напряжение исток/сток, а Lch — эффективная длина канала. При более высоких напряжениях скорость выходит на насыщение, и боковое поле становится неоднородным. Этой скорости насыщения обычно избегают в схемах CMOS, но она становится более проблематичной для очень коротких устройств. Скорость насыщения для электронов в кремнии при комнатной температуре составляет около 107 см/с, для дырок она несколько меньше. Для транзистора, работающего при малых напряжениях (т. е. в линейном режиме), подвижность зависит от напряжений затвора и истока/стока (Vgs и Vsd), длины и ширины канала (Lch и Wch) и емкости затвора на единица площади (Кокс; Фарад/см2):
(или крутизной), где подвижность определяется как скорость заряда на единицу поля. В транзисторе, работающем при достаточно низком напряжении, скорость будет увеличиваться пропорционально поперечному полю (Vsd/Lch), где Vsd — напряжение исток/сток, а Lch — эффективная длина канала. При более высоких напряжениях скорость выходит на насыщение, и боковое поле становится неоднородным. Этой скорости насыщения обычно избегают в схемах CMOS, но она становится более проблематичной для очень коротких устройств. Скорость насыщения для электронов в кремнии при комнатной температуре составляет около 107 см/с, для дырок она несколько меньше. Для транзистора, работающего при малых напряжениях (т. е. в линейном режиме), подвижность зависит от напряжений затвора и истока/стока (Vgs и Vsd), длины и ширины канала (Lch и Wch) и емкости затвора на единица площади (Кокс; Фарад/см2):
ff C0xWch( Vgs — Vth) Vsd
Параметр подвижности не зависит от геометрии устройства и связан с током через устройство. Поскольку ток определяет скорость, с которой логические сигналы могут перемещаться по цепи, эффективная мобильность является важным показателем качества для любого электронного устройства.
Поскольку ток определяет скорость, с которой логические сигналы могут перемещаться по цепи, эффективная мобильность является важным показателем качества для любого электронного устройства.
Другим важным фактором, влияющим на производительность устройства, является подпороговый наклон, определяемый как обратный наклон кривой зависимости log (Isd) от Vg для напряжений ниже Vth. Типичная кривая зависимости тока от напряжения для устройства NMOS показана на рис. 3.4. В подпороговой области ток экспоненциально зависит от напряжения:
, где n — число, обычно больше 1. При комнатной температуре идеальный случай (т. е. минимальное рассеяние заряда и захват заряда на границе раздела) приводит к n = 1 и обратному наклону (2,3 кТл)/q ~ 60 мВ/декаду. . Подпороговый наклон МОП-устройства является мерой скорости, с которой заряд рассеивается из области канала, когда устройство выключается. Поскольку скорость диффузии заряда не зависит от размера устройства, подпороговый наклон не будет заметно меняться при уменьшении размера транзистора. Отсутствие масштабирования подпорогового наклона имеет серьезные последствия для ограничений масштабирования устройства. В частности, он накладывает ограничение на то, насколько Vth может быть уменьшено, поскольку ток при нулевом напряжении должен поддерживаться на низком уровне, чтобы контролировать ток в выключенном состоянии Ioff. Это, в свою очередь, накладывает ограничение на то, насколько может быть уменьшено напряжение затвора, а это означает, что идеальные желаемые законы масштабирования постоянного поля, описанные ниже, не могут быть точно соблюдены.
Отсутствие масштабирования подпорогового наклона имеет серьезные последствия для ограничений масштабирования устройства. В частности, он накладывает ограничение на то, насколько Vth может быть уменьшено, поскольку ток при нулевом напряжении должен поддерживаться на низком уровне, чтобы контролировать ток в выключенном состоянии Ioff. Это, в свою очередь, накладывает ограничение на то, насколько может быть уменьшено напряжение затвора, а это означает, что идеальные желаемые законы масштабирования постоянного поля, описанные ниже, не могут быть точно соблюдены.
Уменьшение размера транзистора не оказывает существенного влияния ни на подвижность, ни на подпороговую крутизну. При идеальном масштабировании постоянного поля ширина, длина и толщина канала уменьшаются в один и тот же коэффициент (k). Так как же получается, что меньшие по размеру транзисторы с меньшим током могут создавать более быстрые схемы? Скорость транзисторной схемы определяется скоростью, с которой логический элемент (например, инвертор) может переходить из одного состояния в другое. Это переключение требует зарядки или разрядки конденсатора на выходном узле (т.е. другом устройстве в цепи). Поскольку емкость C = (Wch-Lch-eeo)/tox, общая емкость затвора уменьшится на масштабный коэффициент k. Заряд, необходимый для зарядки конденсатора, равен Q = CV, что
Это переключение требует зарядки или разрядки конденсатора на выходном узле (т.е. другом устройстве в цепи). Поскольку емкость C = (Wch-Lch-eeo)/tox, общая емкость затвора уменьшится на масштабный коэффициент k. Заряд, необходимый для зарядки конденсатора, равен Q = CV, что
- 0 0,2 0,4 0,6 0,8 1,0 Напряжение затвора, Вг (В)
РИСУНОК 3.4 Рабочие характеристики типичного МОП-устройства. (а) Ток, измеренный на стоке, как функция напряжения, приложенного к затвору. Эти же данные представлены в линейном и логарифмическом масштабах. Экстраполяция линейных данных представляет собой оценку порогового напряжения Vth. Наклон данных в логарифмическом масштабе для V < Vth дает подпороговый наклон. Обратите внимание, что устройство остается работоспособным при температурах >100°C, с увеличением обратного подпорогового наклона и увеличением тока отключения (Ioff) по мере повышения температуры. (б) Ток, измеренный на стоке, как функция напряжения исток/сток для различных значений напряжения затвора для того же устройства, что и в (а). Штриховая линия указывает на переход к текущему насыщению.
Штриховая линия указывает на переход к текущему насыщению.
РИСУНОК 3.4 Рабочие характеристики типичного МОП-устройства. (а) Ток, измеренный на стоке, как функция напряжения, приложенного к затвору. Эти же данные представлены в линейном и логарифмическом масштабах. Экстраполяция линейных данных представляет собой оценку порогового напряжения Vth. Наклон данных в логарифмическом масштабе для V < Vth дает подпороговый наклон. Обратите внимание, что устройство остается работоспособным при температурах >100°C, с увеличением обратного подпорогового наклона и увеличением тока отключения (Ioff) по мере повышения температуры. (б) Ток, измеренный на стоке, как функция напряжения исток/сток для различных значений напряжения затвора для того же устройства, что и в (а). Штриховая линия указывает на переход к текущему насыщению.
означает, что уменьшение C и уменьшение V на коэффициент K приводит к уменьшению необходимого общего заряда на коэффициент K2. Следовательно, уменьшение тока на K по-прежнему приводит к увеличению скорости зарядки на масштабный коэффициент K, что позволяет увеличить скорость цепи на аналогичный коэффициент.
Еще один способ подумать об этом — напрямую рассчитать время, необходимое для зарядки выходного узла схемы. Скорость заряда конденсатора:
dV dt
, где C — полная емкость в фарадах. Поскольку I и C уменьшаются с размером, скорость зарядки также не зависит от размера. Однако, поскольку меньшее устройство будет работать при меньшем напряжении, время, необходимое для зарядки, будет уменьшаться (и схема будет работать быстрее) по мере уменьшения размера. Выражение для времени зарядки получается путем интегрирования уравнения 3.3, где V = Vsd, I = Isd и C = (C, и подстановки тока из выражения подвижности (уравнение 3.1):
Лч-WJ;
Это показывает, что когда Vgs и Lch уменьшаются на K, время зарядки также уменьшается на тот же коэффициент, что приводит к увеличению скорости цепи.
Продолжить чтение здесь: 65 Архитектура нанокомпьютера
Была ли эта статья полезной?
Конспекты лекций | Микроэлектронные устройства и схемы | Электротехника и информатика
arrow_back просматривать материалы курса библиотека_книги
TE = тепловое равновесие
MOS = металл-кремний
MOSFET = полевой транзистор металл-оксид-полупроводник
BJT = транзистор с биполярным переходом
CMOS = комплементарный металл-оксид-полупроводник
CS = общий исток
OCTC = разомкнутая цепь постоянная времени
| LEC # | ТЕМЫ | СЛАЙДЫ | ДОПОЛНИТЕЛЬНЫЕ ПРИМЕЧАНИЯ |
|---|---|---|---|
| 1 |
Введение в полупроводники, легирование, генерация/рекомбинация, концентрации носителей ТЭ. Динамика и транспорт носителя: дрейф. Динамика и транспорт носителя: дрейф.
|
(PDF) | |
| 2 | Избыточные населенности и минимальное время жизни носителей, фотопроводимость. Неоднородные концентрации и диффузия. Первый и второй законы Фика. | (PDF) | |
| 3 | Пять основных уравнений. Приборные структуры в ТЭ: носители и электростатический потенциал; Правило 60 мВ. Уравнение Пуассона (ПУ). | (PDF) |
Решение пяти уравнений (PDF) Фотопроводники (PDF) |
| 4 | P-n-переходы в тепловом равновесии и при обратном смещении, приближение истощения (DA), сравнение с раствором PE. | (PDF) | |
| 5 | Просмотрите перекрестки с обратным смещением. Рассмотрим прямое смещение и частный случай инжекции неосновных носителей в квазинейтральные области. | (PDF) | |
| 6 |
Смещенные в прямом направлении p-n-переходы: инжекция носителей, вольт-амперные характеристики (идеальные и реальные; прямые и обратные). Инъекция инженерного носителя. Инъекция инженерного носителя.
|
(PDF) | |
| 7 | Транзисторы с биполярным переходом: два связанных диода, терминальные характеристики, области действия | (PDF) | |
| 8 | Солнечные элементы и светодиоды (светоизлучающие диоды). | (PDF) | |
| 9 | МОП-конденсаторы: DA применяется для накопления, разрядки и инверсии двухвыводных МОП-конденсаторов; V FB , V T , Q A и Q N | (PDF) | |
| 10 | Трехвыводной МОП-конденсатор. МОП-транзисторы: начните постепенное приближение канала (GCA) с использованием DA и игнорированием подпороговых несущих. | (PDF) | Слайды Нобелевской премии CCD (PDF) |
| 11 |
Полная модель GC/DA для i DS : насыщение, модуляция длины канала. Выходные характеристики; регионы деятельности.
|
(PDF) |
Модель тока стока (PDF) Аппроксимация последовательного канала для МОП-транзисторов (PDF) |
| 12 | Подпороговая работа MOSFET. Разработка модели; сравнить с полным численным решением. Сравните / сопоставьте с BJT. | (PDF — 1,0 МБ) | Примечания к подпороговому моделированию (PDF, 1,1 МБ) |
| 13 | Линейные эквивалентные схемы для MOSFET и BJT на низкой и высокой частоте; крутизна подпороговых МОП-транзисторов. | (PDF) | |
| 14 | Основы логического инвертора. Введение в КМОП: передаточные характеристики, запас по шуму, оптимальные размеры устройства. | (PDF) |
Анализ и конструкция инвертора (PDF) Анализ задержек переключения инвертора (PDF) |
| 15 |
Анализ КМОП, продолжение: задержки переключения, рассеиваемая мощность, компромисс между скоростью и мощностью.
|
(PDF) | Анализ задержки и мощности затвора CMOS (PDF) |
| 16 | Анализ КМОП, продолжение: подпороговая утечка, правила масштабирования и куда все это идет. | (PDF) |
Масштабирование КМОП и рассеиваемая мощность (PDF) Масштабирование CMOS: сравнение 1970 и 2000 (PDF) |
| 17 | Основы линейного усилителя: показатели производительности, смещение источника тока, токовые зеркала, среднечастотный диапазон, двухпортовое представление. | (PDF) | |
| 18 | Каскадные блоки с одним транзистором: каскады с общим истоком, общим затвором и общим стоком (повторители); характеристики и особенности. | (PDF) | |
| 19 | Дифференциальные усилители: большие характеристики передачи сигнала; анализ малых сигналов с использованием синфазных и дифференциальных входов. | (PDF) | |
| 20 |
Многокаскадные усилители I: каскадирование дифференциальных каскадов; смещение источника тока; выходные каскады.
|

