Какие основные параметры транзисторов важны при их выборе. Как правильно читать справочные данные по транзисторам. Чем отличаются транзисторы малой, средней и большой мощности. На что обращать внимание при подборе транзисторов для различных применений.
Классификация и типы транзисторов
Транзисторы являются одними из ключевых компонентов современной электроники. Эти полупроводниковые приборы используются для усиления и переключения электрических сигналов. По принципу работы выделяют два основных типа транзисторов:
- Биполярные транзисторы — работают за счет инжекции неосновных носителей заряда
- Полевые транзисторы — работают за счет изменения проводимости канала под действием электрического поля
По мощности рассеивания транзисторы подразделяются на:
- Маломощные — до 0.3 Вт
- Средней мощности — от 0.3 до 1.5 Вт
- Мощные — свыше 1.5 Вт
Также транзисторы классифицируют по частотным свойствам, материалу (кремниевые, германиевые), области применения и другим параметрам.

Основные параметры биполярных транзисторов
При выборе биполярных транзисторов необходимо учитывать следующие ключевые параметры:
- Максимально допустимое напряжение коллектор-эмиттер UCEmax
- Максимально допустимый ток коллектора ICmax
- Максимальная рассеиваемая мощность Pmax
- Коэффициент усиления по току h21E
- Граничная частота fT
- Емкость коллекторного перехода Cc
- Обратный ток коллектора ICBO
Эти параметры определяют предельные режимы работы транзистора и его усилительные свойства. Рассмотрим их подробнее.
Максимально допустимое напряжение коллектор-эмиттер UCEmax
UCEmax — это максимальное напряжение между коллектором и эмиттером, которое может выдержать транзистор без пробоя. Обычно составляет от единиц до сотен вольт. Для маломощных транзисторов типичные значения 20-60В, для мощных — до 1000В и выше.
Максимально допустимый ток коллектора ICmax
ICmax определяет предельный ток, протекающий через коллектор транзистора. Зависит от мощности и конструкции транзистора. Для маломощных транзисторов составляет десятки-сотни мА, для мощных — единицы и десятки ампер.

Максимальная рассеиваемая мощность Pmax
Pmax — это максимальная мощность, которую может рассеивать транзистор без перегрева и выхода из строя. Определяется конструкцией корпуса и кристалла. Для маломощных транзисторов обычно не превышает 0.3-0.5 Вт, для мощных может достигать сотен ватт.
Ключевые параметры полевых транзисторов
Основными параметрами полевых транзисторов являются:
- Максимальное напряжение сток-исток UDSmax
- Максимальный ток стока IDmax
- Крутизна характеристики S
- Пороговое напряжение UGS(th)
- Входная емкость Ciss
- Выходная емкость Coss
- Сопротивление канала в открытом состоянии RDS(on)
Рассмотрим особенности этих параметров для полевых транзисторов.
Максимальное напряжение сток-исток UDSmax
UDSmax определяет предельно допустимое напряжение между стоком и истоком транзистора. Для маломощных полевых транзисторов обычно составляет 20-100В, для мощных может достигать 1000В и более.
Максимальный ток стока IDmax
IDmax — это максимально допустимый постоянный ток стока. Зависит от размеров кристалла и конструкции корпуса. Для маломощных транзисторов составляет сотни мА — единицы А, для мощных — десятки и сотни ампер.

Крутизна характеристики S
Крутизна S показывает, насколько сильно изменяется ток стока при изменении напряжения на затворе. Измеряется в мА/В или А/В. Чем выше крутизна, тем лучше усилительные свойства транзистора.
Выбор транзисторов для различных применений
При подборе транзисторов для конкретных схем необходимо учитывать следующие факторы:
- Требуемую мощность и рабочие напряжения/токи
- Рабочую частоту
- Коэффициент усиления
- Температурный диапазон
- Тип корпуса
- Стоимость
Для маломощных низкочастотных схем подойдут недорогие биполярные транзисторы общего применения. Для высокочастотных схем лучше использовать ВЧ и СВЧ транзисторы с высокой граничной частотой. В мощных схемах применяются специализированные силовые транзисторы в корпусах с хорошим теплоотводом.
Как читать справочные данные по транзисторам
Справочные данные по транзисторам обычно включают следующие разделы:
- Предельно допустимые значения параметров
- Электрические характеристики
- Типовые характеристики в графическом виде
- Габаритный чертеж корпуса
- Рекомендации по применению
При чтении справочных данных важно обращать внимание на условия измерения параметров, допуски, температурные зависимости. Также полезно сравнивать параметры нескольких аналогичных транзисторов для оптимального выбора.

Особенности транзисторов различной мощности
Транзисторы малой, средней и большой мощности имеют следующие отличительные особенности:
Маломощные транзисторы (до 0.3 Вт)
- Малые размеры корпуса (TO-92, SOT-23 и т.п.)
- Низкие рабочие токи (десятки-сотни мА)
- Невысокие рабочие напряжения (до 40-60В)
- Применяются в слаботочной электронике
Транзисторы средней мощности (0.3-1.5 Вт)
- Корпуса с улучшенным теплоотводом (TO-220, SOT-223)
- Рабочие токи до 1-3А
- Рабочие напряжения до 100-200В
- Используются в источниках питания, усилителях звука
Мощные транзисторы (свыше 1.5 Вт)
- Массивные корпуса с радиатором (TO-3, TO-247)
- Большие рабочие токи (десятки ампер)
- Высокие рабочие напряжения (сотни вольт)
- Применяются в силовой электронике, импульсных источниках питания
Современные тенденции в технологии транзисторов
В настоящее время наблюдаются следующие тенденции в развитии транзисторных технологий:
- Уменьшение размеров транзисторных структур до нанометровых масштабов
- Применение новых полупроводниковых материалов (GaN, SiC)
- Создание 3D-структур транзисторов
- Развитие технологий корпусирования с улучшенным теплоотводом
- Оптимизация параметров для специализированных применений
Эти инновации позволяют создавать все более быстродействующие, экономичные и надежные транзисторы для различных областей электроники.

Заключение
Транзисторы остаются ключевыми активными компонентами современной электроники. Правильный выбор типа и параметров транзистора во многом определяет характеристики электронных устройств. Знание основных параметров и особенностей различных типов транзисторов позволяет разработчикам создавать оптимальные схемотехнические решения.
Транзисторы- справочники
СПРАВОЧНИКИ ПО ТРАНЗИСТОРАМ
Полупроводниковые приборы. Транзисторы средней и большой мощности:
Приводятся электрические и эксплуатационные характеристики полупроводниковых приборов – полевых и биполярных транзисторов средней и большой мощности. Даются классификация система обозначений, основные стандарты для описанных приборов. Для конкретных приборов приводятся сведения об основном назначении габаритных и присоединительных размерах, маркировке предельных эксплуатационных режимах и условиях работы.
Петухов В.М. Биполярные транзисторы средней и большой мощности, сверхвысокочастотные и их зарубежные аналоги. Том 5. — М.:КУБК-а, 1997. – 544с.
Приводятся
электрические и эксплуатационные
характеристики полупроводниковых
приборов – биполярных транзисторов
средней и большой мощности СВЧ. Даются
классификация и система обозначений,
основные стандарты для описанных
приборов. Приводятся сведения об основном
назначении, габаритных и присоединительных
размерах, маркировке, предельных
эксплуатационных режимах и условиях
работы.
Даются
классификация и система обозначений,
основные стандарты для описанных
приборов. Приводятся сведения об основном
назначении, габаритных и присоединительных
размерах, маркировке, предельных
эксплуатационных режимах и условиях
работы.
Мощные низковольтные СВЧ транзисторы для подвижных средств связи.// Радио. — 1999. – №10. — С. 45-46, – №11, — С. 43-44. Библиогр. 4 назв.
Приведены параметры транзисторов КТ8197, КТ9189, КТ9192, КТ9188А, КТ9109А и КТ9133.
621.382.(031)
А424
Аксенов А.И., Нефёдов А.В. Отечественные полупроводниковые приборы: Аналоги отечественных и зарубежных приборов: Спр., пособие. Кн. 1-3. / А.И. Аксенов, А.В. Нефёдов.- 3-е изд., доп. — М.: СОЛОН-Р. 2002. Библиогр. 10 назв.
В табличной форме
систематизированы в алфавитно-цифровой
последовательности данные на отечественные
биполярные и полевые транзисторы,
выпрямительные диоды, столбы и блоки,
варикапы, стабилитроны и стабисторы,
тиристоры, светоизлучающие и инфракрасные
диоды, линейные шкалы и цифробуквенные
индикаторы, диодные и транзисторные
оптопары источников электропитания,
высокоскоростных импульсных устройств,
формирователей мощных импульсов,
усилителей и генераторов различных
частот.
Аксенов А.И., Нефёдов А.В. Отечественные полупроводниковые приборы специального назначения. Книга 2. — М.: СОЛОН-Р, 2002.
В книге 2 систематизированы в табличной форме в алфавитно–цифровой последовательности данные по основным электрическим параметрам и конструктивному исполнению на отечественные биполярные и полевые транзисторы, выпрямительные диоды, столбы и блоки, варикапы, стабилитроны и стабисторы, тиристоры, светоизлучающие и инфракрасные диоды, линейные шкалы и цифро-буквенные индикаторы, диодные и транзисторные оптопары, предназначенные для применения в специальной радиоэлектронной аппаратуре.
621.382.3(031)
П314
Петухов В. М.
Взаимозаменяемые
транзисторы. Справочник.
– М.:
ИП РадиоСофт,
2003. – 384 с.
М.
Взаимозаменяемые
транзисторы. Справочник.
– М.:
ИП РадиоСофт,
2003. – 384 с.
Книга представляет собой исправленное и расширенное издание справочника «Аналоги отечественных и зарубежных транзисторов». Для удобства работы с изданием приводятся прямой (отечественный прибор — зарубежный аналог) и обратный (зарубежный прибор — отечественный аналог) перечни приборов, построенные в алфавитно-цифровой последовательности.
Аксенов А. И. Отечественные полупроводниковые приборы. Аналоги отечественных и зарубежных приборов. Справ. пособие А. И. Аксенов, А. В. Нефедов. — 5-е изд., доп. и испр. — М. СОЛОН-Пресс, 2005. — 583 с. ил. — (Ремонт; вып. 59). — Библиогр. 10 назв.
В табличной форме
систематизированы в алфавитно-цифровой
последовательности данные на отечественные
биполярные и полевые транзисторы,
выпрямительные диоды, столбы и блоки,
варикапы, стабилитроны и стабисторы,
тиристоры, светоизлучающие и инфракрасные
диоды, линейные шкалы и цифробуквенные
индикаторы, диодные и транзисторные
оптопары источников электропитания,
высокоскоростных импульсных устройств,
формирователей мощных импульсов,
усилителей и генераторов различных
частот.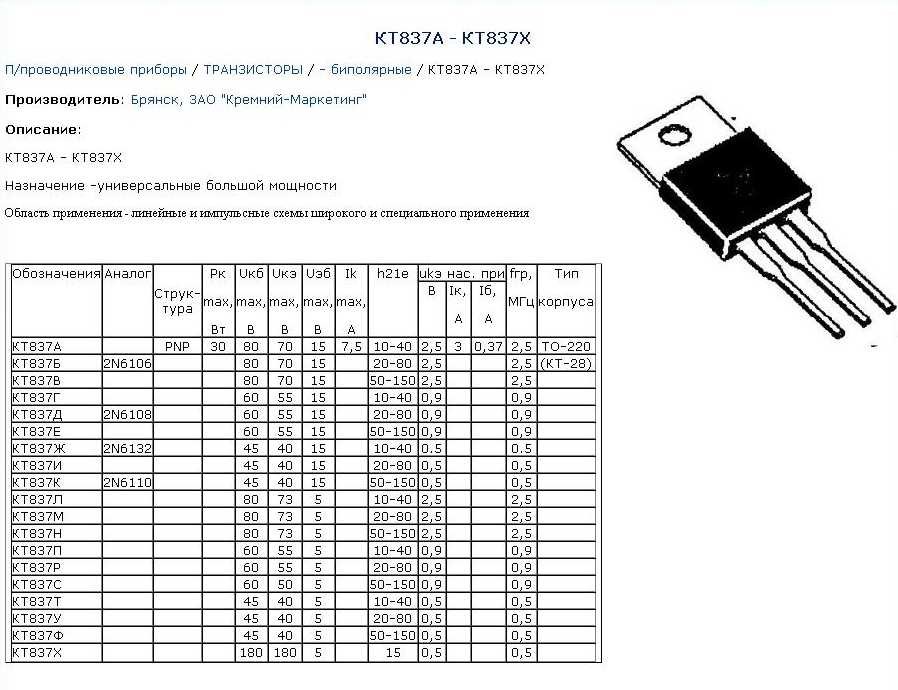 Приведены справочные данные по
всем отечественным мощным полевым
транзисторам и самым распространенным
приборам зарубежного производства.
Приведены справочные данные по
всем отечественным мощным полевым
транзисторам и самым распространенным
приборам зарубежного производства.
Ежов В.Б., Перельман Б.Л. Отечественные полупроводниковые приборы и зарубежные аналоги. Справочник -«НТЦ МИКРОТЕХ», изд.3-е перераб. и доп.-2005. —180с.
В справочник включены данные по основным электрическим параметрам и другим характеристикам на более чем 4000 типов полупроводниковых приборов: транзисторов, диодов, стабилитронов, тиристоров, варикапов, излучателей, оптопар, индикаторов и преобразователей Холла, выпускаемых в настоящее время отечественными производителями. Значительному числу отечественных приборов сопоставлены полные или функциональные зарубежные аналоги.
Петухов В. М. Взаимозаменяемые транзисторы. Справочник. – М.: ИП РадиоСофт, 2006. – 384 с.
Книга представляет
собой исправленное и расширенное издание
справочника «Аналоги отечественных
и зарубежных транзисторов». Для удобства
работы с изданием приводятся
прямой (отечественный прибор – зарубежный
аналог) и обратный (зарубежный прибор
– отечественный аналог) перечни
приборов, построенные в алфавитно-цифровой
последовательности.
Для удобства
работы с изданием приводятся
прямой (отечественный прибор – зарубежный
аналог) и обратный (зарубежный прибор
– отечественный аналог) перечни
приборов, построенные в алфавитно-цифровой
последовательности.
5.10.2013 г.
|
|
Точная характеристика микроволновых транзисторов на основе глубокого обучения с использованием полностью автоматизированных суррогатов регрессии .
 IEEE транс. Электр. Устройство. 2021;68(3):1318–1325. doi: 10.1109/TED.2020.3048918. [CrossRef] [Google Scholar]
IEEE транс. Электр. Устройство. 2021;68(3):1318–1325. doi: 10.1109/TED.2020.3048918. [CrossRef] [Google Scholar] 2. Thakker RA, Sathe C, Sachid AB, Baghini MS, Rao VR, Patil MB. «Новый табличный подход к проектированию схем FinFET. IEEE транс. вычисл. Помощь Des. интегр. Цепи Сист. 2009 г.;28(7):1061–1070. doi: 10.1109/TCAD.2009.2017431. [CrossRef] [Google Scholar]
3. Ван Дж., Сюй Н., Чой В., Ли К.-Х. & Park, Y. Общий подход к регистрации изменений процесса в моделях FET на основе таблиц поиска. в проц. Междунар. конф. Simulation Semiconductor Processes Devices (SISPAD), Вашингтон, округ Колумбия, США, 309–312 (2015).
4. Маринкович З., Крупи Г., Каддеми А., Маркович В., Шреурс ДММП. Обзор приложений искусственных нейронных сетей для моделирования слабого сигнала микроволновых полевых транзисторов. Междунар. Дж. Нумер. Модель. Электрон. сеть Дев. Поля. 2020; 33:1–3. [Академия Google]
5. Хусро А., Хусейн С., Хашми М.С., Ансари А.К. Метод моделирования поведения малых сигналов GaN-транзистора с высокой подвижностью электронов с использованием искусственной нейронной сети: точный, быстрый и надежный подход. Междунар. Дж. РФ Микроу. вычисл. Помогал инж. 2020;30:1–4. doi: 10.1002/mmce.22112. [CrossRef] [Google Scholar]
Междунар. Дж. РФ Микроу. вычисл. Помогал инж. 2020;30:1–4. doi: 10.1002/mmce.22112. [CrossRef] [Google Scholar]
6. Zhang QJ, Gupta KC, Devabhaktuni VK. Искусственные нейронные сети для радиочастотного и микроволнового проектирования: от теории к практике. IEEE транс. Микров. Теория Тех. 2003;51(4):1339–1350. doi: 10.1109/TMTT.2003.809179. [CrossRef] [Google Scholar]
7. Creech GL, Paul BJ, Lesniak CD, Calcatera MC. Искусственные нейронные сети для быстрой и точной ЭМ-САПР СВЧ-схем. IEEE транс. Микров. Теория Тех. 1997;45(5):794–802. дои: 10.1109/22.575602. [CrossRef] [Google Scholar]
8. Райас-Санчес Дж. Э. ЭМ-оптимизация СВЧ-схем с использованием искусственных нейронных сетей: современное состояние. IEEE транс. Микров. Теория Тех. 2004;52(1):420–435. дои: 10.1109/ТМТТ.2003.820897. [CrossRef] [Google Scholar]
9. Позар Д.М. Микроволновая техника. Аддисон-Уэсли; 1990. [Google Scholar]
10. Фрики Д.А. Преобразования между параметрами S, 2, Y, h, ABCD и T, которые действительны для комплексных импедансов источника и нагрузки. IEEE транс. Микров. Теория Тех. 1994;42(2):205–211. doi: 10.1109/22.275248. [CrossRef] [Google Scholar]
IEEE транс. Микров. Теория Тех. 1994;42(2):205–211. doi: 10.1109/22.275248. [CrossRef] [Google Scholar]
11. Джарндал А. Подход к электротермическому моделированию нейронной сети для микроволновых активных устройств. Междунар. Дж. РФ Микроу. вычисл. Помогал инж. 2019;29:1–9. doi: 10.1002/mmce.21764. [CrossRef] [Google Scholar]
12. Cao Y, Wang G, Zhang Q. Новый подход к обучению для параметрического моделирования микроволновых пассивных компонентов с использованием комбинированных нейронных сетей и передаточных функций. IEEE транс. Микров. Теория Тех. 2009;57(11):2727–2742. doi: 10.1109/TMTT.2009.2032476. [CrossRef] [Google Scholar]
13. Махути П. Применение алгоритмов искусственного интеллекта для моделирования фазовых характеристик отражения неоднородного элемента отражающей решетки. Междунар. Дж. Нумер. Модель. Электрон. сеть Дев. Поля. 2020; 33:1–2. [Академия Google]
14. Чалышкан А., Гюнеш Ф. Трехмерная оптимизация дизайна искусственной сети на основе электромагнитных данных круглой антенны с отражающей решеткой с полуэллиптическими кольцами для приложений X-диапазона. Микров. Опц. Технол. лат. 2022;64(3):537–543. doi: 10.1002/mop.33113. [CrossRef] [Google Scholar]
Микров. Опц. Технол. лат. 2022;64(3):537–543. doi: 10.1002/mop.33113. [CrossRef] [Google Scholar]
15. Zhang C, Jin J, Na W, Zhang QJ, Yu M. Обратное моделирование многозначных нейронных сетей и приложения к микроволновым фильтрам. IEEE транс. Микров. Теория Тех. 2018;66(8):3781–3797. doi: 10.1109/TMTT.2018.2841889. [CrossRef] [Google Scholar]
16. Koziel S, Mahouti P, Calik N, Belen MA, Szczepanski S. Усовершенствованное моделирование микроволновых структур с использованием полносвязной регрессионной модели, ориентированной на производительность. IEEE-доступ. 2021; 9: 71470–71481. doi: 10.1109/ACCESS.2021.3078432. [CrossRef] [Google Scholar]
17. Zhang J, Feng F, Zhang QJ. Быстрая оценка выхода пассивных микроволновых компонентов с использованием моделей нейропередаточной функции на основе уменьшения порядка модели. IEEE Микров. Провод. Комп. лат. 2021;31(4):333–336. дои: 10.1109/LMWC.2021.3059993. [CrossRef] [Google Scholar]
18. Козиэль С., Петренко-Дабровска А. и Бэндлер Дж. В. Эффективное с точки зрения вычислений суррогатное моделирование микроволновых компонентов с использованием анализа основных компонентов. В 2020 IEEE/MTT-S Int. Микров. Симп. (ИМС) , 68–71 (2020).
и Бэндлер Дж. В. Эффективное с точки зрения вычислений суррогатное моделирование микроволновых компонентов с использованием анализа основных компонентов. В 2020 IEEE/MTT-S Int. Микров. Симп. (ИМС) , 68–71 (2020).
19. Прасад А.К., Рой С. Точный полиномиальный хаос уменьшенной размерности для эффективной количественной оценки неопределенности микроволновых/радиочастотных сетей. IEEE транс. Микров. Теория Тех. 2017;65(10):3697–3708. doi: 10.1109/TMTT.2017.2689742. [CrossRef] [Google Scholar]
20. Козиэль С., Лейфссон Л. Оптимизация аэродинамической формы на основе суррогатов с помощью моделей с переменным разрешением. AIAA J. 2013;51(1):94–106. doi: 10.2514/1.J051583. [CrossRef] [Google Scholar]
21. Leifsson L, Koziel S. Оптимизация формы с переменным разрешением: выбор модели с низкой точностью и масштабируемость. Междунар. Дж. Матем. Мод. номер Опц. 2015;6(1):1–21. [Google Scholar]
22. Маринкович З., Крупи Г., Шреурс Д., Каддеми А., Маркович В. Моделирование микроволн FinFET на основе искусственных нейронных сетей, включая кремниевую подложку с потерями. Микроэлектрон. англ. 2011;88(10):3158–3163. doi: 10.1016/j.mee.2011.06.019. [CrossRef] [Google Scholar]
Моделирование микроволн FinFET на основе искусственных нейронных сетей, включая кремниевую подложку с потерями. Микроэлектрон. англ. 2011;88(10):3158–3163. doi: 10.1016/j.mee.2011.06.019. [CrossRef] [Google Scholar]
23. Маринкович З., Крупи Г., Каддеми А., Маркович В. Сравнение аналитического и нейронного подходов к моделированию слабого сигнала с множественным смещением полевых транзисторов микроволнового масштаба. Микров. Опц. Техн. лат. 2010;52(10):2238–2244. doi: 10.1002/mop.25432. [CrossRef] [Google Scholar]
24. Маринкович З., Крупи Г., А. Каддеми и Маркович В. О нейронном подходе для моделирования слабого сигнала на полевых транзисторах до 50 ГГц. В 10-й семинар по применению нейронных сетей в электротехнике: NEUREL 2010 , 89–92 (2010).
25. Гюнеш Ф., Махути П., Демирель С., Белен М.А., Улуслу А. Экономически эффективное моделирование микроволновых транзисторов на основе GRNN с уменьшенным количеством измерений. Междунар. Дж. Нумер. Модель. Электрон. сеть Поля устройств. 2017;30:3–4. doi: 10.1002/jnm.2089. [CrossRef] [Google Scholar]
сеть Поля устройств. 2017;30:3–4. doi: 10.1002/jnm.2089. [CrossRef] [Google Scholar]
26. Гюнеш Ф., Белен М.А., Махути П., Демирель С. Моделирование сигналов и шума микроволновых транзисторов с использованием векторной разреженной регрессии на основе характеристик. Радиотехника. 2016;25(3):490–499. doi: 10.13164/re.2016.0490. [CrossRef] [Google Scholar]
27. Satılmış G, Güneş F, Mahouti P. Основанное на физических параметрах основанное на данных моделирование параметров слабого сигнала металл-полупроводникового полевого транзистора. Междунар. Дж. Нумер. Модель. Электрон. сеть Поля устройств. 2021; 34:1–3. doi: 10.1002/jnm.2840. [CrossRef] [Google Scholar]
28. Na, W., Yan, S., Feng, F., Liu, W., Zhu, L., & Zhang, Q. J. Последние достижения в оптимизации структуры модели на основе знаний и методы экстраполяции для микроволновых приложений. Междунар. Дж. Нумер. Модель. Электрон. сеть Устройства Нивы (2021).
29. Мортеза М.С. Новый подход к проектированию малошумящего стабильного широкополосного СВЧ-усилителя с использованием гибридного метода оптимизации. IETE J. Res. 2020; 1:1–7. [Google Scholar]
IETE J. Res. 2020; 1:1–7. [Google Scholar]
30. Şenel, B. & Şenel, F.A. Новый подход к оптимизации нейронной сети для моделирования параметров рассеяния и шума микроволнового транзистора. Междунар. Дж. Нумер. Модель. Электрон. сеть Устройства Нивы (2021).
31. Козиэль, С., Чалик, Н., Махути, П. и Белен, М. А. Точное моделирование антенных структур с помощью ограничения домена и пирамидальных глубоких нейронных сетей. IEEE Trans. Муравей. Предложение (2021 г.).
32. Tao J, Feng Q. Компактная сверхширокополосная антенна MIMO с полущелевой структурой. IEEE Ант. Провод. Проп. 2017; 16: 792–795. doi: 10.1109/LAWP.2016.2604344. [CrossRef] [Google Scholar]
33. Бейкер Дж. А. и Джейкобс Дж. П. Эмпирическое исследование преимуществ увеличения глубины нейронной сети для моделирования входных характеристик антенны. В Междунар. конф. Электромагнетизм в Adv. заявл. , 1180–1181 (2019). 10.1109/ИКЭАА.2019.8879115.
34. Швегманн, К. П., Клейнханс, В., Салмон, Б.П., Мдакане, Л.В. и Мейер, Р.Г.В. Очень глубокое обучение для распознавания судов на радиолокационных изображениях с синтетической апертурой. В IEEE Trans. Geosci. и Remote Sens. Symposium , 104–107 (2016). 10.1109/ИГАРСС.2016.7729017.
П., Клейнханс, В., Салмон, Б.П., Мдакане, Л.В. и Мейер, Р.Г.В. Очень глубокое обучение для распознавания судов на радиолокационных изображениях с синтетической апертурой. В IEEE Trans. Geosci. и Remote Sens. Symposium , 104–107 (2016). 10.1109/ИГАРСС.2016.7729017.
35. Бергстра Дж., Бенжио Ю. Случайный поиск для оптимизации гиперпараметров. Дж. Мах. Учиться. Рез. 2012;13(1):281–305. [Google Scholar]
36. Нири П. Автоматическая настройка гиперпараметров в глубоких сверточных нейронных сетях с использованием асинхронного обучения с подкреплением. В IEEE Междунар. конф. Когнитивные вычисления , 73–77 (2018). 10.1109/ICCC.2018.00017.
37. Чен XY, Пэн XY, Пэн Y, Ли J-B. Классификация целей радиолокационного изображения с синтезированной апертурой на основе глубокого обучения. Дж. Инф. Скрытие Мультим. Сигнальный процесс. 2016;7:1345–1353. [Google Scholar]
38. Коухалванди Л., Джейлан О., Озогуз С. Автоматизированная оптимизация на основе глубокого нейронного обучения для высокопроизводительных конструкций усилителей. IEEE транс. Цепи Сист. Я Регул. Пап. 2020;67(12):4420–4433. дои: 10.1109/TCSI.2020.3008947. [CrossRef] [Google Scholar]
IEEE транс. Цепи Сист. Я Регул. Пап. 2020;67(12):4420–4433. дои: 10.1109/TCSI.2020.3008947. [CrossRef] [Google Scholar]
39. Чалик Н., Белен М.А., Махути П., Козиэль С. Точное моделирование частотно-избирательных поверхностей с использованием полносвязной регрессионной модели с автоматическим определением архитектуры и выбором параметров на основе байесовской оптимизации. IEEE-доступ. 2021;9:38396–38410. doi: 10.1109/ACCESS.2021.3063523. [CrossRef] [Google Scholar]
40. Моку Дж. Применение байесовского подхода к численным методам глобальной и стохастической оптимизации. Дж. Глоб. Оптим. 1994;4:347–365. doi: 10.1007/BF01099263. [CrossRef] [Google Scholar]
41. Jia W, Chen X-Y, Zhang H, Xiong LD, Lei H, Deng SH. Оптимизация гиперпараметров для моделей машинного обучения на основе байесовской оптимизации. Дж. Электрон. науч. Тех. 2019;17(1):26–40. [Google Scholar]
42. Ян Л., Абдалла С. Об оптимизации гиперпараметров алгоритмов машинного обучения: теория и практика. Нейрокомпьютинг. 2020; 415: 295–316. doi: 10.1016/j.neucom.2020.07.061. [Перекрестная ссылка] [Академия Google]
Нейрокомпьютинг. 2020; 415: 295–316. doi: 10.1016/j.neucom.2020.07.061. [Перекрестная ссылка] [Академия Google]
43. Адлам, Б., Вейл, К. и Капур, А. Исследование генеративно-состязательных сетей Вассерштейна. http://arxiv.org/abs/1910.14137 (2019 г.).
44. Рохас Р. Алгоритм обратного распространения. Нейронные сети. Спрингер; 1996. С. 149–182. [Google Scholar]
45. Вену Г. и Венаягамурти Г. К. Сравнение оптимизации роя частиц и обратного распространения в качестве алгоритмов обучения нейронных сетей. В проц. 2003 IEEE Swarm Intel. Симп. , 110–117 (2003).
46. Илонен Дж., Камарайнен Дж.К., Лампинен Дж. Алгоритм обучения дифференциальной эволюции для нейронных сетей с прямой связью. Нейронный процесс. лат. 2003;17(1):93–105. doi: 10.1023/A:1022995128597. [CrossRef] [Google Scholar]
47. Ягини М., Хошрафтар М.М., Фаллахи М. Гибридный алгоритм для обучения искусственных нейронных сетей. англ. заявл. Артиф. Интел. 2013;26(1):293–301. doi: 10. 1016/j.engappai.2012.01.023. [CrossRef] [Google Scholar]
1016/j.engappai.2012.01.023. [CrossRef] [Google Scholar]
48. Хохрайтер С. Проблема исчезающего градиента при обучении рекуррентных нейронных сетей и решения проблем. Междунар. Дж. Неуверенно. Нечеткость знаний. На основе сист. 1998;6(2):107–116. doi: 10.1142/S0218488598000094. [CrossRef] [Google Scholar]
49. Loffe S, Szegedy C. Пакетная нормализация: ускорение глубокого обучения сети за счет уменьшения внутреннего ковариатного сдвига. Междунар. конф. Мах. Учиться. 2015; 1: 448–456. [Google Scholar]
50. Кеке Х., Ли С., Дэн В., Ю З., Ма Л. Вывод структуры сетевой системы с синергией глубокой остаточной сети и полносвязной многоуровневой сети. Нейронная сеть. 2022; 145: 288–299. doi: 10.1016/j.neunet.2021.10.016. [PubMed] [CrossRef] [Академия Google]
51. Бергстра Дж., Барденет Р., Бенжио Ю. и Кегл Б. Алгоритмы оптимизации гиперпараметров. В Достижения в системах обработки нейронной информации (2011).
52. Бергстра Дж., Яминс Д., Кокс Д. Создание науки о поиске моделей: оптимизация гиперпараметров в сотнях измерений для архитектур машинного зрения. Междунар. конф. Мах. Учиться. 2013;1:115–123. [Google Scholar]
Создание науки о поиске моделей: оптимизация гиперпараметров в сотнях измерений для архитектур машинного зрения. Междунар. конф. Мах. Учиться. 2013;1:115–123. [Google Scholar]
53. Одзаки Ю., Танигаки Ю., Ватанабе С. и Ониши М. Многокритериальная древовидная парзен-оценка для задач оптимизации, требующих значительных вычислительных ресурсов. В Проц. Жене. Эво. Комп. конф. , 533–541.
54. Уильямс К.К., Расмуссен К.Э. Гауссовские процессы для машинного обучения. Массачусетский технологический институт Пресс; 2012. с. 4. [Google Scholar]
55. Erwianda MSF, Kusumawardani SS, Santosa PI, Rimadana MR. Улучшение модели классификатора состояния путаницы с использованием xgboost и оценщика парзена с древовидной структурой. Междунар. Сем. Рез. Инф. Тех. Интел. Сист. 2021; 1: 309–313. [Google Scholar]
56. Патро, С. Г. К. и Саху, К. К. Нормализация: этап предварительной обработки. http://arxiv.org/abs/1503.06462.
57. Коутс, А., Нг, А. и Ли, Х. Анализ однослойных сетей в неконтролируемом изучении признаков. Семинар и конференция PMLR. Труды , 215–223 (2011).
Семинар и конференция PMLR. Труды , 215–223 (2011).
58. Li Z, Fan Y, Liu W. Влияние отбеливающего преобразования на операции объединения в сверточных автоэнкодерах. EURASIP J. Adv. Сигнальный процесс. 2015; 37:1–10. [Google Scholar]
59. Xavier, G. & Bengio, Y. Понимание сложности обучения нейронных сетей с глубокой прямой связью. В Семинар и конференция PMLR. Труды , 249–256 (2010).
60. Вей Х., Сяо Л. и Пеннингтон Дж. Доказуемое преимущество ортогональной инициализации при оптимизации глубоких линейных сетей. http://arxiv.org/abs/2001.05992 (2020 г.).
61. Хе, К., Чжан, X., Рен, С. и Сун, Дж. «Углубление в выпрямители: превосходство на уровне человека в классификации Imagenet», Proceedings of the IEEE Int. конф. на Computer Vision , 1026–1034, (2015).
62. Катажина Дж. и Чарнецкий В. М. «О функциях потерь для глубоких нейронных сетей в классификации», Препринт arXiv arXiv: 1702.05659 (2017).
63. Фушики Т. Оценка ошибки предсказания с помощью перекрестной проверки в K-кратном порядке. Стат. вычисл. 2011;21:137–146. doi: 10.1007/s11222-009-9153-8. [CrossRef] [Google Scholar]
Фушики Т. Оценка ошибки предсказания с помощью перекрестной проверки в K-кратном порядке. Стат. вычисл. 2011;21:137–146. doi: 10.1007/s11222-009-9153-8. [CrossRef] [Google Scholar]
64. Рефаилзаде П., Танг Л., Лю Х. Перекрестная проверка. Энциклоп. База данных сист. 2009; 5: 532–538. doi: 10.1007/978-0-387-39940-9_565. [CrossRef] [Google Scholar]
65. Широкополосный биполярный радиочастотный транзистор Infineon Silicon Germanium Carbon (SiGe:C) с гетеропереходом (HBT) с интегрированной защитой от электростатического разряда BFP720ESD. https://www.infineon.com/cms/en/product/rf-wireless-control/rf-transistor/ultra-low-noise-sigec-transistors-for-use-up-to-12-ghz/bfp720esd/ #!моделирование. По состоянию на 4 октября 2022 г.
66. Малошумящий кремниевый биполярный ВЧ-транзистор Infineon BFP193W. www.infineon.com/cms/en/product/rf/rf-transistor/high-linearity-rf-transistors/bfp193w/?redirId=191085#!документы. По состоянию на 4 октября 2022 г.
67. Avago Technologies. VMMK-1218 Малошумящий E-PHEMT от 0,5 до 18 ГГц в корпусе в форме пластины . www.farnell.com/datasheets/77787.pdf. По состоянию на 10 апреля 2022 г.
VMMK-1218 Малошумящий E-PHEMT от 0,5 до 18 ГГц в корпусе в форме пластины . www.farnell.com/datasheets/77787.pdf. По состоянию на 10 апреля 2022 г.
68. Махути П., Гюнеш Ф., Чалык Н., Белен М. А. и Козиэль С. Характеристика микроволновых транзисторов с использованием условий смещения постоянного тока. Порт данных IEEE .
69. Пашке А., Гросс С., Масса Ф., Лерер А., Брэдбери Дж., Чанан Г. и соавт. PyTorch: императивный стиль, высокопроизводительная библиотека глубокого обучения. Доп. Нейронная инф. Процесс. Сист. 2019; 1:8024–8035. [Google Scholar]
70. Willmott CJ, Matsuura K. Преимущества средней абсолютной ошибки (MAE) над среднеквадратичной ошибкой (RMSE) при оценке средней производительности модели. Клим. Рез. 2005;30(1):79–82. doi: 10.3354/cr030079. [CrossRef] [Google Scholar]
71. Drucker H, Burges CJ, Kaufman L, Smola A, Vapnik V. Машины регрессии опорных векторов. Доп. Нейронная инф. Процесс. Сист. 1996;9:1–10. [Google Scholar]
72. Шульц Э., Спекенбринк М., Краузе А. Учебное пособие по регрессии гауссовских процессов: моделирование, изучение и использование функций. Дж. Матем. Психол. 2018;85:1–16. doi: 10.1016/j.jmp.2018.03.001. [CrossRef] [Google Scholar]
Шульц Э., Спекенбринк М., Краузе А. Учебное пособие по регрессии гауссовских процессов: моделирование, изучение и использование функций. Дж. Матем. Психол. 2018;85:1–16. doi: 10.1016/j.jmp.2018.03.001. [CrossRef] [Google Scholar]
73. MathWorks. Байесопт: выбор оптимальных гиперпараметров машинного обучения с использованием байесовской оптимизации . www.mathworks.com/help/stats/bayesopt.html. По состоянию на 28 мая 2022 г.
74. MathWorks. Fitrgp: подгонка модели 9 регрессии гауссовского процесса (GPR)0008 . https://www.mathworks.com/help/stats/fitrgp.html.
75. MathWorks. Fitrsvm: подбор модели машинной регрессии опорных векторов . https://www.mathworks.com/help/stats/fitrsvm.html.
Моделирование и извлечение параметров на основе физических эффектов в биполярных транзисторах
На этой странице
АннотацияВведениеВыводыСсылкиАвторское правоСтатьи по теме стабильные интегральные схемы, которые требуют более точных программ моделирования в процессе проектирования. PSPICE, широко используемый для имитации общего поведения интегральных схем, не учитывает многие физические эффекты, которые можно обнаружить в реальных устройствах. Компактные модели HICUM и MEXTRAM были разработаны в последние десятилетия, чтобы устранить этот недостаток. В этой статье представлены некоторые из физических аспектов, которые до сих пор не были изучены, такие как выражение напряжения база-эмиттер, включая эффект коэффициента эмиссии эмиттера (), физическое объяснение и процедура моделирования, а также новый метод извлечения для диффузионный потенциал , основанный на смещенной в прямом направлении емкости база-эмиттер, демонстрирующий превосходное соответствие между экспериментальными и теоретическими результатами.
PSPICE, широко используемый для имитации общего поведения интегральных схем, не учитывает многие физические эффекты, которые можно обнаружить в реальных устройствах. Компактные модели HICUM и MEXTRAM были разработаны в последние десятилетия, чтобы устранить этот недостаток. В этой статье представлены некоторые из физических аспектов, которые до сих пор не были изучены, такие как выражение напряжения база-эмиттер, включая эффект коэффициента эмиссии эмиттера (), физическое объяснение и процедура моделирования, а также новый метод извлечения для диффузионный потенциал , основанный на смещенной в прямом направлении емкости база-эмиттер, демонстрирующий превосходное соответствие между экспериментальными и теоретическими результатами.
1. Введение
Каждый день продукты и процессы для микросистем становятся все более сложными и обеспечивают высокую степень точности и стабильности. Моделирование конструкции должно быть очень точным, чтобы повысить стабильность и воспроизводимость устройств. Между элементами электронных схем, используемых в микросистемах, часто встречаются интегральные датчики температуры и термокомпенсированные источники опорного напряжения. Надежная конструкция этих схем, изготовленных с использованием передовых биполярных технологий и технологий BiCMOS, серьезно пострадала из-за недостатков модели SPICE Gummel-Poon (SGPM), как обсуждалось Schroter et al. [1] и нуждаются в более физических и точных моделях.
Между элементами электронных схем, используемых в микросистемах, часто встречаются интегральные датчики температуры и термокомпенсированные источники опорного напряжения. Надежная конструкция этих схем, изготовленных с использованием передовых биполярных технологий и технологий BiCMOS, серьезно пострадала из-за недостатков модели SPICE Gummel-Poon (SGPM), как обсуждалось Schroter et al. [1] и нуждаются в более физических и точных моделях.
Напряжение база-эмиттер, благодаря своей чрезвычайно воспроизводимой экспоненциальной характеристике, является основным элементом конструкции микросхемы. датчики температуры и источники опорного напряжения с температурной компенсацией. Для достижения требуемой точности и стабильности в этих схемах необходимо точное описание зависимости напряжения база-эмиттер от температуры.
Приведенные в литературе выражения были получены для тока коллектора. Коллекторный ток биполярного транзистора NPN, работающего в активной области, при малых уровнях тока, без учета коэффициента эмиссии эмиттера, прямого и обратного эффектов Раня, определяется Цивидисом [2]:
где – абсолютная температура, напряжение база-эмиттер, заряд электрона и постоянная Больцмана ( эВ/К). Членом -1 можно пренебречь, когда инжектируемый ток намного больше, чем ток насыщения.
Членом -1 можно пренебречь, когда инжектируемый ток намного больше, чем ток насыщения.
Выражение для (1), полученное Цивидисом [2], известно как «точное выражение» и имеет вид
где и – напряжение базового эмиттера и запрещенной зоны при эталонной температуре. Точность выражения (2) зависит от точности используемой модели напряжения запрещенной зоны. В литературе сообщалось о различных моделях, как обсуждалось в других работах [2–6], полученных разными методами для собственного кремния. В 1982 г. Мейер [7], используя линейную аппроксимацию для напряжения запрещенной зоны [5], получил следующее выражение для :
где — экстраполированное значение напряжения запрещенной зоны при нуле Кельвина и параметр, связанный с зависимостью глобальной подвижности от температуры через, как обсуждалось Слотбумом и Граафом [8], который является результатом механизмов рассеяния, вызванных тепловыми колебаниями и ионизированными примесями, как обсуждалось Амадором. и другие. [9],
Значения и могут быть получены из экспериментальных измерений при трех температурах рабочего диапазона. Экспериментальные измерения диффузионных пластин и различных типов биполярных транзисторов, как сообщалось в других источниках [7, 10], показали отрицательную корреляцию между обоими параметрами, как сообщалось в литературе.
Экспериментальные измерения диффузионных пластин и различных типов биполярных транзисторов, как сообщалось в других источниках [7, 10], показали отрицательную корреляцию между обоими параметрами, как сообщалось в литературе.
Для улучшения описания прямые и обратные ранние эффекты обсуждались в другом месте [11, 12]. Тем не менее коэффициент эмиссии эмиттера и его влияние до сих пор недостаточно изучены.
Моделирование и извлечение рассматриваемых здесь параметров основаны на экспериментальных измерениях емкости база-эмиттер, смещенной в прямом направлении, с использованием измерительной установки, показанной на рис. 1. . Измерения постоянного тока были выполнены с помощью мультиметра Agilent с разрядностью 6 1/2 разряда. Ошибка измерения Ce в мосте из-за параллельной проводимости диодов база-эмиттер незначительна, за исключением области, близкой к максимальному значению Ce, где она составляет всего 2%. Поэтому поправки в экспериментальные значения Ce не вносятся.
Из экспериментальных измерений Ce, выполненных с помощью стандартных биполярных транзисторов MAT01, было обнаружено неожиданное экспоненциальное увеличение при значительном прямом смещении. Такое поведение не учитывается ни в моделях Ideal, Gummel-Poon, ни в первых моделях MEXTRAM и HICUM Ce, что можно увидеть в других работах [13–15]. Из рисунка 2 видно, что три модели не соответствуют экспоненциальному поведению Ce и начинают увеличиваться при более высоких напряжениях смещения. По этой причине было необходимо разработать новую модель емкости эмиттера с прямым смещением биполярных транзисторов, опубликованную Nagy et al. [16], которая включает область с экспоненциальным поведением емкости эмиттера Ce при увеличении прямого смещения. Физическое объяснение экспоненциального роста Ce было найдено в теории переходной области p-n-перехода, обсуждавшейся Shockley et al. [17]. Современные модели компактных биполярных транзисторов, такие как MEXTRAM и HICUM, обсуждались в других источниках [18, 19].] учитывать нейтральный заряд, используя модель времени прохождения заряда.
Такое поведение не учитывается ни в моделях Ideal, Gummel-Poon, ни в первых моделях MEXTRAM и HICUM Ce, что можно увидеть в других работах [13–15]. Из рисунка 2 видно, что три модели не соответствуют экспоненциальному поведению Ce и начинают увеличиваться при более высоких напряжениях смещения. По этой причине было необходимо разработать новую модель емкости эмиттера с прямым смещением биполярных транзисторов, опубликованную Nagy et al. [16], которая включает область с экспоненциальным поведением емкости эмиттера Ce при увеличении прямого смещения. Физическое объяснение экспоненциального роста Ce было найдено в теории переходной области p-n-перехода, обсуждавшейся Shockley et al. [17]. Современные модели компактных биполярных транзисторов, такие как MEXTRAM и HICUM, обсуждались в других источниках [18, 19].] учитывать нейтральный заряд, используя модель времени прохождения заряда.
Моделирование и извлечение рассматриваемых здесь параметров основаны на новой модели емкости база-эмиттер с прямым смещением, описанной Nagy et al. [16]. Краткое описание дается следующим образом.
[16]. Краткое описание дается следующим образом.
2.1. Краткое описание новой модели емкости база-эмиттер биполярного транзистора
Новая модель построена с использованием двух выражений, связанных с функцией сглаживания: трехпараметрического идеального выражения, которое преобладает при малом прямом смещении, и выражения нейтральной емкости, которое преобладает при увеличении прямого смещения. , как обсуждалось Nagy et al. [16]. Примечательно соответствие новой модели Се экспериментальным результатам. Эта модель Ce в зависимости от напряжения база-эмиттер и температуры определяется выражением где функция сглаживания, определенная для интервала напряжения, заданного выражением где (i) — напряжение база-эмиттер при максимуме Ce, (ii) — максимальное значение напряжений база-эмиттер, удовлетворяющее условию объемного заряда с учетом экспериментальных измерений.
В идеальной модели или модели емкости пространственного заряда где – емкость при нулевом смещении.
Температурная зависимость емкости эмиттера при нулевом смещении определяется выражением
Это также известно, как сообщается Schroter et al.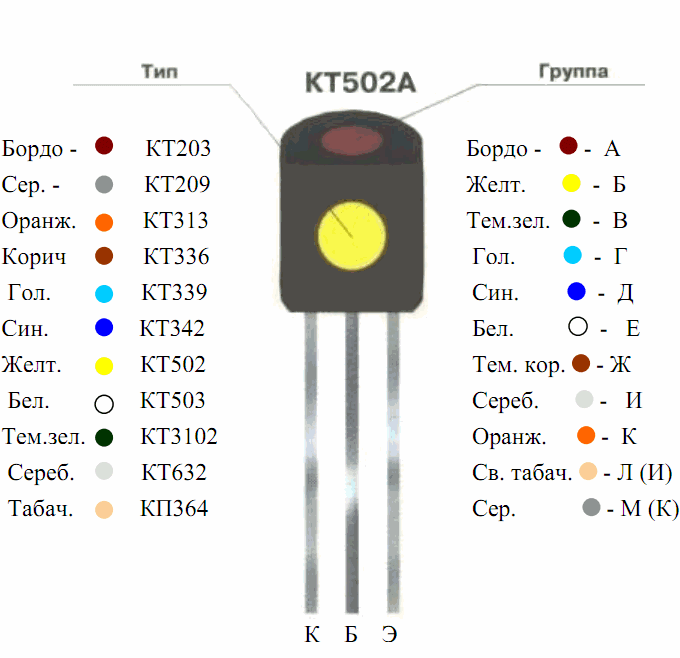 [13] видно, что диффузионное напряжение зависит от температуры через
Выражение нейтральной емкости было получено с использованием теории Шокли о емкости переходной области p-n перехода. Для случая биполярного транзистора это можно записать так, как показано Nagy et al. [16] как
с
где — эталонная температура, а — напряжение запрещенной зоны, экстраполированное при нулевом значении Кельвина.
[13] видно, что диффузионное напряжение зависит от температуры через
Выражение нейтральной емкости было получено с использованием теории Шокли о емкости переходной области p-n перехода. Для случая биполярного транзистора это можно записать так, как показано Nagy et al. [16] как
с
где — эталонная температура, а — напряжение запрещенной зоны, экстраполированное при нулевом значении Кельвина.
На основании выражения (11) и условия максимальной емкости найдена важная зависимость между и (что позволяет экспериментально определить при любой температуре), Моделирование экспериментально измеренных значений Ce при 39,3 ° C было использовано для оценки температурной зависимости новой модели Ce. Измеренные и смоделированные значения Ce с новой моделью при двух температурах показаны на рисунке 3.
Параметры моделирования, извлеченные из экспериментальных измерений при 29.3°C, равны pF, , V, pF, pF и V. Пределы интервала сглаживающей функции при °C равны V и V, а при °C равны V и V. Измеренные и прогнозируемые значения с использованием новой модели приведены в таблице 1.
Измеренные и прогнозируемые значения с использованием новой модели приведены в таблице 1.
Наблюдается очень хорошая точность экстраполяции 1 %, за исключением Ce max с почти 8 % ошибкой, которая может быть связана с ±5 % временным и температурным дрейфом емкостного моста во время измерений.
3. Влияние коэффициента излучения излучателя
Изменение коэффициента излучения излучателя () в зависимости от температуры было измерено и опубликовано в других источниках [20, 21]. При очень низкой температуре (230 К–300 К) обнаружено увеличение значения . До сих пор нет удовлетворительного объяснения этому явлению.
В этой статье представлен физический подход к поведению через емкость эмиттер-база. С учетом влияния коэффициента эмиссии ток коллектора можно записать как
из которого можно получить выражение в виде
Уравнение (15) показывает, что на это влияет как значение коэффициента эмиссии, так и его изменение с температурой. Можно выделить три случая: (а) для всего диапазона температур : в этом случае (15) сводится к выражению, известному в литературе; (б) и постоянна для всего температурного диапазона : в этом случае не затрагивается только линейный член; (c) и изменяется в зависимости от : в этом случае затрагиваются все члены.
Это делает необходимым характеризовать изменение как функцию смещения и температуры.
3.1. Физический подход к коэффициенту эмиссии эмиттера
Многие авторы считают коэффициент эмиссии, как и в модели SPICE Gummel-Poon (SGP), постоянной величиной, близкой к единице, для объяснения неидеальности экспоненциальной зависимости тока коллектора от напряжения эмиттер-база как обсуждалось в других работах [2, 10] (см. (14)). Тем не менее, как обсуждалось Гаммелем и Пуном [14], в исходной модели Гаммеля-Пуна параметр не является параметром, а определяется при заданном и как величина, обратная наклону графика Гуммеля, заданному при низком уровне закачки
Расширение модели Гаммеля-Пуна, как обсуждалось Nagy et al. [22] определение температуры в приводит к
где – емкость эмиттера и заряд нулевого смещения в базе, который можно считать постоянным. Это выражение позволяет физически подойти к его поведению при прямом смещении и температуре через , что широко изучалось в других работах [13, 14, 23, 24].
3.2. Моделирование коэффициента эмиссии эмиттера
Была разработана новая процедура моделирования для описания поведения коэффициента эмиссии биполярного транзистора (смещенного при постоянном токе коллектора) в зависимости от температуры. В этой процедуре используются оригинальные выражения Гуммеля-Пуна, включающие его температурную зависимость (см. (17)) и новая модель Ce, разработанная как функция напряжения база-эмиттер и температуры.
Блок-схема, показывающая процедуру моделирования, используемую для получения, представлена на рис. 4, которая включает экспериментальные и смоделированные значения Ce при 290,3°С.
3.3. Результаты моделирования
Коэффициент эмиссии рассчитывался в диапазоне температур 240 K–300 K по формуле (17), где значение считалось постоянным и равным 6,0 пФ. Параметры моделирования, извлеченные из экспериментальных измерений Ce при эталонной температуре (29,3 ° C), были следующими: pF, V, , pF и , pF и V. Условия смещения для моделирования при были заданы V и V, оба выбраны в область с экспоненциальным поведением емкости эмиттера Ce при увеличении прямого смещения.
Результаты моделирования стандартного биполярного транзистора MAT01 с V и вертикальных PNP-транзисторов, изготовленных по КМОП-технологии 0,5 µ мкм с , V при двух уровнях смещения, показаны на рисунках 5 и 6.
Температурная чувствительность связана с продуктом , как видно из (17). Это подразумевает зависимость площади эмиттера, подтвержденную экспериментальными измерениями при низких температурах для различных площадей эмиттера, как обсуждалось Вангом и Мейером [20]. Из представленных результатов моделирования видно, что увеличение при низкой температуре также зависит от условий смещения и технологических параметров и . В случае вертикальных транзисторов pnp, изготовленных с 0,5 μ м КМОП-технология, смоделированное поведение показывает аналогичную тенденцию, чем сообщаемые измеренные данные.
3.4. Оценка влияния на
Оценка влияния коэффициента эмиссии эмиттера была получена с использованием линейной аппроксимации для в (15) из , в результате чего
где и представляют собой параметры наилучшего соответствия для , извлеченные из экспериментальных измерений. Теперь (18) изменяется как
Вносимая погрешность без учета изменения коэффициента эмиссии с температурой оценивалась для транзисторов, изготовленных по разным технологиям, с использованием (19). Результаты представлены в таблице 2, где ошибка , выраженная в эквивалентной температуре, была оценена с учетом типичного изменения напряжения база-эмиттер в −2 мВ/°C.
Теперь (18) изменяется как
Вносимая погрешность без учета изменения коэффициента эмиссии с температурой оценивалась для транзисторов, изготовленных по разным технологиям, с использованием (19). Результаты представлены в таблице 2, где ошибка , выраженная в эквивалентной температуре, была оценена с учетом типичного изменения напряжения база-эмиттер в −2 мВ/°C.
Эти результаты оценивают удобство учета изменения коэффициента эмиссии в зависимости от температуры при проектировании цепей на основе напряжения база-эмиттер, т.к. датчики температуры и источники опорного напряжения с компенсацией запрещенной зоны.
4. Встроенное напряжение
Разность потенциалов на p-n-переходе в состоянии равновесия, известная как контактный потенциал, диффузионный потенциал или «встроенный потенциал», является фундаментальным параметром в теоретическом исследовании и моделировании. р-n перехода и полупроводниковых приборов. Этот потенциал присутствует в теоретических выражениях пространственного заряда, в идеальной модели емкости пространственного заряда pn-перехода в модели емкости эмиттер-база Пуна-Гуммеля, компактных моделях HICUM и Mextram, как обсуждалось в других работах [15, 23–26]. Определение значения , как параметра, связанного с равновесием, возможно только косвенно, из измерения емкости соответствующего перехода.
Определение значения , как параметра, связанного с равновесием, возможно только косвенно, из измерения емкости соответствующего перехода.
Как сообщил Шротер [13], диффузионное напряжение зависит от температуры через где – диффузионный потенциал при стандартной температуре.
4.1. Измерение
Определение значений основано на (13) с использованием экспериментальных измеренных значений , полученных с помощью измерительной установки, показанной на рисунке 1.
Для сравнения экспериментального и теоретического поведения диффузионного потенциала с температурой теоретические с помощью выражения (20) рассчитывали, принимая за экспериментальное значение при самой низкой температуре измерения и значение V, приведенное Мейером [27] для транзистора MAT01. Результаты представлены на рис. 7.9.0003
Результаты показывают превосходное соответствие между теорией и экспериментом с максимальной ошибкой менее 2%. Эти результаты подтверждают метод измерения, используемый для определения диффузионного потенциала, и оценку (20) для описания поведения диффузионного потенциала в зависимости от температуры.
5. Выводы
Физическая точка зрения при анализе приближений, использованных в выражении, позволяет получить улучшенное описание зависимости напряжения база-эмиттер от температуры с учетом влияния коэффициента эмиссии эмиттера и его прямой зависимости от емкость Се.
Полученные результаты позволяют применить физический подход к поведению с прямым смещением и температурой, а также процедуру моделирования значений с использованием новой модели Ce.
Оценка погрешности, вносимой без учета коэффициента эмиссии, показывает, что удобно учитывать изменение коэффициента эмиссии с температурой при проектировании цепей на базе напряжения база-эмиттер, т.к. датчики температуры и источники опорного напряжения с компенсацией запрещенной зоны.
Разработан новый метод измерения диффузионного потенциала, основанный на теории нейтральной емкости p-n перехода и измерении эмиттерной емкости Ce в зависимости от . Измерения показывают хорошее соответствие с теоретическим поведением, подтверждая правильность как используемого метода, так и теоретического уравнения, описанного в литературе.
Ссылки
-
М. Шротер, С. Леманн, С. Фрегонес и Т. Циммер, «Эффективная в вычислительном отношении физическая модель компактного биполярного транзистора для проектирования схем — часть I: формулировка модели», Транзакции IEEE на электронных устройствах , vol. 53, нет. 2, стр. 279–286, 2006 г.
Посмотреть по адресу:
Сайт издателя | Google Scholar
-
Ю. П. Цивидис, «Точный анализ температурных эффектов в характеристиках IC-VBE с применением эталонного источника запрещенной зоны», IEEE Journal of Solid-State Circuits , vol. 15, нет. 6, pp. 1076–1084, 1980.
Посмотреть по адресу:
Google Scholar
-
Блудау В., Онтон А., Хейнке В. Температурная зависимость ширины запрещенной зоны кремния.0243 Журнал прикладной физики , том. 45, нет. 4, стр. 1846–1848, 1974.
Посмотреть по адресу:
Сайт издателя | Google Scholar
-
C.
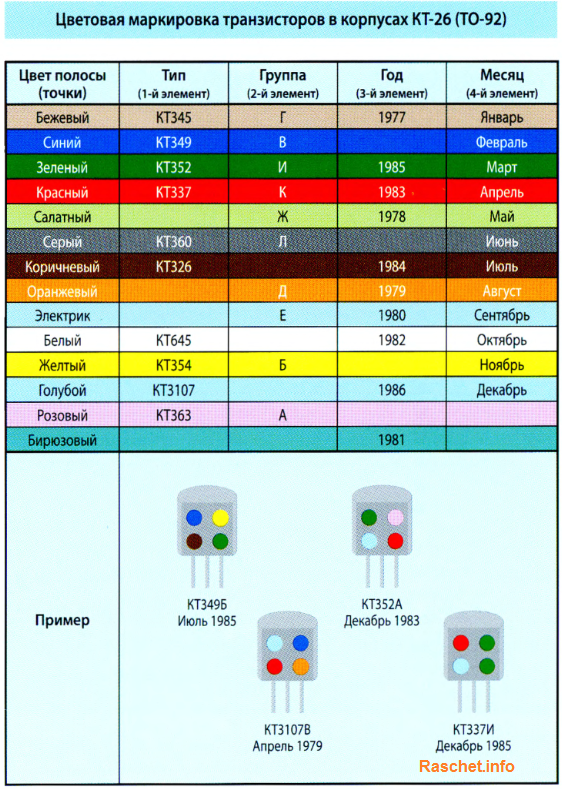 D. Thurmond, «Стандартные термодинамические функции для образования электронов и дырок в Ge, Si, GaAs и GaP», Journal of the Electrochemical Society , vol. 122, нет. 8, pp. 1133–1141, 1975.
D. Thurmond, «Стандартные термодинамические функции для образования электронов и дырок в Ge, Si, GaAs и GaP», Journal of the Electrochemical Society , vol. 122, нет. 8, pp. 1133–1141, 1975. Просмотр по адресу:
Google Scholar
-
Г. К. МакФарлейн, Дж. П. Маклин, Дж. Э. Куаррингтон и В. Робертс, «Тонкая структура в спектре края поглощения Si», Physical Review , vol. 111, нет. 5, pp. 1245–1254, 1958.
Посмотреть по адресу:
Google Scholar
-
Варшни Ю.П. Температурная зависимость энергетической щели в полупроводниках. Physica , vol. 34, нет. 1, pp. 149–154, 1967.
Посмотреть по адресу:
Google Scholar
-
GCM Meijer, Интегральные схемы и компоненты для эталонов ширины запрещенной зоны и датчиков температуры , к.
 т.н. диссертация, Делфтский технологический университет, Нидерланды, 19 лет82.
т.н. диссертация, Делфтский технологический университет, Нидерланды, 19 лет82. -
JW Slotboom и HC de Graaff, «Измерения сужения запрещенной зоны в кремниевых биполярных транзисторах», Solid State Electronics , vol. 19, нет. 10, pp. 857–862, 1976.
Посмотреть по адресу:
Google Scholar
-
Р. Амадор, А. Поланко и А. Надь, «Разброс η и VG0 и его влияние на чувствительность биполярного датчика Цельсия с ИС», Sensors and Actuators A , vol. 77, нет. 1, стр. 9–13, 1999.
Посмотреть по адресу:
Сайт издателя | Google Scholar
-
А. Охте и М. Ямагата, «Прецизионный кремниевый транзисторный термометр», IEEE Transactions on Instrumentation and Measurement , vol. 26, нет. 4, pp. 335–341, 1977.
Просмотр по адресу:
Google Scholar
-
Ван Ставерен А.
 , Верховен К.Дж. Транзакции IEEE в цепях и системах I , том. 43, нет. 5, стр. 418–421, 1996.
, Верховен К.Дж. Транзакции IEEE в цепях и системах I , том. 43, нет. 5, стр. 418–421, 1996. Посмотреть по адресу:
Сайт издателя | Google Scholar
-
С. Миялкович, «Обобщенный ранний фактор для компактного моделирования биполярных транзисторов с неоднородной базой», Electronics Letters , vol. 39, нет. 24, стр. 1757–1758, 2003.
Посмотреть по адресу:
Сайт издателя | Google Scholar
-
М. Шротер, «HICUM, масштабируемая физическая модель компактного биполярного транзистора», октябрь 2000 г., http://www.iee.et.tu-dresden.de/iee/eb/comp_mod.html .
Посмотреть по адресу:
Google Scholar
-
Х. К. Гаммел и Х. К. Пун, «Интегральная модель управления зарядом биполярных транзисторов», Bell System Technical Journal , vol.
 49, нет. 5, pp. 827–852, 1970.
49, нет. 5, pp. 827–852, 1970. Посмотреть по адресу:
Google Scholar
-
JCJ Paasschens и WJ Kloosterman, «The Mextram Bipolar Transistor Model — Level 504», Nat. лаборатория Несекретный отчет, NL – UR 2000/811, Philips NatLab.
Посмотреть по адресу:
Google Scholar
-
А. Надь, А. Поланко и М. Альварес, «Новая модель емкости база-эмиттер транзистора с биполярным переходом», Sensor Letters , vol. 4, нет. 3, стр. 305–311, 2006 г.
Посмотреть по адресу:
Сайт издателя | Google Scholar
-
В. Шокли, «Теория p-n переходов в полупроводниках и транзисторах с p-n переходами», Bell Systems Technical Journal , vol. 28, нет. 3, стр. 435–489, 1949.
Посмотреть по адресу:
Google Scholar
-
С.
 Фрегонес, С. Леманн, Т. Циммер и др., «Модель компактного биполярного транзистора с вычислительной эффективностью, основанная на физике, для проектирования схем — часть II: извлечение параметров и экспериментальные результаты», IEEE Транзакции на электронных устройствах , том. 53, нет. 2, стр. 287–295, 2006 г.
Фрегонес, С. Леманн, Т. Циммер и др., «Модель компактного биполярного транзистора с вычислительной эффективностью, основанная на физике, для проектирования схем — часть II: извлечение параметров и экспериментальные результаты», IEEE Транзакции на электронных устройствах , том. 53, нет. 2, стр. 287–295, 2006 г. Посмотреть по адресу:
Сайт издателя | Google Scholar
-
М. Шротер и Х. Тран, «Расчет параметров, связанных с накоплением заряда, для биполярных транзисторов Si и SiGe на основе моделирования устройства», в Proceedings of the NSTI Nanotechnology Conference and Trade Show , pp. 735–740, май 2006 г. датчиков температуры», в Proceedings of the 13th European Conference on Solid-State Transducers , стр. 553–556, Гаага, Нидерланды, сентябрь 1999 г.0307
G. Wang и GCM Meijer, «Температурные характеристики биполярных транзисторов, изготовленных по технологии CMOS», Sensors and Actuators A , vol.
 87, нет. 1–2, стр. 81–89, 2000.
87, нет. 1–2, стр. 81–89, 2000. Посмотреть по адресу:
Сайт издателя | Google Scholar
-
А. Надь, А. Поланко и М. Альварес, «Вклад в повышение точности проектирования биполярных ИС с помощью физических эффектов», в Трудах 20-го симпозиума по интегральным схемам и проектированию систем (SBCCI ’07). ) , Рио-де-Жанейро, Бразилия, сентябрь 2007 г. 57, нет. 12, стр. 2181–2182, 1969.
Просмотр по адресу:
Google Scholar
-
B. C. Bouma and A. C. Roelofs, «Experimental Definition of Forward-biased Emitter-Base capacitance», Solid State4 Electronics, 90 об. 21, нет. 6, стр. 833–836, 1978.
Просмотр по адресу:
Google Scholar
-
I. E. Getreu, Моделирование биполярного транзистора , Elsevier, New York, NY, USA, 1978.



 По мере появления дополнительной информации,
она включалась в справочник.
По мере появления дополнительной информации,
она включалась в справочник.