Какие существуют основные типы корпусов микросхем для поверхностного монтажа. Чем отличаются корпуса SOIC, QFP, BGA и другие. Как выбрать оптимальный тип корпуса для конкретного применения. Каковы преимущества и недостатки разных корпусов микросхем.
Основные типы корпусов микросхем для поверхностного монтажа
Корпуса микросхем для поверхностного монтажа (SMD) пришли на смену традиционным корпусам с выводами для сквозного монтажа. Они позволяют значительно повысить плотность монтажа компонентов на печатной плате и автоматизировать процесс сборки. Рассмотрим основные типы SMD корпусов:
- SOIC (Small Outline Integrated Circuit) — прямоугольный корпус с выводами по двум сторонам
- QFP (Quad Flat Package) — квадратный корпус с выводами по четырем сторонам
- BGA (Ball Grid Array) — корпус с шариковыми выводами на нижней поверхности
- LGA (Land Grid Array) — корпус с контактными площадками на нижней поверхности
- QFN (Quad Flat No-lead) — корпус без выводов с контактными площадками по периметру нижней поверхности
Особенности корпуса SOIC
SOIC (Small Outline Integrated Circuit) — один из самых распространенных типов корпусов для микросхем средней степени интеграции. Его основные характеристики:
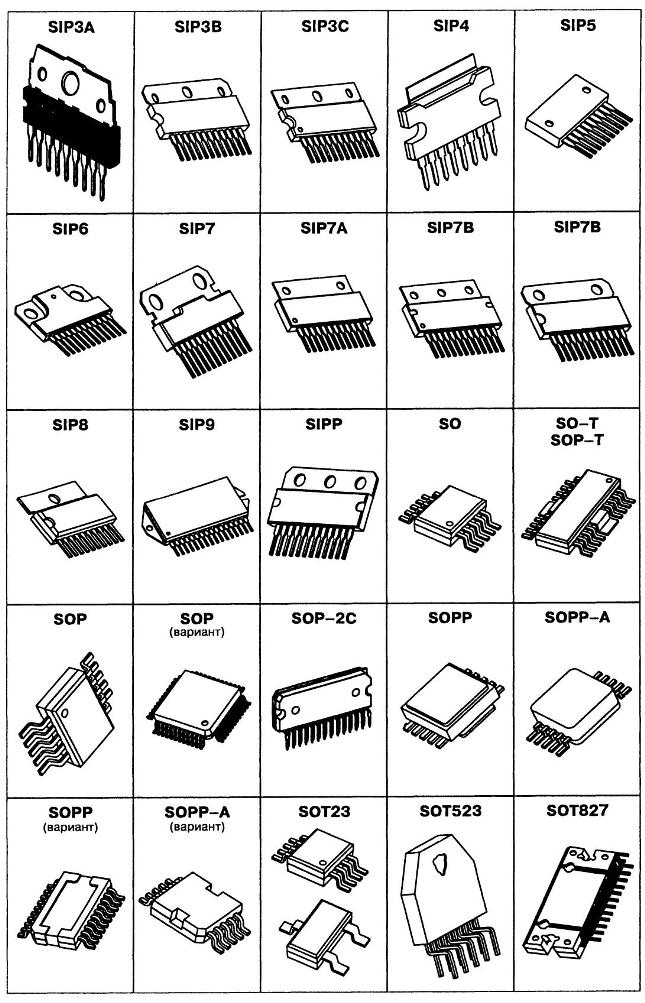
- Прямоугольная форма
- Выводы расположены по двум длинным сторонам
- Шаг выводов — 1.27 мм
- Количество выводов — от 8 до 28
- Размеры корпуса зависят от числа выводов
SOIC пришел на смену корпусу DIP и имеет меньшие габариты при том же функционале. Он широко применяется для упаковки операционных усилителей, логических микросхем, стабилизаторов напряжения и других компонентов средней степени интеграции.
Преимущества и недостатки корпуса QFP
QFP (Quad Flat Package) — квадратный корпус с выводами по всем четырем сторонам. Его особенности:
- Квадратная или прямоугольная форма
- Выводы расположены по всему периметру
- Шаг выводов — от 0.4 до 1 мм
- Количество выводов — от 32 до 304
- Размеры корпуса — от 7×7 до 40×40 мм
Преимущества QFP:
- Большое количество выводов при компактных размерах
- Хороший теплоотвод
- Удобство монтажа и контроля пайки
Недостатки:
- Сложность трассировки печатной платы при большом числе выводов
- Чувствительность к механическим воздействиям
QFP широко используется для корпусирования микроконтроллеров, процессоров, ПЛИС и других сложных микросхем.

Особенности и применение корпуса BGA
BGA (Ball Grid Array) — корпус с матрицей шариковых выводов на нижней поверхности. Его ключевые характеристики:
- Квадратная или прямоугольная форма
- Шариковые выводы расположены в виде матрицы на нижней поверхности
- Шаг выводов — от 0.4 до 1.27 мм
- Количество выводов — от 64 до нескольких тысяч
- Размеры корпуса — от 5×5 до 50×50 мм
Преимущества BGA:
- Максимальное количество выводов при минимальных размерах
- Отличный теплоотвод
- Низкая индуктивность выводов
- Высокая надежность соединений
Недостатки:
- Сложность монтажа и замены
- Необходимость рентгеновского контроля пайки
- Высокая стоимость оборудования для монтажа
BGA применяется для корпусирования высокопроизводительных процессоров, графических ускорителей, микросхем памяти и других сложных компонентов с большим числом выводов.
Сравнение корпусов LGA и BGA
LGA (Land Grid Array) похож на BGA, но вместо шариковых выводов имеет контактные площадки на нижней поверхности. Основные отличия:
- LGA не имеет выступающих выводов, что упрощает транспортировку
- Монтаж LGA требует специальных паяльных паст или припоя
- LGA обеспечивает более низкий профиль корпуса
- BGA более устойчив к механическим воздействиям
- LGA позволяет достичь меньшего шага выводов (до 0.3 мм)
LGA чаще применяется для процессоров и микросхем памяти, а BGA — для графических процессоров и ПЛИС. Выбор между ними зависит от конкретного применения и требований к надежности.

Преимущества корпуса QFN
QFN (Quad Flat No-lead) — корпус без выводов с контактными площадками по периметру нижней поверхности. Его особенности:
- Квадратная или прямоугольная форма
- Контактные площадки расположены по периметру нижней поверхности
- Шаг контактных площадок — от 0.4 до 0.65 мм
- Количество выводов — от 8 до 156
- Размеры корпуса — от 2×2 до 12×12 мм
Преимущества QFN:
- Минимальные габариты
- Отличный теплоотвод через центральную площадку
- Низкая индуктивность выводов
- Простота монтажа
- Низкая стоимость
QFN активно применяется для корпусирования маломощных микроконтроллеров, радиочастотных микросхем, датчиков и других компонентов, требующих минимальных размеров.
Как выбрать оптимальный тип корпуса микросхемы
При выборе типа корпуса для конкретного применения следует учитывать следующие факторы:
- Количество необходимых выводов
- Требования к габаритам и занимаемой площади на плате
- Тепловые характеристики микросхемы
- Частотные характеристики сигналов
- Технологические возможности производства
- Требования к надежности и устойчивости к внешним воздействиям
- Стоимость корпусирования и монтажа
Для микросхем с небольшим числом выводов (до 28) оптимальным выбором будет SOIC или QFN. Для сложных микросхем с большим числом выводов подойдут QFP или BGA. При необходимости минимизации размеров стоит обратить внимание на QFN и CSP (Chip Scale Package).

Тенденции развития корпусов микросхем
Основные тенденции в развитии корпусов микросхем:
- Уменьшение размеров и шага выводов
- Увеличение числа выводов
- Улучшение тепловых характеристик
- Снижение паразитных параметров
- Переход к 3D-компоновке кристаллов
- Применение новых материалов
Развитие корпусов идет в направлении создания систем в корпусе (System-in-Package, SiP) и гетерогенной интеграции различных кристаллов в одном корпусе. Это позволяет создавать сложные системы с минимальными размерами и высокой производительностью.
Корпуса для микросхем на миллиметровых волнах
Ответ в том, что с корпусными устройствами значительно проще обращаться и они подходят для крупносерийного производства и монтажа. Бескорпусные кристаллы требуют специального обращения в условиях чистого пространства, а на плату, содержащую такие кристаллы, очень сложно паять другие компоненты. Поэтому чипы, имеющиеся в любом коммерческом продукте, который планируется изготавливать в достаточно больших количествах, скорее всего, должны быть в соответствующем корпусе.
Поскольку 5G создает большой спрос на схемы на миллиметровых волнах (mmWave), это становится причиной дополнительных сложностей упаковки. Физические размеры корпусов становятся значительной частью длины волны, что может вызвать проблемы с резонансом. Всегда нужно принимать во внимание паразитные компоненты проводного соединения, но при более высоких частотах воздействие индуктивных паразитных компонентов может серьезно повлиять на эффективность — следовательно, проводное соединение необходимо считать неотъемлемой частью схемы.
На миллиметровых частотах могут быть использованы некоторые типы корпусов, каждый со своими плюсами и минусами, поэтому их выбор будет зависеть от конкретного устройства. Однако есть общие правила разработки, применимые ко всем видам корпусов.
Во‑первых, необходимо продумать, как корпус будет взаимодействовать и с кристаллом, и с печатной платой. Ключ к успешному корпусированию — совместная разработка схемы и корпуса, чтобы оптимизировать эффективность всего корпусного устройства, а не только самого чипа. Важно начать с того, что размер кристалла должен соответствовать размеру корпуса — это позволит сделать соединительные провода максимально короткими и снизить их индуктивность.
Паразитные компоненты проводного соединения также можно уменьшить за счет использования двух или даже трех соединительных проводов параллельно, что потребует большей соединительной площадки на схеме. Увеличение емкости большей по размеру контактной площадки может помочь улучшить РЧ-производительность корпуса за счет создания фильтра нижних частот в сочетании с индуктивностью проводного соединения. Также полезно оптимизировать емкость на печатной плате, поскольку она образует другой конец фильтра.
Также полезно оптимизировать емкость на печатной плате, поскольку она образует другой конец фильтра.
Формованные пластиковые корпуса — это рабочая лошадка недорогого крупносерийного производства. Технология основана на выводной рамке: тонкий лист металла с вытравленными на нем контурами множества устройств. Кристаллы обычно присоединяются с помощью проводимого эпоксида, затем на контактные площадки добавляют соединительные провода, и все устройство помещается в пластиковый формовочный компаунд. Добавление формовочного компаунда также увеличивает потери и диэлектрическую нагрузку, что необходимо учитывать в процессе проектирования.
Многие процессы предполагают пассивацию чипа, что позволяет смягчить влияние формовочного компаунда. При проектировании миллиметровых микросхем всегда применяется электромагнитное моделирование (ЭМ), и эта оптимизация должна включать в себя формовочный состав.
Упакованное в корпус устройство должно быть установлено на печатную плату, что требует тщательной разработки. Подложка печатной платы не должна быть слишком толстой, так как это делает ее дисперсионной при более высоких частотах — характеристики распространения волн зависят от частоты. Кроме того, применение тонкой подложки помогает снизить индуктивность заземления и улучшает теплопроизводительность. Для присоединения кристалла большинство миллиметровых микросхем в пластиковых корпусах имеют открытую контактную площадку, которая должна быть соединена с заземлением печатной платы. Для этого используется массив переходных отверстий, а тонкая подложка помогает сохранить низкую эффективную индуктивность заземления. Если индуктивность заземления окажется слишком высокой, вокруг микросхемы может возникнуть ответная реакция, которая ухудшит производительность и в итоге создаст проблемы со стабильностью.
Подложка печатной платы не должна быть слишком толстой, так как это делает ее дисперсионной при более высоких частотах — характеристики распространения волн зависят от частоты. Кроме того, применение тонкой подложки помогает снизить индуктивность заземления и улучшает теплопроизводительность. Для присоединения кристалла большинство миллиметровых микросхем в пластиковых корпусах имеют открытую контактную площадку, которая должна быть соединена с заземлением печатной платы. Для этого используется массив переходных отверстий, а тонкая подложка помогает сохранить низкую эффективную индуктивность заземления. Если индуктивность заземления окажется слишком высокой, вокруг микросхемы может возникнуть ответная реакция, которая ухудшит производительность и в итоге создаст проблемы со стабильностью.
Поскольку индуктивность увеличивается и с частотой, и с коэффициентом усиления, эффект от этого особенно выражен на миллиметровых частотах, что делает необходимым заземление с низкой индуктивностью.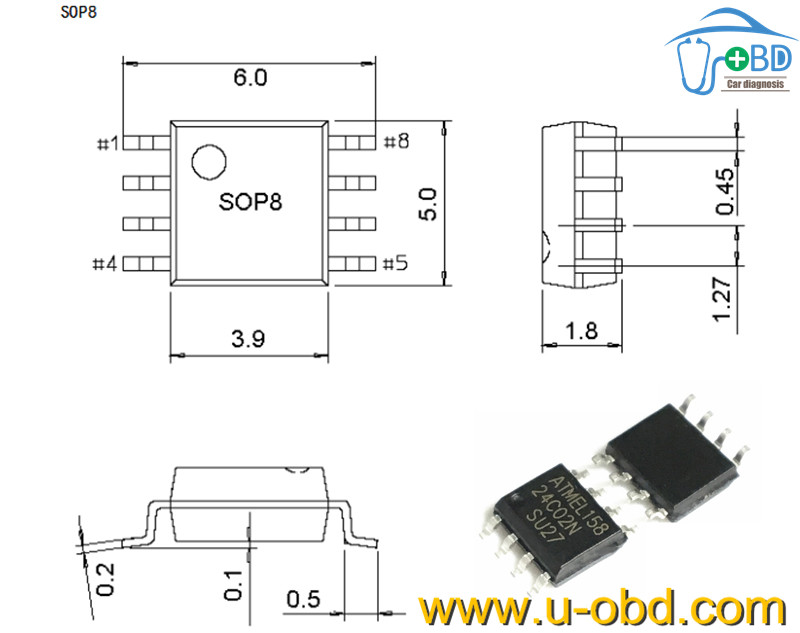 Большинство доступных на рынке усилителей миллиметрового диапазона в корпусах для поверхностного монтажа имеют коэффициент усиления около 20–25 дБ; при использовании миллиметровых усилителей с более высоким коэффициентом усиления вероятны проблемы при заключении в корпус для поверхностного монтажа.
Большинство доступных на рынке усилителей миллиметрового диапазона в корпусах для поверхностного монтажа имеют коэффициент усиления около 20–25 дБ; при использовании миллиметровых усилителей с более высоким коэффициентом усиления вероятны проблемы при заключении в корпус для поверхностного монтажа.
Для некоторых устройств можно применять настраиваемую выводную рамку, предлагающую функции, упрощающие эксплуатацию при более высоких частотах. За счет заземления некоторых неиспользуемых выводов непосредственно на контактную площадку кристалла можно улучшить целостность заземляющего соединения и таким образом снизить индуктивность заземления и улучшить переход от радиочастотных портов к микросхеме. Формованные корпуса обычно предназначаются на 30–35 ГГц, но в зависимости от функциональности микросхемы они могут отлично работать и на более высоких частотах.
Пластиковые корпуса с воздушными полостями кажутся похожими на формованные, но у них есть воздушная полость над чипом, которая снижает воздействие формовочной смеси на производительность устройства. Хотя этот вид корпуса требует определенных затрат на инструменты, он предлагает лучшую радиочастотную характеристику на более высоких миллиметровых частотах и успешно используется в Plextek RFI для создания усилителей мощности на частотах до 43 ГГц. На рис. 1 показано сравнение формованного пластикового корпуса и корпуса с воздушной полостью. Оба корпуса имеют плоскую четырехугольную конфигурацию без выводов (QFN) размером 5×5 мм.
Хотя этот вид корпуса требует определенных затрат на инструменты, он предлагает лучшую радиочастотную характеристику на более высоких миллиметровых частотах и успешно используется в Plextek RFI для создания усилителей мощности на частотах до 43 ГГц. На рис. 1 показано сравнение формованного пластикового корпуса и корпуса с воздушной полостью. Оба корпуса имеют плоскую четырехугольную конфигурацию без выводов (QFN) размером 5×5 мм.
Рис. 1.
а) Формованный пластиковый QFN-корпус 5×5 мм, содержащий 28 ГГц FEM;
б) QFN-корпус с воздушной полостью 5×5 мм, содержащий 39 ГГц
На рынке также существуют керамические корпуса с открытым корпусом, демонстрирующие отличную работу до 40 ГГц. Имеющая твердое металлическое основание и воздушную полость микросхема может быть спроектирована в соответствии с размерами корпуса, что обеспечивает оптимальную РЧ-эффективность корпусированной детали. Хотя они значительно дороже пластиковых корпусов, особенно при низких объемах, но при увеличении количества издержки заметно снижаются.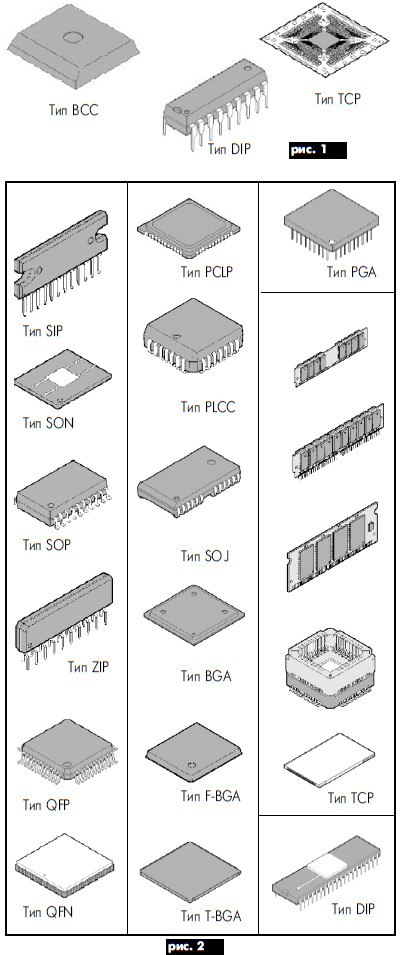
Преимущество керамических корпусов в том, что они более устойчивы к окружающей среде и потенциально более герметичны. Можно разработать версии под заказ, но самой популярной версией является стандартный корпус с подтвержденной радиочастотной эффективностью. Многие открытые керамические корпуса выпускаются в формате QFN — это самый распространенный подход для миллиметровых волн.
Корпуса из слоистого материала (Laminate packages) также могут быть выполнены в формате QFN. Потенциальное преимущество данного типа корпусов состоит в том, что их можно настраивать изнутри в соответствии с размером кристалла. Кристалл устанавливается во внутреннее углубление, верхняя поверхность которого находится практически на той же высоте, что и место присоединения кристалла, это позволяет сократить длину проводов.
Такие корпуса оптимальны и для монтажа нескольких кристаллов в один корпус (рис. 2), поскольку в них можно прокладывать маршруты между микросхемами и даже устанавливать дискретную фильтрацию, не требующую дополнительных затрат. Корпуса из многослойного материала для поверхностного монтажа использовались для коммерческих продуктов на частотах до 45 ГГц.
Корпуса из многослойного материала для поверхностного монтажа использовались для коммерческих продуктов на частотах до 45 ГГц.
Рис. 2. QFN-корпус из слоистого материала 10×10 мм с тремя чипами 25 ГГц FEM с дискретной фильтрацией
Корпусирование на уровне пластины в масштабе кристалла (Wafer Level Chip Scale Packaging — WL/CSP) в большей степени распространено для кремниевых микросхем, чем для GaAs. На заключительном этапе обработки добавляется «уровень перераспределения», который обеспечивает возможность маршрутизации на верхней части чипа, как на основании корпуса в масштабе кристалла. Затем микросхема переворачивается (монтаж методом перевернутого кристалла) в соответствии с формой корпуса — это снижает индуктивность не только РЧ-соединения, но и соединений от верхней части микросхемы к заземлению. В отличие от GaAs-чипов кремниевые микросхемы изначально не обладают низкой индуктивностью на панель заземления, поэтому метод перевернутого кристалла практически всегда используется в качестве средства соединения кремниевой РЧ-микросхемы с корпусом с низкими паразитными характеристиками.
И наконец, антенна в корпусе (AiP) может стать полезным решением, так как этот метод избавляет от необходимости в РЧ-порте для печатной платы, а значит, конструкцию удается сделать очень компактной. Она может содержать матрицу антенн, совмещенную с фазированной решеткой. В результате на компактном пространстве увеличивается функциональность, что весьма привлекательно для миллиметровых 5G потребительских продуктов. К недостаткам метода относится его специфичность для продукта и отсутствие возможности добавить дополнительную фильтрацию вне корпуса, то есть все требования по фильтрам должны быть предусмотрены внутри корпуса.
Нельзя недооценивать и важность проблемы проведения тестирования продуктов с миллиметровыми микросхемами. Для этих типов корпусов нужен специальный крепежный блок для проведения испытаний, минимизирующий паразитные характеристики и позволяющий выполнять калибровку по эталонным панелям корпуса. Также необходимо разработать подходящую плату нагрузок, чтобы создать реалистичные условия работы для испытания.
В заключение отметим, что корпусирование микросхем на миллиметровых волнах создает для MMIC-проектировщика ряд уникальных задач. Связанные с ними паразитные характеристики могут привести к серьезному ухудшению качества на данных частотах, но при внимательном проектировании этого можно избежать и производить корпусированные устройства для поверхностного монтажа с превосходной эффективностью и в таких объемах, которые требуются для устройств 5G.
Сергей Шихов,
технический директор «А-КОНТРАКТ»
Сам факт перечисления нескольких видов корпусирования показывает, как развивалась эта область электроники, находясь между требованиями потребителей, с одной стороны, и возможностями производств — с другой. Это непрерывный процесс улучшений.
С точки зрения объемной топологии элементов разработчики обладают многолетним опытом расчетов. А проверка готового элемента в действии позволяет оценить эффективность модели, что является базой для расчетов в других диапазонах частот.
Иные типы корпусов и формовочные компаунды являются новой целью для производителей, которые стремятся сохранить лидирующие позиции на современном рынке.
Корпуса микросхем — Типы корпусов микросхем, их виды
В этой статье мы рассмотрим самые основные корпуса микросхем, которые очень часто используются в повседневной электронике.
Содержание статьи
- 1 DIP корпус
- 2 SIP корпус
- 3 ZIP корпус
- 4 SOIC корпус
- 5 SOP корпус
- 6 QFP корпус
- 7 PLCC корпус
- 8 PGA корпус
- 9 Корпус LGA
- 10 Корпус BGA
DIP корпус
DIP ( англ. Dual In-Line Package) — корпус с двумя рядами выводов по длинным сторонам микросхемы. Раньше, да наверное и сейчас, корпус DIP был самым популярным корпусом для многовыводных микросхем. Выглядит он вот так:
В зависимости от количества выводов микросхемы, после слова «DIP» ставится количество ее выводов. Например, микросхема, а точнее, микроконтроллер atmega8 имеет 28 выводов:
Например, микросхема, а точнее, микроконтроллер atmega8 имеет 28 выводов:
Следовательно, ее корпус будет называться DIP28.
А вот у этой микросхемы корпус будет называться DIP16.
Чтобы не считать каждый раз количество выводов, можно их сосчитать только на одной стороне микросхемы и тупо умножить на два.
В основном в корпусе DIP в Советском Союзе производили логические микросхемы, операционные усилители и тд. Сейчас же корпус DIP также не теряет своей актуальности и в нем до сих пор делают различные микросхемы, начиная от простых аналоговых и заканчивая микроконтроллерами.
Корпус DIP может быть выполнен из пластика (что в большинстве случаев) и называется он PDIP, а также из керамики — CDIP. На ощупь корпус CDIP твердый как камень, и это неудивительно, так как он сделан из керамики.
Пример CDIP корпуса.
Имеются также модификации DIP корпуса: HDIP, SDIP.
HDIP (Heat-dissipating DIP) — теплорассеивающий DIP. Такие микросхемы пропускают через себя большой ток, поэтому сильно нагреваются. Чтобы отвести излишки тепла, на такой микросхеме должен быть радиатор или его подобие, например, как здесь два крылышка-радиатора посерединке микрухи:
SDIP (Small DIP) — маленький DIP. Микросхема в корпусе DIP, но c маленьким расстоянием между ножками микросхемы:
SIP корпус
SIP корпус (Single In line Package) — плоский корпус с выводами с одной стороны. Очень удобен при монтаже и занимает мало места. Количество выводов также пишется после названия корпуса. Например, микруха снизу в корпусе SIP8.
У SIP тоже есть модификации — это HSIP (Heat-dissipating SIP). То есть тот же самый корпус, но уже с радиатором
ZIP корпус
ZIP (Zigzag In line Package) — плоский корпус с выводами, расположенными зигзагообразно. На фото ниже корпус ZIP6. Цифра — это количество выводов:
На фото ниже корпус ZIP6. Цифра — это количество выводов:
Ну и корпус с радиатором HZIP:
Только что мы с вами рассмотрели основной класс In line Package микросхем. Эти микросхемы предназначены для сквозного монтажа в отверстиях в печатной плате.
Например, микросхема DIP14, установленная на печатной плате
и ее выводы с обратной стороны платы, уже без припоя.
Кто-то все таки умудряется запаять микросхемы DIP, как микросхемы для поверхностного монтажа (о них чуть ниже), загнув выводы под углом в 90 градусов, или полностью их выпрямив. Это извращение), но работает).
Переходим к другому классу микросхем — микросхемы для поверхностного монтажа или, так называемые SMD компоненты. Еще их называют планарными радиокомпонентами.
Такие микросхемы запаиваются на поверхность печатной платы, под выделенные для них печатные проводники. Видите прямоугольные дорожки в ряд? Это печатные проводники или в народе пятачки. Вот именно на них запаиваются планарные микросхемы.
Вот именно на них запаиваются планарные микросхемы.
SOIC корпус
Самым большим представителем этого класса микросхем являются микросхемы в корпусе SOIC (Small-Outline Integrated Circuit) — маленькая микросхема с выводами по длинным сторонам. Она очень напоминает DIP, но обратите внимание на ее выводы. Они параллельны поверхности самого корпуса:
Вот так они запаиваются на плате:
Ну и как обычно, цифра после «SOIC» обозначает количество выводов этой микросхемы. На фото выше микросхемы в корпусе SOIC16.
SOP корпус
SOP (Small Outline Package) — то же самое, что и SOIC.
Модификации корпуса SOP:
PSOP — пластиковый корпус SOP. Чаще всего именно он и используется.
HSOP — теплорассеивающий SOP. Маленькие радиаторы посередине служат для отвода тепла.
Маленькие радиаторы посередине служат для отвода тепла.
SSOP(Shrink Small Outline Package) — » сморщенный» SOP. То есть еще меньше, чем SOP корпус
TSSOP(Thin Shrink Small Outline Package) — тонкий SSOP. Тот же самый SSOP, но «размазанный» скалкой. Его толщина меньше, чем у SSOP. В основном в корпусе TSSOP делают микросхемы, которые прилично нагреваются. Поэтому, площадь у таких микросхем больше, чем у обычных. Короче говоря, корпус-радиатор).
SOJ — тот же SOP, но ножки загнуты в форме буквы «J» под саму микросхему. В честь таких ножек и назвали корпус SOJ:
Ну и как обычно, количество выводов обозначается после типа корпуса, например SOIC16, SSOP28, TSSOP48 и тд.
QFP корпус
QFP (Quad Flat Package) — четырехугольный плоский корпус. Главное отличие от собрата SOIC в том, что выводы размещены на всех сторонах такой микросхемы
Главное отличие от собрата SOIC в том, что выводы размещены на всех сторонах такой микросхемы
Модификации:
PQFP — пластиковый корпус QFP. CQFP — керамический корпус QFP. HQFP — теплорассеивающий корпус QFP.
TQFP (Thin Quad Flat Pack) — тонкий корпус QFP. Его толщина намного меньше, чем у его собрата QFP
PLCC корпус
PLCC (Plastic Leaded Chip Carrier) и СLCC (Ceramic Leaded Chip Carrier) — соответственно пластиковый и керамический корпус с расположенными по краям контактами, предназначенными для установки в специальную панельку, в народе называемую «кроваткой». Типичным представителем является микросхема BIOS в ваших компьютерах.
Вот так примерно выглядит «кроватка» для таких микросхем
А вот так микросхема «лежит» в кроватке.
Иногда такие микросхемы называют QFJ, как вы уже догадались, из-за выводов в форме буквы «J»
Ну и количество выводов ставится после названия корпуса, например PLCC32.
PGA корпус
PGA (Pin Grid Array) — матрица из штырьковых выводов. Представляет из себя прямоугольный или квадратный корпус, в нижней части которого расположены выводы-штырьки
Такие микросхемы устанавливаются также в специальные кроватки, которые зажимают выводы микросхемы с помощью специального рычажка.
В корпусе PGA в основном делают процессоры на ваши персональные компьютеры.
Корпус LGA
LGA (Land Grid Array) — тип корпусов микросхем с матрицей контактных площадок.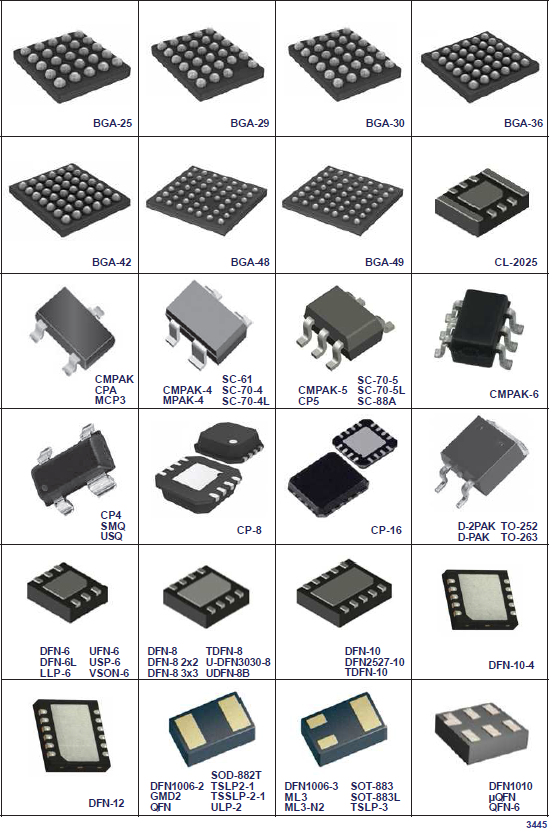 Чаще всего используются в компьютерной технике для процессоров.
Чаще всего используются в компьютерной технике для процессоров.
Кроватка для LGA микросхем выглядит примерно вот так:
Если присмотреться, то можно увидеть подпружиненные контакты.
Сам микросхема, в данном случае процессор ПК, имеет просто металлизированные площадки:
Для того, чтобы все работало, должно выполняться условие: микропроцессор должен быть плотно прижат к кроватке. Для этого используются разного рода защелки.
Корпус BGA
BGA (Ball Grid Array) — матрица из шариков.
Как мы видим, здесь выводы заменены припойными шариками. На одной такой микросхеме можно разместить сотни шариков-выводов. Экономия места на плате просто фантастическая. Поэтому микросхемы в корпусе BGA применяют в производстве мобильных телефонов, планшетах, ноутбуках и в других микроэлектронных девайсах. О том, как перепаивать BGA, я еще писал в статье Пайка BGA микросхем.
В красных квадратах я пометил микросхемы в корпусе BGA на плате мобильного телефона. Как вы видите, сейчас вся микроэлектроника строится именно на BGA микросхемах.
Как вы видите, сейчас вся микроэлектроника строится именно на BGA микросхемах.
Технология BGA является апогеем микроэлектроники. В настоящее время мир перешел уже на технологию корпусов microBGА, где расстояние между шариками еще меньше, и можно уместить даже тысячи(!) выводов под одной микросхемой!
Вот мы с вами и разобрали основные корпуса микросхем.
Ничего страшного нет в том, что вы назовете микросхему в корпусе SOIC SOPом или SOP назовете SSOPом. Также ничего страшного нет и в том, чтобы назвать корпус QFP TQFPом. Границы между ними размыты и это просто условности. Но вот если микросхему в корпусе BGA назовете DIP, то это уже будет полное фиаско.
Начинающим радиолюбителям стоит просто запомнить три самых важных корпуса для микросхем — это DIP, SOIС (SOP) и QFP безо всяких модификаций и стоит также знать их различия. В основном именно эти типы корпусов микросхем радиолюбители используют чаще всего в своей практике.
Типы корпусов ИС: подробное руководство
Введение
Упаковка ИС — это метод защиты полупроводниковых компонентов от внешних физических повреждений или коррозии путем помещения их в упаковочные материалы из керамики или пластика. Существует множество различных типов интегральных схем, соответствующих различным конструкциям схем и требованиям к внешней оболочке. Это приводит к различным типам конструкций корпусов ИС и различным способам их классификации.
Существует множество различных типов интегральных схем, соответствующих различным конструкциям схем и требованиям к внешней оболочке. Это приводит к различным типам конструкций корпусов ИС и различным способам их классификации.
Современные конструкции корпусов ИС — это хорошие возможности для достижения функциональной плотности, гетерогенной интеграции и масштабирования кремния. Кроме того, они идеально подходят для уменьшения общего размера упаковки многих электронных приложений, которые имеют расширенные функциональные возможности устройства и отказоустойчивость кремния.
Что такое упаковка ИС?
Упаковка IC — это сокращенный термин для упаковки интегральных схем. Это компонент или материал, в котором содержится полупроводниковое устройство. Это означает, что упаковка покрывает или окружает схемное устройство и при этом защищает его от физического повреждения или коррозии.
Пластмасса или керамика являются обычно используемыми материалами для упаковки ИС, поскольку они обладают лучшей электропроводностью. Эта функция имеет жизненно важное значение, поскольку упаковка ИС также служит для облегчения монтажа электрических контактов, которые подключены к печатной плате (PCB) электронного устройства. Организация соединений на ИС и то, как они расположены с использованием стандартного пакета ИС, должны соответствовать вариантам использования и приложениям конкретных ИС.
Эта функция имеет жизненно важное значение, поскольку упаковка ИС также служит для облегчения монтажа электрических контактов, которые подключены к печатной плате (PCB) электронного устройства. Организация соединений на ИС и то, как они расположены с использованием стандартного пакета ИС, должны соответствовать вариантам использования и приложениям конкретных ИС.
Упаковка интегральных схем — это заключительный этап производства полупроводниковых устройств, после которого интегральная схема отправляется на тестирование, чтобы определить, соответствует ли она отраслевым стандартам. [1]
Почему важна упаковка ИС?
Интегральные схемы, как правило, хрупкие и не имеют разъемов или контактов для подключения к печатной плате. Благодаря внедрению корпусов схем носители микросхем будут использоваться для защиты деликатной структуры интегральных схем, а также для обеспечения штыревых разъемов. Вышеупомянутая защита возможна благодаря пластику, стеклу, металлу или керамике, из которых могут быть изготовлены упаковки, обеспечивая физический барьер от внешнего воздействия и коррозии. Упаковка ИС также имеет дополнительное преимущество терморегулирования в устройствах, для которых они используются.
Упаковка ИС также имеет дополнительное преимущество терморегулирования в устройствах, для которых они используются.
Кроме того, пакеты состоят из отдельных частей, которые улучшают общую работу интегральной схемы и обеспечивают ее надежность. Выводы обычно изготавливаются из меди и тонкого оловянного покрытия с более тонкими проводами, соединенными с корпусом. Они полезны для установления прочного соединения между выводами и интегральной схемой. После этого выводы соединяются проводящими контактными площадками на полупроводниковом кристалле, а затем припаиваются к печатной плате на внешней части корпуса. Даже дискретные компоненты, такие как конденсаторы, транзисторы или диоды, имеют широкий спектр корпусов с небольшим количеством выводов, используемых для них. [2]
Типы корпусов ИС
Существует много корпусов ИС и различных способов их классификации. Что касается пакетов ИС, то часто можно встретить технические сокращенные термины, такие как DIP, SIP, SOP, SSOP, TSOP, MSOP, QSOP, SOIC, QFP, TQFP, BGA и т.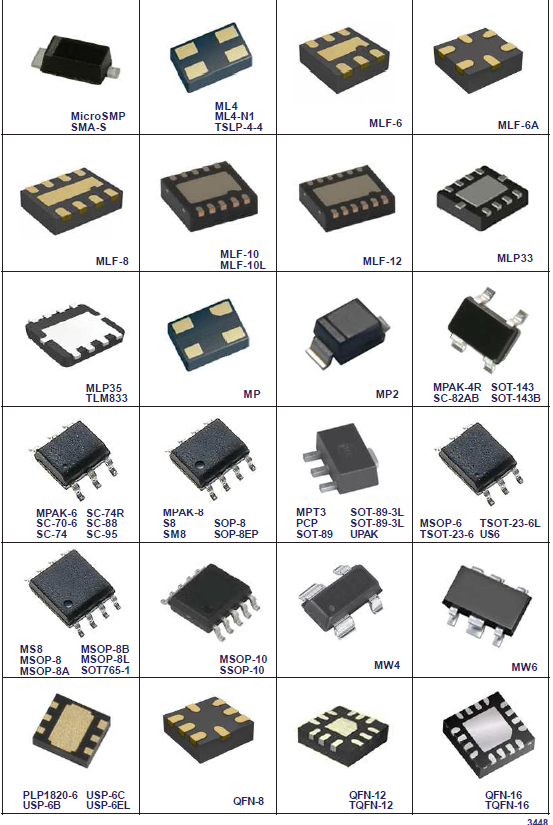 д. Все это названия различных пакетов ИС. и классифицировать их можно по-разному. Типы корпусов ИС
д. Все это названия различных пакетов ИС. и классифицировать их можно по-разному. Типы корпусов ИС
можно отличить по способу монтажа, поскольку они делятся на две широкие категории, а именно технологию сквозного монтажа и технологию поверхностного монтажа (SMT). В корпусах со сквозными отверстиями выводы вставляются через отверстия на печатной плате, а затем припаиваются, в то время как в корпусах для поверхностного монтажа компоненты монтируются непосредственно на внешней стороне платы. Компоненты упаковки для поверхностного монтажа называются устройствами для поверхностного монтажа (SMD).
Другой способ классификации корпусов интегральных схем — по расположению контактов. Интегральные схемы обычно имеют линейную, квадратную или прямоугольную форму, поэтому расположение выводов может быть линейным, в двух параллельных направлениях, с четырех сторон или в матричной форме. Дальнейшая классификация может быть сделана по форме штифта или клеммы. Формы могут быть линейными, L-образными, J-образными, игольчатыми, с взаимным складыванием и в форме ленты/пленки, среди прочих. Наконец, пакеты IC можно отличить по количеству клемм или контактов. Существуют двухполюсные, трехполюсные, четырехполюсные, пятиполюсные, шестиполюсные и более шестиполюсные пакеты. Размеры терминала также могут служить отличительным фактором для аналогичных типов упаковки. [3]
Наконец, пакеты IC можно отличить по количеству клемм или контактов. Существуют двухполюсные, трехполюсные, четырехполюсные, пятиполюсные, шестиполюсные и более шестиполюсные пакеты. Размеры терминала также могут служить отличительным фактором для аналогичных типов упаковки. [3]
Некоторые распространенные типы корпусов интегральных схем обсуждаются в последующих разделах.
Несущий элемент для микросхем
Несущий элемент для микросхем — это тип SMT-упаковки для интегральных схем. Также известный как контейнер для микросхем или пакет микросхем, держатель микросхем позволяет вставлять полупроводниковые микросхемы или припаивать их к печатной плате (PCB), сохраняя при этом хрупкие компоненты защищенными. Носитель микросхемы может быть прикреплен к печатной плате путем вставки, пайки или удерживания пружинами, в зависимости от его конструкции.
Носители со штекерами, также известные как держатели для розеток, имеют J-образные металлические штыри или выводы, которые можно использовать для соединения на плате с помощью пайки или гнезда. Когда носитель припаивается непосредственно к плате, это называется поверхностным монтажом.
Когда носитель припаивается непосредственно к плате, это называется поверхностным монтажом.
Пружинный метод крепления используется в тех случаях, когда сила пайки или штифтов может повредить хрупкие компоненты. Обычно это делается путем установки пружинного механизма в области, где будет прикреплен компонент, затем пружины осторожно отодвигаются в сторону, чтобы зафиксировать деталь на месте. Чип-носители также могут быть бессвинцовыми с металлическими площадками для соединений. Когда выводы выходят за пределы упаковки, это называется плоской упаковкой.
Существует несколько различных типов держателей чипов, изготовленных из самых разных материалов, таких как керамика, силикон, металл и пластик. Держатели чипов обычно имеют квадратную или прямоугольную форму, а соединения выполнены на всех четырех сторонах корпуса. Они также бывают разных размеров и толщины. [4]
Типы корпусов держателей чипов обычно обозначаются аббревиатурами и включают:
- BCC: Держатель чипов с выпуклыми краями
- CLCC: Керамический держатель чипов без выводов
- LCC: держатель микросхем с выводами
- LCCC: держатель керамических микросхем с выводами
- DLCC: двойной держатель микросхем без выводов
- PLCC: держатель микросхем с пластиковыми выводами
- PoP: упаковка на упаковке.

Корпуса со сквозными отверстиями
Компоненты со сквозными отверстиями имеют выводы, которые втыкаются в одну сторону печатной платы и припаиваются к контактным площадкам на другой стороне платы для механического и электрического соединения их с печатной платой. Эти упаковки бывают керамическими и пластиковыми и подразделяются на следующие категории:
Пакет с одинарными линейными контактами (SIP или SIPP): Он имеет один ряд соединительных контактов, расположенных вертикально вдоль граничной линии пакета. Он не так широко используется, как DIP (Dual In-line Package), но пригождается для упаковки сетевых резисторов и чипов оперативной памяти. Обычные однорядные пакеты включают SIP (одиночный встроенный пакет), SSIP (термоусадочный одинарный встроенный пакет) и HSIP (одиночный встроенный пакет с радиатором).
Двойные линейные блоки (DIP): Двойной линейный корпус или двойной линейный корпус (DIPP) имеет два параллельных ряда электрических соединительных контактов в прямоугольном пластиковом корпусе. Он может быть установлен в сквозное отверстие на печатной плате или вставлен в розетку. Также он различается по размеру из-за разницы в количестве пинов в разных упаковках, которое обычно колеблется от 4 до 64.
Он может быть установлен в сквозное отверстие на печатной плате или вставлен в розетку. Также он различается по размеру из-за разницы в количестве пинов в разных упаковках, которое обычно колеблется от 4 до 64.
Общие двухрядные комплекты включают DIP (двойной рядный комплект), SDIP (термоусадочный двухрядный), CDIP (керамический двухрядный), CER-DIP (стеклянный керамический DIP), PDIP (пластиковый DIP). ), SKDIP (Skinny DIP), WDIP (Dual In-line with Window Package) и MDIP (Molded DIP).
Пакет DIP-чипов
Zig-Zag In-Line Packages (ZIP) — этот пакет PTH похож на SIP, но с направляющими штифтами, расположенными на линии границы пакета, но имеет зигзагообразную форму. Общие зигзагообразные встроенные пакеты включают ZIP (зигзагообразный встроенный пакет) и SZIP (усадочный зигзагообразный встроенный пакет). [5]
Поверхностный монтаж
Технология упаковки для поверхностного монтажа осуществляется путем монтажа или размещения электронных компонентов непосредственно на поверхности печатной платы. Компоненты для поверхностного монтажа обычно меньше, чем их аналоги для сквозного монтажа, потому что они могут либо иметь меньшие выводы, либо вообще не иметь выводов. Он может иметь короткие штифты или выводы различных стилей, а также использовать керамическое или пластиковое литье.
Компоненты для поверхностного монтажа обычно меньше, чем их аналоги для сквозного монтажа, потому что они могут либо иметь меньшие выводы, либо вообще не иметь выводов. Он может иметь короткие штифты или выводы различных стилей, а также использовать керамическое или пластиковое литье.
Существует пять основных типов корпусов интегральных схем для поверхностного монтажа:
- Малая интегральная схема (SOIC)
- Малый корпус (SOP)
- Счетверенный плоский корпус (QFP)
- Пластмассовый носитель микросхемы (PLCC)
- Решетка с шариками (BGA). [6]
Массивы контактов
Массивы контактов (PGA) В корпусах ИС выводы располагаются в виде квадратной или прямоугольной сетки, состоящей из строк и столбцов, а выводы расположены в регулярном порядке на нижней стороне корпуса. Они используют крошечные штифты для создания соединений, которые расположены в виде регулярного массива на нижней стороне упаковки. PGA имеет множество вариантов, определяемых расположением массива и количеством соединений. Они могут монтироваться на печатные платы методом сквозного отверстия или вставляться в сокет и в основном используются для изготовления процессоров. [7]
PGA имеет множество вариантов, определяемых расположением массива и количеством соединений. Они могут монтироваться на печатные платы методом сквозного отверстия или вставляться в сокет и в основном используются для изготовления процессоров. [7]
Варианты массива штифтов:
- Керамический массив штырей (CPGA)
- Пластиковый массив штырей (PPGA)
- Ступенчатый массив штырей (SPGA) Штыревая решетка
Плоские корпуса
Плоские корпуса ИС имеют два или четыре ряда клемм, расположенных по краям интегральной схемы. Тип монтажа, используемый для этих корпусов, обычно представляет собой поверхностный монтаж с выводами, имеющими L-образную, J-образную форму или полностью отсутствующими, и в этом случае они называются безвыводными клеммами. Общие плоские пакеты ИС включают: QFP (Quad Flat Package), TQFP (Thin Quad Flat Package), STQFP (Small Thin Quad Plastic Flat Package), FQFP (Quad Flat Package с мелким шагом), (Low profile Quad Flat Package), VQFP (очень маленький четырехъядерный плоский корпус), ETQFP (открытый тонкий четырехъядерный плоский корпус), PQFN (четырехъядерный плоский корпус Power), PQFP (плоский пластиковый четырехъядерный корпус), QFJ (четырехъярусный плоский J-выводной корпус), QFN ( Пакет Quad Flat без свинца) и т. д. [8]
д. [8]
Микросхема TQFP
Малые контурные корпуса
Малый контурный корпус, называемый «Малогабаритная интегральная схема», или SOIC, представляет собой небольшой прямоугольный корпус для поверхностного монтажа с выводами типа «крыло чайки» и пластиковым или керамическим формованием. Штыри нарисованы в форме буквы L с обеих сторон корпуса, а выводы выходят из более длинного края корпуса. [9]
Небольшой контурный пакет имеет несколько вариантов упаковки ИС, в том числе:
- SOJ (небольшой контурный пакет с J-выводами)
- TSOP (тонкая малая контурная упаковка)
- SSOP (усадочная малая контурная упаковка)
- TSSOP (тонкая термоусадочная малая контурная упаковка)
- QSOP (четверть размера малая контурная упаковка) VSOP (очень маленькая контурная упаковка).
Пакеты в масштабе чипа
Пакет в масштабе чипа (CSP) представляет собой корпус интегральной схемы (ИС) для поверхностного монтажа, площадь которого не более чем в 1,2 раза превышает площадь исходного кристалла. Первоначально CSP был аббревиатурой для упаковки размером с чип, но он был адаптирован для упаковки в масштабе чипа, поскольку не так много упаковок размером с чип.
Первоначально CSP был аббревиатурой для упаковки размером с чип, но он был адаптирован для упаковки в масштабе чипа, поскольку не так много упаковок размером с чип.
В стандарте J-STD-012 IPC (Института соединения и упаковки электронных схем) для внедрения технологии Flip Chip and Chip Scale Technology говорится, что чип должен быть однокристальным и иметь шаг шарика не более 1 мм перед ним. может квалифицироваться как пакет в масштабе чипа. [10]
Корпуса в масштабе чипа классифицируются как:
- Индивидуальный CSP на основе выводной рамы (LFCSP)
- CSP на основе гибкой подложки
- CSP с перевернутым чипом (FCCSP)
- CSP на основе жесткой подложки
- CSP перераспределения на уровне пластины (WL-CSP).
Шариковая решетка
Шариковая решетка или корпус BGA — это тип корпуса для поверхностного монтажа, в котором для электрических соединений используется массив металлических сфер, называемых шариками припоя. Нижняя сторона корпуса используется для соединений, где шарики припоя прикрепляются к ламинированной подложке в виде сетки. Эта подложка имеет внутри проводящие дорожки, которые соединяют соединения кристалла с подложкой с соединениями матрицы с подложкой и шариками с помощью проволочного соединения или технологии флип-чипа. [11]
Нижняя сторона корпуса используется для соединений, где шарики припоя прикрепляются к ламинированной подложке в виде сетки. Эта подложка имеет внутри проводящие дорожки, которые соединяют соединения кристалла с подложкой с соединениями матрицы с подложкой и шариками с помощью проволочного соединения или технологии флип-чипа. [11]
Варианты решетки с шариками включают:
- MAPBGA — литая решетка с технологической решеткой с шариками
- PBGA — решетка с пластиковыми шариками на упаковке и
- MicroBGA.
Ключевые выводы
Упаковка интегральных схем является неотъемлемой частью производства полупроводников. Он стал незаменимым в современном производстве электроники благодаря своим защитным свойствам, терморегулированию и широкому применению, что важно как для проектирования интегральных схем, так и для проектирования печатных плат.
Каталожные номера
1. Ebics. Что такое упакованная ИС и почему это важно? 2022. [Цитировано 20 сентября 2022 г.] Доступно по адресу: https://ebics.net/packaged-ic/
Ebics. Что такое упакованная ИС и почему это важно? 2022. [Цитировано 20 сентября 2022 г.] Доступно по адресу: https://ebics.net/packaged-ic/
2. Millennium Circuits Limited. Что такое упаковка IC и почему это важно? 2022. [Цитировано 20 сентября 2022 г.] Доступно по адресу: https://www.mclpcb.com/blog/ic-packaging-information/#:~:text=their%20outer%20shell.-,Why%20Is%20IC%20Packaging %20Важно%3F,%20Коррозионные%20Эффекты%20%20Возраст
3. Гараж Инженеров. Каковы различные типы пакетов IC? 2022. [Цитировано 20 сентября 2022 г.] Доступно по адресу: https://www.engineersgarage.com/ic-packages-types/ 9.0005
4. Любитель легких технологий. Что такое Чип-носитель? 2022. [Цитировано 20 сентября 2022 г.] Доступно по адресу: https://www.easytechjunkie.com/what-is-a-chip-carrier.htm
5. Эмблема печатной платы. ИС Упаковка. 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://emblepcb.com/ic-packaging/
6. Sierra Assembly. Типы корпусов устройств для поверхностного монтажа. 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://www.sierraassembly.com/blog/what-are-the-popular-types-of-surface-mount-device-packages/
Sierra Assembly. Типы корпусов устройств для поверхностного монтажа. 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://www.sierraassembly.com/blog/what-are-the-popular-types-of-surface-mount-device-packages/
СБОРКА. LGA, PGA, BGA: в чем разница между грид-массивами? 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://www.raypcb.com/lga-pga-bga/ 9.0005
8. Полупроводник для вас. Типы пакетов ИС. 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://www.google.com/amp/s/www.semiconductorforu.com/types-of-ic-packages/amp/
SOIC: Малая интегральная схема. 2021. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://evergreensemiconductor.com/soic-small-outline-integrated-circuit/
10. Techopedia. Что такое Chip-Scale Package (CSP)? 2022. [Цитировано 21 сентября 2022 г.] Доступно по адресу: https://www.techopedia.com/definition/18622/chip-scale-package-csp 9.0005
11. ПЛАТА RAYMING И СБОРКА. Различные типы BGA (пакеты с шариковой решеткой) 2021 г. [Цитировано 21 сентября 2022 г.] Типы пакетов | DIP, SMD, QFP, BGA, SOP, SOT, QFN, SOIC
ПЛАТА RAYMING И СБОРКА. Различные типы BGA (пакеты с шариковой решеткой) 2021 г. [Цитировано 21 сентября 2022 г.] Типы пакетов | DIP, SMD, QFP, BGA, SOP, SOT, QFN, SOIC
— Объявление —
Что такое упаковка ИС?
Последним шагом в создании полупроводникового устройства является упаковка интегральной схемы, которая включает в себя помещение блока полупроводникового материала (на котором изготавливается данная функциональная схема) в защитный корпус для защиты от физических повреждений и коррозии. Существует много типов корпусов ИС, каждый из которых имеет уникальные размеры, способы монтажа и количество выводов.
Наиболее распространенные типы корпусов ИС включают:
- Пакет DIP IC
2. Пакет микросхем для поверхностного монтажа
- QFP -> TQFP, VQFP, LQFP
- СОП -> PSOP, TSOP, TSSOP
- Пакет микросхем SOT
— Реклама —
3. Пакет SOIC
Пакет SOIC
4. Корпус BGA IC
5. Корпус QFN IC
Различные типы корпусов ICДвухрядный корпус (DIP) 3 Наиболее распространенный Корпус интегральной схемы со сквозным отверстием, используемый в схемах, особенно в хобби-проектах. Эта ИС имеет два параллельных ряда контактов, выходящих перпендикулярно из прямоугольного пластикового корпуса.
Габаритные размеры корпуса DIP зависят от количества выводов. Наиболее распространенное количество кеглей: четыре, шесть, восемь, четырнадцать, восемнадцать, двадцать, двадцать восемь и сорок кеглей. Штыри на DIP IC расположены на расстоянии 2,54 мм друг от друга, что является стандартным расстоянием, идеально подходящим для установки в макетные платы, вероплаты и другие макетные платы.
Микросхема DIP также может быть легко припаяна к печатной плате. Иногда вместо пайки ИС непосредственно на печатной плате используется гнездо для ИС. Использование разъема позволяет легко снимать DIP IC с печатной платы и вставлять ее в нее.
Устройство для поверхностного монтажа (SMD)
На рынке доступно множество корпусов для поверхностного монтажа, включая SOP, малогабаритные транзисторы (SOT) и QFP. Для корпусов SMD IC обычно требуются специальные печатные платы, содержащие соответствующий рисунок меди, на который они должны быть припаяны. Обычно для их пайки на печатных платах используются специальные автоматизированные инструменты.
ИС малого размера (SOIC)
Корпус SOIC короче и уже, чем DIP. Это SMD со всеми DIP-выводами, изогнутыми наружу и уменьшенными до размера. Каждый штифт обычно находится на расстоянии около 1,27 мм от следующего.
Пакет Small-outline (SOP)
Это еще меньшая версия пакета SOIC. Подобно SOIC, семейство SOP имеет меньший форм-фактор с расстоянием между выводами менее 1,27 мм. Каждая СОП включает пластиковую упаковку малого размера (PSOP), тонкую упаковку малого размера (TSOP) и тонкую термоусадочную упаковку малого размера (TSSOP).